对于手机等移动设备而言,BGA、CSP 或 POP 等面积阵列封装容易发生跌落故障,因此需要在将这些封装组装到印刷电路板上时对其进行加固。虽然底部填充是一种备选解决方案,但由于涉及额外的固化步骤,这会增加制造成本并降低温度循环可靠性。因此,人们更倾向于采用环氧助焊胶方法,这种方法省去了固化步骤的需求。
在将回流焊接阵列封装到印刷电路板上时,环氧助焊胶用作助焊剂,然后在回流焊之后自行固化,从而提供所需的加固效果,无需额外的固化步骤。由于焊盘塌陷是众多便携式设备的主要故障模式,环氧助焊胶成为了在所有聚合物加固解决方案中,成本低廉且可靠性高的SMT组装首选。
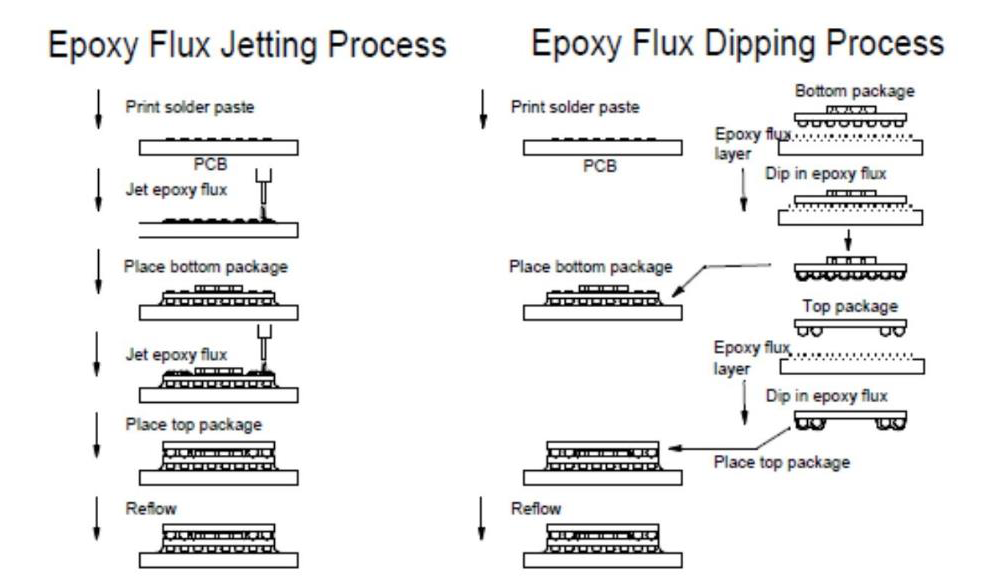
图1.环氧助焊胶喷射和浸渍工艺
环氧助焊胶具有自组装和自纠正功能。焊接后固化的环氧树脂具有绝缘、防腐和可靠性增强功能,它与底部填充胶、粘合胶等相容,提供了额外的器件保护和机械强度。环氧助焊胶可以通过浸渍或印刷方式应用到顶部元器件上,然后将它们贴装到底部元器件上,再进行回流焊接。
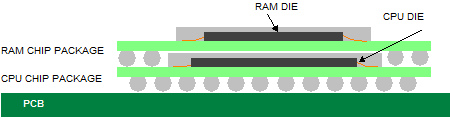
图2.POP层叠封装
环氧助焊胶在POP层叠封装上的应用有以下几个优点:
1.高精度定位:它有效防止顶部元器件在贴装过程中的移位和倾斜,确保元器件的准确定位。
2.减少缺陷:环氧助焊胶有效抵制顶部元器件在再流焊过程中的翘曲变形,从而减少虚焊、开路、球窝等缺陷的产生。
3.提高连接强度和可靠性:它增强了顶部元器件与底部元器件之间的连接强度和可靠性,增强抗剪切、抗拉伸、抗冲击等性能。
4.元器件保护:环氧助焊胶有效密封单个凸块,防止水分、灰尘、杂质等侵入,延长元器件的使用寿命。
总之,环氧助焊胶在POP层叠封装上的应用具有显著的优势,可以提高产品的性能和质量,降低制造成本和风险。环氧助焊胶是一种新型的材料系统,值得在半导体封装、印刷电路板组装乃至一些新兴的元器件工艺如叠层封装(POP)中广泛应用。
福英达助焊胶
深圳市福英达生产的细间距助焊胶适用于晶圆凸点焊接、芯片蒸镀焊接、BGA、SiP、CSP、MicroLED封装、模组集成电路等领域的高精密、高可靠封装。欢迎来电咨询。
审核编辑 黄宇
-
封装
+关注
关注
128文章
9386浏览量
149220 -
PoP
+关注
关注
0文章
33浏览量
16414
发布评论请先 登录
冬季灌封胶不干?环氧聚氨酯低温固化五大避坑指南 |铬锐特实业

Flip Chip水溶性助焊膏:高良率 · 低空洞 · 易清洗 · 适用于先进封装

汉思新材料:电路板IC加固环氧胶选择与应用

汉思新材料:光模块封装用胶类型及选择要点

汉思新材料:无人机哪些部件需要用到环氧固定胶

MF52A 环氧封装CP线热敏电阻介绍

Type C端子母座密封胶是一种热固化单组份环氧密封胶粘剂,与其他类型的密封胶相比,有哪些优势?其应用行业

半导体晶圆制造洁净室高架地板地脚用环氧ab胶固定可以吗?-江苏泊苏系统集成有限公司

UV胶 vs 热熔胶 vs 环氧胶:电子工业粘接材料大比拼

汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案




 环氧助焊胶在POP层叠封装上的应用
环氧助焊胶在POP层叠封装上的应用









评论