近期,台积电将其高性能计算与 AI 芯片封装技术亮相于国际固态电路大会(简称 ISSCC 2024),据悉,此技术有望将芯片晶体管数目由现有的1000亿级跃升至1万亿级。
台积电高级研发副总裁张晓强指出,本项新技术主要针对AI芯片性能增强。新型HBM高带宽存储器与Chiplet架构小芯片的引入需求大量组件及IC基板,由此引发的连通性及能源消耗等问题难免产生。他特别强调,借助硅光科技与光纤替代传统I/O电路,实现高效率的数据传输;此外,通过异质芯片堆叠和混合键合,最大限度优化I/O。值得注意的是,这项封装技术将运用集成稳压器应对供电问题,但具体商用时间尚未透露。
台积电透露,当前全球前沿芯片最多可容纳1000亿晶体管,然而新的封装平台能使之增加到1万亿级别。尽管该封装内将搭载集成稳压器解决供电问题,但未来商业化仍待进一步确认。此外,张晓强还暗示台积电的3nm制程技术很可能迅速应用于汽车领域。
-
存储器
+关注
关注
39文章
7715浏览量
170856 -
AI芯片
+关注
关注
17文章
2065浏览量
36570 -
chiplet
+关注
关注
6文章
482浏览量
13504
发布评论请先 登录
台积电2纳米制程试产成功,AI、5G、汽车芯片,谁将率先受益?
【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
美国芯片“卡脖子”真相:台积电美厂芯片竟要运回台湾封装?
下一代高速芯片晶体管解制造问题解决了!
英特尔18A与台积电N2工艺各有千秋
台积电超大版CoWoS封装技术:重塑高性能计算与AI芯片架构
台积电2纳米制程技术细节公布:性能功耗双提升
台积电2nm制成细节公布:性能提升15%,功耗降低35%
台积电分享 2nm 工艺深入细节:功耗降低 35% 或性能提升15%!
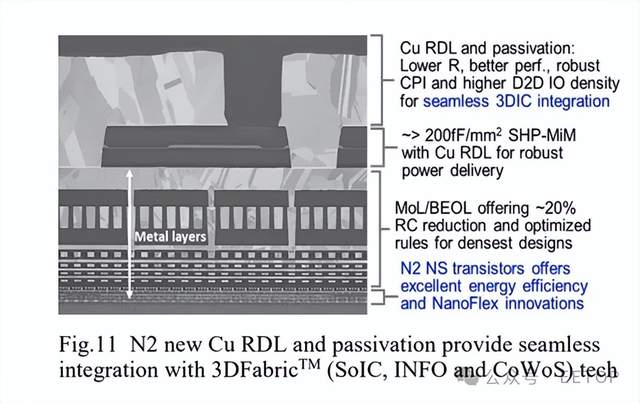





 台积电创新推出万亿晶体管封装平台,专注于高性能计算和AI芯片应用
台积电创新推出万亿晶体管封装平台,专注于高性能计算和AI芯片应用














评论