文章转自:屹立芯创公众号
“TSV是能实现芯片内部上下互联的技术,可以使多个芯片实现垂直且最短互联”,AI算力带动TSV由2.5D向3D深入推进,HBM异军突起,前道大厂凭借积淀的制造优势继续垄断并瓜分全部的市场份额,在新应用催化下,也为后端封测厂和TSV设备公司带来了市场机会。
硅通孔
/
TSV(Through-Silicon Via)
硅通孔TSV是一种能让3D封装遵循摩尔定律演进的互连技术,芯片与芯片之间(Chip to Chip)、芯片与晶圆之间(Chip to Wafer)、晶圆与晶圆之间(Wafer to Wafer)实现完全穿孔的垂直电气连接,可像三明治一样堆叠晶片。这些垂直连接可用于互连多个芯片、存储器、传感器和其他模块,硅通孔互连赋予了各种 2.5D/3D封装应用和架构芯片纵向维度的集成能力,以最低的能耗/性能指标提供极高的性能和功能,以打造更小更快更节能的设备。
·使用TSV,封装系统沿着Z轴进行延伸拓展,出现了2.5D和3D集成,并演化出CoWoS、HBM、Co-EMIB、HMC、Wide-IO、 Foveros、SoIC、X-Cube、VIPack、3D Matrix、VISionS等技术和平台。
·使用TSV,通过更薄的硅芯片缩短互连长度和短垂直连接,有助于减少芯片的整体面积和功耗、将信号传播延迟减少几个数量级。这些优点使其非常适合用于不同的高速应用,例如数据中心、服务器、图形处理单元 (GPU)、基于人工智能 (AI) 的处理器和多种无线通信设备。
·使用TSV,能够实现异构集成。异构集成涉及将来自不同技术和制造商的多个芯片组合到一个封装中,从而使它们能够提供更好的功能和性能。TSV通过为相应芯片提供可靠的互连技术来实现这些功能。
TSV
用到前道制造工艺
//
TSV技术是 2.5D/3D 封装的关键技术,包括制造商、代工厂、封测代工厂都对 TSV的工艺进行了研究。
TSV工艺包含晶圆的表面清洗、光刻胶图案化、干法/湿法蚀刻沟槽、气相沉积、通孔填充、 化学机械抛光等几种关键工艺。运用到晶圆减薄机、掩膜设备、涂胶机、激光打孔机、电镀设备、溅射台、***、刻蚀机。硅通孔 (TSV) 的主要工艺类型分为先通孔(Via-first)、中通孔(Via-middle)和后通孔(Via-last),中通孔目前是高级3D IC以及中介层堆栈的热门选择。
英特尔、台积电、三星等晶圆厂商在前道制造环节经验老道,对前道步骤的TSV技术熟能生巧,因而在2.5D/3D封装技术上独领风骚。
TSV
应用领域
//
3D TSV封装市场分为存储器、逻辑、MEMS 和传感器以及其他应用。由于人工智能催生对DRAM 和 NAND 等内存应用需要TSV实现高密度封装。由于TSV高性能需求,处理器和图形芯片等逻辑应用也受益于TSV封装。MEMS和传感器是TSV封装的另一个不断增长的应用领域。
TSV是实现3D先进封装的重要技术,TSV封装市场由许多主要竞争对手主导,这些竞争对手在2023年以来提高其产品的功能、可靠性和适应性方面取得了重大进展。使用尖端材料和制造方法来增强TSV的性能和耐用性,将电容器和电阻器等无源元件集成到封装中,以及开发晶圆级封装和扇出封装等新型封装架构。
AI激发巨头争霸天下
//
台积电是TSV领域的主导者,其专利涉及TSV制造方法、堆叠3D IC 的TSV设计、与封装相关的TSV结构等。英特尔和高通的地位接近,其专利涉及用于晶体管密度缩放的TSV、堆叠 IC 的封装、3D IC 中用于使其无缺陷的TSV测试流程、TSV互连等。
CoWoS是AI芯片的底层技术,是共同封装HBM和逻辑以获得训练和推理工作负载最佳性能的主要方法。CoWoS来自台积电的2.5D先进封装技术,核心是在同一片硅中介层实现不同堆叠芯片的互联。在硅中介层中为提高互联密度以及数据传输带宽,台积电使用微凸块、硅通孔等技术,将裸片连接代替传统的引线键合。
台积电的下一代先进封装技术为SoIC,计划2026年将产能扩大到20倍以上。该技术是自原本SoC演变而来,是一种使用TSV技术将具有各种功能的相邻芯片结合在无凸块接合结构中的技术,目前已经实现12层堆叠。2023年3月,AMD一次性推出了三款采用3D垂直缓存(3D V-Cache)技术的Zen 4架构桌面处理器,背后得益SoIC技术支持,作为一种无损芯片堆叠技术,意味着不使用微凸点或焊料来连接两个芯片,硅通孔可以在没有任何类型的粘合材料的情况下进行匹配。精于此道,第二代3D V-Cache虽然做了改进,但仍保持最小TSV间距。
2021年特斯拉人工智能日推出了其自研的面向AI专用领域的Dojo D1芯片,特斯拉通过使用台积电芯片先进封装技术InFO_SoW,集成25个D1芯片的训练模块在人工智能训练芯片D1上,从而构建出Dojo超算系统的基本单元。如今特斯拉 Dojo 2 芯片正在采取很多措施来缓解内存带宽限制,使其能够高效地运行自动驾驶FSD、LLM以及人模人样的机器人。
2022年3月,“英国的英伟达”Graphcore发布智能处理单元产品Bow,采用台积电SoIC-WoW混合键合技术,背面TSV允许互连至晶圆内层;较上一代性能提升40%,功耗降低16%。
2022年3月苹果公司推出的M1 ULTRA处理器,通过优化高纵横比的硅通孔,Ultra Fusion/CoWoS-S5使用重新设计的TSV,优化传输特性,以适合高速SerDes传输,同时赋予后任产品M2、M2 Max 到M2 Ultra的强大效能。
AMD在高端芯片率先启用台积电“SoIC+CoWoS”的封装服务获得了不小的收益。致英伟达感到眼红,开始评估SoIC技术,或在2024年至2025年的产品线更新计划中采用。台积电已经将CoWoS、InFO封装的一些流程,外包给OSAT厂商形成成熟的合作模式。
英伟达是台积电的深度绑定客户,在全球对于AI数据中心算力的旺盛需求推动下,英伟达的GPU订单也在不断飙升,其A100、H100等AI GPU的产能支持,都来自台积电的CoWoS封装。目前,英伟达以及其他云服务提供商(CSP)自研芯片的加单下,试图通过加大TSV产线来扩增HBM产能。
2020年,三星推出3D封装技术——X-Cube,基于TSV硅穿孔技术将不同芯片堆叠,已经可以将SRAM芯片堆叠到芯片上方,最大程度上缩短互连长度,在降低功耗的同时能提高传输速率。三星新一代产品DDR5 利用TSV技术堆叠了8层16GBDRAM芯片。DDR5 是高性能低功耗的内存,将广泛应用于大多数的计算场景中,机构预测到2025年后渗透率将超 60%。
AI大模型的数据计算量激增,驱动HBM异军突起。HBM是由AMD和SK Hynix发起的基于3D堆栈工艺的高性能DRAM,其通过使用TSV硅通孔技术垂直堆叠多个DRAM,并与GPU封装在一起。HBM通过SIP和TSV技术将数个DRAM裸片像楼层一样垂直堆叠,可显著提升数据传输速度,适用于高存储器带宽需求,成为当前AI GPU存储单元的理想方案和关键部件。早在十年前,SK海力士运用TSV技术开发DRAM,在业界首次成功研发出HBM。随后,存储巨头三星、美光迎头追赶。目前HBM市场份额SK海力士占据了50%,三星40%,美光10%。机构预测,2023年HBM需求较去年增加99%,2024年将比2023年再增191%!
2021年10月,SK海力士开发出全球首款HBM3,2022年6月量产了HBM3 DRAM芯片。2023年4月,在全球首次实现垂直堆叠12个单品DRAM芯片,成功开发出最高容量24GB的HBM3 DRAM新产品,利用TSV技术将12个比现有芯片薄40%的单品DRAM芯片垂直堆叠,实现了与16GB产品相同的高度,容量较上一代HBM3 DRAM提升50%,并将供货包括英伟达、AMD、微软、亚马逊在内的全球科技巨擘,持续巩固其市场领导地位。SK海力士也因此赚得盆满钵满,数据显示,2023年SK海力士独家供应的HBM3价格上涨5倍,是SK海力士旗下最高毛利产品。由于HBM3E需求暴增,SK海力士决定2024年大扩产、采用最先进的10纳米等级第五代(1b)技术,多数新增产能将用来生产HBM3E。如今,SK海力士的晶圆级封装(WLP)业务部门已决定通过公司内部补充后端工艺技术人才,强化TSV硅通孔技术的研发、量产和良率管理。
2023年9月,三星HBM内存通过NVIDIA验证并同意签订供应协议。NVIDIA计划2024年出货最高200万颗H100,这将有力提升当前萎靡不振的业绩营收。目前三星已经量产了HBM2E和HBM3,三星正在开发HBM4,预计2025年推出。
2023年6月AMD发布次世代GPU MI300X,搭配的HBM3来自由SK海力士及三星电子的合力供应。
HMC(混合存储立方体)是美光标准的高端服务器产品,HMC通过3D TSV集成技术把内存控制器集成到DRAM堆叠封装里以实现更大的内存带宽。目前美光放弃HMC技术,转向HBM。2022年11月,美光推出了1βDRAM 技术,可跳过EUV量产。美光指出,1β是全球最先进的DRAM制程节点,使用硅通孔(TSV)技术可实现DRAM芯片的多层堆叠提升模块容量。2023年7月,美光推出美光 HBM3 Gen 2,称其内存是世界上速度最快的,具有 1.2 TB/s 的聚合带宽,8 高堆叠容量为 24GB。未来还有 12 高堆叠版本,容量可达 36GB。
2023年5月三星量产12纳米级16Gb DDR5 DRAM, DDR5 利用TSV 技术堆叠了8层16GB DRAM 芯片,DDR5 模块容量提升至 512GB。2023年9月,三星推出业界最高容量12纳米级32Gb DDR5 DRAM并于年底前量产,但这次竟然没有用TSV生产,邪了。
Foveros是英特尔推出的有源板载技术,实现三维面对面异构集成芯片堆叠,从 3D Foveros 在中介层里有大量的TSV穿孔,负责联通上下的焊料凸起,让上层芯片和模块与系统其他部分通信。并将Foveros技术与EMIB相结合成Co-EMIB使芯片封装更具弹性。2023年9月英特尔展示了其最新款的酷睿Ultra处理器。Ultra 1 即采用Foveros封装。
英特尔正在积极投入先进制程研发,并同步强化先进封装业务。目前正在马来西亚槟城兴建最新的封装厂,规划到 2025 年时,其3D Foveros 封装的产能将增加四倍。
如今TSV正被成功应用于玻璃基板上,与以往相比,新一代处理器将在更小的体积内实现更多的组件,从而提高了设备的紧凑性和性能。这项突破性的技术披露为未来的计算设备和人工智能提供了崭新的可能性。
2023年6月,英特尔发表了界领先的背面供电解决方案PowerVia,其中技术之一使用TSV进行电源布线。在PowerVia中,芯片的晶体管层中有纳米级TSV(Nano TSV)。使用TSV可以让电力更直接地输送到晶体管层,避免了必须设计和内置埋入电源轨所需的路由。PowerVia预计将于2024年随Intel 20A制程节点推出,并致力于在2030年实现在单个封装中集成一万亿个晶体管,PowerVia对这两大目标而言都是重要里程碑。
Amkor的TSV技术使最先进的封装能够满足高性能和低能耗的需求。已开发出多种后端技术平台,以实现对TSV晶圆进行大批量加工和封装。TSV晶圆工艺始于已形成盲孔TSV的300毫米晶圆。晶圆工艺包括对晶圆进行减薄使TSV露头,最后以背面 (BS) 金属化完成TSV互连结构。
除了以上大佬,在TSV技术深耕的企业还有高通、IBM、意法半导体、NXP Semiconductors NV、ASML Holding NV、Dialog Semiconductor plc、索尼、东芝、恩智浦、应用材料公司、Positivo Tecnologia SA、AMS欧司朗、Avianca Holdings SA、Banco Santander、Mercado Libre、FOSiP等。
中国封测厂雄踞一方
//
目前,中国地区具备TSV量产能力的封测厂商主要包括日月光、力成科技、长电科技、通富微电、华天科技、晶方科技、苏州科阳、华进半导体、珠海天成先进半导体。另外还有气派科技、甬矽电子、厦门云天半导体、颀中科技有储备硅穿孔技术。
2.5D/3D是日月光VIPack平台六大技术之一,具有TSV的Si内插器可以用作桥接组件基板和集成电路板之间的精细间距能力差距的平台。它还有助于保持焊盘间距缩放路径,而不受组装基板技术的限制。日月光是2.5D/3D封装技术的先驱之一,并已成功推出全球首款配备HBM的2.5D IC封装量产产品。公司控股的矽品精密工业有限公司拥有2.5D/3D 的TSV集成实力。
力成科技3D IC解决方案提供硅通孔 、最后通孔和存储立方体芯片堆叠,应用于HBM产品和CMOS图像传感器。2020年宣布成立专责事业部投入CIS封装市场,运用既有的直通矽晶穿孔技术发展晶片尺寸晶圆级封装(WLCSP)。新一代深穿孔技术(Cu-TSV)2024年落地生产。
力成科技拥有完备的MEOL/BEOL全程工艺能力。TSV保形铜填充的良好控制电镀,RDL能力线/间距:5um / 5um。对于Via Last(VL)工艺,IDM/Foundry将进行FEOL(CMOS)和金属化,PTI进行u-bump、TSV形成、TSV填充、RDL;即堆叠和组装过程(BEOL)。对于芯片堆叠工艺,首先通过MEOL工艺完成芯片(TSV、u-bump)的互连,然后通过BEOL工艺完成分割,进一步通过热压接合(TCB)进行芯片堆叠。
TSV技术构成华天科技3D Matrix平台的重要构成。TSV技术,主要结构就是MVP、MVPPlus和直孔的工艺,主要应用于影像传感器的封装;eSinC采用TSV通孔实现垂直方向互联,大大提高了互联密度和集成度。互联TSV深宽比可以做到3:1,目前给客户出样的3D堆叠封装共集成5颗芯片,整体封装厚度小于1mm,该技术的目标应用主要是Al、IoT、5G和处理器等众多领域。华天科技TSV及FC集成电路封测产业化项目即将全面达产,可年新增高性能集成电路封装测试48万片。
通富微电在高性能计算领域建成了2.5D/3D封装平台VISionS。晶圆级TSV,利用次微米级 interposer 以TSV将多芯片整合于单一封装。在存储器领域,公司多层堆叠NAND Flash及LPDDR封装实现稳定量产,同时在国内首家完成基于TSV技术的3DS DRAM封装开发。2.5D/3D生产线建成后,将实现国内在HBM(高带宽内存)高性能封装技术领域的突破。
晶方科技是TSV晶圆级芯片尺寸封装和测试服务的全球领先供应商。率先投资TSV技术,结合创新设计方案选配合适的工艺设备和材料,利用晶圆级硅通过 (TSV) 技术改进电气性能开发了完整的晶圆级CSP封装工艺,建立了国内首条300毫米中道TSV规模化量产生产线, 为2.5D和3D 先进封装的需求提供解决方案。目前集成电路12英寸TSV及异质集成智能传感器模块项目正顺利进展。
华进半导体自公司成立之初便集中精力开发TSV技术,并在国内率先实现了12吋硅通孔转接板的制造;基于此研发成果,华进还重点开发了Via-Las TSV、晶圆级封装等先进工艺,构建了较为完整的三维系统集成和2.5D全套封装设计到硅转接板晶圆制造到2.5D组装成套一站式解决方案。
苏州科阳主要采用TSV 3D封装技术从事CIS 芯片和滤波器芯片的晶圆级封装服务。目前已发展成为具备年产30亿颗芯片的知名晶圆级先进封装企业,为国内多家顶尖半导体企业国产化提供关键解决方案,是全球TSV先进封装细分领域排名居前的方案提供商。已开建12英寸CIS芯片TSV晶圆级封装项目,产能6000片/月,预计总投资约4.24亿元。
广东越海集成技术有限公司2022年11月成立运营,12月完成1.65亿元。将建设晶圆级封装生产线、3D传感器模块生产线生产线采用分期建设模式,一期项目投资9.8亿元,建成12寸TSV封装产能每月1.3万片,8寸及兼容4/6寸TSV封装产能每月2万片,可服务于快速增长的新能源汽车和自动驾驶等多个领域,加速国产化产业进程。
2023年3月,西安微电子技术研究所12英寸晶圆级TSV立体集成项目在珠海高新区举行开工仪式项目的开工建设。该项目由西安微电子、时代远望、中兴新、深创投、格金六号几家共同投资设立,并在4月联合成立珠海天成先进半导体科技有限公司,规划投资30亿,将3D TSV立体集成作为重要突破方向,打造2.5D/3D产品广泛应用于高算力处理器、高密度存算等领域。
该项目预计一期达产后可实现年产24万片TSV晶圆能力,年产值规模超8亿元。二期能力扩充后,可实现年产60万片TSV晶圆能力。项目定位于行业领先的TSV立体集成科研生产基地,技术水平国际先进,产品类型多元化,覆盖3D TSV立体集成、2.5D系统集成等领域。
尽管大陆封测厂商加速TSV的产业化进程,但在先进封装全球产业的市场份额占比仍小,在当前风起云涌的HBM市场应用为毫无存在感。目前韩国厂商将全球50%的存储芯片出口到了中国大陆,95%出口到了中国大陆、中国香港、中国台湾、越南和菲律宾!中国是全球最大的数据中心芯片市场。英伟达、英特尔、AMD等芯片厂商约50%的收入来自数据中心芯片。这三家主要数据中心芯片在中国大陆地区(含香港)2022年营收占比分别为21.4%、27.2%、22.1%。
中国大陆TSV为代表的2.5D/3D封装与国外公司的技术差距明显,仍需加足马力,产研协同攻克,当务之急的有赖于TSV设备的国产化要与客户需求同步接轨。同时,需要伴随2024/2025以后的TSV产能落地后,国内HBM市场将实现初步突破。
国内
TSV
设备供应商
//
中微公司是中国最大的半导体等离子体刻蚀设备和化学薄膜设备供应商。Primo TSV®(TSV200E、Primo TSV300E)是中微推出的首款用于高性能硅通孔刻蚀应用的高密度等离子体硅通孔刻蚀设备,均可刻蚀孔径从低至1微米以下到几百微米、深度可达几百微米的孔洞。中微的TSV硅通孔刻蚀机在8英寸和12英寸设备国内市场占有率超过50%,市场份额呈现进一步上升趋势。当前,新应用包括DRAM 中的高深款比的多晶硅掩膜、12英寸的3D芯片的硅通孔刻蚀工艺(TSV)均已验证成功。
北方华创是目前国内集成电路高端工艺装备的先进企业,于2020年推出12英寸先进封装领域深硅刻蚀机PSE V300,因性能达到国际主流水平,在结构系统方面,PSE V300采用每腔单片设计,在气流场均匀性等方面工艺表现良好。机台可同时配置6个腔室,在保证大产能量产方面性能良好。在硅通孔应用方向,在等离子刻蚀机方面还有封装用的PSE V300Di、HSE D300、HSE P300、BMD P300;物理气相沉积设备有Polaris Series以及氧化扩散设备和清洗设备。到2023年6月,北方华创12英寸深硅刻蚀机PSE V300累计实现销售100腔,成为国内TSV量产生产线主力机台。助力Chiplet TSV工艺发展。经过三年的迭代更新,PSE V300已从最初的2.5D/3D封装领域,逐渐应用至功率器件、图像传感器及微机电系统等众多领域。
先进封装***是上海微电子目前的主打产品,国内市场占有率已连续多年第一,主要产品是500系列***(SSB500 40/50) 系列步进投影***主要应用于200mm/300mm集成电路先进封装领域,可满足TSV制程的晶圆级光刻工艺需求。2022年上海微电子制造的中国首台2.5D/3D封装***下线交付用于高端数据中心的高性能计算芯片和高端AI芯片等高密度异构集成芯片。
芯碁微装专业从事以微纳直写光刻为技术核心的直接成像设备及直写光刻设备的研发和生产,在晶圆级封装领域,公司的 WLP 系列产品可用于 8inch/12inch 集成电路先进封装领域,涉及到的工艺流程包括垂直布线TSV,在TSV制程工艺中优势明显。
盛美半导体设备(上海)致力于先进半导体湿法清洗工艺。应用于晶圆级封装的电镀设备Ultra ECP 可填充3d硅通孔TSV。基于盛美半导体电镀设备的平台,该设备可为高深宽比(深宽比大于10:1)铜应用提供高性能、无孔洞的镀铜功能。
同时公司SAPS技术可用于TSV深孔清洗应用。用于CMP研磨后的清洗设备有Ultra C WPN(WIDO)、单片清洗机Ultra C SAPS。拥有兆声波技术完成TSV晶片的刻蚀后清洗公司还有至纯科技、华林科纳等。
拓荆科技是国内唯一产业化应用集成电路 PECVD 设备的厂商,公司 12 英寸 PEALD 设备 FT-300T 可沉积 SiO2 和 SiN 材料薄膜,可用于3D TSV先进封装。
微导纳米是以原子层沉积(ALD)技术为核心的高端设备制造商。iTomic HiK系列原子层沉积镀膜系统适用于TSV介质层。
华海清科主要从事CMP设备和工艺及配套耗材的研发、生产、销售与服务,独立自主研制的12英寸化学机械抛光设备顺利出货,主要就是用于TSV化学机械的抛光。2023年5月发售新一代12英寸超精密晶圆减薄机Versatile-GP300。
屹立芯创晶圆级压膜机,是一款集真空压膜、精密压膜和高效贴膜于一体的高性能设备,它的出现,不仅推动了填孔覆膜机技术的进步,更为整个半导体制造领域带来了新的发展可能。屹立芯创以强大的技术实力和对创新的坚持,正在引领半导体制造领域进入一个全新的时代。

屹立芯创晶圆级真空贴压膜机制程效果,TSV填覆率可达1:20
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54463浏览量
469660 -
IC封装
+关注
关注
4文章
196浏览量
27734 -
TSV
+关注
关注
4文章
139浏览量
82784 -
HBM
+关注
关注
2文章
435浏览量
15887 -
先进封装
+关注
关注
2文章
563浏览量
1063
发布评论请先 登录
SK海力士投资19万亿韩元在韩国建设先进封装厂
封测巨头全球“圈地”,先进封装正成为AI时代的战略制高点
无源TSV转接板的制作方法




 先进封装技术之争 | 巨头手握TSV利刃垄断HBM市场,中国何时分一杯羹?
先进封装技术之争 | 巨头手握TSV利刃垄断HBM市场,中国何时分一杯羹?






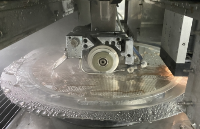



评论