在半导体行业的激烈竞争中,先进封装技术已成为各大厂商角逐的关键领域。英特尔作为行业的重要参与者,近日在电子元件技术大会(ECTC)上披露了多项芯片封装技术突破,再次吸引了业界的目光。这些创新不仅展现了英特尔在技术研发上的深厚底蕴,也为其在先进封装市场赢得了新的竞争优势。
英特尔此次的重大突破之一是 EMIB-T 技术。EMIB-T 全称为 Embedded Multi-die Interconnect Bridge with TSV,是嵌入式多芯片互连桥接封装技术的重大升级版本,专为高性能计算和异构集成设计。其技术升级主要体现在三个核心方面。
在信号传输与供电优化上,EMIB-T 在传统 EMIB 的硅桥结构中创新性地嵌入硅通孔(TSV)。传统 EMIB 采用悬臂式供电路径,存在较高的电压降,而 TSV 从封装底部直接供电,这一改变将电源传输电阻降低 30% 以上,极大地减少了电压降和信号噪声。这使得它能够稳定支持 HBM4 和 HBM4e 等高带宽内存的供电需求,同时兼容 UCIe-A 互连技术,数据传输速率可达 32 Gb/s+。举例来说,在 AI 加速器和数据中心处理器等对供电稳定性和数据传输速率要求极高的场景中,EMIB-T 的这一特性能够确保设备稳定运行,避免因供电不足或信号干扰导致的性能下降。
面对高速信号传输中常出现的电磁干扰问题,EMIB-T 在桥接器内部集成了高密度金属 - 绝缘体 - 金属(MIM)电容器。这一设计可有效抑制电源噪声,确保信号完整性。在复杂异构系统中,如同时集成了多种不同功能芯片的 AI 计算平台,不同芯片间的信号容易相互干扰,而 MIM 电容器的存在使得 EMIB-T 能够保持稳定的通信性能,保障整个系统的高效运行。
在封装尺寸与集成密度的提升上,EMIB-T 支持最大 120x180 毫米的封装尺寸,单个封装可集成超过 38 个桥接器和 12 个矩形裸片(die)。目前,其凸块间距已实现 45 微米,未来计划进一步缩小至 35 微米甚至 25 微米。这种高密度集成能力为 Chiplet 设计提供了更广阔的空间。以单个封装中整合 CPU、GPU、HBM 内存和 AI 加速模块为例,通过 EMIB-T 技术,这些不同功能的芯片能够紧密协作,显著提升系统级性能,同时减少了整个系统的体积和功耗。
除了EMIB-T 技术,英特尔还在散热和热键合技术方面取得进展。随着人工智能和数据中心应用的迅猛发展,芯片功耗和封装尺寸不断增加,散热成为了关键挑战。英特尔推出的新分散式散热器设计,通过将散热器拆分为平板和加强筋,优化了与热界面材料(TIM)的耦合,减少了约 25% 的 TIM 焊料空隙,大大提升了热传导效率。并且,该设计支持集成微通道的散热器,液体可直接通过一体式热沉(IHS)冷却处理器,适用于热设计功耗(TDP)高达 1000W 的芯片封装,为高性能计算平台提供了可靠的热管理解决方案。
在热键合技术上,英特尔开发了一种针对大型封装基板的新型热压粘合工艺,解决了芯片和基板在粘合过程中的翘曲问题。该工艺通过最小化热差,提高了制造良率和可靠性,支持更大尺寸的芯片封装,并实现了更精细的EMIB 连接间距。这不仅增强了 EMIB-T 的互连密度,也为复杂异构芯片设计提供了更高的灵活性。
英特尔的这些先进封装技术突破具有深远意义。在行业竞争层面,现代处理器越来越多地采用复杂的异构设计,将多种类型的计算和内存组件集成到单个芯片封装中,先进封装技术成为实现这一目标的基石。英特尔凭借这些创新,能够与台积电等竞争对手在先进封装领域展开有力角逐。在市场应用方面,AWS、思科等企业已与英特尔合作,将 EMIB-T 应用于下一代服务器和网络设备,这表明英特尔的新技术得到了市场的认可,有望在数据中心、边缘计算和消费电子等多个领域得到广泛应用。从技术发展趋势来看,英特尔计划在 2025 年下半年实现 EMIB-T 封装的量产,并逐步将凸块间距从 45 微米缩小至 25 微米,以支持更高密度的芯片集成。随着玻璃基板技术的成熟,EMIB-T 有望在 2028 年实现单个封装集成超过 24 颗 HBM,进一步推动内存带宽的突破。这将对全球半导体封装技术的发展方向产生深远影响,引领行业向更高性能、更高集成度的方向发展。
审核编辑 黄宇
-
英特尔
+关注
关注
61文章
10274浏览量
179238 -
先进封装
+关注
关注
2文章
517浏览量
968
发布评论请先 登录
吉方工控荣膺英特尔中国2025市场突破奖
英特尔连通爱尔兰Fab34与Fab10晶圆厂,加速先进制程芯片生产进程
英特尔代工:明确重点广合作,服务客户铸信任
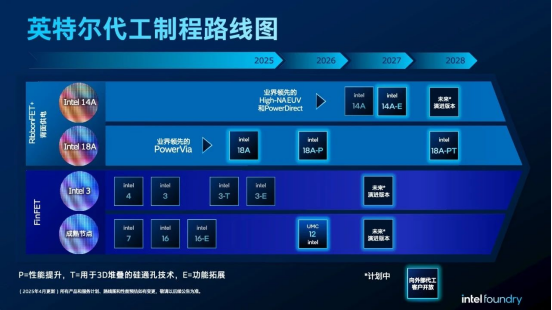
超700位客户及合作伙伴齐聚英特尔Vision 2025

英特尔先进封装:助力AI芯片高效集成的技术力量

请问OpenVINO™工具套件英特尔®Distribution是否与Windows® 10物联网企业版兼容?
英特尔任命王稚聪担任中国区副董事长
英特尔代工或引入多家外部股东
英特尔代工在IEDM 2024展示多项技术突破
英特尔IEDM 2024大晒封装、晶体管、互连等领域技术突破

英特尔展示互连微缩技术突破性进展
英特尔推出全新英特尔锐炫B系列显卡






 英特尔先进封装,新突破
英特尔先进封装,新突破













评论