thelec报道说,随着高带宽存储器(hbm)和3d包的商用化,热压缩(tc)联合收缩机市场正在迅速增长。为应对市场增长,三星子公司semes和韩美半导体等国内设备公司成功实现了hbm用tc键合机国产化,但海外设备公司对tc键合机的依赖度仍然很高。
业界有关人士表示:“韩国tc键合机市场似乎正在依靠存储器配件企业实现多边化。”三星电子从日本东丽、新川和旗下的sez接收产品。sk海力士目前正在从新加坡asmpt和韩美半导体收购用于hbm的tc键合机设备。
tc键合机是hbm和半导体3d粘合剂为代表性应用领域的加工后,在晶片上堆积一个芯片的热压缩粘合剂。日本企业tc键合机的市场占有率很高。tc键合机销量排在前6位的公司中,日本公司占据了3家公司(西宝、新川、东丽)。此外,新加坡的asmpt和荷兰的besi也是tc键合机市场的强者。besi在非存储器用tc键合机的销售中占很大比重。
业界解释说:“到最近为止,海外装备企业的tc joint主要用于制造hbm。最近,semicus和韩美半导体开始供应hbm用tc键合机。”
semes从2000年代后期开始开发键合机装置。在2008至2009年间,该公司申请了5项粘合剂机械相关专利。之后开始研究多层键合机设备,目前提供sdb-3000md prime等芯片键合机设备。
韩美半导体于2017年进入tc键合机市场。当时与sk海力士共同开发键合机,用于hbm初期产品的量产。最近,韩美半导体成功开发出hbm3用“dual tc bonder 1.0 dragon”,向sk海力士承揽了415亿韩元规模的hbm制造设备订单。
虽然韩国tc键合机正在进行国产化,但预计短期内很难完全代替外国设备。因为三星电子计划在新一代hbm上使用东丽和新川设备。
一家装备企业的相关人士表示:“hbm虽然采用了韩国企业的dibonder装备,但是在进入非存储器市场上遇到了困难。”并表示:“besi、asmpt等正在向台积电、日月光、安靠等提供产品。”
-
芯片
+关注
关注
463文章
54424浏览量
469318 -
半导体
+关注
关注
339文章
31237浏览量
266561 -
粘合剂
+关注
关注
0文章
26浏览量
10313 -
HBM
+关注
关注
2文章
433浏览量
15884
发布评论请先 登录
光缆单价:在市场竞争与政策引导下的走向
高频超声键合技术:引线键合工艺优化与质量检测方法

NTC热敏芯片键合工艺介绍
国产时钟缓冲器:技术革新与市场竞争
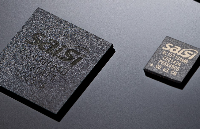
IGBT 芯片平整度差,引发键合线与芯片连接部位应力集中,键合失效

芯片制造中的键合技术详解

突破堆叠瓶颈:三星电子拟于16层HBM导入混合键合技术

晶源微 CSC7137D 芯片的成本优势在哪些市场竞争中更明显?




 HBM需求猛增,TC键合机设备市场竞争加剧
HBM需求猛增,TC键合机设备市场竞争加剧


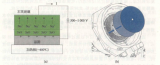





评论