近日,“2023功率与光电半导体器件设计及集成应用论坛”于西安召开。论坛由第三代半导体产业技术创新战略联盟(CASA)指导,西安交通大学、极智半导体产业网(www.casmita.com)、第三代半导体产业主办,西安电子科技大学、中国科学院半导体研究所、第三代半导体产业技术创新战略联盟人才发展委员会、全国半导体应用产教融合(东莞)职业教育集团联合组织、西安和其光电股份有限公司等单位协办。
期间,天津工业大学副教授李龙女带来了《基于***的平面型封装1700V碳化硅模块开发与性能表征》的主题报告。
SiC/GaN器件具有低导通电阻、快速开关、高耐压、低开关损耗和高工作温度当前亟需针对SiC器件/模块的先进封装,需要创新低寄生/杂散阻抗、高散热效率的高可靠封装结构,以及高耐温 (> 200oC), 高导电性和高可靠的封装材料。
报告介绍了开发采用全烧结银互连和DBC的平面型封装SiC功率模块的研究成果,研究指出材料方面采用氮化铝基板和烧结银垫块的封装结构,可明显降低双面封装结构整体应力,有利于提高模块可靠性。
封装结构方面采用模块-C间隔排布MOS芯片和二极管方式,最高结温更低,且各芯片间的温度差异更小,且寄生电感较小,更有利于保持模块性能。基于课题组低温纳米银烧结工艺,制备基于***的平面型封装1700V碳化硅半桥模块,模块整体厚度约5 mm。
通过测试,各栅源电压下栅源漏电流均很小。70A输出时,漏源导通压降为1.6V,与芯片I-V曲线一致,表明封装过程寄生阻抗低,双面互连也未引起芯片预损伤和老化退化。
-
芯片
+关注
关注
463文章
54422浏览量
469270 -
功率模块
+关注
关注
11文章
700浏览量
47036 -
碳化硅
+关注
关注
26文章
3545浏览量
52662
原文标题:天津工业大学李龙女:基于国产芯片的平面型封装1700V碳化硅模块开发与性能表征
文章出处:【微信号:第三代半导体产业,微信公众号:第三代半导体产业】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
技术突围与市场破局:碳化硅焚烧炉内胆的氮化硅陶瓷升级路径
QDPAK封装SiC碳化硅MOSFET安装指南

基于1700V碳化硅MOSFET的反激辅助电源设计

基本半导体汽车级Pcore6 HPD Mini封装碳化硅MOSFE模块介绍

打线门极电阻,助力SiC碳化硅模块性能提升
双脉冲测试技术解析报告:国产碳化硅(SiC)功率模块替代进口IGBT模块的验证与性能评估

简单认识博世碳化硅功率半导体产品
倾佳电子研究报告:B2M600170R与B2M600170H 1700V碳化硅MOSFET在电力电子辅助电源中的应用
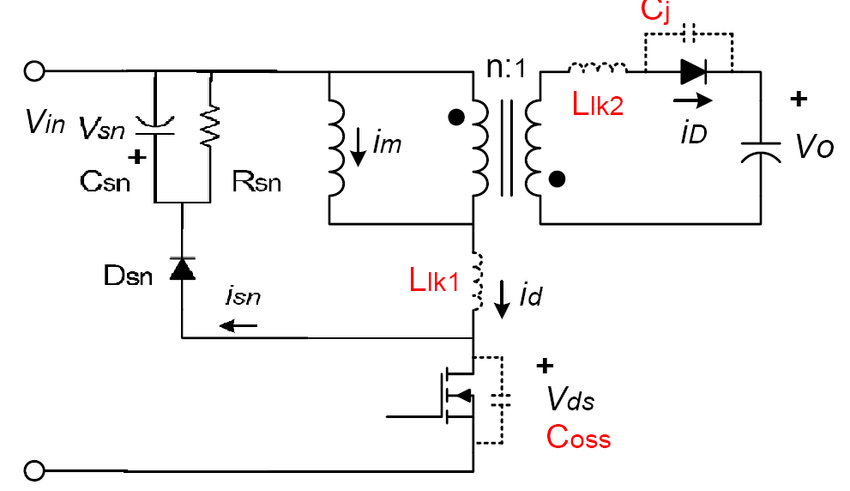
北京工业大学开源鸿蒙技术俱乐部正式揭牌成立

倾佳电子面向电力电子功率变换系统的高可靠性1700V碳化硅MOSFET反激式辅助电源设计

基本半导体推出34mm封装的全碳化硅MOSFET半桥模块




 天津工业大学李龙女:基于***的平面型封装1700V碳化硅模块开发与性能表征
天津工业大学李龙女:基于***的平面型封装1700V碳化硅模块开发与性能表征






评论