来源:英凯高级材料责任有限公司
领先的高性能电子材料制造商英凯高级材料责任有限公司宣布发布其突破性产品:导热底部填充胶 - UF 158A2。
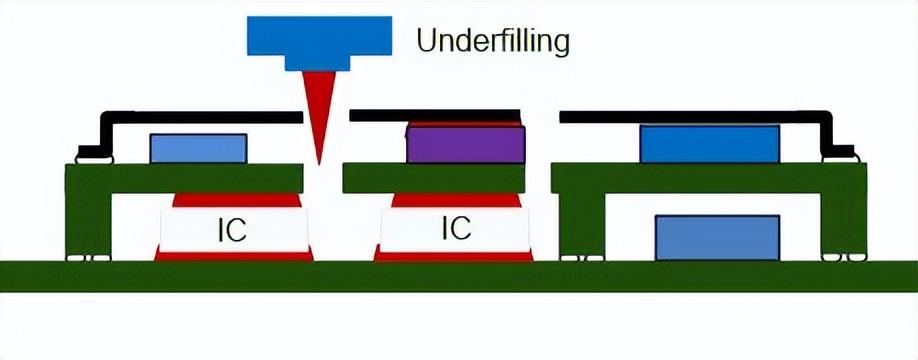
UF 158A2 非常适合用于温度循环、冲击和振动会损坏电子元件的高可靠性应用。该产品具有出色的导热性和高温稳定性,即使在最苛刻的环境中也能确保最佳性能。
“我们很高兴将 UF 158A2 引入我们的产品组合,”YINCAE 首席执行官 Wusheng Yin 博士说。 “我们相信 UF 158A2 将为我们的客户提供可靠且具有成本效益的解决方案:1). 快速流动且易于使用底部填充 100x100 mm 芯片(20m 间隙);2) 缩短制造过程;3). 高导热率 3-4W/mk;4). 快速固化和可返工;5). 巨大的成本节约,满足他们的热管理需求。”
UF 158A2 有多种配方可供选择,以满足不同的应用要求。该产品易于使用,可在低温下固化,适用于各种电子设备。凭借其卓越的性能、可靠性和易用性,UF 158A2 将成为电子行业的重要参与者。
* * * * * * * * * *
英凯高级材料责任有限公司成立于 2005 年,总部位于纽约奥尔巴尼,是微芯片和光电设备中使用的高性能涂料、粘合剂和电子材料的领先制造商和供应商。 YINCAE 产品提供新技术来支持从晶圆级到封装级、板级和最终设备的制造过程,同时促进更智能、更快速的生产并支持绿色倡议。
苏州会议
雅时国际(ACT International)将于2023年5月,在苏州组织举办主题为“2023-半导体先进技术创新发展和机遇大会”。会议包括两个专题:半导体制造与封装、化合物半导体先进技术及应用。分别以“CHIP China晶芯研讨会”和“化合物半导体先进技术及应用大会”两场论坛的形式同时进行。详情点击链接查看:https://w.lwc.cn/s/7jmaMn
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。
审核编辑黄宇
-
导热
+关注
关注
0文章
345浏览量
13723 -
电子材料
+关注
关注
0文章
73浏览量
11209
发布评论请先 登录
让电池包安然度过“火炉”与“极寒”:高导热硅脂在新能源汽车热管理中的实战记
汉思新材料斩获小间距芯片填充胶专利,破解高端封装空洞难题

汉思新材料:底部填充胶可靠性不足如开裂脱落原因分析及解决方案

解决高功率快充散热难题,傲琪G500导热硅脂的专业方案
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人

汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利




 突破性导热底部填充胶 - UF 158A2
突破性导热底部填充胶 - UF 158A2












评论