随着chatgpt在国内外不断的被关注着,研发自己的芯片也成为每个公司要努力的方向,今天我们讨论的FCBGA有机基板,是指应用于倒装芯片球栅格阵列封装的高密度IC封装基板。也就是说FCBGA封装是芯片底部处引脚由锡球所取代的方式,几百颗微小锡球固定其通过助焊剂定位后以表面贴焊技术固定到PCB,底部锡球的排列恰好也要对应到基板相应位置。
作为板级封装基板,在较小的空间内承载大量电子元器件。由于build-up基板优秀的电学性能和低廉的制造成本,FCBGA有机基板开始取代陶瓷基板,被应用于倒装芯片封装领域。FCBGA封装技术具有高集成度、小尺寸、高性能、低功耗等优势,FCBGA适用于多种种类的芯片,其常用于CPU、微控制器和GPU等高性能芯片,还适用于网络芯片、通信芯片、存储芯片、数字信号处理器(DSP)、传感器、音频处理器等等。FCBGA目前是移动设备中的理想封装技术,被广泛应用于智能手机、平板电脑和其他移动设备中。
随着芯片升级与性能的不同封装要求,对基板与焊点的清洁度要求也越加提高。 旋风非接触除尘设备目前应用在以下芯片封装领域,并且可以根据用户客户需求扩大应用 :

FBGA Board基板、印刷、镀层、背胶、

FCBGA倒装芯片球栅格阵列、图形加速芯片实装前的清洁
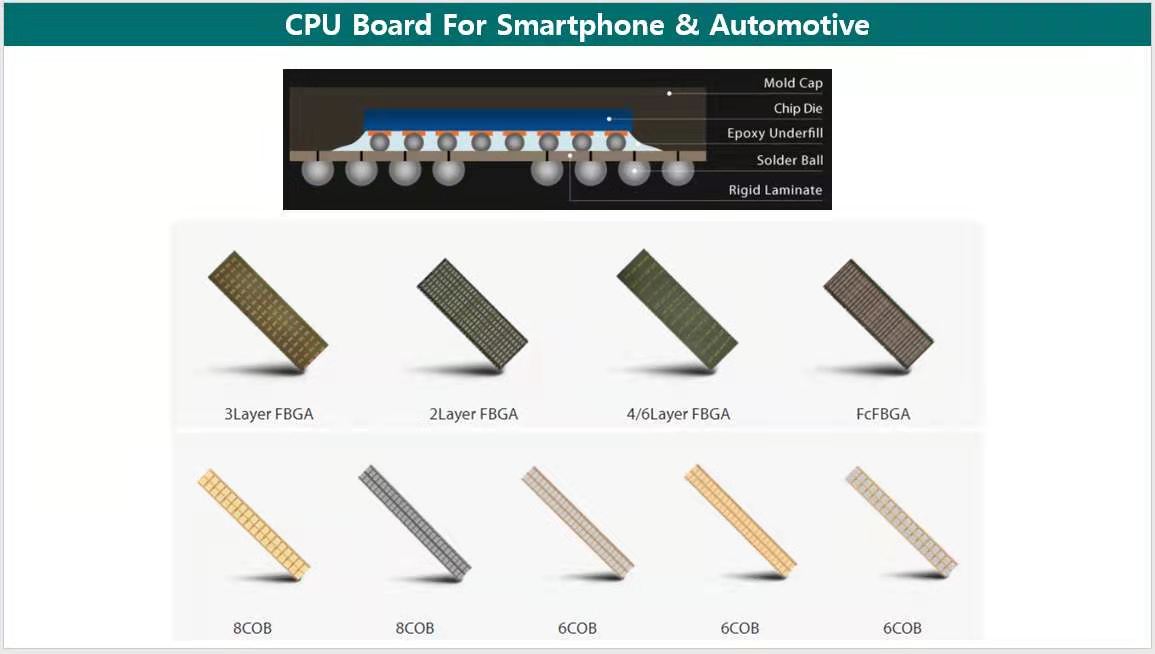
CPU Board制造时的清洁工程
审核编辑黄宇
-
芯片
+关注
关注
463文章
54410浏览量
469128 -
封装
+关注
关注
128文章
9325浏览量
149032 -
BGA
+关注
关注
5文章
586浏览量
51945
发布评论请先 登录
IDT产品工艺变更通知解读
DW-181水溶性助焊剂:面向先进封装工艺的高性能解决方案

CoWoS(Chip-on-Wafer-on-Substrate)先进封装工艺的材料全景图及国产替代进展

芯片封装等领域清洁除尘工艺解决方案
短距离光模块 COB 封装与同轴工艺的区别有哪些

人工智能加速先进封装中的热机械仿真


激光焊接技术在焊接微波组件壳体工艺中的应用

SK海力士HBS存储技术,基于垂直导线扇出VFO封装工艺

非接触式超声波流量传感器在涂布流体管理中的应用
提升功率半导体可靠性:推拉力测试机在封装工艺优化中的应用

半导体封装工艺流程的主要步骤




 FCBGA封装工艺中的旋风非接触除尘清洁
FCBGA封装工艺中的旋风非接触除尘清洁







评论