成果展示
直接电化学双-电子氧还原(2e ORR)制备过氧化氢(H2O2),为原位绿色生产H2O2提供了一种较好的替代蒽醌氧化技术的方法。由于有利于H2O2形成途径的含氧官能团,氧化碳材料已显示出其优异的2e ORR活性。然而,由于O含量相当低(<15%),O掺杂碳催化剂的2e ORR性能受到O诱导的活性位点密度的阻碍。 基于此,香港城市大学支春义教授(通讯作者)等人报道了一种以葡萄糖(C6H12O6)作为碳(C)源,制备出具有高氧/碳(O/C)原子比的碳量子点(carbon quantum dot, CQD)催化剂,其O含量为30.4 at%。实验测试发现,富氧CQD催化剂表现出优异的H2O2生产催化性能,选择性接近100%,超过了所有报道的O掺杂碳催化剂。此外,CQD催化剂在H2O2的实际生产中表现出巨大的潜力,其产率高达10.06 mg cm-2 h-1,法拉第效率(FE)为97.7%,并且在10 h内具有良好的稳定性。实验和理论研究证实,CQD催化剂中醚基(C-O-C)的绝大部分C-O键,C-O键的碳原子是2e ORR最活跃的位点。该工作为设计用于可持续电合成H2O2的高效无金属碳基催化剂提供了一种有效且简便的策略。
背景介绍
过氧化氢(H2O2)作为一种重要的防腐剂和氧化剂,在化学和医疗行业中发挥着至关重要的作用。然而,传统的工业生产H2O2的蒽醌工艺存在能耗高、成本高的问题。电催化双-电子氧还原(2e ORR)生成H2O2为绿色合成H2O2提供了一种有前景的替代方案,但2e ORR受到竞争性四-电子氧还原(4e ORR)的阻碍,因此开发高活性和选择性的电催化剂至关重要。 目前,无金属碳基催化剂十分具有吸引力,因为碳基材料的电子构型和配位环境可通过杂原子掺杂剂(O、N等)进行调整。但是,已报道的碳基催化剂中O含量(大多低于15 at%)受到碳(C)源和制备途径的限制。非均相电催化是指表面电化学过程,其反应速率与催化剂的表面活性位点密切相关。因此,通过高比面积暴露更多的活性位点对于电催化剂加速电催化过程具有重要意义。碳量子点(CQDs)作为准零维(0D)碳具有极高的比面积,为杂原子的功能化提供了大量的缺陷位点和显着暴露了多相电催化的丰富活性位点。
图文解读
理论计算与表征密度泛函理论(DFT)计算发现,*OOH吸附能与活性位点的电荷呈线性关系:更多的电荷导致更高的*OOH 吸附能。随着电荷的增加,ΔG*OOH的值从0.360 eV增加到4.72 eV,表明含O官能团可通过调节活性位点的电荷状态来有效调节ΔG*OOH。此外,ΔG*OOH与极限电位(UL)呈火山型关系,其中火山图的顶点表明将电催化2eORR为H2O2所需的过电位为0 V。需注意,基面中的C-O-C基团对H2O2的产生具有最佳活性,过电位为0.02 V,ΔG*OOH为4.23 eV。因此,在超高C-O含量下,CQD催化剂对H2O2的生成具有良好的选择性和活性。

图1. DFT计算

图2. CQD催化剂的制备与表征

图3. CQD催化剂的结构表征催化性能电化学活性表面积(ECSA)与催化活性呈正相关性,与CS(2.89 cm2)和rGQD(20.53 cm2)相比,CQDs的ECSA最大(20.82 cm2),表明CQDs的催化性能最好。催化剂的H2O2选择性用氧还原和H2O2氧化电流来定量。CQD催化剂的H2O2选择性明显高于CSs和rGQD:在0.2至0.65 V内,CQD的平均选择性超过90%,最大值达到97.5%。此外,CQD的Tafel斜率为212.6 mV dec-1,低于CS(230.8 mV dec-1)和rGQD(252.4 mV dec-1),表明CQD具有更快的反应动力学。因此,CQD在H2O2选择性方面表现出最好的催化2eORR活性。
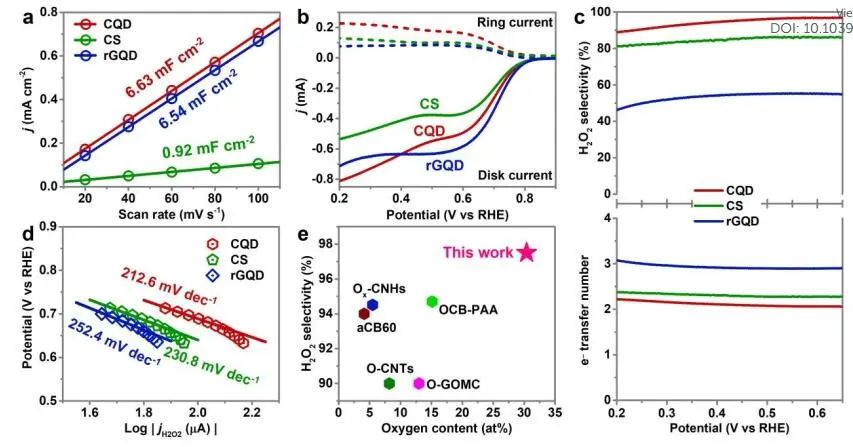
图3.CQD催化剂的催化性能实际性能体极化曲线表明,在0.2-0.8 V的电位范围内,在O2饱和溶液中记录的三种催化剂的电流明显大于在Ar饱和溶液中记录的电流。随着工作电位的负移,CQD的H2O2产量逐渐增加,并在0.3 V vs RHE时达到最大值10.06 mg cm-2 h-1。同时,CQD的平均H2O2法拉第效率(FE)超过95%,最高FE为97.7%。值得注意的是,这两个值高于CSs和rGQDs,表明CQD的优异2eORR活性得益于高O含量。与CS和CQD相比,rGQD由于其低氧含量,其H2O2产率和FE较差,表明碳基材料中的含氧物种对提高电化学H2O2生产的催化活性和选择性的积极作用。在经过10 h的长期测试,CQD的H2O2产率和FE的波动几乎为零,表明富氧CQD催化剂具有良好的稳定性。
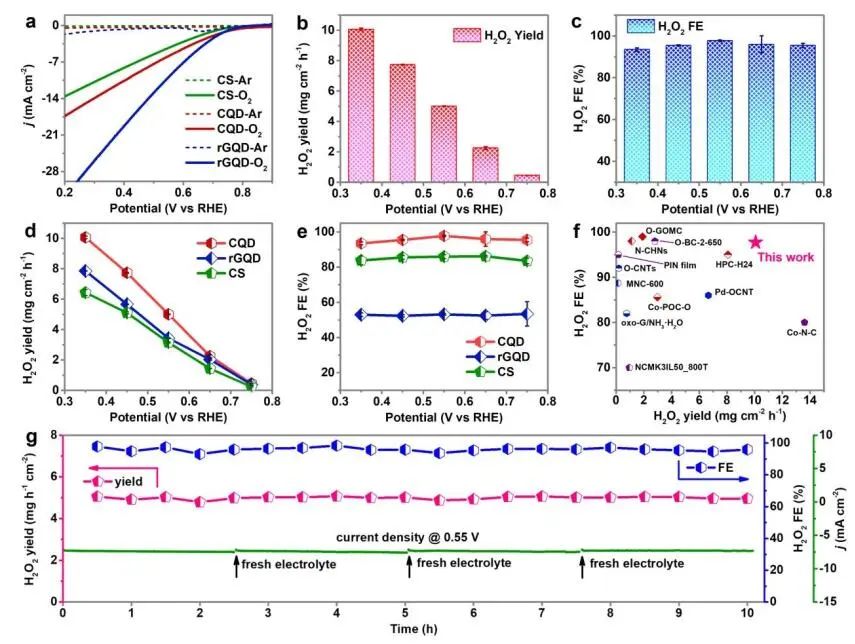
图5. CQD催化剂的实际性能
文献信息
Ultrahigh Oxygen-doped Carbon Quantum Dots for Highly Efficient H2O2 Production via Two-Electron Electrochemical Oxygen Reduction. Energy Environ. Sci.,2022, DOI: 10.1039/D2EE01797K. https://doi.org/10.1039/D2EE01797K.
审核编辑 :李倩
-
电荷
+关注
关注
1文章
665浏览量
37426 -
催化剂
+关注
关注
0文章
94浏览量
10843 -
量子点
+关注
关注
7文章
250浏览量
27144
原文标题:支春义EES:氧掺杂碳量子点用于过氧化氢电合成
文章出处:【微信号:清新电源,微信公众号:清新电源】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
美国AII XLT氧气传感器专用于高 CO₂酸性气体环境氧浓度检测

SPM 溶液清洗:半导体制造的关键清洁工艺

SPM在工业清洗中的应用有哪些

半导体清洗中SPM的最佳使用温度是多少
如何选择合适的SC1溶液来清洗硅片

sc-1和sc-2可以一起用吗

破局港口岸电痛点!安科瑞 AcrelEMS-PSP 实现 “降本、提效、减碳” 三重价值

半导体rca清洗都有什么药液

瞬态吸收助力理解AQ(蒽醌)在H•−ORR光催化过程中的作用机制




 氧掺杂碳量子点用于过氧化氢电合成
氧掺杂碳量子点用于过氧化氢电合成








评论