据媒体报道,作为全球一号代工厂,台积电已经开始大规模量产第六代CoWoS晶圆级芯片封装技术,集成度大大提高。
我们知道,如今的高端半导体芯片越来越复杂,传统的封装技术已经无法满足,Intel、台积电、三星等纷纷研发了各种2.5D、3D封装技术,将不同IP模块以不同方式,整合封装在一颗芯片内,从而减低制造难度和成本。
CoWoS的全称为Chip-on-Wafer-on-Substrate,是一种将芯片、基底都封装在一起的技术,并且是在晶圆层级上进行,目前只有台积电掌握,技术细节属于商业机密。
它属于2.5D封装技术,常用于HBM高带宽内存的整合封装,比如AMD Radeon VII游戏卡、NVIDIA V100计算卡都属于此类。
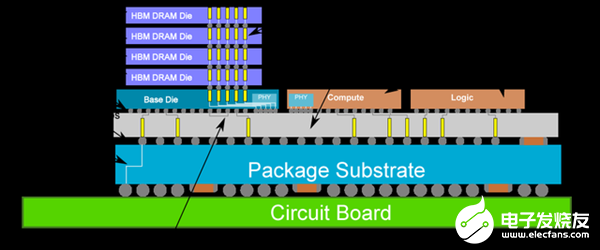
CoWoS封装结构简图
Radeon VII集成封装了四颗HBM
台积电当然也不会披露第六代CoWoS的细节,只是说可以在单个封装内,集成多达12颗HBM内存。
最新的HBM2E已经可以做到单颗容量16GB,12颗封装在一起那就是海量的192GB!
不知道哦什么样的芯片需要这么大的整合内存……
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
台积电
+关注
关注
44文章
5822浏览量
177210 -
晶圆
+关注
关注
53文章
5477浏览量
132902 -
内存
+关注
关注
9文章
3255浏览量
76591 -
CoWoS
+关注
关注
0文章
171浏览量
11552
发布评论请先 登录
相关推荐
热点推荐
192GB,SK海力士开始为英伟达Vera Rubin量产SOCAMM2
电子发烧友网报道(文 / 吴子鹏)日前,SK 海力士宣布正式量产基于第六代 10 纳米级(1c)LPDDR5X DRAM 的 192GB 容量 SOCAMM2(Small Outline
SK海力士正式量产基于1c LPDDR5X的192GB容量SOCAMM2
SK海力士20日宣布,正式量产基于第六代10纳米级(1c)LPDDR5X低功耗DRAM的192GB(千兆字节)容量SOCAMM2产品。 SOCAMM2*是一款将主要适用于智能手机等移动端设备
先进封装市场迎来EMIB与CoWoS的格局之争
技术悄然崛起,向长期占据主导地位的台积电CoWoS方案发起挑战,一场关乎AI产业成本与效率的技术博弈已然拉开序幕。 在AI算力需求呈指数级增长的当下,先进封装技术成为突破芯片性能瓶
瑞萨电子推出第六代DDR5 RCD,传输速率达9600MT/s
电子发烧友网综合报道 日前,瑞萨电子宣布推出业界首款面向DDR5寄存双列直插式内存模块(RDIMM)的第六代(Gen6)寄存时钟驱动器(RCD),这款全新RCD率先实现了9600兆传输/秒(MT/s

台积电CoWoS平台微通道芯片封装液冷技术的演进路线
台积电在先进封装技术,特别是CoWoS(Chip on Wafer on Substrate)平台上的微通道芯片液冷技术路线,是其应对高性能计算和AI芯片高热流密度挑战的关键策略。本报

【海翔科技】玻璃晶圆 TTV 厚度对 3D 集成封装可靠性的影响评估
一、引言
随着半导体技术向小型化、高性能化发展,3D 集成封装技术凭借其能有效提高芯片集成度、缩短信号传输距离等优势,成为行业发展的重要方向 。玻璃晶

化圆为方,台积电整合推出最先进CoPoS半导体封装
电子发烧友网综合报道 近日,据报道,台积电将持续推进先进封装技术,正式整合CoWoS与FOPLP,推出新一代CoPoS工艺。 作为
性能跃升,安全护航 ---- 澜起科技重磅发布全新第六代津逮® 性能核 CPU
上海2025年8月15日 /美通社/ -- 在数字化转型浪潮与数据安全需求的双重驱动下,澜起科技今日重磅推出第六代津逮® 性能核 CPU (以下简称 C6P )。这款融合突破性架构、全栈兼容性
什么是晶圆级扇入封装技术
在微电子行业飞速发展的背景下,封装技术已成为连接芯片创新与系统应用的核心纽带。其核心价值不仅体现于物理防护与电气/光学互联等基础功能,更在于应对多元化市场需求的适应性突破,本文着力介绍晶圆级扇入




 台积电量产第六代CoWoS晶圆封装:12颗封装CPU可集成192GB内存
台积电量产第六代CoWoS晶圆封装:12颗封装CPU可集成192GB内存










评论