完善资料让更多小伙伴认识你,还能领取20积分哦,立即完善>
电子发烧友网技术文库为您提供最新技术文章,最实用的电子技术文章,是您了解电子技术动态的最佳平台。
光刻机的难度在于要满足复杂的制程需求、高精度的要求以及大规模生产的挑战。为了应对这些挑战,光刻机制造商需要投入大量的研发资源和技术创新,不断提升设备性能和稳定性。...
在之前的文章里,我们介绍了晶圆制造、氧化过程和集成电路的部分发展史。现在,让我们继续了解光刻工艺,通过该过程将电子电路图形转移到晶圆上。光刻过程与使用胶片相机拍照非常相似。但是具体是怎么实现的呢?...

在上一篇文章,我们介绍了光刻工艺,即利用光罩(掩膜)把设计好的电路图形绘制在涂覆了光刻胶的晶圆表面上。下一步,将在晶圆上进行刻蚀工艺,以去除不必要的材料,只保留所需的图形。...

和高通等领先芯片公司不进行自己的制造,目前通常选择台积电或三星制造。英特尔表示,预计将在今年晚些时候宣布其代工业务的一个关键客户。...
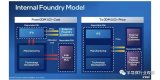
半导体:生产过程主要可分为(晶圆制造 Wafer Fabrication) 、(封装工序 Packaging)、(测试工序 Test) 几个步骤。...

EUV微影技术的落实延续了摩尔定律的寿命,这里的EUV指的其实是一种紫外光源,跟过去光刻技术所采用的光源比起来,EUV的波长更短,因此有助于大幅提高分辨率。...
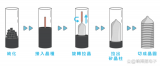
从技术趋势上来看,封装工艺的发展带动载板发展,FC工艺已成主流,多芯片3D封装、大尺寸高多层基板是当前发展方向。...

封装可靠性设计是指针对集成电路使用中可能出现的封装失效模式,采取相应的设计技术,消除或控制失效模式,使集成电路满足规定的可靠性要求所采取的技术活动。...
广义而言,半导体基板即为晶圆。我们可以直接在晶圆表面堆叠晶体管,即半导体电路的基本元件,也可以构建新的一层,将其作为基板并在上面形成器件。特别是用于通信、军事和光学元件等特殊用途的晶体管,或是高性能和高质量的晶体管,它们都需要用到外延晶片。在本文中,我们将介绍这种在晶圆之上由超纯硅构成的超高纯层(也...

传统上,IC芯片与外部的电气连接是用金属引线以键合的方式把芯片上的I/O连至封装载体并经封装引脚来实现。随着IC芯片特征尺寸的缩小和集成规模的扩大,I/O的间距不断减小、数量不断增多。当I/O间距缩小到70 um以下时,引线键合技术就不再适用,必须寻求新的技术途径。晶元级封装技术利用薄膜再分布上艺,...
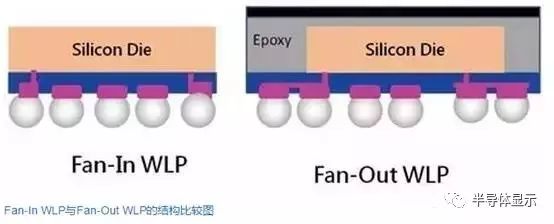
成品测试主要是指晶圆切割变成芯片后,针 对芯片的性能进行最终测试,需要使用的设备主要为测试机和分选机。晶圆测试(Chip Probing),简称 CP 测试,是指通过探针台和测试机的配合使用,对晶圆 上的裸芯片(gross die)进行功能和电学性能参数的测试。...
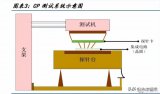
低温共烧陶瓷 ( Low Temperature Co-Fired Ceramics, LTCC ) 封装能将不同种类的芯片等元器件组装集成于同一封装体内以实现系统的某些功能,是实现系统小型化、集成化、多功能化和高可靠性的重要手段。总结了 LTCC 基板所采用的封装方式,阐述了 LTCC 基板的金属...


随着摩尔定律的放缓以及前沿节点复杂性和成本的增加,先进封装正在成为将多个裸片集成到单个封装中的关键解决方案,并有可能结合成熟和先进的节点。...

英特尔将其在半导体和封装研究与技术方面的实力和专业知识与欧洲合作伙伴合作,以开发摩尔定律创新并推动欧洲的微电子技术发展。...

Info封装与CoWoS封装是目前2.5D封装的典型代表,同属于TSMC开发的2.5D封装,那么如何区分 Info封装与CoWoS封装呢?主要从以下方面进行阐述。...

Info封装与CoWoS封装是目前2.5D封装的典型代表,同属于TSMC开发的2.5D封装,那么如何区分 Info封装与CoWoS封装呢?主要从以下方面进行阐述。...

增材制造是一种快速成型技术,通过材料逐步堆积累加的方法实现生产,是正在高速发展的新兴技术。但多年以来,由于材料发展的限制,增材制造技术多以结构件制造应用为主,在电子制造领域发展较为缓慢。...
在干法蚀刻中,气体受高频(主要为 13.56 MHz 或 2.45 GHz)激发。在 1 到 100 Pa 的压力下,其平均自由程为几毫米到几厘米。...