完善资料让更多小伙伴认识你,还能领取20积分哦,立即完善>
电子发烧友网技术文库为您提供最新技术文章,最实用的电子技术文章,是您了解电子技术动态的最佳平台。
随着电子行业的飞速发展, 电子器件的集成度 越来越高, 人们对集成电路的需求逐渐地向高集成 度、 低功耗和小体积的方向发展。倒装芯片球栅格 阵列 (FCBGA:Flip Chip Ball Grid Array) 封装器件以其高密度、多I/O 端口封装和散热好等优点成 为多种集成电路的封装首选, 尤...
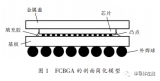
摩尔定律已面临物理、技术与成本极限的多重挑战,集成电路在沿着摩尔定律预测的尺寸缩小路径艰难发展的同时,亟需开辟新的方向。...
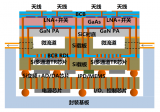
Fab 6 是台积电首个一体式先进封装测试工厂,是台积电不断增加的封装投资的一部分。该晶圆厂已准备好量产台积电 SoIC 封装技术。请记住,当台积电说量产时,他们指的是 Apple iPhone 尺寸的量产,而不是工程样品或内部产品。...

随着摩尔定律的放缓以及前沿节点复杂性和成本的增加,先进封装正在成为将多个裸片集成到单个封装中的关键解决方案,并有可能结合成熟和先进的节点。...

3D 堆栈存储器——HBM、3DS 和 3D NAND——是最大的贡献者,到 2028 年占总市场份额的 70% 以上。增长最快的四大 =平台是 3D SoC、有源硅中介层、嵌入式硅桥和 3D NAND堆。...

如下图所示,CPA model是Pkg Layout(封装基板设计)通过工具提取出来的一个模型,主要包括封装基板中的RLC参数。...
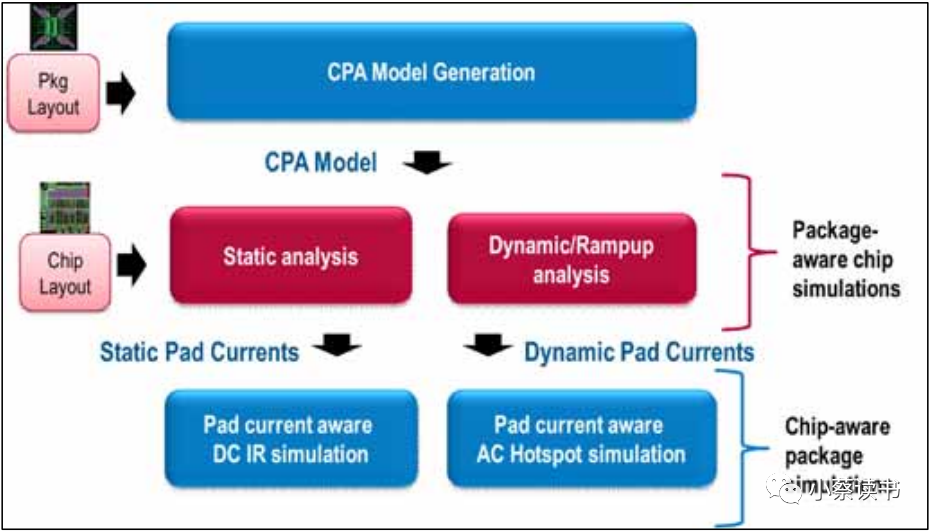
大部分从事后端设计的同行应该没有接触过带封装的IR Drop分析(模块级别的IR分析不需要考虑封装),一般只有PA工程师、后端项目经理、封装同事等才会接触这一部分内容。...
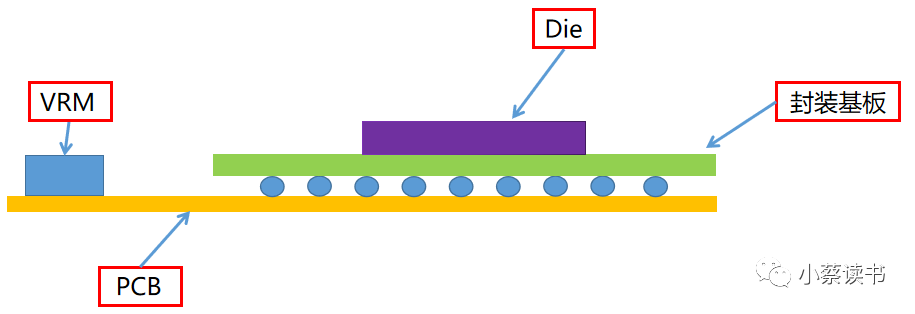
光刻机可分为前道光刻机和后道光刻机。光刻机既可以用在前道工艺,也可以用在后道工艺,前道光刻机用于芯片的制造,曝光工艺极其复杂,后道光刻机主要用于封装测试,实现高性能的先进封装,技术难度相对较小。...
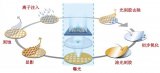
封装可靠性设计是指针对集成电路使用中可能出现的封装失效模式,采取相应的设计技术,消除或控制失效模式,使集成电路满足规定的可靠性要求所采取的技术活动。...
AMD XDNA XDNA带有本地存储器和数据移动器的高度可扩展引擎阵列,是AMD利用深厚的FPGA和自适应SOC编译算法专业知识推出的一种算法工具。...

也称CPAC(globe top pad array carrier)。球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI用的一种封...
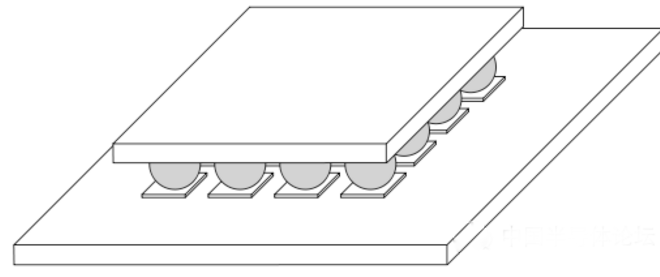
该路线图概述了标准 FinFET 晶体管将持续到 3nm,然后过渡到新的全栅 (GAA) 纳米片设计,该设计将在 2024 年进入大批量生产。Imec绘制了 2nm和A7(0.7nm)Forksheet设计的路线图,随后分别是A5和A2的CFET 和原子通道等突破性设计。...

金属-氧化物半导体场效应晶体管(MOSFET)的革命,让我们可以在相同面积的晶圆上同时制造出更多晶体管。MOSFET体积越小,单个 MOSFET的耗电量就越少,还可以制造出更多的晶体管,让其发挥作用,可谓是一举多得。...

先进封装是对应于先进圆晶制程而衍生出来的概念,一般指将不同系统集成到同一封装内以实现更高效系统效率的封装技术。...

目前,微电子产业已经逐步演变为设计、制造和封装三个相对独立的产业。微电子封装技术即半导体封装技术,又称先进集成电路封装。半导体封装包括组装(Assembly)和封装(Packing)两个方面,它是将数万计的半导体元器件组装成一个紧凑的封装体,与外界进行信息交流,它的基本功能包括电源供给、信息交流、散...

电子封装是集成电路芯片生产完成后不可缺少的一道工序,是器件到系统的桥梁。封装这一生产环节对微电子产品的质量和竞争力都有极大的影响。按目前国际上流行的看法认为,在微电子器件的总体成本中,设计占了三分之一,芯片生产占了三分之一,而封装和测试也占了三分之一,真可谓三分天下有其一。...
凸块制造过程一般是基于定制的光掩模,通过真空溅镀、黄光、电镀、蚀刻等环节而成,该技术是晶圆制造环节的延伸,也是实施倒装(FC)封装工艺的基础及前提。...

太阳能电池需要硅晶片来提高效率并吸收更多的阳光。经常使用非晶硅、单晶硅和碲化镉等材料。Floating Zone 方法等制造工艺可将太阳能电池效率提高近 25%。...
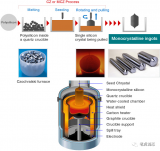
MOSFET结构的核心就是栅极(Gate)。MOSFET与BJT晶体管不同,栅极不与电流沟道(S与D的中间部分)直接接触,只是“间接”发挥作用。...