完善资料让更多小伙伴认识你,还能领取20积分哦,立即完善>
电子发烧友网技术文库为您提供最新技术文章,最实用的电子技术文章,是您了解电子技术动态的最佳平台。
图1为半导体封装方法的不同分类,大致可以分为两种:传统封装和晶圆级(Wafer-Level)封装。传统封装首先将晶圆切割成芯片,然后对芯片进行封装;而晶圆级封装则是先在晶圆上进行部分或全部封装,之后再将其切割成单件。...
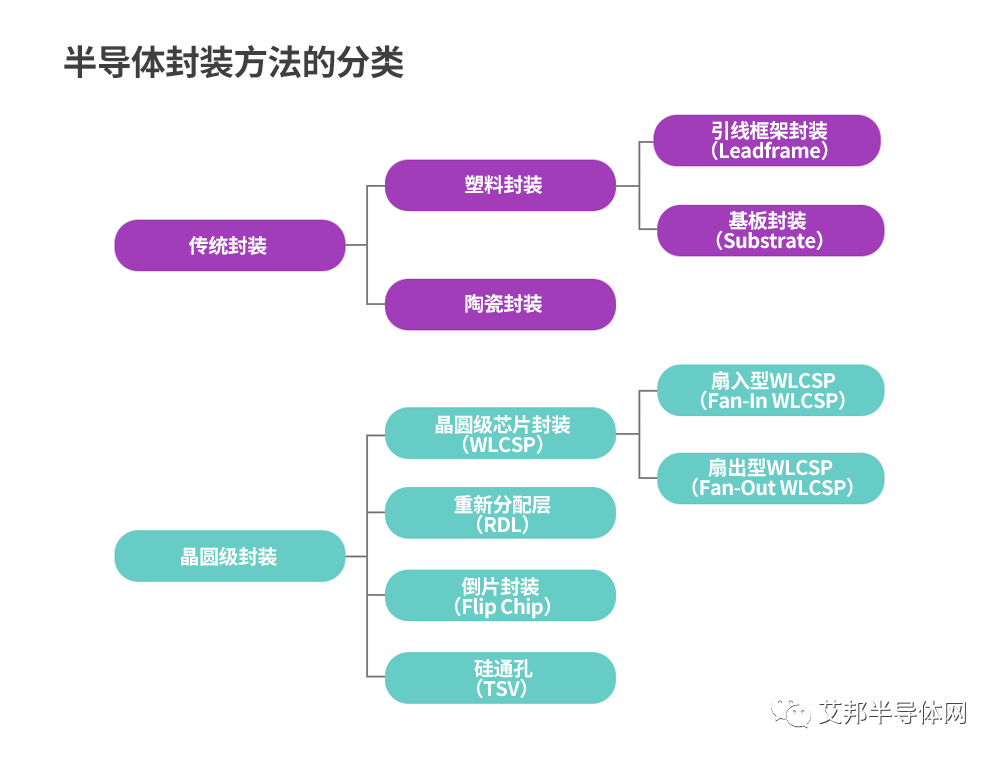
将一个或多个IC芯片用适宜的材料封装起来,并使芯片的焊区与封装的外引脚用引线键合(WB)、载带自动键合(TAB)和倒装芯片键合(FCB)连接起来,使之成为有实用功能的器件或组件。...

在材料方面,对于大尺寸系统级芯片(SoC)封装来说,FCBGA基板的CTE需要更低,才能保证大尺寸芯片封装的可靠性。ABF材料进一步降低CTE的难度很大,BT材料的半固化片的CTE可以达到1×10-6·℃-1~3×10-6·℃-1,作为堆积的绝缘材料在降低FCBGA基板整体CTE方面会做出重要贡献。...

电荷泵是一种增加或反转直流电压的电压变换器。例如,+5V可以转换为+10V或-5V(或更高/更低的值)。...
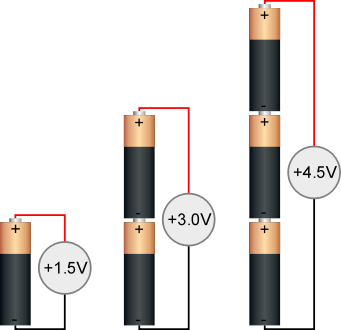
锡焊是一门科学,他的原理是通过加热的烙铁将固态焊锡丝加热熔化,再借助于助焊剂的作用,使其流入被焊金属之间,待冷却后形成牢固可靠的焊接点。...
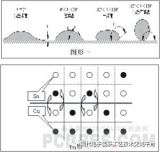
互连是另一个问题。如何将信号和电源从一个地方传输到另一个地方取决于很多因素:涉及信号数量、带宽或比特率、你能容忍的延迟,以及你的预算。...
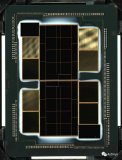
半导体:生产过程主要可分为(晶圆制造 Wafer Fabrication) 、(封装工序 Packaging)、(测试工序 Test) 几个步骤。...

CMP 主要负责对晶圆表面实现平坦化。晶圆制造前道加工环节主要包括7个相互独立的工艺流程:光刻、刻蚀、薄膜生长、扩散、离子注入、化学机械抛光、金属化 CMP 则主要用于衔接不同薄膜工艺,其中根据工艺段来分可以分为前段制程(FEOL)和后段制程(BEOL),前段制程工艺主要为 STI-CMP 和 Po...
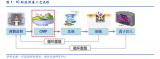
华秋自研数字系统,包括PCB/SMT自动报价系统,DFM软件、智能拼板系统、BOM分析工具等20多种系统和工具,构建了信息化与自动化融合的数字化平台,打通了电子全产业链数字化通路。...

燃气轮机的本质上是一种通过燃料(主要为天然气)与空气燃烧产生出气体推动叶片做功的机械,按照燃烧室温度不同,目前的主流机型为E级、F级和H级。燃气轮机的优势在于阶梯利用,可作为参照的是,目前全球最先进的百万千瓦超超临界煤电机组的额定工况的净效率也不超过47%。...

在一个晶圆上,通常有几百个至数千个芯片连在一起。它们之间留有80um至150um的间隙,此间隙被称之为划片街区(Saw Street)。...
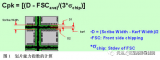
Chiplet技术是一种利用先进封装方法将不同工艺/功能的芯片进行异质集成的技术。这种技术设计的核心思想是先分后合,即先将单芯片中的功能块拆分出来,再通过先进封装模块将其集成为大的单芯片。...

What's C4 Flip Chip? ▼C4 is: Controlled Collapsed Chip Connection受控折叠芯片 连接 ▼Chip is connected to substrate by RDL and Bump芯片通过RDL和凸点连接到基板 ▼Bum...

半导体是医疗设备内部工作的一个组成部分,有助于非导体和导体之间的导电性以控制电流。反过来,制造完美半导体的组装过程非常详细,尤其是现在设备变得越来越小。...
虽然 1BM 的608 晶体管计算机的质量仅 为 ENIAC 的 1/30,但 1t的质量不可能成为陆车单兵的负街,更不可能作为飞机的装载。20 世纪 60年代初,一台能够进行四则运算、乘方、开方的计算器,其质量和一合 21inCRT 电视机相当,体积也远远超过算盘和计算尺。...


先进封装是“超越摩尔”(More than Moore)时代的一大技术亮点。当芯片在每个工艺节点上的微缩越来越困难、也越来越昂贵之际,工程师们将多个芯片放入先进的封装中,就不必再费力缩小芯片了。本文将对先进封装技术中最常见的10个术语进行简单介绍。...

飞机脉动式装配生产线最初从Ford公司的移动式汽车生产线衍生而来,是通过设计飞机装配环节中的各个流程,完善人员配置与工序过程,把装配工序均衡分配给相应作业站位,让飞机以固有的节拍在站位上进行脉冲式移动,操作人员则要在固定站位完成飞机生产装配工作。...
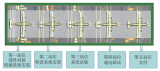
蚀刻是一种从材料上去除的过程。基片表面上的一种薄膜基片。当掩码层用于保护特定区域时在晶片表面,蚀刻的目的是“精确”移除未覆盖的材料戴着面具。...
