完善资料让更多小伙伴认识你,还能领取20积分哦,立即完善>
电子发烧友网技术文库为您提供最新技术文章,最实用的电子技术文章,是您了解电子技术动态的最佳平台。
蜗杆传动必须根据单位时间内的发热量等于同时间内的散热量条件进行热平衡计算 措施:加装散热片以及增大散热面积、在蜗杆轴端加装风扇以加速空气流动、在传动箱内装循环冷却管路...

在半导体制造过程中,每个半导体元件的产品都需要经过数百道工序。这些工序包括前道工艺和后道工艺,前道工艺是整个制造过程中最为重要的部分,它关系到半导体芯片的基本结构和特性的形成,涉及晶圆制造、沉积、光刻、刻蚀等步骤,技术难点多,操作复杂。...
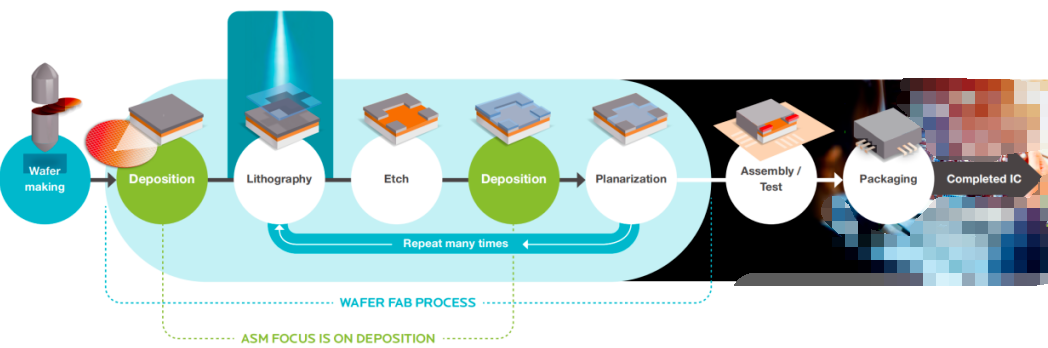
CoWoS 技术概念,简单来说是先将半导体芯片(像是处理器、记忆体等),一同放在硅中介层上,再透过Chip on Wafer(CoW)的封装制程连接至底层基板上。...
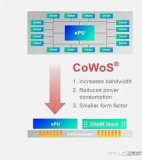
1. 先进制程受限,先进封装/Chiplet提升算力,必有取舍。...

Chiplet,就是小芯片/芯粒,是通过将原来集成于同一系统单晶片中的各个元件分拆,独立为多个具特定功能的Chiplet,分开制造后再透过先进封装技术将彼此互联,最终集成封装为一系统晶片组。...

全球范围内正在经历一场能源革命。根据国际能源署的报告,到 2026 年,可再生能源将占全球能源增长量的大约 95%。太阳能将占到这 95% 中的一半以上。...
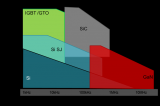
标准开发:通过组织全球 10 000 多名业界专家,成功开发了 220多项标准,其中IPC-A-610 标准是全球应用最广泛的标准之一,被国际电工委员会(IEC)推荐为电子组件的全球首选验收标准;其中 IPC 中国41 个技术组已完成了31 项标准的开发。...
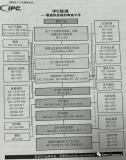
焊锡球是现代化三种激光焊锡工艺中的主要技术方式之一,与激光锡丝、锡膏一起为中、微小电子领域的重要加工工艺。深圳紫宸激光作为国内首批从事激光焊锡应用研发的企业,一直致力于激光锡丝、锡膏及锡球焊接技术的突破和产业化应用。...

厚度不同的两块钢板对接时,为避免截面急剧变化引起严重的应力集中,常把较厚的板边逐渐削薄,达到两接边处等厚。对接接头的静强度和疲劳强度比其他接头高。在交变、冲击载荷下或在低温高压容器中工作的联接,常优先采用对接接头的焊接。...
高质量固态纳米孔的制备是DNA测序、纳流器件以及纳滤膜等应用的关键技术。当前,在无机薄膜材料中制备固态纳米孔的主流方法是聚焦离子/电子束刻蚀。...
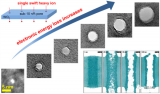
半导体芯片由许多比指甲盖还小、比纸还薄的微观层(layer)组成。半导体堆叠得又高又实,形成类似于高层建筑的复杂结构。...
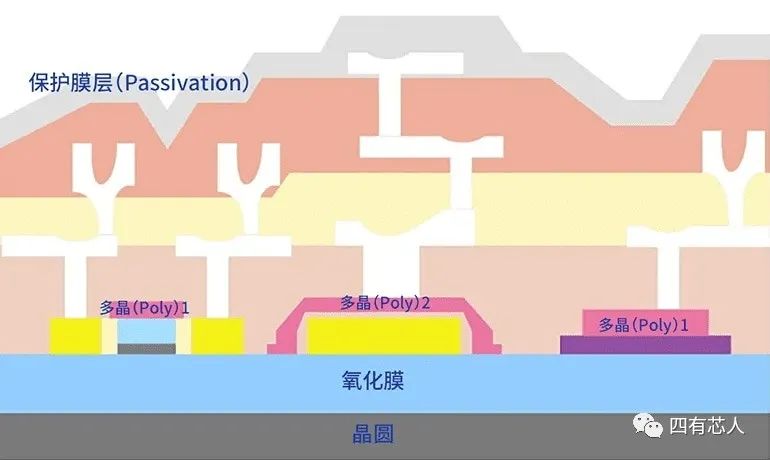
图1为您呈现了半导体封装方法的不同分类,大致可以分为两种:传统封装和晶圆级(Wafer-Level)封装。传统封装首先将晶圆切割成芯片,然后对芯片进行封装;而晶圆级封装则是先在晶圆上进行部分或全部封装,之后再将其切割成单件。...
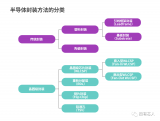
离子注入机是芯片制造中的关键装备。在芯片制造过程中,需要掺入不同种类的元素按预定方式改变材料的电性能,这些元素以带电离子的形式被加速至预定能量并注入至特定半导体材料中,离子注入机就是执行这一掺杂工艺的芯片制造设备。...

放线电压Bleed Voltage 控制在整个线弧成型过程当中,金 线在进行释放动作时的超音波输出能量.放线电压在焊线头完成 反向位移后开始进行线弧放线动作时被激活,直到焊线头到达弧 型放线量的最高点,线夹关闭的时候,此时放线电压才被关闭....

结合 FOWLP 近期技术发展和 应用的现状, 总结了发展趋势; 从 FOWLP 结构的工艺缺陷和失效模式出发, 阐述了 FOWLP 的工艺流程和重点工艺环节。...
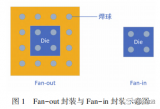
DBC基板铜箔厚度较大(一般为100μm~600μm),可满足高温、大电流等极端环境下器件封装应用需求(为降低基板应力与翘曲,一般采用Cu-Al2O3-Cu的三明治结构,且上下铜层厚度相同)。...

随着三维集成技术的发展,如何将不同材料、结构、工艺、功能的芯片器件实现一体化、多功能集成化是未来系统集成发展的重点。基于TSV、再布线(RDL)、微凸点(Micro Bump)、倒装焊(FC)等关键工艺的硅转接基板集成技术是将处理器、存储器等多种芯片集成到同一个基板上,可提供高密度引脚的再分布。...
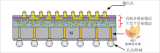
硅是地壳中第二丰富的元素(氧是第一-) 。它天然存在于硅酸盐(含Si-O)岩石和沙子中。半导体器件制造中使用的元素硅是由高纯度石英和石英岩砂生产的,这些石英和石英砂含有相对较少的杂质。...
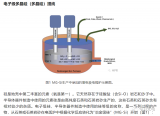
大家在画板子时候,是不是经常找不到合适的封装,有时候又懒得画 下面给大家分享3个封装库,基本上常用的封装都能找得到,还带3D模型的!...

芯片厂为什么要使用超纯水? 普通的水中含有氯,硫等杂质,会腐蚀芯片中的金属。如果水中有Na,K等金属杂质,会造成MIC(可动离子污染)等问题。因此芯片制造需要一个绝对干净的水质,超纯水应运而生。...
