以下完整内容发表在「SysPro电力电子技术」知识星球
- 文字原创,素材来源:公司官网 / 年报 / IR 记录 / 行业媒体公开报道
- 本篇为基于公开资料的系统整理,不包含任何未授权获取的内部材料
|SysPro备注:把 2025H2–2026H1 国内公开披露的主机厂、Tier1、模块厂、芯片厂和板厂动作放到同一框架里,讲清楚各家公司到底在做什么、做到哪一步、各自路线的优劣势是什么、哪些结论已经足够确定、哪些还必须谨慎观察。
导语:过去一年,国内内嵌式 PCB / 嵌入式功率模块可谓百家争鸣。25年上半年之前,大家更多是在讲"这条路线很先进""未来可能替代传统模块",但到 2025年底、直至今日,公开信号已经开始落到样品试制、实测指标、绝缘 / 热阻瓶颈、板厂工艺导入以及整机收益这些更硬的层面。

图片来源:SysPro
我们把这件事拆成三层来理解:
第一层是路线层:到底是纯 PCB 嵌板、AMB 陶瓷内嵌、S-cell/p²Pack,还是更偏 advanced packaging 的panel-level 路线;
第二层是公司层:主机厂、Tier1、模块厂、芯片厂和板厂各自在卡什么位;
第三层才是结论层:哪些公司已经把路线推进到样件和验证,哪些还停留在口径与故事?
目录
01 为什么这条路线在 2026 年突然变得值得认真看
02 四条主流技术路线:纯PCB嵌板、AMB陶瓷内嵌、S-cell、面板级功率封装
03–10 完整版章节(知识星球发布)
- 03 先看需求侧:OEM与Tier1
- 04 重点公司逐家拆解
- 05 第二梯队公司与路线补充观察
- 06 PCB 板厂怎么参与进来
- 07 四条主流路线与一张图
- 08 最后的判断
- 09 总结:谁在把路线做成工程路径?
公开正文 01
01 为什么这条路线在 2026 年突然变得值得认真看
如果只看近一两年的公开信号,真正的变化不是“又多了几家企业说自己在做嵌入式模块”,而是大家真正开始从概念和口号,转向样品试制、性能验证、热-绝缘矛盾、PCB 工艺导入、产能与资本开支这些更硬的工程节点。

图片来源:SysPro
最典型的两个新增事件,一个来自辰致集团:它在 2026 年 1 月公开表示,PCB 嵌入式功率模块已经完成样品试制,并完成相关性能测试验证。另一个来自联合动力:在 2026 年 4 月公开讨论他们重点在AMB 陶瓷内嵌方案如何解决嵌埋式 SiC 模块的散热绝缘瓶颈上。前者说明这条路线已经走到样件和验证阶段,后者说明行业开始承认:单纯把芯片埋进 PCB,并不能自动解决热和绝缘问题。

图片来源:SysPro
再往前补一条底层背景,广汽在 2025 年 8 月官方发布“星源增程”时,已经把“夸克电驱 2.0 应用嵌入式功率模块”写成了对外卖点,并同时给出了体积减小 80%、电控最高效率 99.9%、1000V 平台下驱动电机功率密度 17.29kW/kg 等指标。这里可以看到:嵌入式功率模块已经开始从封装工程师内部讨论的话题,进入主机厂对外发布语言。

图片来源:SysPro
同样值得注意的是,联合电子在 2025 年底公开的嵌入式SiC逆变砖,把方向直接拉到“逆变器系统边界重构”。它不是只说封装,而是在说:把功率芯片、驱动、保护、采样、辅助电源甚至控制电路一起往板上做深集成。这说明国内头部 Tier1已经不满足于把嵌入式PCB当成“下一代模块壳体”,而是在把它当成重构逆变器架构的机会。
所以,我们今天看 2026 年国内这条技术线,最合理的判断不是“谁已经绝对量产”,而是:谁已经把路线、样件、制造平台和目标场景同时公开出来?能把这四个条件同时满足的公司,现在并不多。

公开正文 02
02 四条主流技术路线:纯PCB嵌板、AMB陶瓷内嵌、S-cell 、面板级功率封装
我们先聊聊主流的技术路线。
第一条路线,是纯 PCB 嵌板式路线。
这条路线的核心逻辑很直接:通过多层精密叠层、厚铜嵌埋和更短的主功率回路,把寄生电感压到极低水平,从而允许 SiC 器件用更激进的开关速度工作。
例如,联合电子的逆变砖,核心卖点就是这条逻辑:寄生杂感低至 1nH,CLTC 工况效率约 99.5%,而且它不只在做功率部分,还把辅助电源、驱动、保护、传感、采样都往里塞。
第二条路线,是 AMB 陶瓷内嵌 PCB 路线。
这条路线的出发点不是“杂感不够低”,而是“热和绝缘扛不扛得住”。
联合动力公开提到:现有嵌埋式 SiC 方案里,PCB 板内层可以用铜块和激光孔导热,但外层高导热胶膜的导热系数普遍低于 15W/m·K;而 SiC 芯片峰值工况下可能超过 200℃,这会逼着行业转向更高导热、更稳绝缘的陶瓷路径。
 图片来源:NE时代/芯片板级埋入与集成散热器一体化思路
图片来源:NE时代/芯片板级埋入与集成散热器一体化思路
第三条路线,是以 S-cell /p²Pack 为代表的 cell 型嵌板式 PCB 路线。
它更像是在纯 PCB 嵌板与 AMB 陶瓷内嵌之间寻找一个更适合工程落地的折中点:不是把所有收益都压在极限低杂感上,而是把热路径、绝缘边界、互连结构、尺寸、成本和量产制造窗口放在同一张表里一起平衡。

图片来源:英飞凌 / S-cell 与 6 层 PCB 剖面示意
第四条路线,是面板级 Chip Embedded Power Package 路线。
它同样属于芯片嵌入式功率封装的大方向,但工艺语言已经明显转向 panel-level advanced packaging。它的核心特征不再只是把功率芯片嵌进基板,而是围绕 coreless、Cu RDL、via filling、EMC,以及 glass / panel substrate 等工艺模块展开,目标是提升板级集成密度、制造效率和先进封装兼容性。所以这条路线更适合被理解为功率封装与面板级先进制造的交叉路线,而不是简单等同于车用主驱逆变砖的延长线。
 图片来源:AOI
图片来源:AOI
完整内容在知识星球中发布
完整版导航
-
芯片
+关注
关注
463文章
54375浏览量
468986 -
pcb
+关注
关注
4415文章
23955浏览量
426009 -
嵌入式
+关注
关注
5209文章
20622浏览量
336753 -
大功率封装
+关注
关注
0文章
6浏览量
5700
发布评论请先 登录
安世中国荣膺2026年度半导体原厂直供先锋品牌
不用找原厂也能做门禁卡吗?

为什么原厂越来越需要一套自己的 Studio
多家主机厂相关代表赴国芯科技调研交流
延长石油采气厂OCR识别数采案例

光庭信息与为旌科技自动泊车PoC项目通过主机厂验收
安波福ADAS解决方案在国内领先主机厂实现量产
石油炼化厂融合定位系统:技术解码与场景应用

智慧工厂物联网解决方案:纺织厂边缘计算网关应用

安达发 主机厂必看!APS高级排产软件让订单交付周期从龟速变闪电!
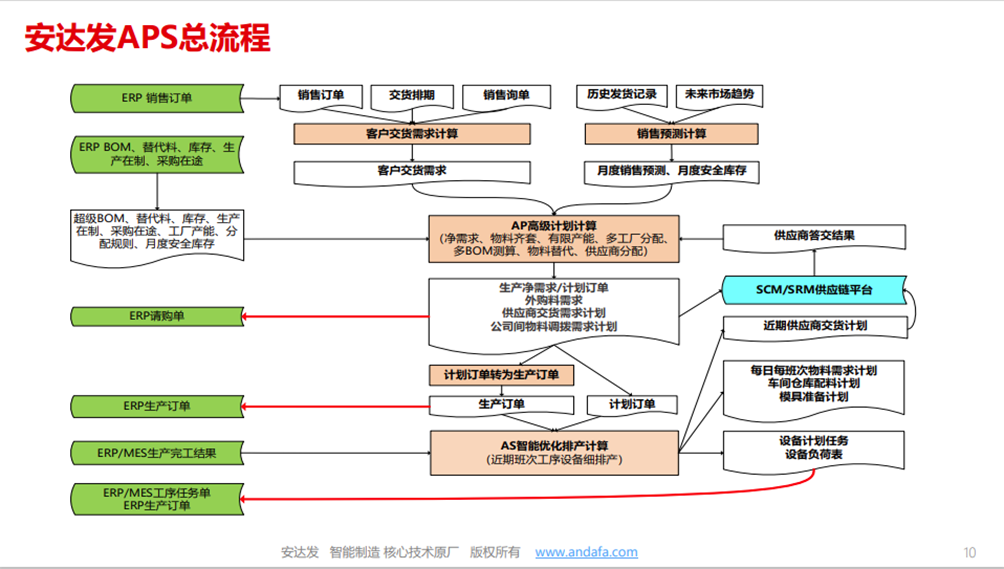



 2026国内嵌入式PCB功率封装技术路线全景:主机厂、Tier1、模块厂、芯片厂和板厂
2026国内嵌入式PCB功率封装技术路线全景:主机厂、Tier1、模块厂、芯片厂和板厂


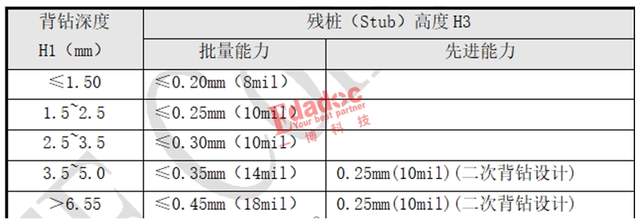



评论