2026年3月,日本名古屋大学低温等离子体科学研究中心与该校孵化初创企业nu-rei株式会社,将在应用物理学会春季学术讲演会上集中发布关于次世代功率半导体材料——氧化镓(Ga₂O₃)的六项关键研究成果。这一系列突破标志着日本在氧化镓材料生长工艺上取得系统性进展,有望大幅降低制造成本、提升器件性能,为电动汽车、可再生能源及宇宙开发等高端领域的应用铺平道路。
一、核心工艺突破:高密度氧自由基源(HD-ORS)
本次研究的核心技术亮点,是成功开发了高密度氧自由基源(HD-ORS)。传统氧化镓生长过程中,反应速率与结晶质量长期受到限制。HD-ORS通过采用臭氧与氧气的混合气体,将原子态氧密度提升至传统方法的2倍。
这一技术突破带来了双重优势:
· 强力促进氧化反应:显著加速Ga₂O向Ga₂O₃的转化;
· 有效抑制副产物生成:减少生长过程中易挥发的Ga₂O中间产物,从而在分子束外延(MBE)和物理气相沉积(PVD)两种主流工艺中,均实现了高速、稳定的薄膜生长。
二、生长速度飞跃:量产成本有望大幅下降
利用HD-ORS技术,研究团队在生长效率上取得了显著提升:
· MBE工艺:在仅300℃的低温条件下,实现了1微米/小时的超高速同质外延生长。
· PVD工艺:生长速度更是超过1微米/小时,接近传统MBE工艺效率的10倍。
这种高吞吐量技术直接解决了氧化镓量产中的效率瓶颈,对于降低功率器件的制造成本具有决定性意义,有力推动了从实验室研究到产业应用的转化进程。
三、异质外延突破:在硅基板上实现高质量生长
长期以来,氧化镓难以在低成本硅(Si)基板上高质量生长,是制约其集成化应用的主要障碍。此次研究团队成功攻克了这一难题。
技术路径包括:
· 采用RCA湿法清洗与镓原子层朗缪尔吸着前处理相结合的方法;
· 有效去除硅基板表面的自然氧化膜,并防止高温环境下的二次氧化。
最终,研究团队在2英寸硅基板上成功实现了氧化镓的异质外延生长,并经由热处理获得了单晶结构。这一成果意味着,氧化镓器件可以借助硅基板优异的热传导性和成熟的工艺平台,开发出更高耐压、更低成本、更易集成的功率器件,为未来与硅基产线兼容铺平道路。
四、P型掺杂难题取得关键进展
功率器件制造中长期存在的p型掺杂难题也获得了重要突破。研究团队深化了利用NiO(氧化镍)扩散层形成p型氧化镓的工艺路线。
具体步骤包括:
· 镍离子注入;
· 氧等离子体退火;
· 快速热退火(RTA)。
实验证实,该技术不仅在氧化镓基板上能够形成稳定的pn结,在氮化镓基板上同样有效。所形成的pn结电流密度达到镍肖特基二极管的2倍,为构建完整的氧化镓功率开关器件(如MOSFET、IGBT等)提供了关键的材料基础。
五、产学研协同:从基础研究到产业转化的高效链条
日本在第三代及第四代半导体材料领域持续高强度投入,尤其在氧化镓这种超宽禁带半导体方面,试图通过材料生长工艺的革新确立领先地位。名古屋大学与nu-rei公司的此次合作,是典型的产学研协同创新模式——从高校的基础理论突破,到初创企业的技术转化,再到公开学术讲演会的集中发布,形成了完整的成果转化链条。这种机制有助于加速实验室成果向工业化生产过渡,并在全球半导体供应链重构的背景下,增强日本在下一代功率半导体领域的竞争力。
六、对中国半导体产业的启示
对于中国半导体产业而言,这一系列技术突破释放了明确的信号:功率半导体材料迭代的紧迫性正在加剧。
· 氧化镓凭借其超高耐压(禁带宽度约4.8eV,远超SiC和GaN)和低成本硅基集成的潜力,有望在高压电力电子领域(如智能电网、电动汽车逆变器、高铁牵引系统)形成新的竞争格局。
· 当前,中国企业正积极布局碳化硅(SiC)和氮化镓(GaN)产业链,但氧化镓在异质外延、p型掺杂等核心工艺上的快速进展,提示我们必须提前布局——包括相关专利、关键设备、材料生长及器件设计等。
· 如果忽视这一技术路线,未来可能在下一代功率半导体的标准制定和市场竞争中陷入被动。
因此,建议国内科研机构与产业界密切关注日本在氧化镓领域的最新动态,加强基础研究投入,推动产学研协同攻关,争取在即将到来的氧化镓时代占据一席之地。
中国半导体,未来可期
版权与免责声明:一、本公众号注明“原创”的文章,其他媒体可以转载,但转载时必须保持内容的完整性,且务必注明来源。二、本公众号注明其他来源的文章,是出于分享信息之目的而转载的公开内容,版权归原作者所有。如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
材料
+关注
关注
3文章
1582浏览量
28689 -
功率半导体
+关注
关注
23文章
1489浏览量
45267 -
氧化镓
+关注
关注
5文章
91浏览量
10903
发布评论请先 登录



 日本氧化镓技术再获突破:六项成果集中发布,低成本量产指日可待
日本氧化镓技术再获突破:六项成果集中发布,低成本量产指日可待


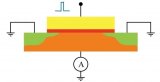




评论