环旭电子微小化创新研发中心(MCC)宣布,历经三年研发与验证,成功整合真空印刷塑封(Vacuum Printing Encapsulation, VPE)技术与高径深比(>1:3)铜柱巨量移转技术,并率先导入胶囊内视镜微缩模块与高散热行动装置电源管理模块,展现跨领域系统级微型化封装的实质成果。
同时,MCC亦完成多折高线弧打线(Multiple Bend, High Wire Loop Profile)与基板级选择性塑封(Board-level Selective Encapsulation)的整合技术,并成功应用于基站射频功率放大器模块的开发。上述技术整合显示环旭电子在系统级先进封装领域的深厚积累。
AI应用带动消费电子产品的智能化升级,电子产品所需模块的设计复杂度持续提高,模块开发周期对新产品研发的影响更为突出。传统模封技术(如转注成型、压注成型)虽具备量产成熟稳定的优势,但受限于昂贵的BT载板与客制模具,产品开发周期长达12周以上,可能造成产品上市时程的延迟。
真空印刷塑封技术提供突破性解决方案。该技术采用液态塑脂印刷,钢板开制仅需1周,不需任何客制模具,使产品从设计到量产的时程可缩短达90%;并能以更有成本优势、交期更短的FR4 PCB取代BT载板,协助微型化产品降低约30%的开发成本。FR4 PCB的室温封填与低模流压特性,尤其适用于模块设计采用对高温或高模流压敏感的组件,例如微机电、高径深比铜柱与高线弧打线等,提高新创与少量多样产品的开发弹性,加速高可靠度微型化技术的市场导入。
环旭电子微小化创新研发中心AVP沈里正博士表示:"真空印刷塑封技术同样适用于高算力与高功率模块,可支持SMD、裸芯片与封装IC的异质整合,满足多元应用需求。目前已有三款Wi-Fi 模块(单面、双面、复合式电磁屏蔽)通过X-ray、SAT、FCT等多阶段验证,并经MSL3、TCT等可靠度测试,性能表现与传统模封技术相当,确保质量与功能完整。"
微小化创新研发中心具备完整技术平台、专业设计团队与量产等级设备,提供从概念设计、封装开发到量产导入的一站式整合服务;中心亦配置专属SiP Lab与NPI产线,确保复杂系统级封装(SiP)技术的可量产性与最终性能。
展望未来,环旭电子微小化创新研发中心将持续扩充测试载具验证与设备能量、深化可靠度验证,以技术创新与客户共创为核心,携手全球伙伴应对AI世代微小化模块产品制造的新挑战。
-
SiP
+关注
关注
6文章
543浏览量
107995 -
环旭电子
+关注
关注
0文章
76浏览量
4001 -
先进封装
+关注
关注
2文章
562浏览量
1060
发布评论请先 登录
环旭电子旗下环兴光电取得光创联科技控制权
环旭电子模组化与微小化制程技术如何突破AI能源高墙

环旭电子越南海防厂投资建设光模块产能
环旭电子量产新一代Thunderbolt 5智能型扩充基座
环旭电子借助NVIDIA Omniverse与RTX GPU构建工厂级数字孪生系统
华宇电子分享在先进封装技术领域的最新成果
环旭电子亮相第九届中国系统级封装大会
环旭电子谈异质整合驱动MCU应用新格局
环旭电子推出EMVCo认证智能平板POS装置
环旭电子系统级封装屏蔽隔栅技术介绍




 环旭电子整合真空印刷塑封与铜柱移转技术 推动系统级先进封装应用
环旭电子整合真空印刷塑封与铜柱移转技术 推动系统级先进封装应用

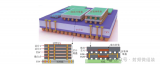




评论