电子发烧友网综合报道 顶部散热(TSC)封装在今年受到市场欢迎,在年中的上海慕尼黑展上我们注意到多家厂商推出了TSC封装产品,并提到这些产品目前市场需求量较大,尤其是在汽车OBC等应用中。
近期,Wolfspeed 面向汽车和工业市场发布商业化量产的顶部散热U2封装器件,来扩展系统设计选项。U2封装可作为对其他供应商生产的 MOSFET 的直接替代,为客户成熟的设计提供了采购灵活性,并改善了封装爬电距离,以支持 650 V 至 1200 V 系统的设计。符合车规级 AEC-Q101 标准的 1200 V 器件即将发布,涵盖 16 mΩ 至 160 mΩ 范围。工规器件可作为预生产或生产就绪样品提供。
根据wolfspeed介绍,传统上,大多数标准的表面贴装分立功率半导体器件通过与PCB接接触,从器件底部散热,PCB下方附有散热器或冷却板。这种方法在许多不同的电力电子应用中都很常见,特别是在 PCB安装和散热器设计不受到系统尺寸和重量严格限制的应用场合。
另一方面,TSC器件通过封装的上表面散热。在顶部散热TSC封装内部,芯片直接焊接在顶部漏极铜框架上,芯片通过封装上表面导热到上方的散热器。相对于传统底部散热封装,TSC封装可以实现更大的耗散功率和更优的散热性能,助力客户从容应对系统热设计要求。顶部散热设计还允许双面使用 PCB,因为 PCB 下表面不再需要用于散热器贴装。
安森美此前的实测显示,如果使用具有底面裸露焊盘的MOSFET,同时使用经过热优化的PCB进行导热和散热,则散热片无论是安装 PCB的底面还是MOSFET的顶面,MOSFET温度之间的差异仅为不到3°C。
这意味着MOSFET温度取决于散热片尺寸。在20.0A负载电流下,与没有任何散热片的设置相比,使用60mm散热片的MOSFET温度大约低30°C。
与没有任何散热片的设置相比,使用25mm散热片时,MOSFET的温度大约降低15至20°C;使用10mm散热片时,MOSFET的温度比没有任何散热片的设置低10°C。
该温度变化与三个散热片的热阻成正比。它还表明,如果使用热优化的PCB布局,散热片需要一定的质量和导热性才能显著降低温度。
而具有顶面裸露焊盘和散热片的MOSFET可实现与底面裸露焊盘安装在经过热优化的PCB上且散热片位于封装顶面的MOSFET类似的热性能。如果要尽量减少流入PCB的热量,则带有顶面裸露焊盘的MOSFET是正确的选择,因为它们对安装在封装顶面的散热片具有最小的热阻。
目前Wolfspeed也推出了基于Wolfspeed第四代 (Gen 4) 芯片技术的顶部散热器件的样品,工程师可进行申请。第四代 (Gen 4) MOSFET 在全温度范围内具备业界领先的开关性能,并具有宽 Vgs兼容性,允许 +18 V 和 -0 V 门极驱动。第四代 (Gen 4) 技术还具有体二极管软恢复特性,可在关断时刻产生更低的 Vds 峰值——这使得 Wolfspeed 第四代 (Gen 4) MOSFET 能应对更严酷工况并且具有更低的 FIT 失效率。
除了wolfspeed之外,其他功率器件厂商也已经推出了相关封装技术和产品。包括英飞凌DDPAK和QDPAK封装的SiC器件;瞻芯电子推出的TC3Pak封装1200V SiC MOSFET;威世PowerPAK封装产品;英诺赛科的Dual-Cool En-FCLGA封装;派恩杰 T7 系列SiC MOSFET器件;安森美推出的顶部散热封装TCPAK57;华润微推出的QDPAK&TOLT顶部散热封装等。
小结:
随着汽车、工业等领域的需求不断提高,顶部散热封装得益于其优异的散热性能以及支持更高的器件功率密度,正在在汽车、工业领域迅速渗透,并持续扩展到更多的应用场景。
近期,Wolfspeed 面向汽车和工业市场发布商业化量产的顶部散热U2封装器件,来扩展系统设计选项。U2封装可作为对其他供应商生产的 MOSFET 的直接替代,为客户成熟的设计提供了采购灵活性,并改善了封装爬电距离,以支持 650 V 至 1200 V 系统的设计。符合车规级 AEC-Q101 标准的 1200 V 器件即将发布,涵盖 16 mΩ 至 160 mΩ 范围。工规器件可作为预生产或生产就绪样品提供。
根据wolfspeed介绍,传统上,大多数标准的表面贴装分立功率半导体器件通过与PCB接接触,从器件底部散热,PCB下方附有散热器或冷却板。这种方法在许多不同的电力电子应用中都很常见,特别是在 PCB安装和散热器设计不受到系统尺寸和重量严格限制的应用场合。
另一方面,TSC器件通过封装的上表面散热。在顶部散热TSC封装内部,芯片直接焊接在顶部漏极铜框架上,芯片通过封装上表面导热到上方的散热器。相对于传统底部散热封装,TSC封装可以实现更大的耗散功率和更优的散热性能,助力客户从容应对系统热设计要求。顶部散热设计还允许双面使用 PCB,因为 PCB 下表面不再需要用于散热器贴装。
安森美此前的实测显示,如果使用具有底面裸露焊盘的MOSFET,同时使用经过热优化的PCB进行导热和散热,则散热片无论是安装 PCB的底面还是MOSFET的顶面,MOSFET温度之间的差异仅为不到3°C。
这意味着MOSFET温度取决于散热片尺寸。在20.0A负载电流下,与没有任何散热片的设置相比,使用60mm散热片的MOSFET温度大约低30°C。
与没有任何散热片的设置相比,使用25mm散热片时,MOSFET的温度大约降低15至20°C;使用10mm散热片时,MOSFET的温度比没有任何散热片的设置低10°C。
该温度变化与三个散热片的热阻成正比。它还表明,如果使用热优化的PCB布局,散热片需要一定的质量和导热性才能显著降低温度。
而具有顶面裸露焊盘和散热片的MOSFET可实现与底面裸露焊盘安装在经过热优化的PCB上且散热片位于封装顶面的MOSFET类似的热性能。如果要尽量减少流入PCB的热量,则带有顶面裸露焊盘的MOSFET是正确的选择,因为它们对安装在封装顶面的散热片具有最小的热阻。
目前Wolfspeed也推出了基于Wolfspeed第四代 (Gen 4) 芯片技术的顶部散热器件的样品,工程师可进行申请。第四代 (Gen 4) MOSFET 在全温度范围内具备业界领先的开关性能,并具有宽 Vgs兼容性,允许 +18 V 和 -0 V 门极驱动。第四代 (Gen 4) 技术还具有体二极管软恢复特性,可在关断时刻产生更低的 Vds 峰值——这使得 Wolfspeed 第四代 (Gen 4) MOSFET 能应对更严酷工况并且具有更低的 FIT 失效率。
除了wolfspeed之外,其他功率器件厂商也已经推出了相关封装技术和产品。包括英飞凌DDPAK和QDPAK封装的SiC器件;瞻芯电子推出的TC3Pak封装1200V SiC MOSFET;威世PowerPAK封装产品;英诺赛科的Dual-Cool En-FCLGA封装;派恩杰 T7 系列SiC MOSFET器件;安森美推出的顶部散热封装TCPAK57;华润微推出的QDPAK&TOLT顶部散热封装等。
小结:
随着汽车、工业等领域的需求不断提高,顶部散热封装得益于其优异的散热性能以及支持更高的器件功率密度,正在在汽车、工业领域迅速渗透,并持续扩展到更多的应用场景。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装
+关注
关注
128文章
9330浏览量
149047 -
TSC
+关注
关注
0文章
41浏览量
26680
发布评论请先 登录
相关推荐
热点推荐
TSC427双功率 MOSFET 驱动芯片详解
MAX626/7/8 - TSC426/7/8 双功率 MOSFET 驱动芯片详解 在电子工程师的日常设计中,功率 MOSFET 驱动芯片是一个常见且关键的元件。今天我们就来详细聊聊 Maxim
TSC426双功率MOSFET驱动器
深入解析MAX626/7/8 - TSC426/7/8双功率MOSFET驱动器 引言 在电子工程师的日常设计工作中,MOSFET驱动器是至关重要的元件,它能有效控制功率MOSFET的开关动作。今天
TSC428双功率 MOSFET 驱动器:设计与应用解析
MAX626/7/8 - TSC426/7/8 双功率 MOSFET 驱动器:设计与应用解析 在电子设计的领域中,功率 MOSFET 驱动器是至关重要的组件,它能将低电平的控制信号转换为高电压
TSC2200:PDA模拟接口电路的全面解析
TSC2200:PDA模拟接口电路的全面解析 在电子设备的设计中,模拟接口电路起着至关重要的作用,它能实现模拟信号与数字信号的转换和处理。今天我们要深入探讨的是德州仪器(Texas
浅析助焊剂在功率器件封装焊接中的应用匹配要求
本文聚焦助焊剂在功率器件封装焊接中的应用环节与匹配要求,其核心作用为清除氧化层、降低焊料表面张力、保护焊点。应用环节覆盖焊接前预处理、焊接中成型润湿、焊接后防护。不同功率

江西萨瑞微电子P6SMFTHE系列产品深度解析:小封装承载大能量的功率器件
在电子设备小型化与高功率密度需求日益凸显的今天,功率器件的封装与性能平衡成为行业技术突破的核心痛点。江西萨瑞微电子作为国内领先的功率半导体I

STMicroelectronics TSC1641高精度功率监控器技术解析
的I^2^C/SMbus到12.5MHz的MIPI I^3^C的数据速率,从而与各种STM32产品兼容。TSC1641支持在特定寄存器中配置电压、电流、功率和温度的警报阈值。该器件采用塑料DFN10
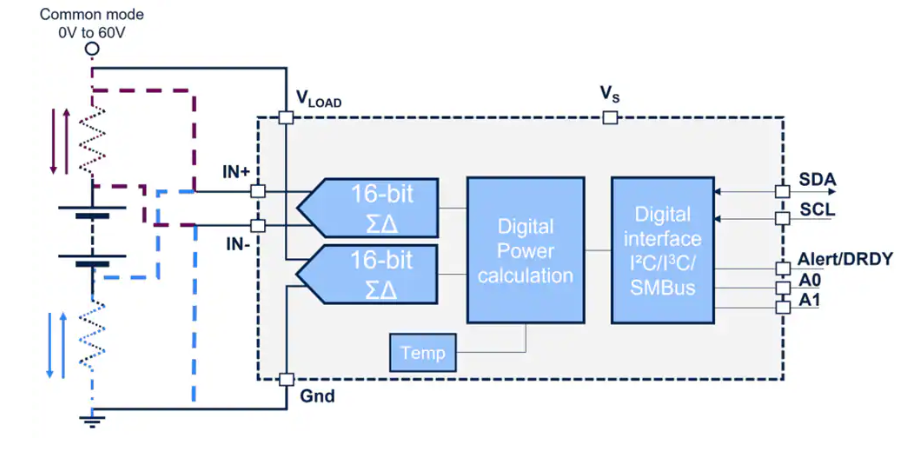
TSC1214功率监测器AFE技术解析:低侧数字监控的创新设计
STMicroelectronics TSC1214功率监测器模拟前端(AFE)设计用于监测低压电源。数字电流、电压和温度监测器TSC1214采用双重监测路径,通过14位ADC监测电流,通过11位ADC监测电压或温度。该AFE可
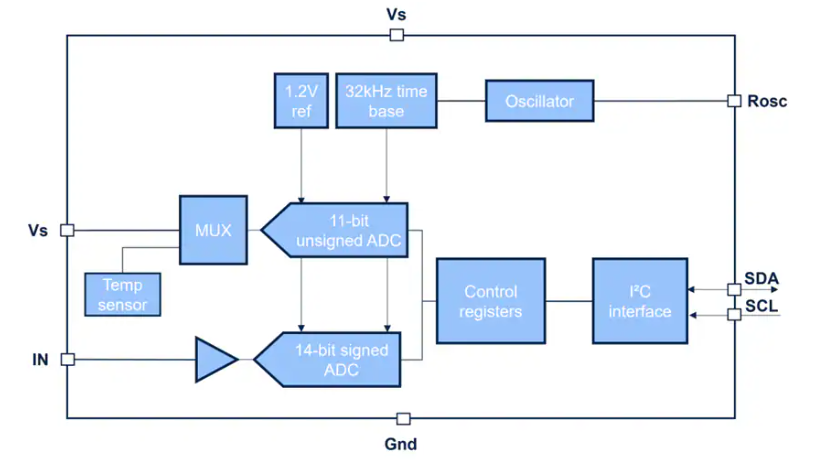
罗姆与英飞凌携手推进SiC功率器件封装兼容性,为客户带来更高灵活度
全球知名半导体制造商罗姆(总部位于日本京都市)宣布,与英飞凌科技股份公司(总部位于德国诺伊比贝格,以下简称“英飞凌”)就建立SiC功率器件封装合作机制签署了备忘录。双方旨在对应用于车载充电器、太阳能
芯片收缩对功率半导体器件封装领域发展的影响
、0.3 mm极致封装间距、200 W/cm²级三维散热、混合键合与FOPLP量产落地,以及AI驱动的设计-检测一体化,正共同重塑功率器件的可靠性边界、集成密度与成本曲线。以上预示着一个由“尺寸微缩+异构集成+系统级优化”定义的
英飞凌推出采用Q-DPAK 封装的CoolSiC™ MOSFET 1200V G2,将工业应用功率密度提升至新高度
【2025年8月1日,德国慕尼黑讯】全球功率系统和物联网领域的半导体领导者英飞凌科技股份公司(FSE代码:IFX/OTCQX代码:IFNNY)近日推出了采用顶部散热(TSC)Q-DPAK封装

功率器件测量系统参数明细
(Wafer Sort),剔除不良品,提升后端封装良率。 功率器件研发与特性分析:全面表征器件静态参数(IV特性:BVdss, Rds(on), Vth, Igss等)和动态参数研究
发表于 07-29 16:21
电源功率器件篇:线路寄生电感对开关器件的影响
、降低线路寄生电感影响的方案
1、优化PCB布局设计
▍缩短功率回路路径
▷ 将功率开关器件、直流母线电容、驱动电路等尽可能靠近布局,减少功率回路的面积。
▷ 采用双面布线的方式,在
发表于 07-02 11:22
功率器件电镀的原理和步骤
在功率半导体制程里,电镀扮演着举足轻重的角色,从芯片前端制程到后端封装,均离不开这一关键工序。目前,我国中高档功率器件在晶圆背面金属化方面存在技术短板,而攻克这些技术难题的关键在于电镀




 TSC封装:功率器件冰凉体验
TSC封装:功率器件冰凉体验




评论