【博主简介】本人系一名半导体行业质量管理从业者,旨在业余时间不定期的分享半导体行业中的:产品质量、失效分析、可靠性分析和产品基础应用等相关知识。常言:真知不问出处,所分享的内容如有雷同或是不当之处,还请大家海涵,如有需要可看文尾联系方式,当前在网络平台上均以“爱在七夕时”的昵称为ID跟大家一起交流学习!
爱在七夕时https://www.zhihu.com/people/duan.yu
半导体封装是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
而其中的Wire Bonding是一种将微电子芯片连接到外部电路的常用工艺。在Wire Bonding工艺中,通过使用电极焊丝将芯片电极和外部金属电路连接起来。其中,焊丝是用金属材料制成的细丝,通过焊丝焊接机械手进行精确的位置控制和焊接操作。Wire Bonding工艺中的一些重要术语包括焊丝直径、焊丝弹性、焊点大小和焊点形状等,这些术语对于确保高质量的焊接连接至关重要。

Wire Bonding是一种常用的半导体封装技术,用于连接芯片和封装基板之间的金属线。该工艺涉及多个术语,如金线、金球、焊盘、焊点、焊线、焊点间距等。
金线是连接芯片和封装基板的主要组成部分,通常由金、铝或铜制成。金球是金线的一端,用于连接芯片的金属引脚。
焊盘是封装基板上的金属垫片,用于接收金线的焊接。焊点是金线与焊盘之间的连接点。焊线是金线的另一端,用于连接封装基板上的其他电路元件。焊点间距是指相邻焊点之间的距离,影响着连接的可靠性和性能。
坦白来讲,对于半导体后端封装工序的相关内容分享,在我各平台上均已分享得比较多了:
超声波焊接(Ultrasonic welding)工艺应在半导体引线键合中的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247515757&idx=1&sn=f9163fa9bbf9e0502251a81918650e83&scene=21#wechat_redirect
半导体封装Wire Bonding (引线键合)工艺技术的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247509620&idx=1&sn=65c3a7f3343807cc633cf20511f04876&scene=21#wechat_redirect
半导体“楔形键合(Wedge Bonding)”工艺技术的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247515918&idx=1&sn=65d5d8c22f576eb637586aefa250cb52&scene=21#wechat_redirect
半导体“封装过程”工艺技术的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247514778&idx=1&sn=00fe6a0db439331830cb111f6c3b89da&scene=21#wechat_redirect
半导体封装“焊线键合(Wire Bonding)”线弧相关培训的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247512372&idx=1&sn=f1dd55515a10bc67a663c2f55bde02c7&scene=21#wechat_redirect
半导体IC封装工艺技术的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247507180&idx=1&sn=d86dfdb3ab276c06fa732d3b9765f95c&scene=21#wechat_redirect
半导体金线键合(Gold Wire Bonding)封装工艺技术简介;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247507082&idx=1&sn=f6aad777d848e50482cf5a8004ab496f&scene=21#wechat_redirect
半导体“金线键合(Gold Wire Bonding)”工艺技术的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247502190&idx=1&sn=cf81535e395a50d6baa88c7942fd4da4&scene=21#wechat_redirect
半导体Wire Bonding 工艺技术的详解;mp.weixin.qq.com/s?__biz=Mzk0MzYyODY5Mg==&mid=2247494587&idx=1&sn=8fc08e6ca23866c754833dafdbb244b8&scene=21#wechat_redirect
所以,本章节主要想跟大家分享的还是半导体封装Wire Bonding工艺的基础知识,感觉其中有些内容还是可圈可点的:





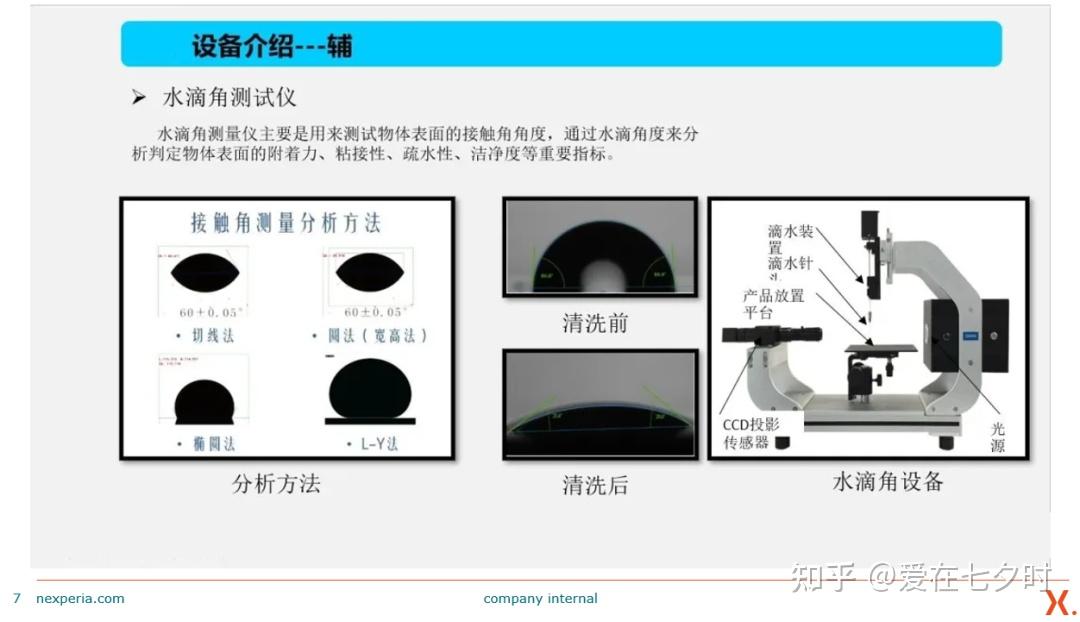




http://weixin.qq.com/r/QhAjO9TE64mUrZBY90VQ (二维码自动识别)
因为本PPT章节太多,剩下部分如有朋友有需要,可加入我“知识星球”免费下载PDF版本。注意:此资料只可供自己学习,不可传阅,平台有下载记录,切记!文末有加入“星球”方式,欢迎加入后一起交流学习。
总之,引线键合(Wire Bonding)工艺技术是微电子封装中不可或缺的一部分,它通过精细的金属线连接技术,实现了芯片与外部电路的电气互连,对于确保电子设备的性能和可靠性发挥着重要作用。随着技术的不断进步,引线键合也在不断优化,以适应更高性能和更低成本的需求。

-----End-----
免责声明
我们尊重原创,也注重分享;文字、图片版权归原作者所有。转载目的在于分享更多信息,不代表本号立场,如有侵犯您的权益请及时联系(一三七 二八三五 六二六五),我们将第一时间删除,谢谢!
审核编辑 黄宇
-
半导体封装
+关注
关注
4文章
331浏览量
15276 -
引线键合
+关注
关注
2文章
40浏览量
8637
发布评论请先 登录
层压基板引线键合工艺原理、关键参数及推拉力测试机检测方法

半导体引线键合熔断电流全解析:推拉力测试机如何提升器件可靠性?

高频超声键合技术:引线键合工艺优化与质量检测方法

半导体封装引线键合技术:超声键合步骤、优势与推拉力测试标准

一文读懂引线键合可靠性:材料选型、失效风险与测试验证全解析

一文了解什么是半导体引线键合中的弹坑?

半导体芯片制造技术——“芯片键合”工艺技术的详解;

半导体封装Wire Bonding (引线键合)工艺技术的详解;

半导体封装“焊线键合(Wire Bonding)”线弧相关培训的详解;

半导体“金(Au)丝引线键合”失效机理分析、预防及改善的详解;

半导体“楔形键合(Wedge Bonding)”工艺技术的详解;

什么是引线键合?芯片引线键合保护胶用什么比较好?




 半导体封装“引线键合(Wire Bonding)”基础知识详解
半导体封装“引线键合(Wire Bonding)”基础知识详解







评论