过渡金属硫化物(TMDs)的厚度可调能带结构使其在光电子领域备受关注。PtSe₂作为新型层状材料,具有从半导体到半金属的相变特性,带隙可调控。然而,其精确光学常数数据长期缺失,制约器件优化。椭圆偏振仪凭借亚纳米级精度、无损测量及同步获取膜厚与光学参数的优势,成为解决该问题的关键手段。Flexfilm费曼仪器作为国内领先测量供应商所提供的Flexfilm全光谱椭偏仪,可精确量化PtSe₂的折射率n、消光系数k及厚度d,结合多尺度表征解析厚度依赖规律与相变机制。
1
PtSe₂薄膜的制备和光学表征
flexfilm
样品制备
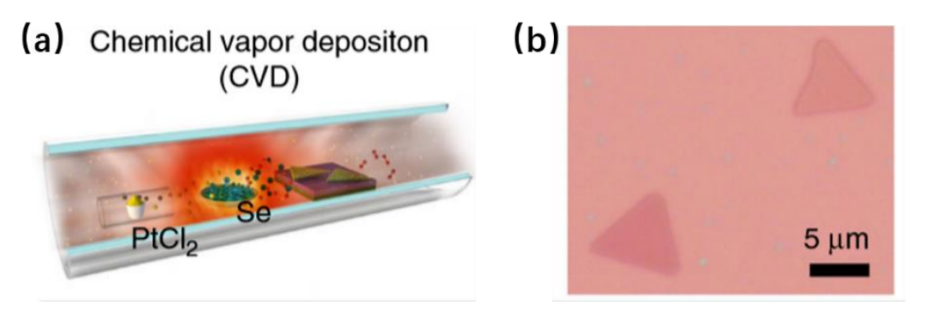
(a)化学气相沉积的方法制备 PtSe₂ 的示意图(b)制备得到的 PtSe₂薄膜的光学显微图
在实验中用到的6 块不同厚度的 PtSe₂薄膜(标号分别为样品 A-F)所有样品的尺寸均约为 1×1×0.03 cm³。这些样品均为采用化学气相沉积的方法沉积在蓝宝石(Al₂O₃)基底上得到的。
光学表征
首先对样品 A-F 进行了光学表征,以验证样品的质量。利用原子力显微镜(AFM)观察了样品的表面形貌以及测量了 6 个样品的厚度,与椭偏仪拟合得到的厚度进行比较。
各样品的生长时间、使用 AFM 和椭偏仪测量的厚度以及相应的 Se/Pt 化学计量比

2
椭偏仪测量PtSe₂薄膜的光学常数
flexfilm
测量参数
光谱范围:360–1700 nm
入射角:50°
波长步长:5 nm
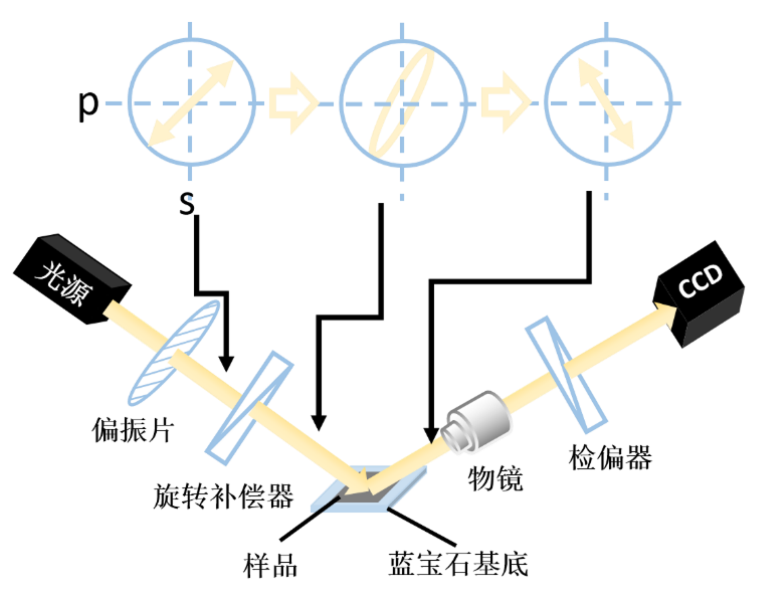
椭偏仪内部光路示意图
光路流程
超连续光源 → 槽光栅(分光) → 偏振片(线偏振光) → 1/4波片(椭圆偏振光) → 样品反射 → 物镜 → 检偏器 → CCD探测器
测量原理
通过分析反射光中 s/p偏振分量 的振幅比(ψ)和相位差(Δ),结合菲涅尔反射理论,反演样品的光学常数(n, κ)和厚度。
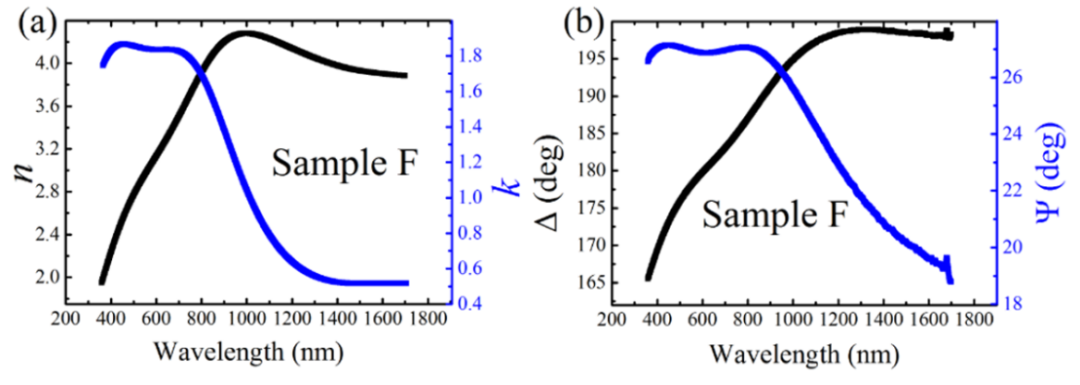
采用 Lorentz + Tauc-Lorentz + Drude + eps 线型拟合得到的 (a)n和k;(b) ψ和Δ
模型建立:采用"蓝宝石基底/PtSe₂薄膜/空气"三层模型,以Lorentz + Tauc-Lorentz + eps色散关系拟合,均方根误差(RMSE)< 5,优于Drude混合模型。
3
光学常数厚度依赖性
flexfilm
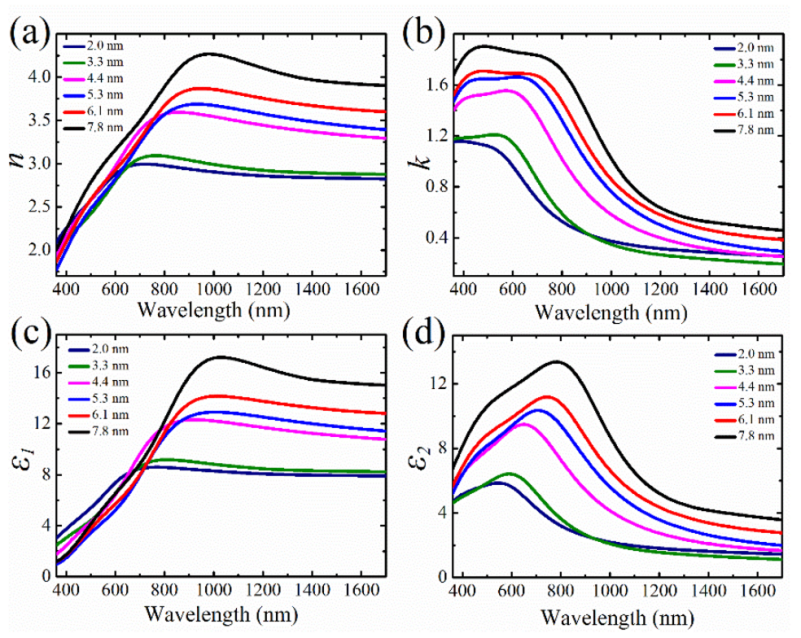
测量得到的不同厚度的PtSe₂的(a)折射率n;(b)消光系数k;(c)介电函数实部ε₁;(d)介电函数虚部ε₂
通过椭偏拟合获得PtSe₂的光学常数(n, k,ε₁,ε₂)及厚度d,关键规律如下:
折射率 n:随厚度增大而增大(长波区更显著);随波长增加呈"先增后减"趋势,且峰值位置随厚度红移。
消光系数k:样品的厚度越大,消光系数k的值越大(红外区显著增强);除最薄样品(A)外,所有k谱存在双吸收峰,峰间距随厚度减小而缩小;波长依赖性:短波区平稳 → 600–1200 nm剧减 → 长波区趋稳。
介电函数:ε₁变化同n;ε₂谱呈单峰结构,峰位随厚度增加红移。
本文使用椭偏仪在紫外到红外光谱范围内(360-1700 nm)测量了不同厚度PtSe₂的光学常数, 化学气相沉积制备的蓝宝石基底上的 PtSe₂薄膜的光学常数表现为强烈的厚度依赖特性,随着薄膜厚度增加,其折射率n和消光系数k都增大,原因是随样品厚度增加其半金属的成分也增加。PtSe₂光学常数的厚度依赖特性为我们调控基于 PtSe₂的光电器件提供了新的维度,有助于 PtSe₂在光电器件领域的应用。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件可以精确量化PtSe₂的折射率n、消光系数k及厚度d。Flexfilm费曼仪器以创新技术解决二维材料的光学常数标定难题,助力全球薄膜材料领域的高质量发展。
原文参考:《基于椭偏仪测量的PtSe2光学性质研究》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
材料
+关注
关注
3文章
1594浏览量
28696 -
光谱
+关注
关注
4文章
1060浏览量
37418
发布评论请先 登录
全光谱椭偏仪测量:金属/半导体TMDs薄膜光学常数与高折射率特性

椭偏仪在半导体的应用|不同厚度c-AlN外延薄膜的结构和光学性质




 全光谱椭偏仪在二维材料中的应用 | 解析PtSe₂光学常数厚度依赖关系
全光谱椭偏仪在二维材料中的应用 | 解析PtSe₂光学常数厚度依赖关系





评论