文章来源:学习那些事
原文作者:小陈婆婆
本文简单介绍了芯片离子注入后退火会引入的工艺问题:射程末端(EOR)缺陷、硼离子注入退火问题和磷离子注入退火问题。
热退火是半导体制造中不可或缺的关键步骤,通过技术分类优化和固相外延再生长,可显著提升器件性能。未来,智能控制、材料创新和跨学科研究将推动热退火技术的进一步发展,为先进工艺节点和新型器件研发提供支撑。
关键目的
晶格修复:通过热能驱动原子重排,恢复离子注入导致的非晶层结构(修复温度约500℃)。
杂质激活:使注入的间隙杂质原子进入晶格替位位置,形成电活性掺杂(激活温度约950℃)。
薄膜改性:致密化疏松薄膜,改善高k栅介质特性(如降低栅泄漏电流)。
合金形成:优化金属硅化物(如CoSi、NiSi)的接触电阻和本体电阻。
技术分类与特性

射程末端(EOR)缺陷
射程末端缺陷是高剂量离子注入后,退火过程中非晶硅(a-Si)与单晶硅(c-Si)界面处形成的稳定位错环缺陷。其形成源于离子注入导致的非晶化层在退火时发生固相外延再生长(SPER),界面处点缺陷(如空位和间隙原子)的扩散与聚结形成扩展缺陷。

图1射程末端(EOR)缺陷示意图
关键影响因素

对器件性能的影响与解决方案
电学性能退化
漏电流增加:位错环位于PN结耗尽区时,反向漏电流增加2-3个数量级。
可靠性风险:缺陷簇加速电迁移,器件寿命缩短50%以上。
工程化解决方案

前沿技术进展与应用拓展
缺陷工程突破
二维材料调控:山东大学团队通过氩等离子体辐照调控Bi₂O₂Se中的O/Se空位缺陷,实现超快激光输出(脉宽266fs),比传统材料缩短50%。
纳米技术应用:利用缺陷增强纳米炸药性能(威力提升千百倍),推动军事领域变革。
退火工艺创新
储氢合金退火:北方稀土贮氢公司开发新工艺,产品合格率提升0.6%,能耗降低6%。
硅钢退火技术:中冶南方研发带气氛高频感应加热装备,实现±5℃温度控制,满足新能源汽车硅钢需求。
跨学科研究
量子退火算法:中科院高能物理研究所将量子退火启发式算法应用于粒子径迹重建,加速万倍。
生物医学应用:缺陷工程调控钛合金表面抗菌性(抑菌率>99%),提升人工关节性能。
射程末端缺陷是离子注入工艺中需精准调控的关键问题。通过退火条件优化、杂质工程和工艺创新,可显著减少其影响。未来,智能控制、材料创新和跨学科研究将推动器件性能与可靠性的进一步提升,并为新能源、生物医学等领域带来革命性突破。
硼离子注入退火特性
硼退火特性是硼离子注入后,通过热能驱动原子重排,使间隙硼原子进入晶格替位位置形成电活性掺杂的过程。电学激活比例(自由载流子数Np/注入剂量Ns)是衡量激活程度的关键指标。
温度依赖特性

逆退火现象解析
在500-600℃范围内,注入产生的点缺陷通过结团降低系统能量,形成扩展缺陷(如位错环)。硼原子因小尺寸效应(原子半径≈0.88Å)易被缺陷团俘获,导致替位硼浓度下降,出现电学激活比例随温度升高反常降低的现象。
工艺挑战与解决方案
对器件性能的影响
阈值电压漂移:激活比例不足导致PMOS阈值电压(Vth)偏移±15%。
漏电流增加:未激活硼原子在氧化层中形成陷阱电荷,增加栅泄漏电流。
可靠性风险:逆退火导致激活比例波动,加速负偏压温度不稳定性(NBTI)。
前沿技术进展与应用拓展
退火工艺创新
储氢合金退火:北方稀土贮氢公司开发新工艺,产品合格率提升0.6%,能耗降低6%。
硅钢退火技术:中冶南方研发带气氛高频感应加热装备,实现±5℃温度控制,满足新能源汽车硅钢需求。
纳米技术应用
硼掺杂纳米金刚石:1000℃退火后,纳米金刚石相含量增加,硼浓度提高,薄膜电阻率降低至0.1Ω·cm。

图2 不同注入剂量条件下硼的退火特性
量子点调控:通过退火温度调控硼量子点尺寸,优化光电器件发光效率。
跨学科研究
量子退火算法:中科院高能物理研究所将量子退火启发式算法应用于粒子径迹重建,加速万倍。
生物医学应用:硼中子俘获疗法(BNCT)中,通过退火优化硼涂层结构,提升癌症治疗效果。
硼退火特性是半导体制造中需多维度优化的核心问题。通过退火条件优化、杂质工程和工艺创新,可显著减少逆退火现象,提高器件性能。未来,智能控制、材料创新和跨学科研究将推动硼退火技术的进一步发展,为先进工艺节点和新型器件研发提供支撑。
磷离子注入退火特性
磷退火特性是磷离子注入后,通过热能驱动原子重排,使间隙磷原子进入晶格替位位置形成电活性掺杂的过程。同样电学激活比例是衡量激活程度的关键指标。
高剂量注入的退火机理
高剂量(>1×10¹⁵cm⁻²)注入导致非晶层形成,退火时发生固相外延再生长。磷原子与间隙硅原子无区别地结合到晶格位置,显著提高激活比例。
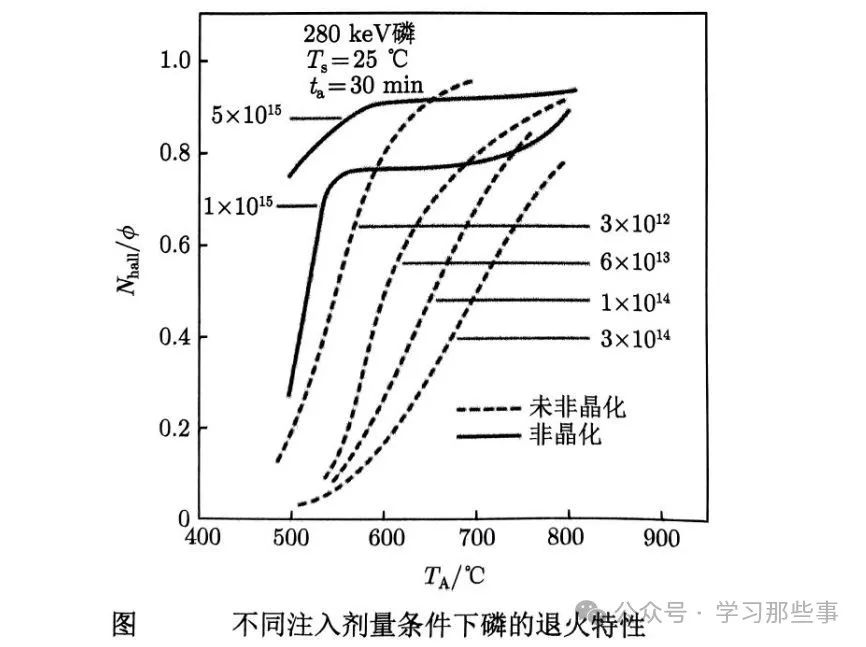
图3 不同注入剂量条件下磷的退火特性
对器件性能的影响
阈值电压漂移:激活比例不足导致NMOS阈值电压(Vth)偏移±15%。
接触电阻:未激活磷原子在硅化物/硅界面形成势垒,增加接触电阻。
可靠性风险:激活比例波动加速正偏压温度不稳定性(PBTI)。
前沿技术进展与应用拓展
退火工艺创新
储氢合金退火:北方稀土贮氢公司开发新工艺,产品合格率提升0.6%,能耗降低6%。
硅钢退火技术:中冶南方研发带气氛高频感应加热装备,实现±5℃温度控制,满足新能源汽车硅钢需求。
纳米技术应用
磷掺杂纳米金刚石:1000℃退火后,纳米金刚石相含量增加,磷浓度提高,薄膜电阻率降低至0.1Ω·cm。
量子点调控:通过退火温度调控磷量子点尺寸,优化光电器件发光效率。
磷退火特性是半导体制造中需多维度优化的核心问题。通过退火条件优化、杂质工程和工艺创新,可显著提高激活比例,提升器件性能。未来,智能控制、材料创新和跨学科研究将推动磷退火技术的进一步发展,为先进工艺节点和新型器件研发提供支撑。
-
芯片
+关注
关注
463文章
54706浏览量
471481 -
半导体
+关注
关注
339文章
31560浏览量
267997 -
工艺
+关注
关注
4文章
730浏览量
30445 -
离子注入
+关注
关注
5文章
71浏览量
10684
原文标题:芯片制造离子注入问题——热退火
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
退火工艺(Thermal Annealing)介绍
6.1.6 离子注入及后续退火过程中的缺陷行成∈《碳化硅技术基本原理——生长、表征、器件和应用》

SiC的离子注入工艺及其注意事项
离子注入的目的及退火过程
离子注入工艺中的激活退火流程和原理




 芯片离子注入后退火会引入的工艺问题
芯片离子注入后退火会引入的工艺问题


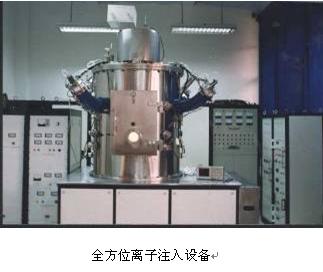
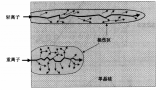
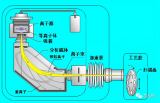


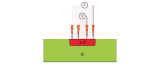



评论