文章来源:半导体与物理
原文作者:jjfly686
本文介绍了芯片制造领域离子注入工艺中的激活退火的流程和原理。
在芯片制造中,离子注入工艺就像一场精准的“原子轰炸”——把硼、磷、砷等掺杂原子加速到几十甚至几百千电子伏的能量,强行轰进硅片里。这些外来原子进入晶格之后,并不能马上发挥作用,它们要么挤在晶格缝隙里,要么把硅原子撞得东倒西歪,整个晶格结构乱成一团。这时候,就需要一场“高温唤醒”仪式——激活退火。

为什么要激活?注入之后的混乱局面
高能离子撞进晶格的过程,其实相当暴力。轻的离子像子弹穿过棉花,留下的损伤相对较少;重的离子则像炮弹砸进砖墙,把周围一大片晶格都轰成碎片。结果是,硅片表面层形成大量空位、间隙原子,严重的情况下甚至变成非晶态。
更麻烦的是,注入进去的掺杂原子,大部分都待在晶格的间隙位置,而不是替代硅原子的位置。只有在替代位置上的原子,才能真正贡献载流子(电子或空穴),改变半导体的导电类型和电阻率。这些“挤在缝里”的原子,就跟路人甲一样,完全不干活。
激活退火的任务有两个:一是让混乱的晶格重新排列整齐,修复注入造成的损伤;二是让掺杂原子从间隙位置“跳”进空出来的硅原子位置,真正成为晶格的一部分,从而贡献载流子。

不同材料,不同“脾气”:激活温度取决于什么
激活温度没有统一标准,主要看三个因素:衬底材料的熔点、掺杂离子的种类、以及注入剂量。
对于最常见的硅材料,硼离子的激活温度通常在900°C到1000°C左右。砷和磷这类重离子,需要的温度也差不多,但高剂量注入后形成的非晶层,激活行为会更复杂。有个研究提到,电离辅助退火在550°C到900°C范围内表现出温度依赖性,激活能会随注入剂量变化。
碳化硅这种宽禁带材料就“难伺候”多了。因为它化学键强,晶格非常稳定,要让注入的离子激活,通常需要1100°C以上甚至高达1600-1700°C的高温。有研究用F离子注入4H-SiC,在500°C到1100°C范围内进行激活退火,发现温度越高,扩散到界面处的F元素浓度也越高,说明激活效果与温度正相关。

轻离子和重离子:谁更难
轻离子和重离子的差别,主要体现在注入时造成的损伤程度不同。
轻离子(比如硼)质量小,跟晶格原子的碰撞截面小,能量损失慢,能穿透更深。它们造成的损伤相对分散,主要是一些孤立的点缺陷,不容易形成连续的缺陷层。这种损伤在退火时比较容易恢复,需要的温度和时间也相对温和。
重离子(比如砷、锑、以及磷也算中等偏重)就完全不同了。它们质量大,一头撞进去就跟保龄球砸进瓶子堆一样,会在路径上产生一连串的晶格位移,形成密集的缺陷区域。当剂量足够高时,甚至会在表面形成一层连续的非晶层。要把这层彻底“重结晶”,需要更高的温度,而且结晶过程是从底部的单晶衬底往上“长”回去的,速度和质量受温度控制。有研究对比过Si和Be注入InGaAs材料,发现Si(中等质量)在850°C/5秒条件下能接近100%激活,而Be(轻离子)最大激活率只有56%左右。
另外,重离子在退火过程中更容易发生扩散再分布,尤其是长时间高温退火时,它们会到处乱跑,导致掺杂轮廓变形,影响器件性能。这也是为什么现代工艺更青睐快速热退火——温度高但时间极短(几秒到几十秒),在激活杂质的同时尽量限制扩散。

激活退火看似就是把晶圆放进炉管里烤一烤,但背后的物理机制相当复杂。不同的衬底材料、不同的掺杂离子、不同的注入条件,都需要量身定制的退火配方。轻离子温和,重离子暴烈;硅比较“好说话”,碳化硅和氮化镓则是出了名的“难搞”。工程师们通过调节温度、时间、升温速率,甚至用上碳膜覆盖、氮气保护等各种技巧,目的只有一个:让那些被强行塞进去的原子,最终乖乖坐进它们该坐的位置,为芯片贡献出稳定的电性能。
-
芯片制造
+关注
关注
11文章
734浏览量
30527 -
离子注入
+关注
关注
5文章
71浏览量
10672
原文标题:离子注入:激活退火
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
离子注入工艺仿真

退火工艺(Thermal Annealing)介绍
6.1.6 离子注入及后续退火过程中的缺陷行成∈《碳化硅技术基本原理——生长、表征、器件和应用》




 离子注入工艺中的激活退火流程和原理
离子注入工艺中的激活退火流程和原理


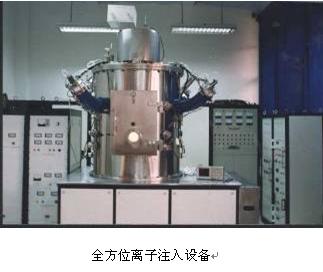
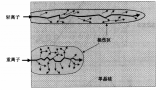

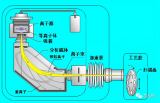



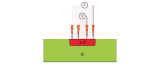



评论