高电流的硅或错离子注入将严重破坏单晶体的晶格结构,并在晶圆表面附近产生非晶态层。硅或错的非晶态注入过程可以完全消除通道效应,因为在非晶态衬底中,掺杂物界面的分布轮廓由离子注入形成,一般遵循高斯分布,这是可以预测、重复和控制的。
这种预先非晶态注入的方式增加了额外的离子注入步骤,使生产成本增加。当特征尺寸不断缩小时,热退火的热积存也减少了。对于纳米节点技术,可能没有足够的热积存通过退火恢复预非晶注入引起的晶体损伤,残留的缺陷可能导致结的漏电。
损伤与热退火
离子注入过程中,离子因为与晶格原子碰撞逐渐失去能量,同时会将能量转移给碰撞原子。这些转移的能量会使碰撞原子从晶格的束缚能中释放出来,通常的束缚能为25eV左右。这些自由原子在衬底内运行时会与其他的晶格原子产生碰撞,并通过转移足够的能量将碰撞原子从晶格碰离出来。这些过程将持续进行,直到没有任何一个自由原子有足够的能量把其他的晶格原子释放岀来为止。高能量的离子可以使数千晶格原子的位置偏离。高能量的注入离子所产生的损伤如下图所示。
由单一离子造成的损伤可以在室温下通过衬底内原子的热运动很快自我退火而消除。然而在离子注入过程中,离子总数非常大,以至于单晶衬底中靠近表面部分造成大量的晶格损伤,进而使单晶硅变成非晶态,退火过程无法在短时间内修复晶体的损伤。损伤的效应与剂量、能量和离子的质量有关,会随剂量与离子能量的增大而增加。如果注入的剂量过高,靠近衬底表面的离子射程内,衬底的晶体结构会完全被破坏而变成非晶态。
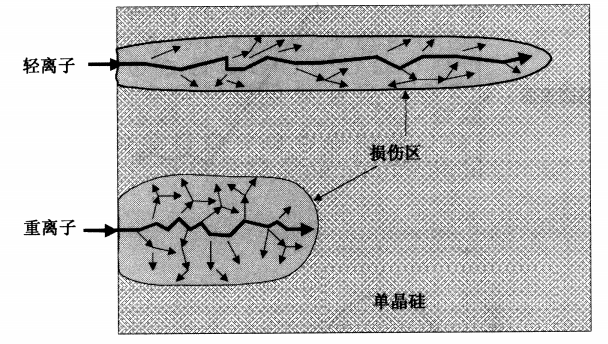
为了达到元器件设计的要求,晶格损伤必须在热退火过程中修复成单晶结构并激活掺杂物。只有当掺杂物原子在单晶体晶格位置时,才能有效提供电子或空穴作为电流的主要载体。高温过程中,原子能从热能中获得能量并进行快速热运动。当运动到单晶晶格中具有最低自由能的位置时,就将停留在此位置。
因为在没有被破坏的衬底下是单晶硅,所以被破坏的非晶态层中的硅与掺杂物原子,将在靠近单晶硅界面位置通过落入晶格位置且被晶格能束缚后重建单晶结构。下图说明了在热退火过程中的晶体复原及掺杂物的激活情况。

高温过程中,单晶体的热退火、掺杂物原子的激活和掺杂物原子的扩散将同时发生。当集成电路的图形尺寸缩小到深亚微米时,将只有极小的空间使掺杂物原子扩散,因此必须在加热退火过程中将掺杂物的扩散减到最小。
掺杂物原子在非晶硅中具有不受限制的自由热移动,比在单晶体晶格中的扩散快,这是因为单晶体晶格的束缚能将严重限制掺杂物原子的运动。当温度较低时,扩散过程将快于退火过程;而当温度较高时,例如高于1000摄氏度,退火过程比扩散过程快,这是因为退火的激活能(约5eV)比扩散的激活能(3〜4eV)高。
审核编辑:刘清
-
单晶硅
+关注
关注
7文章
194浏览量
29122
原文标题:半导体行业(一百七十六)之离子注入工艺(六)
文章出处:【微信号:FindRF,微信公众号:FindRF】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
离子注入工艺的设计与计算简介
退火工艺(Thermal Annealing)介绍
6.1.6 离子注入及后续退火过程中的缺陷行成∈《碳化硅技术基本原理——生长、表征、器件和应用》






 离子注入工艺的损伤与热退火
离子注入工艺的损伤与热退火



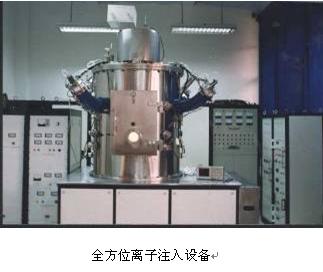

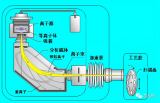


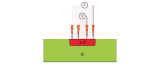










评论