本文简单介绍了离子注入工艺中的重要参数和离子注入工艺的监控手段。
在硅晶圆制造过程中,离子的分布状况对器件性能起着决定性作用,而这一分布又与离子注入工艺的主要参数紧密相连。
离子注入技术的主要参数涵盖了离子源的类型、注入剂量、注入能量、注入角度以及硅片的旋转等因素。
离子注入工艺参数
1)注入剂量
掺杂离子的整体浓度主要受注入剂量的影响。剂量由束流密度(即单位面积上的离子数量)和注入时间的乘积决定,其具体范围与离子注入设备的性能密切相关。通常,中束流/高能注入机的剂量范围在1011 ~1014cm-2。高束流注入机则在1014~1016cm-2之间,剂量的理论计算公式为:

其中,N代表离子注入剂量(单位:cm-19C)。T为注入时间,I为注入的电流大小;A为注入面积,n为电荷数,e则是单位电荷量。
需要注意的是,离子注入剂量是以束流密度(即单位面积上的离子数)来衡量的,而在实际浓度分析中,如采用二次离子质谱法(SIMS)时,则是以体浓度(即单位体积中的离子数)来表示的。因此,在使用这两种方法时,应注意其计算单位的差异。
2)注入能量
离子注入时的能量,直接关联到离子的运动速度,是决定离子注入深度的关键因素。在集成电路制造中,离子注入的能量范围通常介于0.1keV至1000 keV之间。
离子的注入深度不仅与注入能量有关,还受到注入剂量的影响。如下图所示,展示了Sb离子在不同能量注入下的深度分布,通过SIMS分析得出。可以观察到,随着注入能量的提升,离子的注入深度也随之增加,但相应地,浓度的峰值会有所下降。
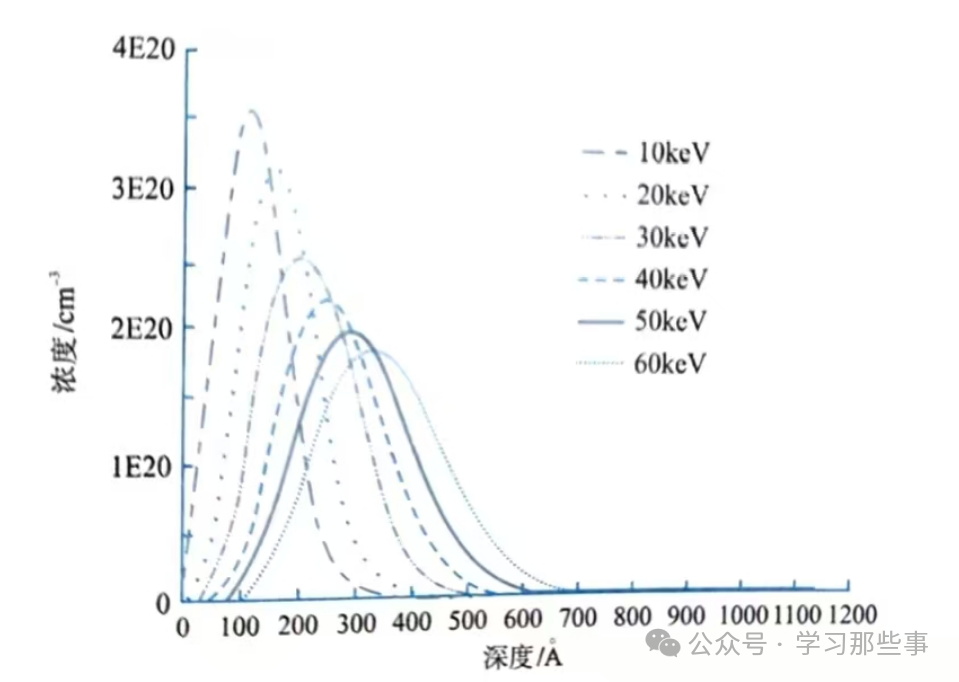
Sb离子在不同能量注入下的深度分布曲线(SIME分析)
下图则描绘了B、P、As三种离子在非晶硅中注入深度随注入能量变化的曲线。从图中可以清晰看出,注入深度与注入能量之间存在正比例关系。此外,对于具有相同注入能量的不同种类离子而言,离子的相对原子质量越大,其注入深度的投影射程(Rp)反而越小。

B、P、As在非晶硅中注入深度随注入能量变化的曲线
3)注入角度
离子注入的角度参数涵盖倾角(tilt)与扭角(twist),如下图所示。倾角对离子注入深度有着显著影响,而扭角则需依据具体产品结构的方向进行相应调整。

离子注入的倾角和扭角
在实际晶圆工艺中,硅晶体以单晶形式存在,展现出特定的晶体结构。因此,从不同晶向观察时,其晶格投影会展现出较大的差异。如下图所示,当沿《110》方向观察时,会形成较多且尺寸较大的沟道。若偏离此角度,沟道数量虽增加,但尺寸会明显减小。当离子沿《110》晶向注入时,部分离子会沿着这些沟道前进,所受原子核和电子的阻碍极小,从而导致注入深度超出预期,形成所谓的沟道效应。

观看方向
在沟道效应的影响下,离子注入的深度和浓度会出现第二个峰值,如下图所示,使得注入深度难以控制。为规避沟道效应,目前主要采用两种方法:一是调整硅晶体的主轴方向,使其偏离注入方向,即调整倾角(通常介于3°至7°之间),使硅晶体呈现无定形状态。通过观察As、Sb、B、P等掺杂离子在不同倾角(如5°、30°、60°和80°)下的SIMS深度分布曲线,可以发现随着倾角的增大,注入深度减小,峰值更靠近表面,且峰值浓度降低。二是采用在硅晶体表面覆盖无定形介质膜的方法,如二氧化硅、氮化硅,或对表面进行非晶化处理(如注入Ge或Si等离子)。
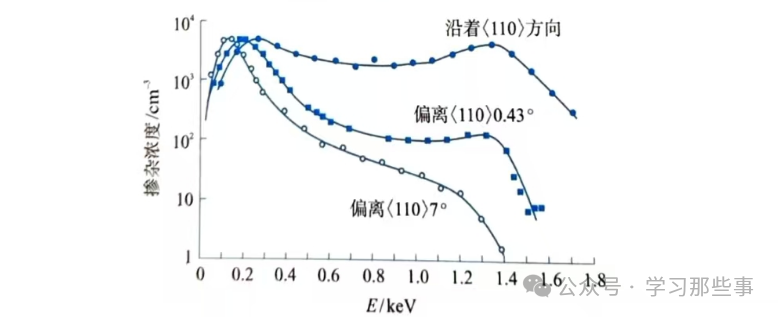
P在110keV能量注入下通道效应对浓度分布的影响
4)硅片旋转
在进行硅片离子注入时,其表面往往存在一定的结构图形,这会导致在注入过程中部分区域被遮挡,形成所谓的阴影效应。为了改善硅片表面的注入均一性,通常需要对硅片进行旋转。例如,在某些离子注入工艺中,硅片会按照总剂量的四分之一进行四次90°的旋转,以此消除阴影效应的影响(见下图,注:虚线部分为阴影区域)。
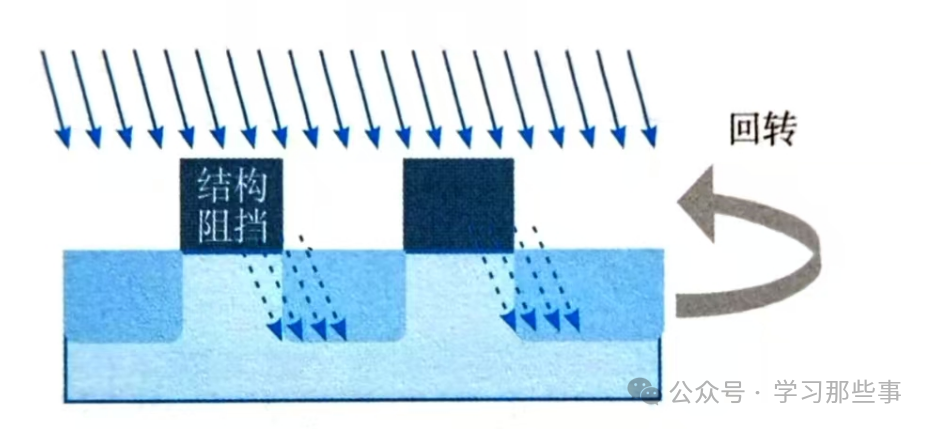
离子倾角注入结构阻挡
5)离子源的选择
掺杂元素种类繁多,主要包括硼(B)、磷(P)、砷(As)、铟(In)、氧(O)、氢(H)、氟(F)以及锗(Ge)等。根据产品的不同应用需求,需要选择掺杂不同的元素。
硼元素常用的离子源为三氟化硼(BF₃)或硼烷(B₂H₆),用于P型掺杂,如形成P型阱、调节P型器件的阈值电压、P型器件掺杂以及源漏极的形成等。由于硼原子质量较轻,所需的注入能量也相对较低,因此通常选择BF₃⁺离子进行注入。
磷元素则常用磷烷(PH₃)或固态红磷作为离子源,用于N型掺杂,如形成N型阱、调节N型器件的阈值电压、N型器件掺杂以及源漏极的形成等。
砷元素则可用砷烷(AsH₃)、固态砷或As₂O作为离子源,与磷一样属于N型掺杂,同时砷还可用于深埋层的注入。
铟元素则以碘化铟(InI)为离子源,与硼一样属于P型掺杂,且作为重离子,常用于轻掺杂注入。
氟元素则可用BF₃作为离子源,用于中和Si/SiO₂界面上的Si悬挂键,以降低界面态密度,减少漏电流和随机电信号噪声的干扰。
锗元素在高剂量注入下能够打乱硅的晶格结构,形成非晶化层,有助于降低沟道效应。此外,它还有助于离子注入后退火过程中的再结晶和电激活。
离子注入工艺的监控
离子注入工艺的各项参数均对最终的产品器件性能有着重要影响,因此,对工艺进行持续且有效的监控显得尤为重要。以下是几种主要的监控手段:
1)热波损伤检测技术(见下图)
硅片经过离子注入后,其晶格会受到一定程度的损伤。通过检测这种晶格损伤的程度,我们可以监控离子注入工艺的稳定性。具体方法是,利用一束激光加热晶圆表面,随后晶圆表面的反射率会发生变化。再用另一束激光测量晶圆表面的特定区域,反射信号会随着反射率的变化而变化,这个检测到的变化信号被称为热波(thermal wave, TW)信号。热波信号与晶格的损伤程度密切相关。这种方法反应迅速,无需破坏晶圆,非常适合在生产线上实时监控离子注入工艺的稳定性。

热波操作监控
2)方块电阻测量法
离子注入后的晶圆需要经过快速热退火处理,以激发掺杂物的电子活性。方块电阻(sheet resistance, Rs)测量仪采用四探针法,即在两根测试针之间施加电流,并测量另外两根测试针之间的电压,以此来计算晶圆的方块电阻值。Rs值是离子注入机台常用的监控指标,它与注入剂量和角度有关。一般来说,剂量越大,Rs值越小。Rs的测量结果也会受到快速热退火工艺稳定性的影响。尽管这种方法没有热波损伤检测那么直接,但其结果较为精确,因此也被广泛应用于生产线上的在线监控。
3)二次离子质谱分析法
通过重离子束轰击晶圆表面,并收集不同时间溅射出的二次离子质谱,我们可以测量掺杂元素的种类、浓度以及注入深度。这是目前反映离子注入情况最为准确的监控方法。然而,SIMS分析无法对整个硅片进行全面分析,需要在专门的实验室中使用SIMS分析设备进行分析,且需要破坏硅片进行取样,因此无法实现在线测量,结果反馈时间也相对较长。
4)表面颗粒监控技术
对于离子注入工艺而言,表面颗粒的主要危害在于它们会阻挡掺杂注入区,导致不完全掺杂结构,进而影响产品的良率。因此,我们需要采用电子显微镜等方法对表面颗粒进行监控。
-
工艺
+关注
关注
4文章
720浏览量
30393 -
离子注入
+关注
关注
5文章
71浏览量
10675
原文标题:离子注入工艺参数
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 离子注入工艺中的重要参数和监控手段
离子注入工艺中的重要参数和监控手段



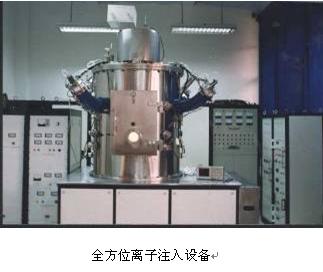

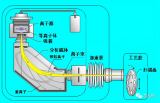


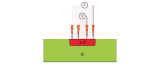



评论