无人机控制板与遥控器板BGA芯片底部填充胶加固方案
方案提供方:汉思新材料

无人机应用趋势概览
随着科技的飞速发展,无人机已广泛应用于航拍、农业监测、物流配送、紧急救援等多个领域,成为现代生活中不可或缺的一部分。为确保无人机在复杂多变的环境中稳定运行,其内部组件的可靠性和耐用性至关重要。
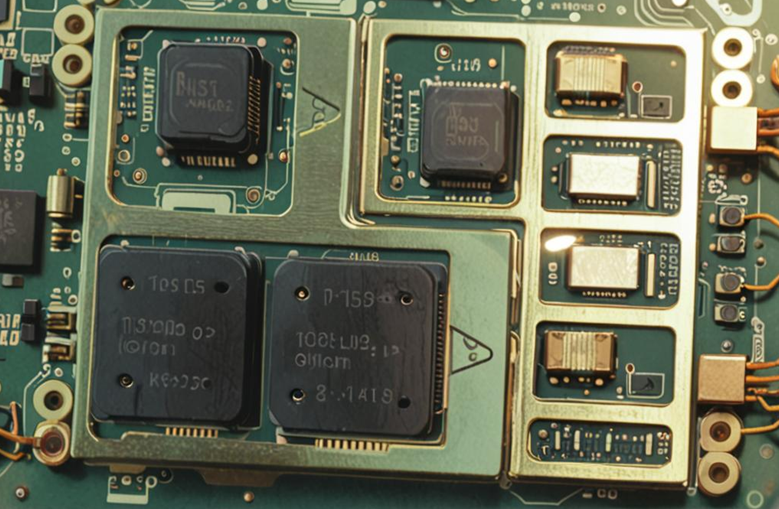
客户产品亮点介绍:
产品名称:无人机控制板 & 遥控器板
核心需求:客户的无人机产品中,搭载了一块尺寸为13*13mm的BGA芯片,该芯片需通过底部填充胶进行加固,以应对极端环境下的挑战。芯片间距仅为0.4mm,要求填充材料具有极高的精度和适应性。
性能要求:固化后的填充胶需能承受-40°C至120°C以上的温度变化,确保无人机在各种气候条件下均能正常工作。
用胶需求与严格测试标准:
耐高低温性能:确保填充胶在极端温度范围内保持稳定的物理和化学性质,不影响无人机的整体性能。
抗冲击与可靠性:增强BGA芯片与基板之间的连接强度,提高产品的抗冲击能力和长期使用的可靠性。
精细填充能力:针对0.4mm的微小间距,填充胶需具备出色的流动性和渗透性,确保完全填充芯片与基板之间的所有缝隙。
汉思新材料专业解决方案:
推荐产品:HS711底部填充胶
产品特点:
卓越耐温性:满足-40°C至120°C以上的温度变化要求,确保无人机在各种环境下稳定运行。
高精度填充:专为微小间距设计,轻松渗透并完全填充芯片与基板间的缝隙,提升连接强度。
高可靠性:经过严格测试,确保填充后的BGA芯片具有出色的抗冲击能力和长期使用的稳定性。
现场测试验证:我们已携带HS711样品至客户工厂进行实地测试,成功应用于无人机控制板和遥控器板,测试结果显示功能一切正常,性能卓越。
汉思新材料,以专业技术和优质产品,为您的无人机产品提供坚实的后盾支持,共同探索无人机技术的无限可能。
-
遥控器
+关注
关注
18文章
878浏览量
72676 -
BGA芯片
+关注
关注
1文章
35浏览量
14025 -
无人机
+关注
关注
237文章
11399浏览量
196836
发布评论请先 登录
四轴无人机控制核心丨笙泉新品(CGF062A) 融合MCU与MDE优势, 实现稳定高效的飞行表现
空天慧眼:HDMI输出转接板适配索尼FCB系列无人机新方案
LR1121 航模遥控应用方案芯片
汉思新材料:电路板IC加固环氧胶选择与应用

中科亿海微SoM模组——激光雷达控制板

BGA底部填充胶固化异常延迟或不固化原因分析及解决方案




 无人机控制板与遥控器板BGA芯片底部填充胶加固方案
无人机控制板与遥控器板BGA芯片底部填充胶加固方案













评论