电子发烧友网报道(文/吴子鹏)根据相关媒体报道,台积电拒绝为三星Exynos处理器提供代工服务,理由是台积电害怕通过最先进的工艺代工三星Exynos处理器可能会导致泄密,让三星了解如何提升最先进制程工艺的良率,而这恰恰是三星在先进制程方面的最大痛点。
据悉,三星System LSI部门已经改变了此前晶圆代工独自研发的发展路线,转而寻求外部联盟合作,不过纵观全球晶圆代工产业,只有台积电、三星和英特尔三家企业具有尖端制程工艺代工的能力。而要发展最先进的3nm和2nm工艺,对于三星来说,可选的伙伴只有台积电。然而,X平台用户@Jukanlosreve透露,台积电不会与三星达成任何形式的合作以大规模生产Exynos系列处理器。台积电并不担心错失Exynos订单,该公司可以凭借其及时交货的优势收取溢价费用。
不过,从三星System LSI部门的动作来看,该公司并没有将宝都押在纯晶圆代工领域,而是将先进封装的权重大幅提升,作为该公司在高性能芯片制造领域突围的关键。
三星晶圆代工绕不过良率低这道坎
根据台湾供应链人士透露,目前台积电在2nm上进展非常顺利,良率已经达到了60%。N2平台能够带来效能提升15%,功耗降低30%。台积电研发和先进技术副总裁Geoffrey Yeap表示,N2是台积电“四年多的劳动成果”,首次采用新型全环绕栅极(GAA)纳米片晶体管,目前主要客户已经完成2nm IP设计并开始验证,台积电还开发出低阻值重置导线层、超高效能金属层间电容,以此对2nm制程工艺的能效进行提升。台积电2nm工艺预计2025年实现量产。
和台积电相比,三星在先进制程方面的进展就没那么顺利了。在当前最前沿的3nm工艺节点上,台积电的良率已经超过了80%,而三星最开始设定的首代和第二代3nm GAA技术的良率目标是70%。然而,根据目前的记录,三星第二代改良版3nm工艺平台的良率只有20%。
尽管面临挑战,三星并未放弃,他们一方面在改善3nm工艺,另一方面也在推进2nm工艺的研发。据悉,三星计划在2027年推出代号为Ulysses(尤利西斯)的2nm工艺Exynos处理器,该处理器将用于Galaxy S27系列。
不过,如果良率问题持续无法得到解决,三星在代工和芯片上的计划都可能搁浅,搭载非高通芯片的三星旗舰机可能成为历史。
三星选择提升先进封装权重
根据韩媒此前的报道,三星正计划“洗牌”先进半导体封装供应链,将从根本上重新评估材料、零部件和设备,影响开发到采购各个环节,从而进一步增强技术竞争力。据悉,三星优先关注设备,跳出现有合作关系的限制,准备在“性能”优先的原则下,重新选择供应商。据悉,三星甚至考虑退回已采购的设备,重新评估其是否符合新的标准。
在先进封装领域,三星的策略开始由“一对一”联合开发计划(JDP)模式转为“一对多”的 JDP 模式,即同时与多家供应商合作开发,以寻求更先进的技术和设备,预计该计划最早将于2025年实施。
在去年的年度股东大会上,三星联席首席执行官庆桂显表示,三星电子在先进封装产业的投资成果将从2024年下半年开始真正显现。2024年三星大举进军先进封装领域,预计2024年先进封装能够为三星带来1亿美元的营收。
目前,三星在先进封装方面有很多代表性技术,比如I-Cube 2.5D封装、X-Cube 3D IC和玻璃基板等。其中,三星I-Cube 2.5D封装通过并行水平芯片放置防止热量积存并扩展性能。三星以硅通孔(TSV)和后道工序(BEOL)为技术基石,整合两个以上的(不同)芯片,使之完美协作,让系统发挥1+1 > 2的功能。
I-Cube 2.5D封装包括I-Cube S、I-Cube E和H-Cube 三种产品形态。I-Cube SI-CUBE S 是一种异构技术,将一块逻辑芯片与一组高带宽存储器 (HBM) 裸片水平放置在一个硅中介层上,兼具高带宽和高性能的优势,即使在大中介层下,仍具有出色的翘曲控制能力;I-Cube E 技术采用硅嵌入结构,不仅具有硅桥的精细成像优势,也同时拥有PLP的技术特点:大尺寸、无硅通孔 (TSV) 结构的RDL 中介层;H-Cube 是一种混合基底结构,将精细成像的 ABF(Ajinomoto Build-up Film)基底和 HDI(高密度互连)基底技术相结合,可在 I-Cube 2.5D 封装中实现较大的封装尺寸。
三星3D IC封装通过垂直堆叠的方式大幅地节省了芯片上的空间,主要包括X-Cube(微凸块)和X-Cube(铜混合键合)两种形态,前者通过增加每个堆栈的芯片密度,进一步提升 X-CUBE 的速度或性能;后者与传统的芯片堆叠技术相比,具有极大的布局灵活性优势。
除了在架构上创新,在材料上三星也在关注玻璃基板。此前有消息人士称,三星计划于2026年大规模量产玻璃基板先进封装。该公司正在悄然布局用于FOPLP(面板级封装)工艺的半导体玻璃基板,相较于塑料基板,玻璃基板以其优异的导热性和稳定性,具有成本低、电学性能优越以及低翘曲率等优势,被视为下一代封装材料的理想选择。不过,玻璃基板也面临着高精度通孔、高质量金属填充、高密度布线和键合技术等方面的技术挑战,如果不能妥善解决,也会演变成为先进封装的良率缺陷。
结语
从目前的情况来看,三星在先进制程方面已经深陷低良率的漩涡,且没有什么有效的应对手段,这导致三星的巨额投资无法变现。目前,寻求外部合作的三星,实际上可选对象只有台积电,但台积电很显然不会参与这项风险奇高的商务合作。在后续发展上,三星在先进封装方面的布局有可能成为重点,成为Chiplet技术发展的重要力量,毕竟三星除了有制造、封装,该公司的HBM技术也处于全球第一梯队。
-
芯片
+关注
关注
463文章
54463浏览量
469582 -
台积电
+关注
关注
44文章
5812浏览量
177080 -
三星
+关注
关注
1文章
1782浏览量
34465
发布评论请先 登录



 被台积电拒绝代工,三星芯片制造突围的关键在先进封装?
被台积电拒绝代工,三星芯片制造突围的关键在先进封装?






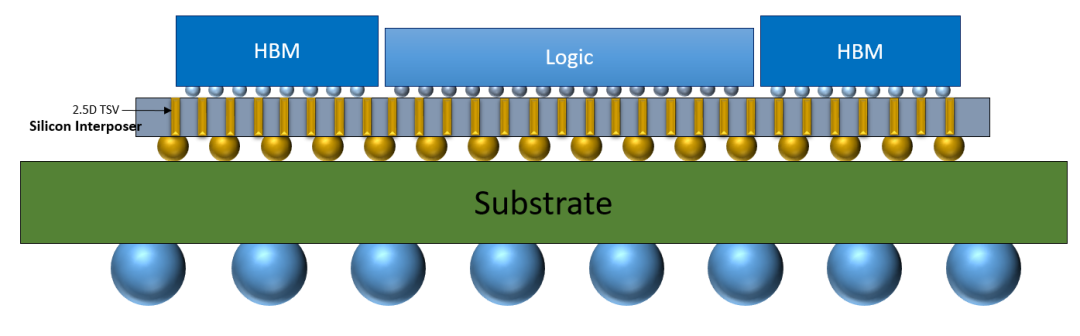



评论