文章来源:学习那些事
原文作者:新手求学
RDL是一层布线金属互连层,可将I/O重新分配到芯片的不同位置。
Redistribution layer(RDL)是将半导体封装的一部分电连接到另一部分的铜金属互连。RDL以线宽和间距来衡量,线宽和间距指的是金属布线的宽度和间距。高端 RDL的线宽可能为2μm甚至更小。
RDL是一层布线金属互连层,可将I/O重新分配到芯片的不同位置,并可以更轻松地将Bump添加到芯片上。
RDL是由Cu和绝缘层构成的布线层,用于Fan-Out、2.5D、3D等封装。
为什么要用到RDL呢?
RDL优化了I/O焊盘的放置,这些焊盘原本位于芯片四周。通过RDL将这些焊盘重新定位到芯片布局中更有利的位置。
比如在Fan-In封装里,处理细间距以及多I/O数量时遇到了很大的困难,为突破这种限制,Fan-out封装出现了,最大的区别就是运用RDL延展出芯片制定焊盘。

图1 Fan-In Package(绿色为芯片)

图2 Fan-Out Package(绿色为芯片)
通过图1和图2的对比可以看出,图2的优势在于I/O数量可以延伸到芯片以外,增加了更多的I/O数量,这一优势的功劳就是RDL的使用,当然Fan Out的成功不仅仅只是RDL的使用。Fan Out封装可以集成多个芯片,运用RDL实现功能上的互连,具体RDL的布局实物图见图3.
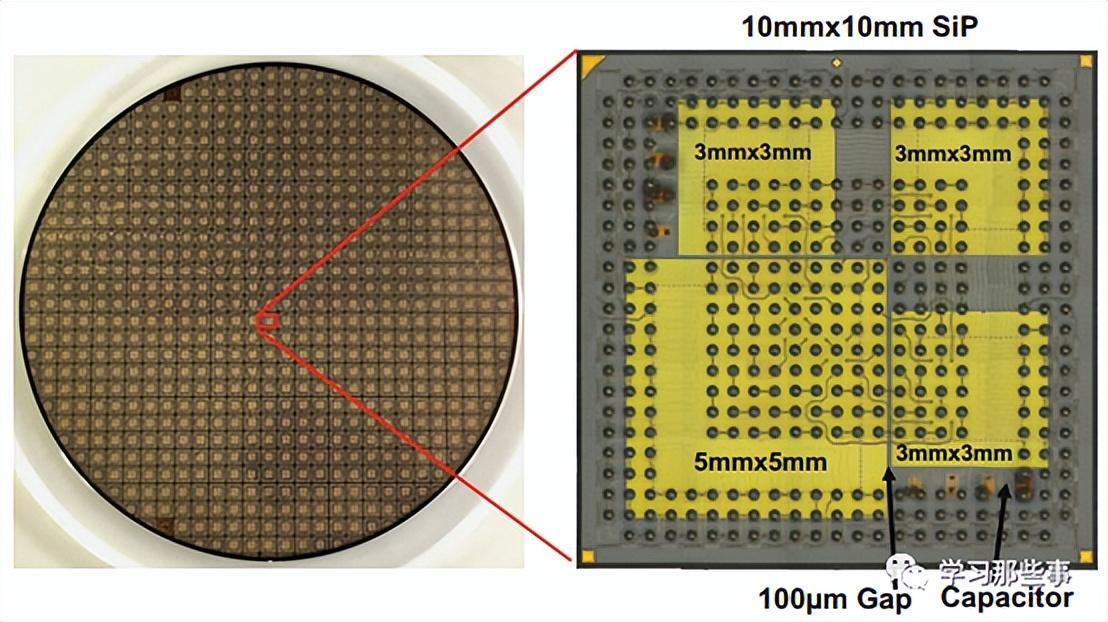
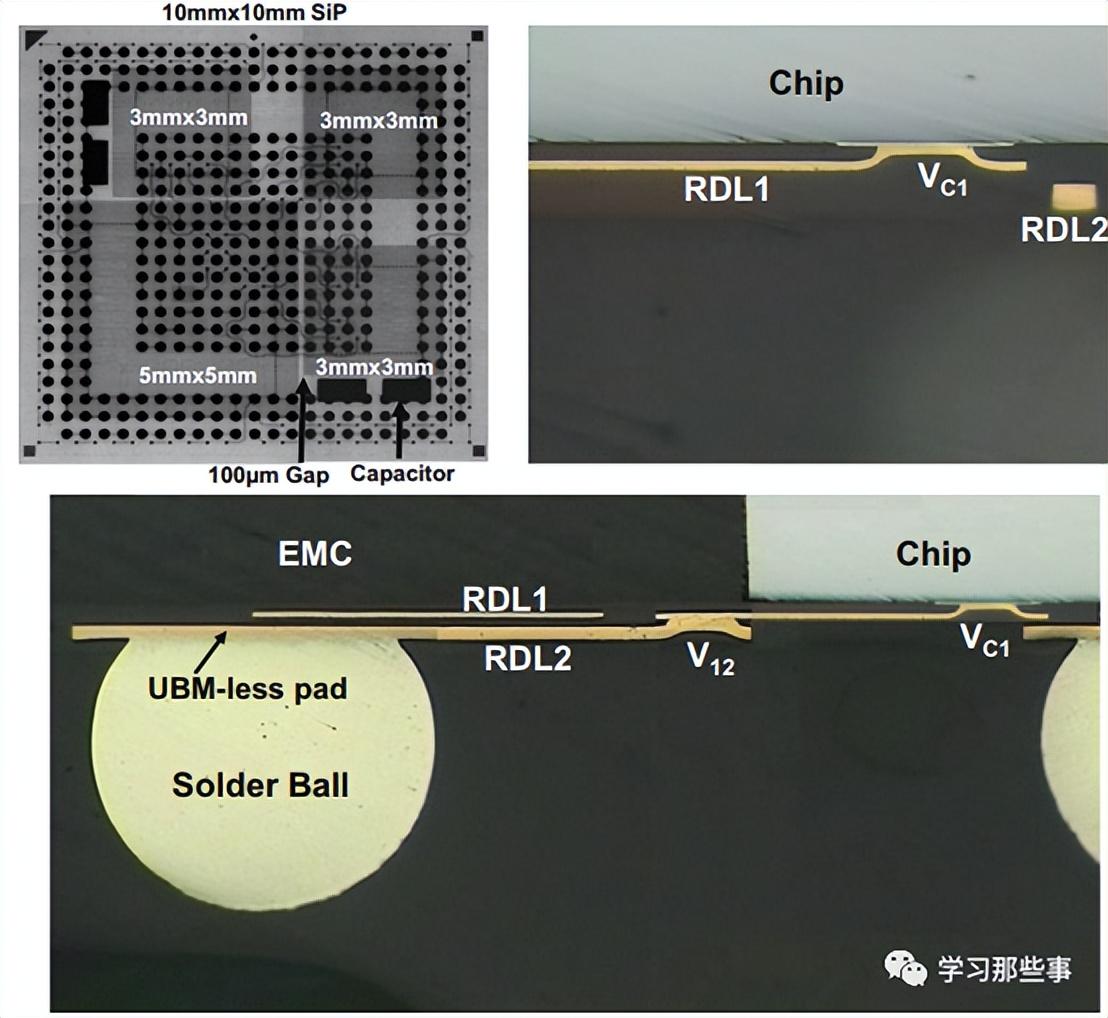
图3 Fan-Out Package
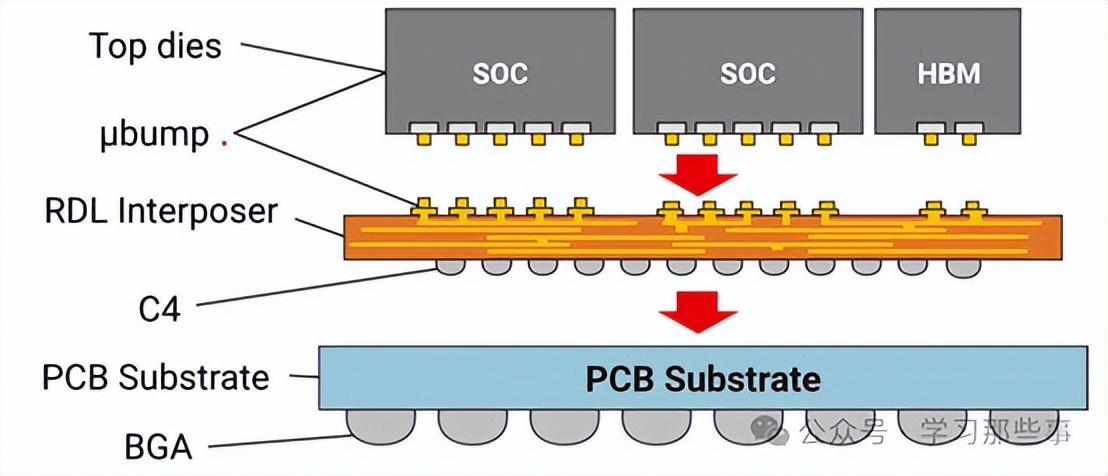
图4 RDL的Interposer使用
所以RDL的作用犹如它的翻译一样,叫重分布层或再布线层。就是通过重新布线来实现焊盘及线路的最佳使用,以实现更紧凑的封装设计。
【近期会议】
10月30-31日,由宽禁带半导体国家工程研究中心主办的“化合物半导体先进技术及应用大会”将首次与大家在江苏·常州相见,邀您齐聚常州新城希尔顿酒店,解耦产业链市场布局!https://w.lwc.cn/s/uueAru
11月28-29日,“第二届半导体先进封测产业技术创新大会”将再次与各位相见于厦门,秉承“延续去年,创新今年”的思想,仍将由云天半导体与厦门大学联合主办,雅时国际商讯承办,邀您齐聚厦门·海沧融信华邑酒店共探行业发展!诚邀您报名参会:https://w.lwc.cn/s/n6FFne
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。联系邮箱:viviz@actintl.com.hk, 电话:0755-25988573
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54428浏览量
469346 -
先进封装
+关注
关注
2文章
562浏览量
1062
发布评论请先 登录
长电科技亮相先进封装开发者大会机器人与汽车芯片专场

先进封装时代,芯片测试面临哪些新挑战?
键合玻璃载板:半导体先进封装的核心支撑材料
当芯片变“系统”:先进封装如何重写测试与烧录规则
半导体先进封装“重布线层(RDL)”工艺技术的详解;
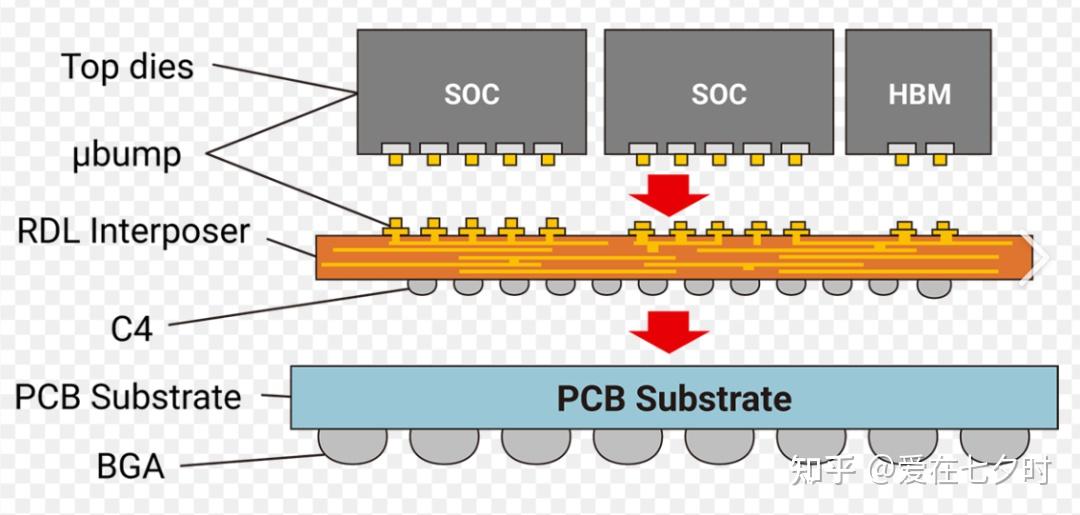



 芯片先进封装里的RDL
芯片先进封装里的RDL




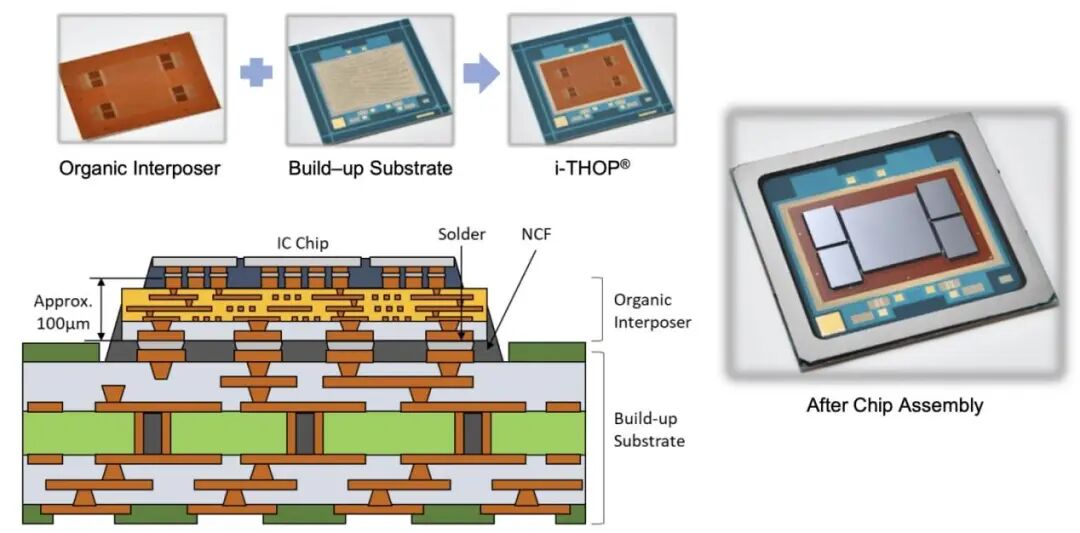






评论