芯片封装的定义与重要性
芯片是现代电子系统的核心组件,其功能的实现离不开与外部电路的连接。芯片封装作为芯片制造的最后环节,起着至关重要的作用。芯片主要以硅为载体,具有高精度的集成功能,但由于硅材料易脆裂,芯片本身无法直接与印刷电路板(PCB)形成电互连。
封装技术通过使用合适的材料和工艺,对芯片进行保护,同时调整芯片焊盘的密度,使其与PCB焊盘密度相匹配,从而实现芯片与PCB之间的电连接。
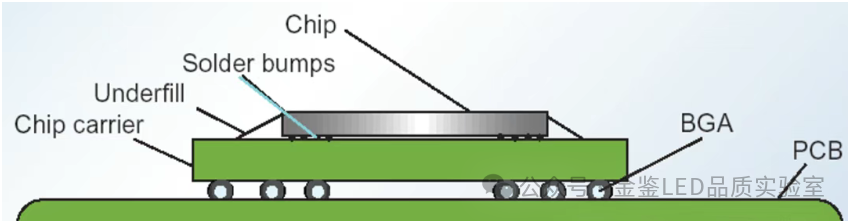
封装技术的发展与芯片集成度的提升密切相关。在过去50多年中,芯片集成度按照摩尔定律持续提高,其关键尺寸急速缩小,而PCB的关键尺寸缩小速度相对较慢,导致芯片与PCB之间的尺寸差异不断扩大。
封装技术作为芯片与PCB之间的“桥梁”,必须不断演进,以适应芯片集成度和性能的提升需求。
以存储芯片为例,其封装技术从早期的双列直插式封装(DIP)发展到小尺寸J形引脚封装(SOJ)、薄型小尺寸封装(TSOP),再到芯片堆叠封装,以及近年来广泛应用的倒装芯片和硅穿孔(TSV)技术,封装技术的进步显著提升了存储容量、速度,并降低了功耗
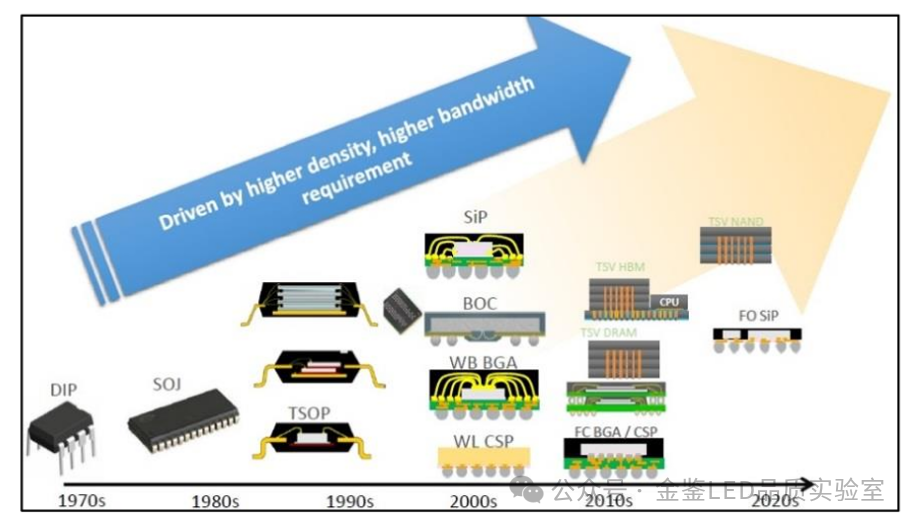
引线键合技术及其对封装技术的支撑
封装技术的核心功能之一是实现芯片与封装体之间、芯片与芯片之间的电互连。
引线键合(Wire Bonding)是封装工艺中最常用的电互连方式之一。其原理是通过加热、加压和超声等方式去除焊盘金属表面的氧化层和污染物,使金属细丝与焊盘金属面接触,达到原子间的引力范围,从而实现界面间原子扩散并形成焊接。
引线键合技术有三种主要方式:热压键合、超声键合和热超声键合。
目前,热超声键合工艺因其高效的焊接效果而被广泛应用于约90%的引线键合封装中。

在集成电路发展的早期阶段,由于芯片集成度较低,焊盘数量少且节距较大,引线键合技术成为芯片与封装体电互连的主要方式。当时的封装外形主要包括晶体管外形封装(TO)、双列直插式封装、小外形封装(SOP)、带引线的塑料芯片载体封装(PLCC)、方型扁平式封装(QFP)和方型扁平无引脚封装(QFN),芯片载体主要以铜制引线框架为主。
到上世纪90年代,以有机基板为载体的球栅阵列封装(BGA)逐渐成为主流。这种封装形式的出现,标志着封装技术从传统的引线框架向有机基板的转变。为了满足BGA封装初期的要求,引线键合技术不断创新,发展出了低弧线倒打、多层焊盘引线、堆叠芯片引线和多芯片间引线等技术,极大地提升了引线密度,从而推动了封装技术的进步。
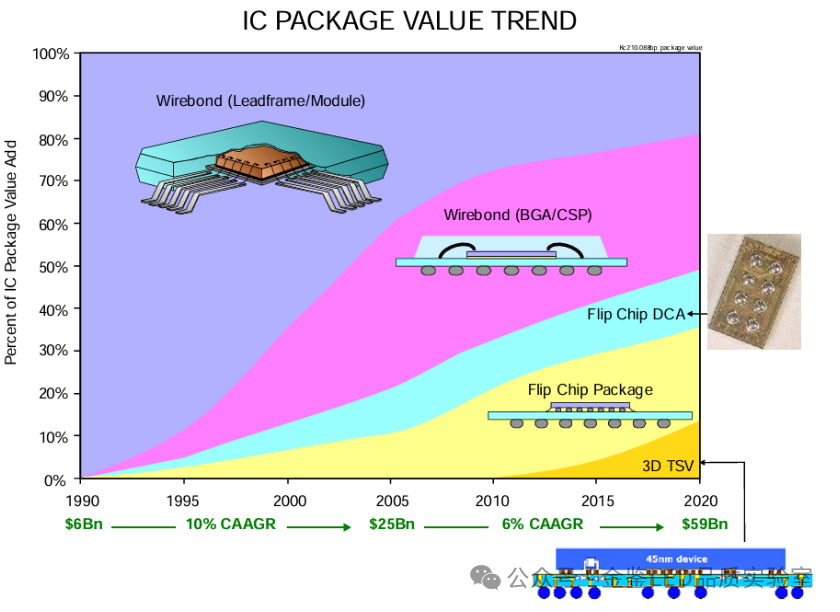
焊球凸块技术在先进封装中的应用
焊球凸块技术是近年来先进封装领域的重要技术之一。随着芯片集成度的进一步提高,芯片与封装体之间的连接密度需求不断增加,传统的引线键合技术逐渐无法满足高性能封装的要求。焊球凸块技术通过在芯片表面形成微小的焊球,实现了芯片与封装体之间的高密度、低电阻连接。
焊球凸块技术的核心优势在于其能够显著提高封装的引脚密度和信号传输速度。
与传统的引线键合相比,焊球凸块技术减少了连接路径的长度,降低了信号传输延迟,同时提高了封装的可靠性。此外,焊球凸块技术还可以与倒装芯片技术相结合,进一步优化封装结构,实现更小的封装尺寸和更高的集成度。
封装技术的未来发展趋势
随着芯片技术的不断发展,封装技术也在持续演进。未来,封装技术将朝着更高密度、更高性能、更低功耗和更小尺寸的方向发展。一方面,封装技术将与芯片制造技术深度融合,通过协同设计和优化,实现芯片与封装的无缝衔接。另一方面,封装技术将不断引入新的材料和工艺,如新型封装基板、纳米材料、光刻技术等,以满足高性能封装的要求。
同时,封装技术也将更加注重绿色环保和可持续发展。随着电子产品的普及和更新换代速度的加快,封装废弃物的处理成为一个重要的环境问题。未来的封装技术将更加注重材料的可回收性和环境友好性,以减少对环境的影响。
此外,封装技术还将与人工智能、物联网、5G通信等新兴技术相结合,为这些技术的发展提供有力支持。例如,在5G通信中,封装技术需要满足高频、高速信号传输的要求;在物联网中,封装技术需要实现低功耗、高可靠性和小型化的设计。
总结
芯片封装技术作为连接芯片与外部电路的关键环节,其发展与芯片集成度的提升密切相关。从早期的引线键合技术到现代的焊球凸块技术,封装技术不断演进,以满足芯片与封装体之间高密度、高性能的电互连需求。
未来,封装技术将继续朝着更高密度、更高性能、更低功耗和更小尺寸的方向发展,并与新兴技术相结合,为电子技术的进步提供有力支持。
-
芯片
+关注
关注
463文章
54686浏览量
471247 -
封装
+关注
关注
128文章
9395浏览量
149235 -
倒装芯片
+关注
关注
1文章
124浏览量
16886
发布评论请先 登录
什么是倒装芯片 倒装芯片技术的优点 倒装芯片封装工艺流程


倒装芯片和晶片级封装技术及其应用
倒装芯片技术触发了北美先进封装市场的进一步增长
倒装芯片(flip chip)算先进封装吗?未来发展怎么样?




 一文了解先进封装之倒装芯片技术
一文了解先进封装之倒装芯片技术











评论