后烘是指(post exposure bake-PEB)是指在曝光之后的光刻胶膜的烘烤过程。由于光刻胶膜还未显影,也就是说还未闭合,PEB也可以在高于光刻胶软化温度的情况下进行。前面的文章中我们在一般光刻过程文章中简单介绍过后烘工艺但是比较简单,本文就以下一些应用场景下介绍后烘的过程和作用。
化学放大正胶
机理
当使用“正常”正胶时,曝光完成后光反应也就完成了,但是化学放大的光刻胶需要随后的烘烤步骤。光反应在曝光期间开始并在后烘环节中完成。“化学放大”的过程发生在,曝光后反应产物的催化下,并在烘烤中完成。这使得较厚的光刻胶可以使用较低的曝光剂量进行曝光,且显影速度快。
后烘条件
没有进过后烘(PEB)工艺的光刻胶将不能显影或只能以极低的速度显影。后烘所需的时间和温度并不取决于光刻胶薄膜的厚度,而是取决于所使用的光刻胶的种类,通常在100-110℃的温度下持续几分钟。
图形反转胶和交联负胶机理
像AZ5214E这样的图形反转胶在反转工艺下需要在曝光后进行后烘工艺,来实现图形的反转,从而使曝光区域在显影后流下来。
交联型负胶电阻,如AZ5214负胶系列或AZ15nxt,需要在后烘环节来进行交联,交联反应是在曝光过程中开始的,被曝光区域结构在显影液中不被溶解而留下。
后烘条件
后烘所需的时间和温度并不取决于光刻胶薄膜的厚度,而是取决于所使用的光刻胶种类,通常为110-130℃,持续几分钟。
图形反转胶的烘烤温度越高,反转胶的结构在显影过程中越稳定,但反转胶在前面未曝光区域在后续的范曝光过程中的感光性越差,显影速度越慢。
负胶的后烘温度越高,交联程度越高,显影后的结构越稳定。然而,随着PEB温度的升高,未暴露的光刻胶区域的热交联增加,因此更难显影。需要注意的是,并不是所有的负胶都需要后烘工艺步骤,有些负胶在曝光过程中就能完成交联反应,因而无需后烘。
高反射率衬底上的正胶机理
在高反射率衬底上的单色光源曝光应用中,由于界面的反射,会在光刻胶内部形成干涉,这种干涉会导致显影时在光刻胶侧壁形成波浪条纹结构,即驻波效应。曝光后的后烘有助于光反应产物的扩散,如下图1所示,因此随后显影过程中的光刻胶结构具有更陡峭和更光滑的侧壁。
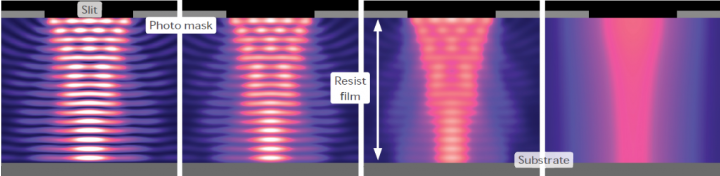
图1 高反衬底上的光强分布以及后烘后的光反应分布
后烘条件
所需的时间和温度并不取决于光刻胶薄膜的厚度,而是取决于所使用的光刻胶种类,通常为110-120℃,持续几分钟。
免责声明:文章来源汶颢 www.whchip.com 以传播知识、有益学习和研究为宗旨。转载仅供参考学习及传递有用信息,版权归原作者所有,如侵犯权益,请联系删除。
审核编辑 黄宇
-
光刻胶
+关注
关注
10文章
358浏览量
31914
发布评论请先 登录
颠覆开发流程!这家国内实验室用AI开发出光刻胶树脂

中国打造自己的EUV光刻胶标准!
光刻胶液体吸收行为的椭圆偏振对比研究

比肩进口!我国突破光刻胶“卡脖子”技术
光刻胶剥离工艺

光刻胶旋涂的重要性及厚度监测方法

国产光刻胶突围,日企垄断终松动
行业案例|膜厚仪应用测量之光刻胶厚度测量

针对晶圆上芯片工艺的光刻胶剥离方法及白光干涉仪在光刻图形的测量

用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量

低含量 NMF 光刻胶剥离液和制备方法及白光干涉仪在光刻图形的测量

金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量

减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量

光刻胶产业国内发展现状
光刻胶剥离液及其制备方法及白光干涉仪在光刻图形的测量




 光刻胶后烘技术
光刻胶后烘技术




评论