来源:台积电
封装使用硅光子技术来改善互连
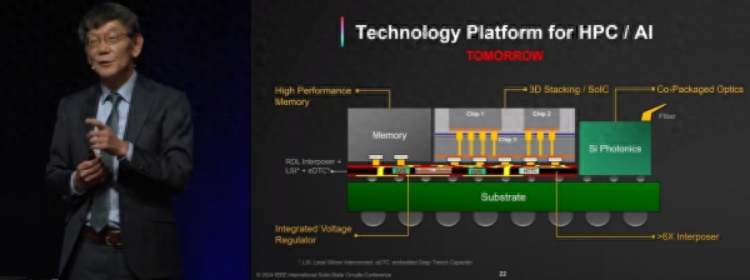
图片来源: ISSCC
芯片巨头台积电(TSMC)近日发布了用于高性能计算和人工智能芯片的新封装平台,该平台利用硅光子技术改善互连。
台积电业务开发副总裁 Kevin Zhang在 ISSCC 2024 IEEE 国际固态电路大会上表示,开发这项技术是为了提高人工智能加速器的性能,可以通过增加更多高带宽内存和芯片来实现。
要增加更多的 HBM 和芯片组,还必须增加更多的内插器和片上基板,这可能会导致互连和电源方面的问题。
Zhang解释说,台积电的新封装技术通过硅光子技术,使用光纤代替 I/O 传输数据。这位副总经理没有提及该技术的商业化时间。
该技术的另一个有趣因素是,异质芯片堆叠在基础芯片上。
封装技术将在芯片上应用混合键合技术,以最大限度地提高 I/O 性能。芯片和 HBM 将安装在中间件上,很可能是本地硅中间件。
Zhang还表示,封装将使用集成稳压器来处理电源问题。
这位副总裁说,目前最先进的芯片可以容纳多达 1000 亿个晶体管,但对于人工智能来说,3D 封装技术可以将晶体管数量增加到 1 万亿个。
*此篇编译文章未经允许,请勿转载。
审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装
+关注
关注
128文章
9329浏览量
149039 -
AI
+关注
关注
91文章
41060浏览量
302568 -
HPC
+关注
关注
0文章
350浏览量
25071
发布评论请先 登录
相关推荐
热点推荐
台积电如何为 HPC 与 AI 时代的 2.5D/3D 先进封装重塑热管理
随着半导体封装不断迈向 2.5D、3D 堆叠以及异构集成,热管理已成为影响性能、可靠性与量 产能力的关键因素之一。面向高性能计算(HPC)和人工智能(AI)的

台积电计划建设4座先进封装厂,应对AI芯片需求
电子发烧友网报道 近日消息,台积电计划在嘉义科学园区先进封装二期和南部科学园区三期各建设两座先进封装厂。这4座新厂的建成,将显著提升
黑芝麻智能推出面向机器人产业的SesameX多维智能计算平台
11月20日,“多维进化,智赋新生”2025年黑芝麻智能机器人平台产品发布会在上海成功举行,正式推出面向机器人产业的SesameX多维智能计算平台,这是业界首个机器人商业化专属部署平台
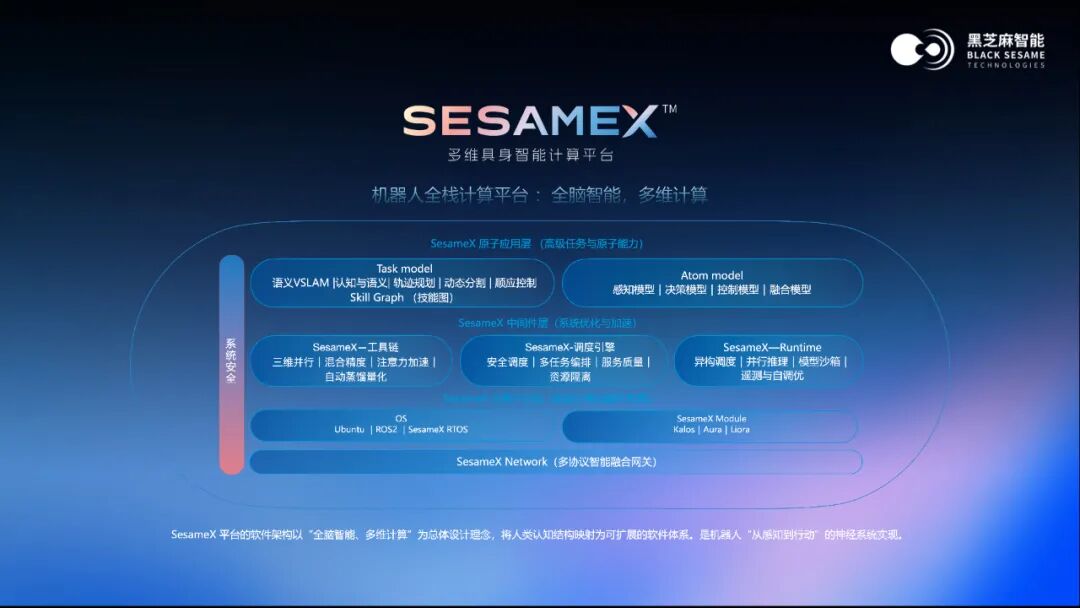
NVIDIA推出面向语言、机器人和生物学的全新开源AI技术
NVIDIA 秉持对开源的长期承诺,推出了面向语言、机器人和生物学的全新开源 AI 技术,为构建开源生态系统做出贡献,扩展 AI 的普及并推
曙光存储推出面向金融的可信AI存储
近日,曙光存储推出面向金融的可信AI存储,助力金融行业高效、安全、稳定地使用关键业务敏感数据。该方案基于全球领先的集中式全闪存储FlashNexus,构建“真存算分离”架构,保障金融可信AI应用,满足金融行业的
Cadence AI芯片与3D-IC设计流程支持台积公司N2和A16工艺技术
上市周期,以满足 AI 和 HPC 客户的应用需求。Cadence 与台积公司在 AI 驱动的 EDA、3D-IC、IP 及光子学等领域展开
化圆为方,台积电整合推出最先进CoPoS半导体封装
电子发烧友网综合报道 近日,据报道,台积电将持续推进先进封装技术,正式整合CoWoS与FOPLP,推出新一代CoPoS工艺。 作为
台积电正面回应!日本芯片厂建设不受影响,仍将全速推进
近日,有关台积电放缓日本芯片制造设施投资的传闻引发业界关注。据《华尔街日报》援引知情人士消息,台积
美国芯片“卡脖子”真相:台积电美厂芯片竟要运回台湾封装?
美国芯片供应链尚未实现完全自给自足。新报告显示,台积电亚利桑那州工厂生产的芯片,因美国国内缺乏优质封装
力旺NeoFuse于台积电N3P制程完成可靠度验证
力旺电子宣布,其一次性可编程内存(One-Time Programmable, OTP)NeoFuse已于台积电N3P制程完成可靠度验证。N3P制程为台



 台积电推出面向HPC、AI芯片的全新封装平台
台积电推出面向HPC、AI芯片的全新封装平台


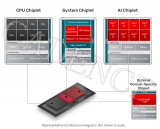




评论