文章来源:芯云知
原文作者:金末
优化硅的形态与沉积方式是半导体和MEMS工艺的关键,LPCVD和APCVD为常见的硅沉积技术。
硅的形态
在半导体和MEMS工艺中,硅有三种形态,分别是单晶硅、多晶硅和非晶硅。区分这三者,主要看晶格结构:单晶硅晶格排列长程有序,短程有序;多晶硅晶格排列长程无序,短程有序;非晶硅长程无序,短程无序。通过XRD晶向分析即可快速区分硅的形态,一个尖峰的是单晶,多个尖峰的是多晶,馒头峰的是非晶。非晶硅和多晶硅可以在580°C实现转换,而单晶硅很难与多晶硅或者非晶硅相互转换。

图 硅的三种形态晶格示意图
硅的沉积方式
硅的沉积方式包括物理气相沉积和化学气相沉积,但在半导体和MEMS实际工艺流程中,几乎采用的都是化学气相沉积法。单晶硅薄膜主要通过MOCVD(金属氧化物化学气相沉积)制备外延层;非晶硅由于是低温工艺,常采用PECVD(等离子体增强化学气相沉积);多晶硅则可以采用PECVD、APCVD(常压化学气相沉积)和LPCVD(低压化学气相沉积),若采用PECVD则需要一步退火,将非晶转多晶。

表 不同化学气相沉积的优缺点
LPCVD沉积多晶硅
工艺线上LPCVD炉管为大型卧式炉,其炉内温度从580°C至650°C且气压从100至400mTorr。最常用的气源是硅烷(SiH4),硅烷在一定温度下实现热分解,生成硅。对于典型LPCVD工艺(例如200mTorr),非晶到多晶的转变温度大约是580°C,一旦超过转变温度,淀积生成多晶硅薄膜。在625°C时,晶粒是大且柱状的,晶向主要是硅(110);而在650°C至700°C之间,晶向(100)占主导地位。未掺杂的多晶硅电阻率很高,通常在10E6~10E8Ω·cm。多晶硅降低电阻率的办法有2种,固态源扩散和离子注入,已了解的高剂量掺杂,多晶硅导电薄膜方阻低于10Ω/□。

图 LPCVD炉示意图
采用LPCVD沉积多晶硅,主要的优势在于可以得到致密的、应力低的、台阶覆盖性好的和片内外均匀性好的高质量膜层。目前,产业上LPCVD多晶硅的材料特性为杨氏模量约150GPa,拉伸强度约1.2GPa,残余应力可以做到±50MPa。多晶硅膜层应力的情况与温度相关,不管淀积压强多大,在温度低于580°C时,应力是压应力。在600°C,应力是中等或较大张应力,但当淀积温度为620°C时,明显地转变为压应力。同时,LPCVD可以实现批量工艺,商用LPCVD炉可以一次容纳100片晶圆。
不足的是LPCVD沉积多晶硅,单次厚度最高2μm,高于则需要分次沉积,但是多次后也会造成膜层应力过大剥离脱落。如果要生长超过10μm多晶硅,如加速度计中的质量块,需要采用APCVD工艺,APCVD需要衬底温度>1000°C及压强>50Torr,沉积速率可达到1μm/min。由于APCVD的高温会使生成多晶硅与下层的SiO2层分离,一般也需要采用LPCVD沉积一层百纳米以下的多晶硅去作为缓冲层(种子层)。
审核编辑:汤梓红
-
多晶硅
+关注
关注
3文章
250浏览量
30761 -
半导体
+关注
关注
339文章
31560浏览量
267900 -
mems
+关注
关注
129文章
4565浏览量
199975
原文标题:为什么多晶硅在MEMS里通常采用LPCVD沉积?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
《炬丰科技-半导体工艺》硅纳米柱与金属辅助化学蚀刻的比较
硅单晶(或多晶)薄膜的沉积
MEMS与传统CMOS刻蚀与沉积工艺的关系
晶片表面沉积氮化硅颗粒的沉积技术




 硅的形态与沉积方式
硅的形态与沉积方式

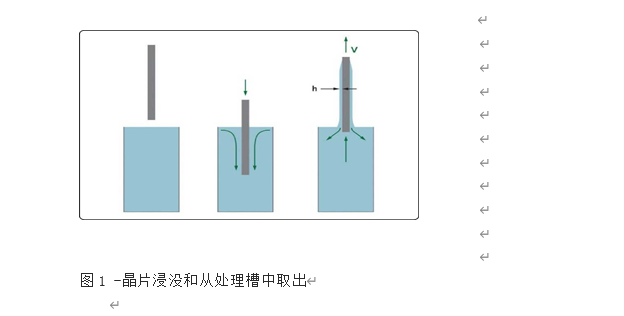
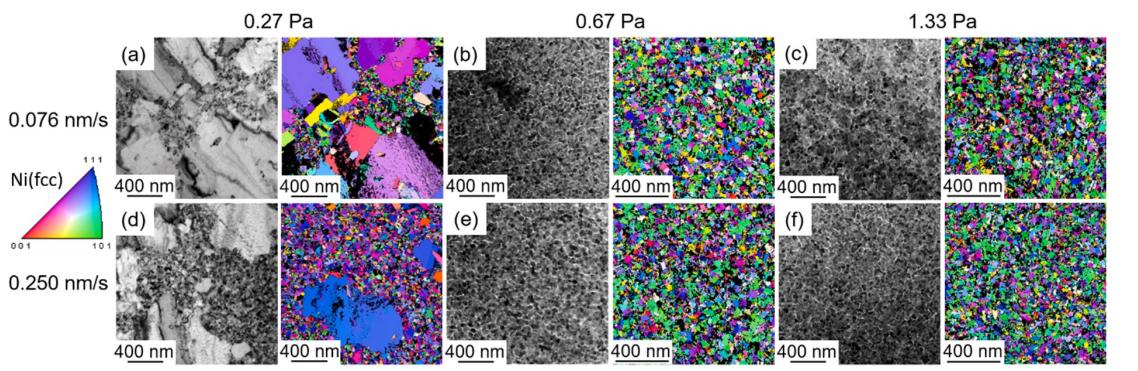







评论