当提到晶振(Crystal Oscillators)时,我们常常不太了解它们是如何制造的。晶振是电子设备中的关键组件,用于产生高精度的电子信号和时钟频率。下面,我们将深入了解晶振的制造过程,从原材料准备到最终产品的出货,详细描述每一个步骤。
第一步:原材料准备
制造晶振的第一步是选择高纯度的石英晶体作为原材料。这些晶体必须经过严格的质量控制,通常要求纯度达到99.999%以上。原材料可以是石英粉末或石英石块。
第二步:生长石英晶体
- 生长室设定:生长室内的温度通常保持在1,700至2,000摄氏度,同时维持高压环境,通常在数千大气压。
- 硅源气体:硅源气体,如三氯化硅(SiCl3),分解并释放硅原子。
- 生长时间:控制生长时间,以达到所需的尺寸。
第三步:切割晶体
- 切割工具:使用高精度的金刚石切割刀片或线切割工具。
- 切割速度:控制切割速度,通常以毫米/分钟为单位。
- 切割润滑条件:确保切割过程中的润滑条件以减少摩擦和热量。
第四步:抛光
- 抛光工艺:使用化学机械抛光(CMP)或机械抛光设备。
- 抛光时间:控制抛光时间,通常以分钟为单位。
- 抛光液:使用高质量的抛光液,通常是硅氧烷或氢氧化铝。
第五步:清洗
- 清洗溶液:使用超纯水和高纯度的化学溶剂。
- 清洗时间和温度:控制清洗时间和温度以确保彻底清除表面污染。
第六步:植入金属电极
- 植入条件:控制离子植入或物理沉积条件,包括能量、电流和金属源。
- 植入深度:控制植入深度以确保金属电极与石英晶片表面结合。
第七步:光刻和蚀刻
- 光刻掩膜设计:设计光刻掩膜以定义电路和引脚的图案。
- 蚀刻条件:使用化学或物理腐蚀来去除不需要的材料,控制腐蚀时间和化学溶液。
第八步:金属沉积
- 沉积工艺:控制金属沉积过程,包括金属源、温度和气氛。
- 沉积时间:控制沉积时间以形成所需的金属层厚度。
第九步:终端制造
- 引脚和连接制造:使用工艺来制造引脚和连接,通常涉及蚀刻和金属沉积。
第十步:测试和校准
- 测试设备:使用频率测试设备和温度控制设备。
- 校准条件:如果需要,进行校准以确保频率和稳定性满足规格。
第十一步:封装
- 封装材料和设计:选择封装材料和设计封装以提供机械支撑和保护。
- 引脚连接:将晶片和引脚连接到封装腔体。
第十二步:质检和品控
- 质检标准:根据性能和品质标准进行检查,包括外观、尺寸和性能测试。
第十三步:最终测试
- 测试条件:使用频率测试设备进行最终测试以验证性能和频率稳定性。
第十四步:包装和出货
- 包装材料:使用适合运输和存储的包装材料。
- 出货条件:准备晶片以供最终的电子设备制造商或应用领域使用。
这些步骤确保了晶振的高质量生产,每一步都是必不可少的,以确保性能和稳定性。晶振在电子设备中发挥着关键作用,提供了高精度的时钟信号和频率控制,使得现代电子设备能够顺利运行。这个看似简单的小组件背后蕴含着精密的科学和工程。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31222浏览量
266441 -
振荡器
+关注
关注
28文章
4191浏览量
143163 -
设备
+关注
关注
2文章
4882浏览量
73850
发布评论请先 登录
相关推荐
热点推荐
芯片制造中的硅片表面细抛光与最终抛光加工工艺介绍
硅片表面细抛光作为实现超精密加工的关键工序,其核心在于通过精准调控抛光布材质、抛光液成分及工艺参数,在5-8μm的加工量范围内实现局部平整度≤10nm、表面粗糙度≤0.2nm的极致控制

半导体精密划片机:QFN封装切割工序的核心支撑
中,切割工序作为衔接封装与成品测试的关键环节,直接决定了芯片的良率、尺寸精度及可靠性,半导体精密划片机则以其微米级的精准控制能力,成为该工序不可或缺的核心设备,为

氩离子的抛光与切割技术
氩离子抛光和切割技术是现代微观分析领域中不可或缺的样品制备手段。该技术通过利用宽离子束(约1毫米宽)对样品进行切割或抛光,能够精确地去除样品表面的损伤层,并暴露出高质量的分析区域,为后
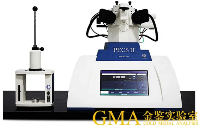
石英晶体频率全指南:从基础到选型
石英晶体的频率与稳定度,直接决定系统的时间基准、相位噪声与同步能力。本文从工程视角梳理频率稳定度、温度特性、相位噪声/抖动与老化等核心概念,并结合 GNSS/5G/工业控制等典型应用,

金刚石线锯切割技术对蓝宝石晶体切面表面形貌优化研究
随着LED技术的迅速发展,蓝宝石晶体作为GaN芯片的主要衬底材料,其市场需求不断增加。金刚石线锯技术在蓝宝石晶体切割中得到了广泛应用,蓝宝石晶体的高硬度也给加工带来了挑战,

碳化硅晶圆特性及切割要点
01衬底碳化硅衬底是第三代半导体材料中氮化镓、碳化硅应用的基石。碳化硅衬底以碳化硅粉末为主要原材料,经过晶体生长、晶锭加工、切割、研磨、抛光、清洗等制造过程后形成的单片材料。按照电学性

半导体哪些工序需要清洗
半导体制造过程中,清洗工序贯穿多个关键步骤,以确保芯片表面的洁净度、良率和性能。以下是需要清洗的主要工序及其目的: 1. 硅片准备阶段 硅片切割后清洗 目的:去除切割过程中残留的金属碎
晶片机械切割设备的原理和发展
通过单晶生长工艺获得的单晶硅锭,因硅材质硬脆特性,无法直接用于半导体芯片制造,需经过机械加工、化学处理、表面抛光及质量检测等一系列处理流程,才能制成具有特定厚度和精度要求的硅片。其中,针对硅锭的晶片




 石英晶体的生长切割抛光等工序
石英晶体的生长切割抛光等工序




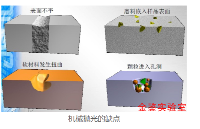





评论