来源:云天半导体
厦门云天半导体继九月初8&12吋 “晶圆级封装与无源器件生产线”正式通线后,经过团队的不懈努力, 8英寸晶圆Fine Pitch光刻工艺开发终破2/2um L/S大关;
以下为部分工艺条件及成果展示:
胶厚均匀性 3.4%
CD开口均匀性 3%
在Test Vehicle光罩下,测试了长线条&短线条,结果不论是在正性光阻还是负性光阻下, 2um的L/S下的线条都是完整而清晰的,而且没有任何显影不洁或过显的外观异常;
2um 短线条(光刻后)
2um长线条-负胶(光刻后)
2um长线条-正胶(光刻后)
SEM切片效果图如下,胶厚:3.308um,CD上开口:2.272um,CD下开口:1.716um,侧壁垂直度约85.2°;
2um孔径SEM
2um长线条经过电镀及种子层刻蚀后,线宽及线距均在工艺管控范围内,未出现线路Peeling及断短路等外观异常;
2um长线条-负胶(电镀后)
2um长线条-负胶(PVD刻蚀后)
厦门云天半导体目前量产化最小L/S为10/10um,工程样品能力最小L/S为7/7um,2/2um的L/S工艺的成功开发是二期通线后的一次重大突破。目前2/2um的L/S工艺还需进一步的开拓验证,为后续量产化的导入做足准备。厦门云天半导体将持续追求“创新、卓越、合作、奋斗”的精神,不断挑战极限、勇攀高峰!
审核编辑黄昊宇
-
光刻
+关注
关注
8文章
367浏览量
31404
发布评论请先 登录
AI需求飙升!ASML新光刻机直击2nm芯片制造,尼康新品获重大突破

新型HERB技术如何重塑芯片蚀刻工艺

【新启航】玻璃晶圆 TTV 厚度在光刻工艺中的反馈控制优化研究

光刻胶剥离工艺

详解超高密度互连的InFO封装技术

光刻胶旋涂的重要性及厚度监测方法

新能源电池深孔极片测量突破:新启航激光频率梳技术消除光学遮挡,达 2um 级精度

1um 以下的光刻深度,凹槽深度和宽度测量

3D 共聚焦显微镜 | 芯片制造光刻工艺的表征应用

MEMS制造领域中光刻Overlay的概念
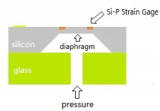
减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量

光刻工艺中的显影技术
激光划刻工艺革新:20.24%高效钙钛矿组件的长期稳定性突破




 厦门云天Fine Pitch光刻工艺突破2um L/S
厦门云天Fine Pitch光刻工艺突破2um L/S





评论