我们测量了硅化物膜(CoSi2、NiSi2、TiSi2和WSi)的溅射刻蚀速率,并研究了离子能量的依赖性,发现它们与二氧化硅薄膜的相对溅射刻蚀速率几乎与溅射离子能量无关,从相对溅射蚀刻速率和计算的Ni和Si的截面比率来估计Ni的表面结合能,并发现由相对溅射刻蚀速率决定的表面结合能与众所周知的值一致。
薄膜(Cosi2,Nisi2,Tisi2,WSi)通过溅射方法在n型Si (100)基板上沉积约200 纳米,这些是由表面分析研究组提供的,它是多晶的,所以说一个的深度是用一个台阶总和来衡量的。
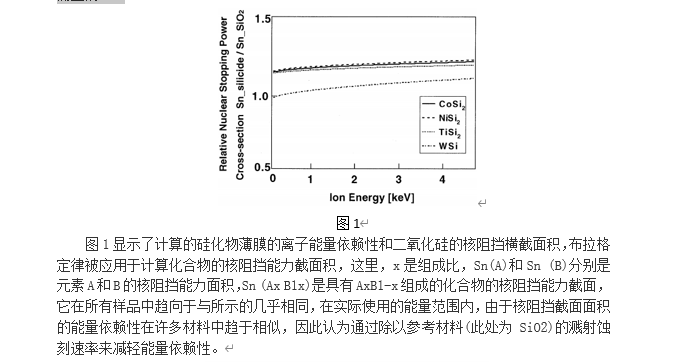
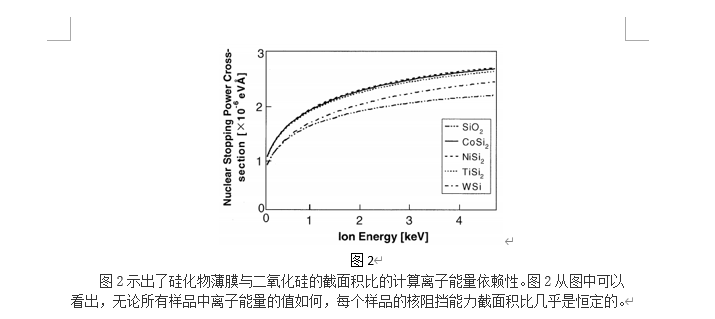

由本实验求出的镍对硅的相对溅射蚀刻速率的离子能量依赖性,用最小二乘法拟合核可阻止截面积比和溅射蚀刻速率,得到硅的离子能量依赖性,根据这些结果,可以认为通过实测不知道表面键能的物质、表面键能和原子密度已知的物质和相对溅射蚀刻速率,计算核阻止能截面积的比,可以推测某物质的表面键能。
测量溅射坑的深度,并且测量硅化物薄膜的溅射蚀刻速率,并且检查这些样品的相对蚀刻速率对SiO2的能量依赖性,可以发现,硅化物薄膜相对于SiO2的相对蚀刻速率具有很小的能量依赖性,如从核阻挡能力横截面积的计算中所预期的,并且能量依赖性放松是实际的优点,因为它可以估计尚未测量的能量下的值,此外,样品的近似表面结合能可以从相对溅射蚀刻速率和核阻挡能力截面比来估计。
审核编辑:汤梓红
-
测量
+关注
关注
10文章
5787浏览量
117125 -
硅薄膜
+关注
关注
0文章
6浏览量
6294 -
刻蚀
+关注
关注
2文章
226浏览量
13859
发布评论请先 登录
湿法刻蚀工作槽全解析:各槽分工协同,揭秘高效精准刻蚀的运作逻辑

磁控溅射工艺时间对金属及氧化物靶材溅射速率的影响:基于台阶仪的薄膜厚度表征

台阶仪应用丨电子束蒸镀与磁控溅射铝膜的厚度与均匀性对比研究

PTC热敏电阻直流磁控溅射工艺解析

一文详解磁控溅射技术

Salicide自对准硅化物工艺的定义和制造流程
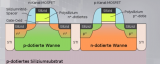
湿法蚀刻的最佳刻蚀条件是什么
晶圆湿法刻蚀技术有哪些优点

湿法刻蚀的工艺指标有哪些
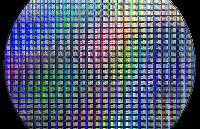
台阶仪测量膜厚的方法改进:通过提高膜厚测量准确性优化镀膜工艺

汽车玻璃透光率检测 | 制备高透光(Ag,Cu)/TiO₂汽车玻璃隔热膜




 硅化物膜的溅射刻蚀速率研究
硅化物膜的溅射刻蚀速率研究


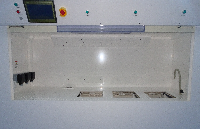




评论