经常听说,高端光刻机不仅昂贵而且还都是国外的,那么什么是光刻机呢?上篇我们聊了从原材料到抛光晶片的制成过程,今天我们就来聊聊什么是光刻~
第一步骤的晶体生长机晶片的制造,我们上篇已经聊过了。今天我们要聊的是光刻,我们先简单聊一聊硅的氧化(热氧化),刻蚀的话我们后面再讲。
硅的氧化
其中包含了在分立器件和集成电路制造过程中遇到的四类薄膜:热氧化膜、电介质膜、多晶硅膜及金属膜。图中,栅氧化层和场氧化层都是采用热氧化的方法生成,因为只有热氧化法能够提供最低界面陷阱密度的高质量氧化层。
热氧化
半导体的氧化有很多方法,比如热氧化法、电化学阳极氧化法和等离子化学汽相淀积法。当中,热氧化法是硅基器件制造中最常见也是最重要的方法和关键工艺。
组成包括:一个电阻加热氧化炉,一个圆筒型熔融石英管。开槽的石英舟放在石英管中,石英槽用来垂直摆放硅片,一个注入口用来注入高纯度干燥氧气或者高纯水蒸气(即干氧氧化法和湿氧氧化:两者反应方程式不一样,干氧氧化生成的氧化层电性能较好,但是生成速度会比湿氧氧化要慢。所以,相对较薄的氧化层我们一般采用干氧氧化;相对较厚的则采用湿氧氧化)。
氧化温度一般维持在 900~1200℃。其中,需要控制温度从低温线性上升到氧化所需的温度,避免温度的突变带来硅片发生形变的风险,同时氧化过程中需要讲温度维持在一定的范围,氧化完成后也要线性地降低温度。
由热氧化法生成的二氧化硅是一个正四面体结构。硅原子位于四面体的中心位置,四个氧原子分别位于四面体的四个顶点。并且此类二氧化硅属于非结晶结构,密度较低,会使各种杂质进入并容易扩散到整个氧化硅层。
在热氧化过程中,硅表面附近的杂质浓度会形成再分布。我们把硅中杂质平衡密度和二氧化硅中的杂质平衡密度的比值称为分凝系数 k。二氧化硅中掺杂杂质的再分布很少具有电活性,但是硅中的掺杂杂质的再分布在氧化过程和器件制造过程中却起着重要作用。
SiO2 的掩模特性
二氧化硅层可以在温度上升时对杂质扩散提供掩模作用。不论是杂质的预淀积,或者是离子注入、化学扩散等技术,一般都会导致在氧化物表面或者附近生成掺杂杂质源。在随后的高温工艺步骤中,在氧化掩模区域中的扩散必须足够的慢,以阻止掺杂杂质通过氧化掩模层向硅的表面扩散。氧化掩模层的厚度一般通过实验测试的方法来获得,主要是在特定的温度和时间下,不能使低掺杂的硅衬底发生反型(典型的氧化掩模层厚度在 0.5um~1um)。总之,二氧化硅是高质量的绝缘材料,在硅片上可以通过热生长的方法形成二氧化硅层,它可以在杂质注入和扩散中作为阻挡层。
目前,针对 45 纳米以下的高端光刻机市场,荷兰 ASML 市场占有率达到 80%,同时 ASML 可以说是唯一一家有能力提供 7 纳米的光刻机厂商。国内光刻机的研究目前还属于提高阶段,去年中国科学院光电技术研究所推出了 22 纳米的光刻机,大大推动了国产光刻机的发展。那么接下来带大家来了解什么是所谓的光刻?
光刻
光刻,就是讲掩膜上的几何图形转移到涂在半导体晶片表面的敏光薄层材料(也就是我们说的光刻胶)上的工艺。这些几何图形确定了集成电路中的各种区域,比如离子注入区,接触窗口和引线键合区等等。但是由光刻工艺造成的光刻胶上的图形只是电路图形的印模,为了产生电路图形,我们还需要再一次将光刻胶上的图形转移到光刻胶下面的各层当中去,这一过程也就是我们所说的刻蚀。
今天我们主要聊聊光刻的以下几个部分:曝光装置、掩模、光刻胶以及结语。
曝光装置
图形的转移主要是通过曝光设备来完成的。而曝光设备的性能主要取决于三个部分:分辨率、对准精度和生产效率。分辨率指的是能够精确转移到半导体表面光刻胶上的最小特征尺寸值;对准精度指的是各个掩模和先前可在硅片上的图形互相套准的准确度;生产效率指的是掩模在固定时间内所能曝光的硅片数量。以上三点是衡量曝光设备性能的主要参数。
基本的曝光方法分为两种:遮蔽式和投影式。
遮蔽式曝光:
遮蔽式又可以根据掩模和硅片之间的距离分为接触式曝光和接近式曝光两种。接触式曝光中,当掩模和硅片接触时,硅片上的灰尘粒子或者硅渣会嵌入到掩膜中,对掩模造成永久性的损伤,在后续使用中会造成曝光的每个硅片上都会留下缺陷。
避免上述的弊端,可以采样接近式曝光,即掩模和硅片之间留有一个小的间隙,通常在 10~50um。但是这样的坏处会分辨率相应地降低。
投影式曝光:
为了遮蔽式曝光的一些弊端,出现了所谓的投影式曝光法。把掩模上的图形投影到涂有光刻胶的硅片上,为了提高分辨率,每次只曝光掩模的一小部分,然后用扫描或者分步重复的方法将整个掩模曝光到硅片上。
由于每次曝光一小部分,可以将掩模图案进行缩小投影到硅片上,缩小倍数取决于使用的透镜和掩模的能力。这样的投影曝光可以在不重新设计透镜的前提下曝光更大的晶片。
掩模
制作掩模类似于我们制作 PCB,首先利用绘制软件完整地绘制出具有电学功能的电路图形,然后利用电子束光刻系统将图形直接转移到对电子束敏感的掩模上。掩模由镀铬玻璃板组成,电路图形首先被转移到对电子束敏感的掩模上,然后再被转移到下面的镀铬层上,得到最终的掩模。对于集成电路的制造一般会分为若干个掩模层,例如隔离区一层,栅极区一层等,可能多大几十层。掩模的一个重要指标是缺陷密度。在制作掩模的过程中或者在以后的图像曝光过程中,都会给掩膜带来缺陷。这样的话便会影响到器件的成品率。
光刻胶
光刻胶又称为抗蚀剂,是一种对辐照敏感的化合物,根据其辐照的响应特性我们分为正性和负性。正胶由三种成分组成:感光剂、树脂基片和有机溶剂。在曝光前,感光剂是不溶于显影液的,曝光后,曝光区内的感光剂由于吸收了光照能量而导致其化学结构发生变化,在显影液中变得可以溶解。显影后,曝光区内的光刻胶被去掉。
负胶是一种含有感光剂的聚合物。曝光后,感光剂吸收光照能量并转变为化学能而引起链反应,使得聚合物分子间发生交联。交联聚合物具有较高的分子量而变得不溶于显影液。经过显影后,未曝光得部分被溶解。负胶得一个主要缺点是在显影时光刻胶会吸收显影液溶剂而膨胀,从而限制了负胶得分辨率。
结语
随着集成电路集成度越来越高,尺寸越来越小(亚微米级到纳米级),光刻设备和光刻工艺也在不断地提高。更高的分辨率、更深的聚焦深度以及更大的曝光范围一直面临着不同的挑战。通过缩短曝光装置的波长、开发新型的光刻胶,发展掩模的性能(一种增强分辨率的相移掩模 PSM),多种曝光方法(比如电子束曝光、X 射线曝光、离子束曝光和超紫外线(我们说地 EUV)曝光)等等手段来提升光刻工艺。光刻在半导体发展中的重要性也日益显著,但迫于难度也是使得其出现部分垄断,也造就了我们这样一个执着攻坚的国家,虽然前路艰难,但是未来仍可期!
责任编辑:wv
-
集成电路
+关注
关注
5469文章
12740浏览量
376251 -
光刻
+关注
关注
8文章
368浏览量
31426
发布评论请先 登录
双色调显影-------光学光刻和极紫外光刻

光刻胶剥离工艺


改善光刻图形线宽变化的方法及白光干涉仪在光刻图形的测量

改善光刻图形垂直度的方法及白光干涉仪在光刻图形的测量

针对晶圆上芯片工艺的光刻胶剥离方法及白光干涉仪在光刻图形的测量

MEMS制造领域中光刻Overlay的概念
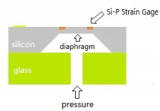
用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量

低含量 NMF 光刻胶剥离液和制备方法及白光干涉仪在光刻图形的测量

为什么光刻要用黄光?
金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量

减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量

光刻工艺中的显影技术
光刻胶剥离液及其制备方法及白光干涉仪在光刻图形的测量




 什么是光刻
什么是光刻





评论