完善资料让更多小伙伴认识你,还能领取20积分哦,立即完善>
电子发烧友网技术文库为您提供最新技术文章,最实用的电子技术文章,是您了解电子技术动态的最佳平台。
摘要:射频前端模块是无线通信的核心,滤波器作为射频前端的关键器件,可将带外干扰和噪声滤除以保留特定频段内的信号,满足射频系统的通讯要求。...

由于高密度打件采用微小化元器件与制程,因此元器件与载板之间的连结,吃锡量大幅减少,为提高打件可靠度,避免外界湿度、高温及压力等影响,塑封制程可将完整的元器件密封包覆在载板上。...

机器学习和人工智能等数据丰富的应用程序是数据中心、5G 和自动驾驶汽车等广泛应用程序的关键数据推动因素。要运行这些应用程序,需要一个强大的处理器,其基础是基于 Si 的集成电路 (IC)。...


改质切割是一种将半导体晶圆分离成单个芯片或晶粒的激光技术。该过程是使用精密激光束在晶圆内部形成改质层,使晶圆可以通过轻微外力沿激光扫描路径精确分离。...

感光速度:即光刻胶受光照射发生溶解速度改变所需的最小能量,感光速度越快,单位时间内芯片制造的产出越高,经济效益越好,另-方面,过快的感光速度会对引起工艺宽容度的减小,影响工艺制程的稳定性。...

无论是采用Fan-in还是Fan-out,WLP晶圆级封装和PCB的连接都是采用倒装芯片形式,芯片有源面朝下对着印刷电路板,可以实现最短的电路径,这也保证了更高的速度和更少的寄生效应。...
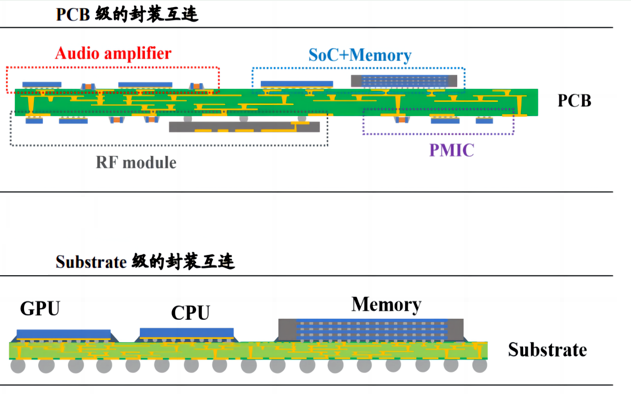
集成电路芯片持续朝着密度不断增加和器件尺寸不断微缩的方向发展,其中最为关键的一个参数就是栅极线条宽度。任何经过光刻后的光刻胶线条宽度或刻蚀后栅极线条宽度与设计尺寸的偏离都会直接影响最终器件的性能、成品率及可靠性,所以先进的工艺控制都需要对线条宽度进行在线测量,通常称为关键尺寸(CriticalD...

摘 要:针对半导体工艺与制造装备的发展趋势进行了综述和展望。首先从支撑电子信息技术发展的角度,分析半导体工艺与制造装备的总体发展趋势,重点介绍集成电路工艺设备、分立器件工艺设备等细分领域的技术发展态势和主要技术挑战。...

芯片的制造过程可以分为前道工艺和后道工艺。前道是指晶圆制造厂的加工过程,在空白的硅片完成电路加工,出厂后依然是完整的圆形硅片。后道是指封装和测试过程,在封测厂中将圆形的硅片切割成单独的晶粒,完成外壳的封装,最后完成终端测试,出厂为芯片成品。...
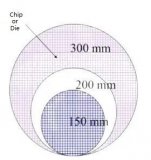
基于传感器和物联网(IoT),可以感知产品的状态,从而进行预防性维修维护,及时帮助客户更换备品备件,甚至可以通过了解产品运行的状态,帮助客户带来商业机会。...
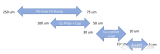
随着晶圆代工制程不断缩小,摩尔定律逼近极限,先进封装是后摩尔时代的必然选择。其中,利用高端封装融合最新和成熟节点,采用系统封装(SiP)和基于小芯片的方法,设计和制造最新的SoC产品已经成为主要的技术路径。2.5D/3D封装正在加速3D互连密度的技术突破,TSV及TGV的技术作为2.5D/3D封装的...

集成电路和电子系统的快速发展,推动着封装和集成技术向着轻型化、高集成度、多样化的方向不断革新,也带动了封装的电/热/机械及结构的设计与仿真工具的快速发展。...
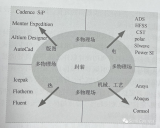
传统CMOS技术的缺陷在于: 衬底的厚度会影响片上的寄生电容, 间接导致芯片的性能下降。 SOI技术主要是将 源极/漏极 和 硅片衬底分开, 以达到(部分)消除寄生电容的目的。...

刻蚀设备的重要性仅次于光刻机。而随着NAND闪存进入3D、4D时代,要求刻蚀技术实现更高的深宽比,刻蚀设备的投资占比显著提升,从25%提至50%。...

经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(Back Grinding)开始后端处理。背面研磨是将晶圆背面磨薄的工序,其目的不仅是为了减少晶圆厚度,还在于联结前端和后端工艺以解决前后两个工艺之间出现的问题。半导体芯片(Chip)越薄,就能堆叠(Stacking)更多芯片,集成度也就越高。但集成...

高端性能封装主要以追求最优化计算性能为目的,其结构主要以 UHD FO、2.5D 和 3D 先进封装为 主。在上述封装结构中,决定封装形式的主要因素为 价格、封装密度和性能等。...
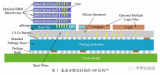
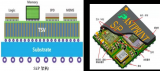
精密陶瓷基板具有优良的电绝缘性、高导热性、高附着强度和大的载流能力。使用温度范围宽,可以达到-55℃~850℃,热膨胀系数接近于硅芯片。在多温区测试环境下,是解决形变的有效方案之一。...