【博主简介】本人“爱在七夕时”,系一名半导体行业质量管理从业者,旨在业余时间不定期的分享半导体行业中的:产品质量、失效分析、可靠性分析和产品基础应用等相关知识。常言:真知不问出处,所分享的内容如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习!
讲到功率模块,相信同行业的朋友都并不陌生。
半导体功率模块是电力电子领域的核心组件,其本质是将多个功率半导体器件、驱动电路、保护电路及散热结构高度集成的模块化单元,用于高效控制和转换电能。
一、功率模块的定义
简单来讲,半导体功率模块是功率电力电子器件按一定的功能组合再灌封成一个模块。其英文全称为:Intelligent Power Module,简称:IPM。中文也可称作:功率电力电子器件或是电源模块。
功率模块(IPM)是通过封装技术将功率半导体芯片(如 IGBT、MOSFET、二极管等)、内部互连、绝缘基板、散热结构及外部端子整合为一体的标准化组件。其核心目标是在紧凑空间内实现高功率密度、高可靠性和低损耗的电能转换,广泛应用于需要高压、大电流控制的场景。
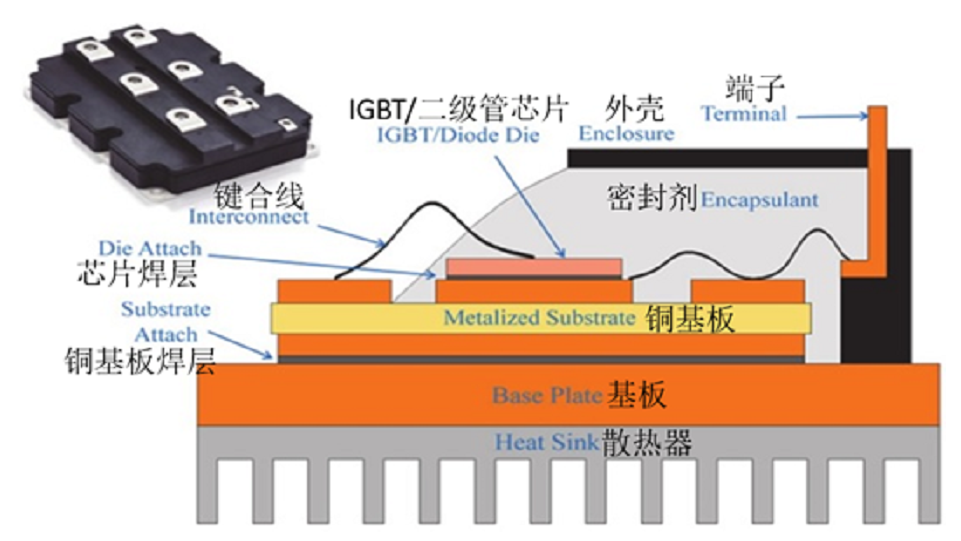
二、功率模块(IPM)的组成
功率模块(IPM)的组成结构复杂且精密,核心是将多种功能单元集成于一体,以实现高效、可靠的电能控制与转换。其主要物理组成部分包括以下几个部分:
1、功率半导体芯片 (Power Semiconductor Chips)
这是功率模块的核心功能单元,负责实现电能的开关和控制。其主要类型包括 IGBT(绝缘栅双极型晶体管)、MOSFET(金属氧化物半导体场效应管)、二极管(如快恢复二极管 FRD、肖特基二极管)以及新一代的 SiC(碳化硅)、GaN(氮化镓)宽禁带半导体芯片。
主要功能是通过控制芯片的导通与关断,实现电流的通断和电压的调节,完成 AC/DC、DC/AC 等电能转换。
用于承载功率芯片,并实现芯片与散热底座之间的电气绝缘和高效热传导。它的主要类型最常见的是 DBC(Direct Bonded Copper,直接键合铜基板),即将铜箔直接键合在陶瓷绝缘层(如氧化铝 Al₂O₃、氮化铝 AlN、氮化硅 Si₃N₄)两侧。此外,还有 AMB(Active Metal Brazed,活性金属钎焊基板),适用于更高可靠性要求。其作用主要体现在两方面:
a. 隔离高压的功率电路与接地的散热底座;
b. 将芯片工作时产生的热量快速传导至散热器。
3、内部互连 (Internal Interconnections)
用于连接功率芯片、绝缘基板和外部端子,实现模块内部的电气通路。一般分为两种方式:
a. 传统方式:引线键合 (Wire Bonding),使用细铝线或铜线通过超声焊接连接芯片电极与基板或端子。成本低,但寄生电感相对较高。
b. 先进方式:Clip 互连 (Clip Bonding),采用铜片替代键合线,通过焊接实现大面积连接,可显著降低寄生电感,提升模块的开关频率和效率。此外,还有烧结互连 (Sintering),使用银或铜烧结材料连接芯片与基板,耐高温、可靠性更高。
4、散热结构 (Heat Dissipation Structure)
负责将功率芯片产生的热量高效导出模块,防止芯片因过热而损坏。其中的铜底板 (Copper Baseplate)是模块的底部通常是一块厚重的无氧铜板,作为主要的机械支撑和散热通道,通过热界面材料(TIM)与外部散热器紧密接触。
而双面冷却 (Double-Sided Cooling)却是一种先进的封装技术,芯片的上下表面都与散热结构相连,散热效率比传统单面冷却提升一倍以上,适用于高功率密度应用。
5、封装外壳与保护材料 (Package Housing & Protection Materials)
为内部组件提供物理保护、环境隔离和机械支撑。主要有以下三个方面构成:
a. 外壳 (Housing):通常由耐高温的工程塑料(如 PBT、PA66)或金属制成,提供坚固的结构,并设有用于连接外部电路的端子(如针脚、铜排)。
b. 灌封胶 (Potting Compound):如硅凝胶或环氧树脂,填充于外壳内部的空隙中,用于防潮、防尘、绝缘,并吸收模块工作时产生的热应力和机械振动,提升可靠性。
c. 传感器 (Sensor):部分高端模块会集成 NTC(负温度系数)热敏电阻等温度传感器,用于实时监测芯片的工作温度,实现过温保护。
所以,一个典型的功率模块由功率芯片、绝缘基板、内部互连、散热结构和封装保护五大部分组成。这些部分协同工作,确保模块在高电压、大电流环境下能够安全、高效、可靠地运行。

三、功率模块(IPM)的结构
功率模块(IPM)结构主要涉及基板设计、器件配置及互连技术,其核心目标是通过优化布局降低寄生电感、提升电流分配均匀性并增强可靠性。以下是关键要点:
1、基板与封装设计
a. 双层DBC基板结构
采用底层DBC(双面覆铜陶瓷)基板与顶层DBC基板上下叠层排列,通过底部导电铜层或接桥连接,形成全桥电路布局。这种结构可有效降低寄生电感,例如SiC封装模块中,DBC与柔性电路板(FCB)结合可减少总寄生电感至1.3nH。
b. 绝缘基板与散热设计
绝缘基板通常由陶瓷或硅化合物构成,上层镀金/银/铜金属层,下层为铜/铝等导电层。基板需具备高热导率以降低热阻,常见材料包括AlSiC、铜等。
2、器件配置与电流管理
a. 桥臂式功率芯片
每个功率模块(IPM)包含多个桥臂,每个桥臂由一对上下管芯片(如MOSFET)构成,分别连接直流正负端子。这种配置可最小化电流包络回路面积,降低导通损耗。
b. 电流均衡设计
通过并联多个功率芯片并紧密排布,以及优化端子布局(如下管靠近负极,上管靠近正极),减少电流分配不均导致的局部过热。
3、互连技术
a. 低寄生电感连接方案
(a)FCB技术 :替代传统金属键合线,通过大面积导电层实现反向电流抵消,接触面积可达85%。
(b)其他方案 :如SiPLIT技术、Cu-Clip连接等,通过改进焊料或互联结构降低电感。
b. 端子与信号连接
功率端子(正负极)通过键合线、超声焊或焊膏焊接与基板连接,信号端子(控制信号)以小电流pin针形式存在。
4、应用与优化
a. SiC模块案例 :1200V/400A SiC功率模块(IPM)通过FCB技术实现低寄生电感(1.3nH),并采用叠层基板技术提升电流承载能力。
b. 热管理 :基板需兼顾重量与散热性能,常见材料为铜/铝/AlSiC,部分模块通过散热片或液冷系统增强散热效率。
所以说,功率模块(IPM)结构通过多层基板设计、器件优化及低电感互连技术,实现了高效率、低损耗的电能转换与控制。
四、功率模块(IPM)的封装工艺技术
功率模块(IPM)封装是将功率半导体器件(如IGBT、MOSFET等)与其他电子元件集成在一起的技术,旨在实现高效、紧凑和可靠的电力转换。其核心原理和关键技术涉及多个方面,包括热管理、电气隔离、互连技术等。
功率模块(IPM)封装工艺随着应用需求的变化不断演进。传统封装技术(如引线键合)存在热循环和机械应力导致的可靠性问题,而新型封装技术(如铜线键合、铝条带键合)通过降低电阻、提高导热性来提升性能。例如,丰田采用铝条带键合技术,而铜线键合因其低电阻和高导热性成为潜在替代方案。此外,直接敷铜(DBC)基板结构和烧结技术(如银烧结)进一步提高了模块的耐高温性能和可靠性。
而近年来,双面散热塑封功率模块(IPM)和高压PCB嵌入式封装成为创新方向。例如,舍弗勒推出的高压PCB嵌入式功率模块(IPM)通过将功率芯片嵌入多层PCB板,显著降低了杂散电感和开关损耗,适配新能源汽车800V高压平台。双面散热模块则通过双面DBC和铜柱结构实现更高功率密度和散热效率。
关于功率模块(IPM)封装工艺技术部分,陆续也会整理出来跟大家分享了,在本章节就不过多赘述了。

五、功率模块(IPM)封装创新要点
功率模块(IPM)创新聚焦低寄生、高散热、宽禁带适配、智能集成与高可靠五大方向,核心在互连、热管理、材料、集成架构四大维度突破,以匹配 SiC/GaN 高频特性并满足车规 / 工业严苛要求。以下是具体创新技术与落地要点:
1、低电感互连技术:从引线到无引线 / 平面化
寄生电感是高频开关损耗与 EMI 的核心瓶颈,互连方案全面升级以降低回路电感。

2、高效热管理:双面冷却与嵌入式散热
热阻限制功率密度,散热架构从单面冷却向双面与嵌入式方案演进。
a. 双面冷却(DSC):芯片上下表面均接触散热结构,散热效率提升 50%-100%,功率密度达 300W/cm³ 以上,已成为车规高功率模块标配。
b. 嵌入式封装:芯片嵌入 PCB 或陶瓷基板,缩短热路径,SiC 模块能量损耗可降 60%,适配 800V + 高压平台。
c. 先进热界面材料(TIM):液态金属、烧结银替代传统硅脂,热阻降 30%-50%,适配芯片结温 Tj 达 175℃-200℃。
d. 顶部散热封装(QDPAK/TOLT):热量从顶部导出,减小 PCB 热应力,提升功率密度。
3、宽禁带适配封装:材料与结构协同优化
SiC/GaN 耐高温、高频特性要求封装材料与结构同步升级。
a. 基板升级:AlN/Si₃N₄陶瓷基板替代 Al₂O₃,导热率提升 2-3 倍(AlN 达 170W/m・K),适配 SiC 芯片 200℃+ 结温。
b. AMB 基板替代 DBC:活性金属钎焊基板,耐高温与可靠性更高,成为车规 SiC 模块主流。
c. 无焊料连接:银烧结解决高温焊料老化问题,功率循环寿命提升 10 倍以上。
d. 绝缘强化:MB 陶瓷或高导热 PP 绝缘层,满足 1200V + 耐压与短爬电距离要求。
4、智能集成与系统级封装(SiP)
从 “功率 + 驱动” 向 “功率 + 驱动 + 控制 + 传感 + 通信” 一体化升级。
a. 数字孪生集成:内置电流 / 电压 / 温度传感器 + DSP,实现结温实时监测、故障预测,符合 ISO 26262 功能安全要求。
b. 多芯片异构集成:SiC 功率芯片与 Si 基驱动 IC 共封装,通过 EMIB/CoWoS 实现高密度互连,模块体积缩小 40%+。
c. 功能集成:PFC + 逆变 + 制动单元一体化封装(如 CIB 结构),简化系统设计,降低成本与体积。
d. 三维堆叠:混合键合 / TSV 技术实现功率芯片与驱动 IC 垂直堆叠,功率密度突破 500W/cm³。
5、材料体系革新:适配高温与高可靠性
封装材料从传统塑料 / 环氧向耐高温、低应力材料升级。
a. 基板:AlN/Si₃N₄替代 Al₂O₃,AMB 替代 DBC,提升导热与可靠性。
b. 灌封胶:硅凝胶替代环氧树脂,吸收热应力,提升湿热环境可靠性(防护等级 IP20+)。
c. 底板:CuMo/CuW 复合底板,匹配芯片与基板 CTE,减少热机械应力。
d. 绿色封装:无铅、无卤材料普及,回收利用率提升至 90%,符合欧盟 WEEE 指令。
功率模块(IPM)封装创新的核心逻辑是 “适配宽禁带 + 提升系统性能 + 保障高可靠性”,低电感互连、双面冷却、SiC/GaN 专用封装与智能集成是当前落地重点。企业需结合应用场景平衡性能、成本与可靠性,优先布局 SiC/GaN 适配封装与双面冷却技术,以抢占新能源与工业自动化市场先机。

六、功率模块(IPM)封装创新趋势的分析
当前功率模块(IPM)封装正围绕低寄生参数、高功率密度、宽禁带适配、智能集成与高可靠性五大方向快速迭代,核心创新集中在互连结构、散热架构、材料体系与系统集成,以适配 SiC/GaN 高频特性并满足车规 / 工业级严苛要求。以下就是本章节要跟大家分享的内容,虽然是十多年前对功率模块(IPM)封装创新趋势的分析,其独特的思维模式和前卫的分析方法,至今却仍然是经典:















因为本培训资料章节太多,完整版如有朋友有需要,可私信我邀请您加入我“知识星球”免费下载PDF版本。注意:此资料只可供自己学习,不可传阅,平台有下载记录,切记!欢迎加入后一起交流学习。
七、总结一下
功率模块(IPM)封装将继续向高效、高可靠性和低成本方向发展。例如,三维集成技术(如埋置、叠层封装)和智能功率模块(IPM)的普及将进一步提升性能。同时,新材料(如纳米银粉)和工艺优化(如无压烧结)将解决现有技术的瓶颈。
同时,功率模块(IPM)封装创新的核心逻辑是 “适配宽禁带 + 提升系统性能 + 保障高可靠性”,低电感互连、双面冷却、SiC/GaN 专用封装与智能集成是当前落地重点。企业需结合应用场景平衡性能、成本与可靠性,优先布局 SiC/GaN 适配封装与双面冷却技术,以抢占新能源与工业自动化市场先机。
审核编辑 黄宇
-
半导体
+关注
关注
339文章
31192浏览量
266320 -
功率模块
+关注
关注
11文章
681浏览量
47029 -
IPM
+关注
关注
6文章
184浏览量
40240
发布评论请先 登录
AOS IPM5模块在印度正式量产,“萨南德—硅谷”桥梁助推全球半导体新格局


半导体先进封装之“2.5D/3D封装技术”的详解;

基本半导体汽车级Pcore6 HPD Mini封装碳化硅MOSFE模块介绍

面向能源互联网的功率半导体变革:基本半导体ED3系列SiC MOSFET功率模块

半导体IGBT模块封装中环氧灌封胶应用的详解;
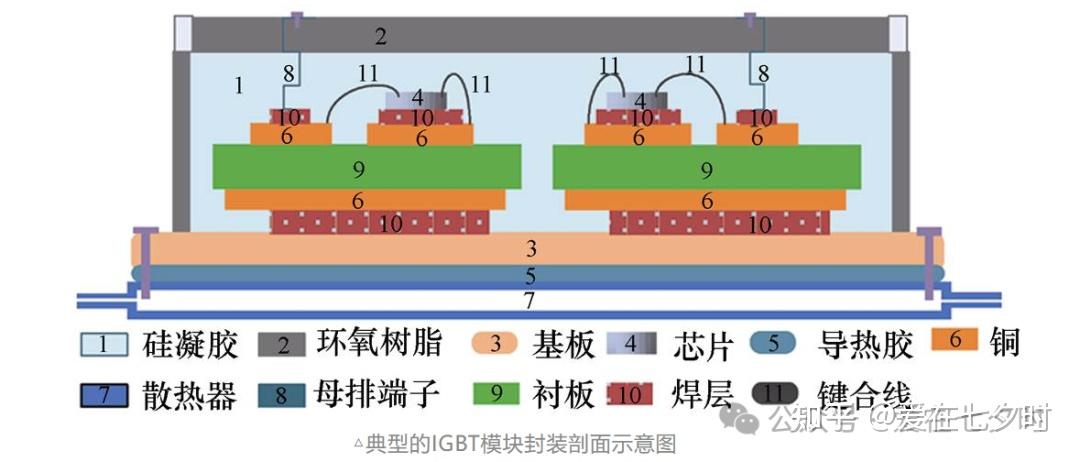
是德科技Keysight B1500A 半导体器件参数分析仪/半导体表征系统主机
倾佳电子针对高性能电力变换的基本半导体34mm封装SiC模块平台战略分析

BW-4022A半导体分立器件综合测试平台---精准洞察,卓越测量
SiC碳化硅功率半导体:电力电子行业自主可控与产业升级的必然趋势





 半导体功率模块(IPM)封装创新趋势分析的详解;
半导体功率模块(IPM)封装创新趋势分析的详解;






评论