【博主简介】本人“爱在七夕时”,系一名半导体行业质量管理从业者,旨在业余时间不定期的分享半导体行业中的:产品质量、失效分析、可靠性分析和产品基础应用等相关知识。常言:真知不问出处,所分享的内容如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习!
随着半导体材料技术的突破,对功率器件电压和频率提出了更高的要求。更高电压和更快开关频率导致器件在工作过程中产生大量的热量,热量作为副产物影响了封装材料的绝缘性能。所以,在电子元器件制造过程中,灌封胶是必不可少的材料之一。而在市面上,最常见的灌封胶就是有机硅灌封胶和环氧灌封胶了。
有机硅凝胶材料因其具有优良的耐温、防水和电气绝缘性能等,成为电子器件必不可少的封装绝缘材料。目前,硅基IGBT模块灌封常用的有机硅凝胶是一种双组份加成型室温或加温硫化有机硅凝胶。
有机硅具有极强的适应性和耐用性,可承受极端温度、机械应变和刺激性化学品,提供可靠的粘合、密封和热稳定性。硅凝胶作为一种特殊的电子灌封材料,除具备有机硅类灌封胶独特的耐候和耐老化性能、优异的耐高/低温性能、良好的疏水性和电绝缘性能之外,还具有内应力小、抗冲击性好、粘附力强的优点,是IGBT模块灌封的首选材料。
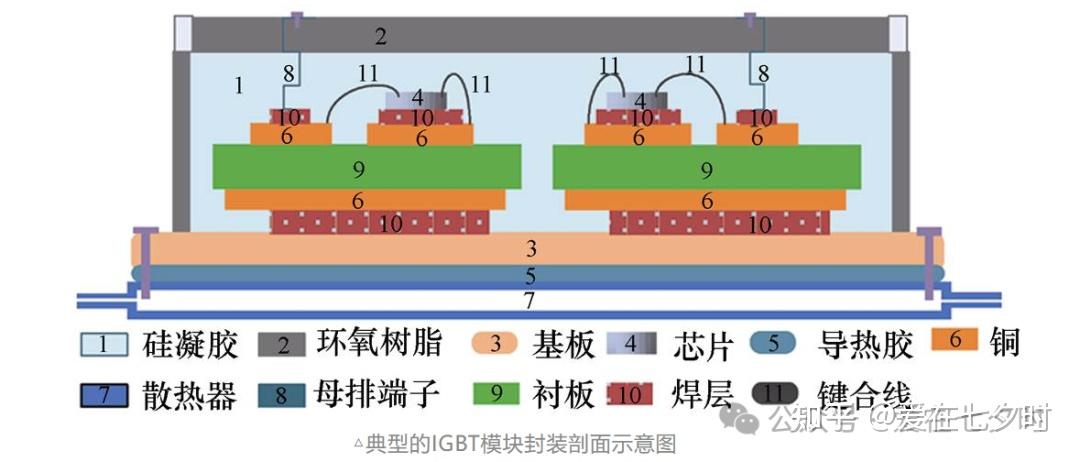
IGBT(Insulated Gate Bipolar Transistor),中文名字叫“绝缘栅双极型晶体管”。目前主要应用在IGBT模块灌封的是有环氧胶和有机硅凝胶两个。主流的大功率模块都是选用的硅凝胶和环氧胶配合使用,既能给模块提供很好的电气绝缘保护(有机硅凝胶),又能给模块给予很好的机械强度保护(环氧胶)。
一、IGBT模块灌封胶的介绍
灌封胶是一种特殊的有机高分子复合材料,广泛应用于电子元器件的制造过程中。常见的灌封胶类型包括环氧树脂灌封胶、有机硅灌封胶(硅酮灌封胶)、聚氨酯灌封胶以及丙烯酸酯灌封胶等。
环氧灌封胶是由环氧树脂、固化剂、填充剂等组成。环氧树脂是环氧灌封胶的主要成分,它的优点是具有优异的物理性能,如高强度、高硬度、高耐热性等。
环氧灌封胶有以下优异性能:
1、优异的机械保护:环氧灌封胶在固化后形成坚硬的外壳,能够有效保护内部电子元件不受物理冲击、振动和压力的损害。
2、卓越的化学和环境抵抗力:环氧灌封胶具有很强的抗化学腐蚀性,能够抵抗多种化学物质的侵蚀。同时,它还能防止湿气、尘埃和其他环境因素对电子组件造成的损害。
3、高度电气绝缘性:环氧灌封胶具有很好的电绝缘特性,可以有效防止电气短路和电气干扰,保证电子设备的安全稳定运行。
4、热稳定性和热管理:环氧灌封胶能够承受较宽的温度范围,提供良好的热稳定性,帮助电子设备在不同的工作环境下维持性能。它还能在一定程度上帮助散热,防止设备过热。
5、防止氧化和腐蚀:环氧灌封胶可以封闭电子元件,防止空气中的氧气与电路接触,从而减少氧化和腐蚀的可能性。
6、提高组件的长期稳定性和可靠性:通过封装,环氧灌封胶能够延长电子组件的使用寿命,减少维护需求和更换频率,从而提高整体的经济效益。
7、多功能和可定制性:环氧灌封胶可根据不同的应用需求调整配方,如改变硬度、粘度、固化时间和颜色等,满足特定工业应用的需求。
8、强粘接力:环氧灌封胶与多种材料(如金属、塑料、陶瓷等)都能形成牢固的粘接,确保封装结构的完整性和耐久性。
二、IGBT模块对灌封胶的要求
基于目前工艺制备的有机硅凝胶灌封于IGBT模块中时,当器件内部温度升高到125℃时,有机硅凝胶内部将产生气泡,并且随着温度升高,硅凝胶内的气泡呈体积增大,数量增多的趋势。绝缘材料中的气泡将严重影响材料的绝缘性能。于是高压大功率IGBT模块对灌封胶提出的新要求有:
1、灌封胶材料绝缘强度高,足以保障芯片终端钝化层及器件内部三结合点处等电场集中位置的绝缘;
2、灌封胶材料制备无副产物;
3、灌封胶材料具有一定的耐热、防水、耐机械性能等。大功率IGBT模块在运行过程中会产生极高的温度,虽然底部的氮化铝底衬起到一定的导热作用,但模块内部温度可能会达到180℃甚至200℃;另外IGBT模块在使用过程中可能会遭受外界湿热、外力冲击、强烈机械振动等不利因素影响,因此要求新一代大功率IGBT模块封装材料具有极佳的耐高温性能,以保证IGBT芯片的运行可靠性;
大功率IGBT用高耐温环氧灌封胶具有很好的耐化学腐蚀性能和很高的剪切强度,能够长期暴露在超过200℃高温环境中,短期甚至能承受高达250℃的高温。
硅凝胶供应商针对IGBT模块提出的新要求,纷纷推出了低应力、十分柔软的IGBT硅凝胶,灌封到IGBT模组上后,硅凝胶的低应力及柔软性,能够达到比较理想的抗冲击、减震效果,同时,凝胶表面的粘性,粘接在IGBT模组上,也能很好的达到防水防潮的保护效果。不仅如此,IGBT硅凝胶优异的电气绝缘性能,如高介电强度和体积电阻率,也能够保护IGBT模块。
三、环氧灌封胶在IGBT模块封装中的应用
IGBT模块按封装形式的不同可分为压接式和焊接式。环氧胶灌封主要应用于焊接式,不仅能提高IGBT模块的绝缘能力,还能提升IGBT模块的可靠性,延长其使用寿命。环氧树脂由于具有极好的电气绝缘性能和操作工艺性,被广泛应用于电子封装领域,采用环氧树脂进行灌封保护的电子元器件具有极好的整体性和尺寸稳定性,能有效延长电子芯片2~3倍的使用寿命。
同时,温度变化所导致的环氧灌封胶体开裂、与外壳的脱离或应力过大导致外壳开裂等问题会对封装结果有直接影响,因此环氧灌封胶的温度性能对其在IGBT模块中的应用影响较大。
目前主要应用在IGBT模块灌封的是环氧胶和有机硅凝胶两个。主流的大功率模块都是选用的硅凝胶和环氧胶配合使用,既能给模块提供很好的电气绝缘保护(有机硅凝胶),又能给模块给予很好的机械强度保护(环氧胶)。
并且,灌封用环氧胶一般是在完成硅凝胶灌封后再进行灌封,经固化后在硅凝胶上层形成一层密度大质地坚硬的保护层,能够起保护和强化模块整体性的作用,对提高模块的抗机械冲击性具有一定的实际意义,这种封装结构方式在轨道交通用IGBT模块上应用较多。
IGBT模块灌封用环氧胶主要采用双组分的形式,是由特种环氧树脂、无机填料和助剂等制备而成,其固化物具有很高的阻燃性和较低的CTE值,可以有效隔离外部不利环境的影响。
但环氧灌封胶固化收缩率较大,且固化后CTE值相对芯片、衬板、绑定线等差异较大,环氧灌封的IGBT模块在温度冲击实验后易开裂、脱离和形变,导致封装失效,因此环氧灌封胶在IGBT模块封装中的应用研究需要重点关注。
研究人员分别对 1# 和 2# 环氧灌封胶进行了灌封实验。下图为两种环氧灌封胶灌封前后的IGBT模块照片。采用 Econo PACK 封装形式的模块,灌封尺寸约为110.0 mm×57.5 mm×17.0 mm。

下表 4 为经过高温存储、低温存储和温度循环后两种环氧灌封胶在 IGBT 功率模块中的应用情况。从下表 4 可以发现,1# 灌封的模块在高温存储、低温存储以及温度循环后并未出现胶开裂,胶体与 IGBT 塑料外壳之间也并未出现由于收缩引起的缝隙和脱离现象,能满足IGBT模块的灌封要求;2# 能完全通过高温存储测试,但由于 CTE 值偏大,模块低温存储以及温度循环后胶体与外壳间脱离,封装失效,在耐温性能方面还存在缺陷,可能还需在环氧胶树脂应用、填料种类及含量等方面进行调整和优化。

四、IGBT模块灌封胶设备
针对IGBT硅凝胶的特点,为实现对IGBT模块产品无气泡灌封的自动化作业,最大限度地满足产品真空灌胶的需求,设备厂商也推出了真空灌胶机,将双组份胶水按照预先设定好的比例和出胶重量,自动配比后自动混合均匀,在预先实现真空的环境里均匀的灌注到每个产品里面,实现高精度注胶以及快速量产。
五、环氧灌封胶在IGBT功率模块封装中应用的实验
为评估国产环氧灌封胶在绝缘栅双极晶体管(IGBT)功率模块封装中的应用情况,选取了两种国产环氧灌封胶进行了综合对比:包括对两种环氧灌封胶固化前黏度、比重和凝胶时间,固化后力学性能、热性能、绝缘性能等的横向对比。分析出两种环氧灌封胶的差异,并利用其分别封装了IGBT功率模块,对所封装的IGBT模块进行了高温存储、低温存储及温度循环等环境测试。对比测试结果表明:两种环氧灌封胶不同的增韧机理、混合比例、固化温度、机械强度和Tg值对封装存在一定影响,但CTE值是影响环氧灌封胶在IGBT模块封装应用的重要参数。
功率半导体模块主要应用于电能转换和电能控制,是电能转换与电能控制的关键器件,被誉为电能处理的"CPU",是节能减排的基础器件和核心技术之一,被广泛应用在先进轨道交通、输配电、电动汽车、新能源、智能家电以及军工等领域。功率模块封装技术是集材料性能研究和应用研究于一体的综合性学科,所涉封装材料由于功率模块的封装形式多样而不同。从材料的种类可以划分为有机材料和无机材料,其中无机封装材料如玻璃、水凝胶陶瓷等由于烧结温度过高或热膨胀系数(CTE)匹配度的问题导致应用较少;而有机封装材料主要是有机硅、环氧树脂和聚酰亚胺等高分子材料,在功率模块中应用范围较广,相关的研究报道也相对较多。
绝缘栅双极晶体管(IGBT)具有易驱动、控制速度快、导通电压低、通态电流大、尺寸小等优点,是一种重要的功率半导体器件。IGBT 模块按封装形式的不同可分为压接式和焊接式。压接式采用的有机材料较少,本文不讨论;焊接式主要采用的是有机硅凝胶和环氧胶灌封,不仅能提高 IGBT 模块的绝缘能力,还能提升IGBT模块的可靠性,延长其使用寿命。环氧树脂由于其良好的绝缘性和工艺性而应用广泛,但环氧灌封胶固化收缩率较大,且固化后CTE值相对芯片、衬板、绑定线等差异较大,环氧灌封的IGBT 模块在温度冲击实验后易开裂、脱离和形变,导致封装失效,因此环氧灌封胶在IGBT模块封装中的应用研究需要重点关注。以下是对两种国产 IGBT模块封装用环氧灌封胶的基本性能、热性能和绝缘性能进行对比测试,并结合材料的基本性能研究两种环氧灌封胶在模块中的应用情况,为国产环氧灌封胶在 IGBT模块中的应用提供一定的参考。
1、原材料及使用工艺
选取两种国产环氧灌封胶作为研究对象,分别标记为1#环氧灌封胶和2#环氧灌封胶,两种环氧灌封胶的关键参数下见表1。

2、测试仪器及方法
黏度采用上海高致精密仪器有限公司NDJ-5S型黏度计进行测试,测试标准为 GB/T 10247— 2008;体积电阻率采用日本HIOKI公司SM7120型高阻计进行测试,测试标准为 GB/T 1410—2006;电气强度采用桂林电器科学研究院有限公司ZHT-10/ 50型电气击穿测试仪进行测试,测试标准为GB/T 1408.1—2006;力学性能采用德国ZWICK公司Z010型万能拉力机进行测试,测试标准为 GB/T 2567—2008;导热系数采用湘潭湘仪仪器有限公DRPL-II型导热测试仪进行测试,测试标准为 GB/T 10295—2008;热失重分析采用梅特勒TGA1(SF)型热重分析仪进行测试,空气氛围,温度从25℃升温到 700℃,升温速率为 5℃/min;玻璃化转变温度采用梅特勒 DSC1 型差示扫描量热仪进行测试,测试标准为 GB/T 19466.2—2004;热膨胀系数采用美国 TA公司TMA Q400型热机械分析仪进行测试,测试标准为GB/T 36800.2—2018;阻燃性采用江都市天璨试验机械厂CZF-5型水平垂直燃烧测试仪进行测试,测试标准为GB/T 2408—2008,样品厚度为6 mm。
3、结果与讨论
(1)环氧灌封胶固化前物理性能对比
环氧灌封胶固化前物理性能主要指胶的黏度、密度、凝胶时间等基本技术参数,如表 1所示。表 1 中的参数决定了环氧灌封胶的使用工艺条件及对灌胶设备的要求,也是环氧灌封胶选型中重要的技术工艺参数。
由于供应商对环氧灌封胶配方设计思路的差异,两种环氧灌封胶固化前特性差异较大。对表 1 数据对比分析可以发现,两种胶的设计思路差别为:1# 为双组分热固化型环氧灌封胶,A、B组分密度和黏度相差较小,采用质量比为 1∶1的比例混合有利于称量和混合施胶。但该胶在常温下混合黏度较大,超过 20 000 mPa·s,室温下难以完成模块灌封,需要将胶加热至40~50℃以获得更合适的操作黏度和渗透性;2# 也为双组分热固化型环氧灌封胶,但 A、B 组分密度和黏度相差大,采用质量比为 4∶1 的比例混合。此外该环氧灌封胶在常温下的混合黏度为 5 540 mPa·s,具有较低操作黏度和渗透性,可无需加热直接完成模块的灌封。但该胶 A 组分填料含量高、黏度大,增加了填料沉降风险,也不利于 A、B 组分混合。综上所述,1# 和 2# 环氧灌封胶固化前性能差异较大,对于储存条件、工艺条件及灌胶设备等要求都会有所不同,需要结合存储条件、灌胶设备、现场工艺条件等实际情况考虑选用。
(2)环氧灌封胶固化后物理性能
a.环氧灌封胶的基本性能
IGBT模块在运行过程中可能会遭受机械振动、冲击和高潮湿等不利影响因素,要求环氧灌封胶具有较大的硬度、抗冲击性、较低的吸水率以保证模块的可靠性。两种环氧灌封胶固化后的基本性能如下表2所示。从下表2可以看出,尽管两种环氧灌封胶固化前后的基本性能差异较大,但固化后都体现出较好的机械强度、较低的吸水率和优异的阻燃性。其中1#环氧灌封胶的导热系数明显大于2#环氧灌封胶,可能是所采用的填料种类及添加量的差异所致。

b. 环氧灌封胶的热性能
热(高温)失效一直是导致IGBT失效的重要原因,因此对IGBT封装材料的热性能需要重点关注。首先对两种环氧灌封胶的热稳定性进行测试,再对其玻璃化转变温度(Tg)及 CTE值等热性能进行讨论,以期对环氧灌封胶在高温条件下的封装失效原因进行分析。
环氧树脂及固化剂的分子量、固化物的交联密度以及填料含量都可能阻碍分子链段的运动,从而对灌封胶的热稳定性造成一定的影响。下图1为两种环氧灌封胶的热失重分析(TGA)曲线。通过TGA曲线的起始分解温度和不同温度下的残留率对比两种环氧灌封胶的耐热性能。从下图1可以看出,1# 和 2# 环氧灌封胶的填料含量分别约为50%和42%,起始热分解温度分别为279.7℃和 298.5℃,2#环氧灌封胶具有较好的耐热性。

两种环氧灌封胶固化物的DSC 曲线如图2所示。样品测试先从室温开始,然后以20℃/min的速率升温至200℃,再以20℃/min的速率降至室温,最后以20℃/min的速率升温至200℃。


从上图 3(a)可以看出,TMA测得两种环氧灌封胶的 Tg分别为 101.3℃和95.5℃,与DSC法测试结果并不相同;从图 3(b)可以看出,1#环氧灌封胶的 CTE 值要低于2#,说明1#环氧灌封胶的热性能更为优异。
两种环氧胶灌封胶的技术资料显示,1#环氧灌封胶选用的树脂类型为双酚A型环氧树脂、邻甲酚醛环氧树脂、纳米壳核增韧剂以及氧化铝等,采用的固化剂为含刚性分子结构的改性酸酐;2#环氧灌封胶树脂类型为低黏度脂环族环氧树脂、酚醛树脂、改性增韧剂、二氧化硅以及氧化铝等,固化剂为甲基六氢苯酐和一定量的促进剂。TMA测试结果表明,由于1#环氧灌封胶中邻甲基酚醛具有更大的分子链结构,与含刚性分子结构的固化剂交联后能有效地阻碍主链的内旋运动,环氧柔性下降,而纳米结构的核壳增韧剂对环氧灌封胶的Tg影响较小。而2#环氧灌封胶虽然采用了分子链结构较大的酚醛树脂,但低羟基当量的酚醛树脂使交联点减少,低黏度脂环族环氧树脂与甲基六氢苯酐固化后也无法形成更大的分子结构阻碍主链内旋运动,分子柔性较大,导致2# 环氧灌封胶的Tg较低。此外,低黏度脂环族环氧树脂虽然交联密度较大,但其固化收缩率较大,通过后期温度冲击或者低温存储测试,有可能会进一步加剧树脂内应力释放和收缩,造成模块封装失效。对比 TMA 与 DSC 测得的Tg发现,TMA不仅能得到环氧灌封胶的热变形温度,还能了解环氧灌封胶在高温状态下的膨胀和变形情况,更直观且更具有参考价值。
c.环氧灌封胶的绝缘性能

4、结论
对两种国产环氧灌封胶进行了对比分析,发现 1# 和 2# 环氧灌封胶的混合比例、固化温度、机械强度、Tg和CTE值并不相同。1# 环氧灌封胶完成IGBT 模块灌封后模块能顺利通过高温存储、低温存储和温度循环测试;由于 2# 环氧灌封胶 CTE 值偏大,所灌封模块只能通过高温存储测试,无法满足 IGBT 功率模块的封装使用要求。因此,CTE值的大小是影响环氧灌封胶在 IGBT模块封装应用的最重要参数。此外,对于环氧灌封胶在 IGBT 模块上的验证过程需要对材料性能、应用工艺以及后期的灌封验证综合考虑,周期较长,如何建立高效的选择机制和打造高可靠性的实验验证平台将是需要面临解决的关键问题。
写在最后面的话
总之,使用环氧灌封胶对电子器件进行灌封封装具有诸多优势,不仅能提高器件的绝缘性、机械强度和抗化学腐蚀性,还能提供良好的密封性,有效保护内部构件免受外界环境的侵害。这不仅能提高电子产品的可靠性和使用寿命,还能大幅降低故障率,为消费者提供更安全、稳定的产品体验。
而今,环氧灌封胶又作为IGBT模块封装的核心材料,其性能直接决定模块的可靠性及寿命。当前技术已通过复合改性和工艺优化显著提升耐热性与机械强度,但高温稳定性、环保性及多功能集成仍是未来突破方向。随着新能源汽车与SiC器件的普及,环氧灌封胶将向高性能化、智能化及绿色化发展,成为支撑下一代功率电子技术的关键材料。

免责声明
【我们尊重原创,也注重分享。文中的文字、图片版权归原作者所有,转载目的在于分享更多信息,不代表本号立场,如有侵犯您的权益请及时私信联系,我们将第一时间跟踪核实并作处理,谢谢!】
参考文献:
[1] 贾扬⋅巴利加 .IGBT 器件物理、设计与应用[M]. 韩雁,丁扣宝, 张世峰译.北京:机械工业出版社,2018.
[2] 王善林,陈玉华.电子封装技术实验[M].北京:冶金工业出版社, 2019.
[3] 斯蒂芬⋅林德 .功率半导体器件与应用[M ].肖曦,李虹译 .北京:机械工业出版社,2019.
[4] KAESSNER S, SCHEIBEL M G, BEHRENDT S, et al. Reliabili‐ ty of novel ceramic encapsulation materials for electronic packag‐ ing[J]. Journal of Microelectronics and Electronic Packaging, 2018,15(3):132-139.
[5] 曾亮,齐放,戴小平,等.高分子绝缘材料在功率模块封装中的研究与应用[J].绝缘材料,2021,54(5):1-9.
[6] 安德列亚斯⋅福尔克,麦克尔⋅郝康普.IGBT模块:技术、驱动和应用[M].韩金刚译.2版.北京:机械工业出版社,2016.
[7] 曾亮,黎超华,李忠良,等 .大功率 IGBT 用耐高温环氧灌封胶的研制[J].绝缘材料,2016,49(3):24-28.
[8] 曾亮,朱伟,李忠良,等 .大功率 IGBT 用环氧树脂灌封胶的流变性能研究[J].绝缘材料,2015,48(6):25-29.
[9] 赵慧宇,丁娉,姜其斌,等.IGBT用双组分加成型有机硅凝胶的国产化研究[J].特种橡胶制品,2013,34(3):31-33.
[10] 丁娉,陈磊,唐毅平,等.新型大功率IGBT用硅凝胶的制备及其应用性研究[J].绝缘材料,2014,47(2):62-65.
审核编辑 黄宇
-
半导体
+关注
关注
336文章
29977浏览量
258069 -
封装
+关注
关注
128文章
9139浏览量
147878 -
IGBT
+关注
关注
1286文章
4260浏览量
260413
发布评论请先 登录
高导热灌封胶如何验证?详解导热系数的精准测试方法与影响因素 | 铬锐特实业

定制灌封胶_特殊场景灌封胶定制化服务流程与案例

一文读懂电控系统核心——功率半导体IGBT模块

半导体晶圆制造洁净室高架地板地脚用环氧ab胶固定可以吗?-江苏泊苏系统集成有限公司

IGBT模块封装中环氧树脂技术的现状与未来发展趋势探析
SiC模块封装技术解析






 半导体IGBT模块封装中环氧灌封胶应用的详解;
半导体IGBT模块封装中环氧灌封胶应用的详解;




















评论