椭偏术因其高灵敏度、非接触与在线测量能力,已成为薄膜与IC工艺检测的重要手段。但仪器的准确性依赖系统中偏振元件与几何参数的精确校准,且在工业环境中这些参数会随时间与环境漂移变化——因此需要快速、简单且准确的校准方法以维持仪器性能。传统校准方法(如双区域法)在实施上复杂且不易在生产线上周期性重复。Flexfilm全光谱椭偏仪可以非接触对薄膜的厚度与折射率的高精度表征,广泛应用于薄膜材料、半导体和表面科学等领域。
本文提出并实验验证了一种基于已知标准样品的快速“样品校准法”用于椭偏仪系统参数的反演与校正,并将校准后的单波长与光谱椭偏仪结合RCWA用于半导体工艺(薄膜厚度与刻蚀结构/CD)检测,实验最大厚度误差约 2.6 Å,证明了方法在IC在线检测中的可行性与优越性。
1
椭圆偏振测量术的原理
flexfilm
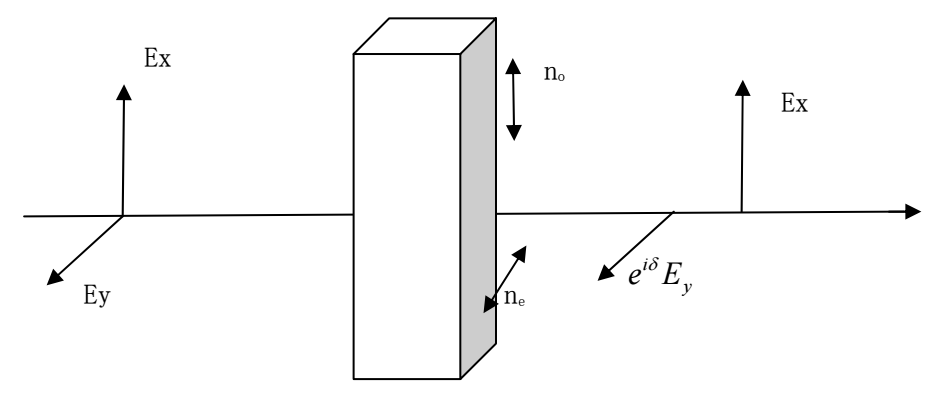
椭圆偏振光产生示意图
椭偏测量通过偏振光在样品表面对 p、s 分量的不同反射引起的振幅比与相位差来反演样品的 n、k、d。
2
椭偏测量的校准
flexfilm
传统椭偏校准法概览

(a)(b)残余函数法(c)区域差异函数法(d)双区域校准法
残余函数法:RAE 系统中构造 R (P)=1-(α'²+β'²),找最小值对应的 Ps;PSCRA 系统中构造 R₂(P)、R₄(P),Δ=90° 时最敏感,Δ=0°/±180° 失效。
反正切校准法:构造 Θ₂=½tan⁻¹(β₂'/α₂')、Θ₄=½tan⁻¹(β₄'/α₄'),线性拟合求 Cs、A-As;Ψ=90°/Δ=90° 时失效。
区域差异函数法:用四阶傅里叶系数构造 Φ₄(P),Δ=0°/±180° 时灵敏度高,Ψ=45°/Δ=90° 时失效。
双区域校准法:在 Ps 和 Ps+π/2 附近旋转起偏器,拟合两条 Θ₄(P) 直线,交点为 Ps;需样品存在,Ψ≠45°。
采用双区域校准法的实验结果

(a)双区域校准法测得的实验数据及其拟合(b)Θ2函数值的分布
实验:起偏器旋转范围 [-4°,4°],间隔 0.5°,17 个数据点拟合。
结果:Ps=311.42°,Θ₂平均值 - 35.6946°,计算 Cs=77.6137° 、A-As=-158.3084 °,A 值与人为放置位相差 0.8°。
新颖的标准样品校准法
传统方法缺陷:需频繁调整光学元件,机械不稳定 / 人为误差影响精度;入射角人工测量误差大,自动探测装置结构复杂。
样品校准法思路:利用已知 n、k、d 的标准样品,通过光强傅里叶系数 + 最小二乘法反演系统参数(P、A、Cs、δ、θ₀)。
样品校准法优点及实施过程
用琼斯/穆勒矩阵建模,若干光学参数(n、k、d)已知的标准样品作为标定参考,实验上通过旋转起/检偏器或补偿器(如 PSCRA)对输出光强做傅里叶分解,把仪器待校准参数作为未知量,提取谐项并用最小二乘/非线性拟合,同时求解仪器与样品参数。该方法实现简单、速度快、能把真实系统误差内化,适合在线/生产线周期性校准;为降低多解与提高灵敏度,应通过合理的样品选择、增波长或增样本数以及归一化策略来增强拟合稳定性,从而在非接触、快速测量下实现薄膜与刻蚀结构的精密表征。
3
单波长椭偏仪(SWE)— 模拟与实验
flexfilm

误差函数对入射角的敏感性
实验条件:7 个标准样品(厚度 26.76-2894.40Å,参考值由椭偏仪测得),波片转速 1800°/s,采集频率 20kHz。
校准参数结果:P 平均值 132.14°(SD=0.15°)、A=-9.67°(SD=0.15°)、Cs=53.03°(SD=0.17°)、δ=90.003°(SD=0.001°)、θ₀=68.19°(SD=0.23°)。
厚度测量结果:最大误差 2.6Å(130.71Å 样品),超薄样品(26.76Å)误差 3.6Å(相对精度 13.5%),厚样品(2894.40Å)相对精度 0.09%。
误差原因:薄样品灵敏度不足、样品氧化、参考厚度准确性。
4
光谱椭偏仪—扩展与多波长优势
flexfilm

椭偏仪测量现有样品的厚度

利用 129.60 埃样品校准得到的校准参数值

利用校准参数测得的样品厚度值
实验:无样品(理论 Ψ=45°,Δ=0°),测量 598-616nm 波段。
结果:Ψ 波动 [45.02,45.10] 度,Δ 波动 [-0.06,0.30] 度,符合理论。
误差原因:起偏器 / 检偏器角度误差、光学器件缺陷、空气湿度。
5
光谱椭偏仪在集成电路刻蚀结构检测中的应用
flexfilm
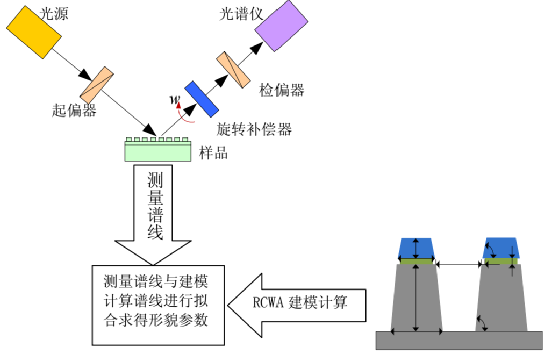
椭偏仪用于集成电路检测原理框图
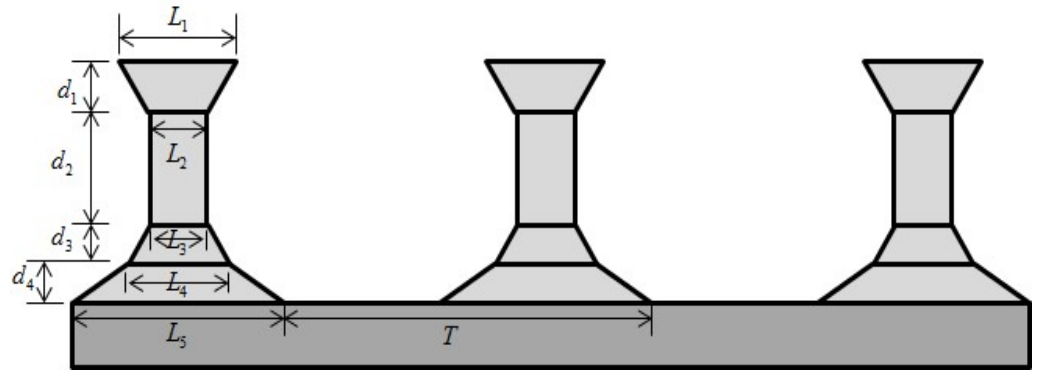
利用 RCWA 建立沟槽模型
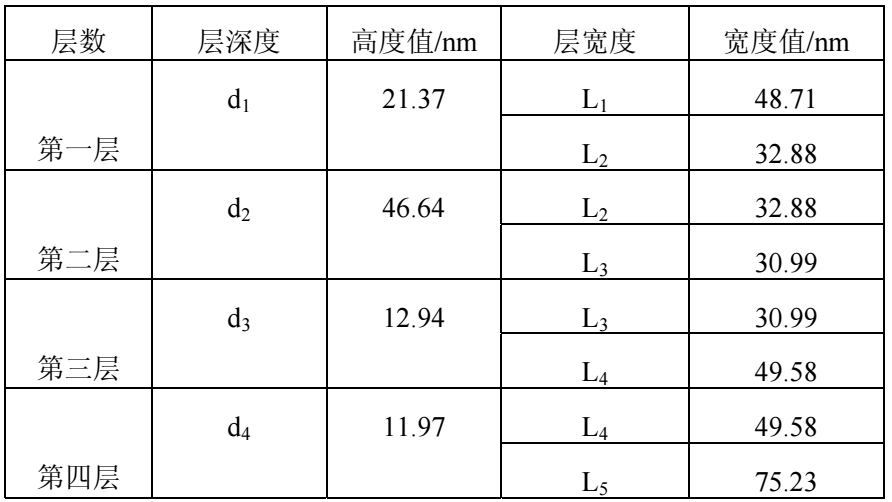
光谱椭系统测量偏集成电路结构结果
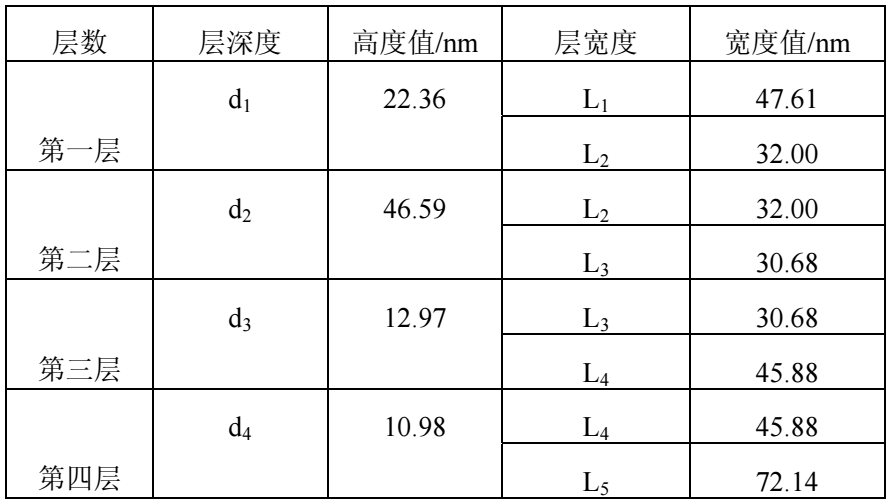
垂直入射系统测量集成电路结构结果
方法:将光谱椭偏测得的四条傅里叶系数谱(α2, α4, β2, β4)与 RCWA 建库拟合相结合,直接反演周期性刻蚀槽的层高、层宽与深度。
实验(周期 T=90 nm,总深度 ~100 nm 的硅槽):拟合率总体 ~96.4%(242–1000 nm,紫外区拟合较差),得出分层模型;与垂直入射测量比较,总高度差仅 0.02 nm,但每层宽度差在 1–4 nm。
结论:光谱椭偏 + RCWA 在 CD/深度测量上表现良好,适合在线无损检测场景。
基于标准样品的椭偏仪校准方法,在单波长与光谱椭偏仪系统中验证其可行性(单波长最大测量误差 2.6Å,光谱椭偏仪厚样品相对误差约 1.3%),并结合 RCWA 算法实现集成电路刻蚀结构(硅槽)的三维形貌检测,为集成电路工艺在线检测提供技术支撑。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪能非破坏、非接触地原位精确测量超薄图案化薄膜的厚度、折射率,结合费曼仪器全流程薄膜测量技术,助力半导体薄膜材料领域的高质量发展。
原文参考:《椭偏仪在集成电路检测中的应用》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
集成电路
+关注
关注
5469文章
12763浏览量
376367 -
检测
+关注
关注
5文章
4981浏览量
94419 -
薄膜材料
+关注
关注
0文章
38浏览量
4576
发布评论请先 登录
椭偏仪原理和应用 | 精准测量不同基底光学薄膜TiO₂/SiO₂的光学常数

聚焦位置对光谱椭偏仪膜厚测量精度的影响

椭偏仪测量薄膜厚度的原理与应用

椭偏仪的原理和应用 | 薄膜材料或块体材料光学参数和厚度的测量

光谱椭偏仪入门指南:原理、方法与基础应用

穆勒矩阵椭偏仪:DVRMME技术的系统误差建模与校准补偿

基于均匀样品的薄膜厚度测量:椭偏仪vs.反射仪

一文学懂椭偏仪:测量薄膜/块体材料的折射率、消光系数及厚度

光谱椭偏仪SE:光学常数nk、薄膜厚度与数据分析




 椭偏仪在集成电路检测中的应用:以标准样品校准法校准椭偏参数
椭偏仪在集成电路检测中的应用:以标准样品校准法校准椭偏参数






评论