P-BGA与F-BGA热变形过程及钢网开口优化分析
在电子封装领域,BGA(球栅阵列)封装的热变形行为对封装的可靠性和焊接良率具有重要影响。热变形曲线作为描述这一行为的关键工具,以二维图的形式直观展现了BGA封装在三维空间中的变形情况。其中,纵坐标代表基于测量平面的BGA中心高度与角部或边缘高度的差值,即动态翘曲度(正值表示中心上凸,负值表示中心下凹或四角上翘);横坐标则代表温度点。了解P-BGA和F-BGA这两种最广泛使用的BGA封装的热变形过程,对于优化钢网开口设计至关重要。
一、P-BGA热变形过程
P-BGA(塑料球栅阵列)的热变形行为呈现典型的双阶段特征,其典型热变形曲线如图1-1所示:

图1-1 P-BGA的典型热变曲线
Tg点前变形机制(BGA载板主导)
在温度未达到EMC(包封材料)的玻璃化转变温度(Tg)时,BGA载板(通常为BT树脂或FR-4材料)的线膨胀系数(CTE,约14ppm/℃)起主导作用。
由于载板平面方向CTE小于垂直方向,加热时四角区域因约束较少而率先上翘,形成负向动态翘曲度。
Tg点后变形机制(EMC主导)
当温度超过Tg后,EMC的CTE发生突变(由14ppm/℃增至55ppm/℃),其体积膨胀效应超过载板约束,导致变形方向反转为中心上凸,形成正向动态翘曲度。
焊球阵列的全阵列分布特性加剧了这种变形反转,使中心区域成为应力集中点。
二、F-BGA热变形过程
F-BGA(柔性球栅阵列)的热变形行为受Cu盖影响显著,其典型热变形曲线如图1-2所示(不带Cu盖)和图1-1中相关部分所示(带Cu盖):
不带Cu盖的F-BGA
变形趋势与P-BGA相似,但因柔性基材的缓冲作用,四角上翘幅度较小,中心上凸量也相应降低。其典型热变形曲线如图1-2所示。
带Cu盖的F-BGA
Cu盖(CTE≈17ppm/℃)通过机械约束降低EMC的自由膨胀空间,使四角上翘幅度减少30-50%。
Cu盖与EMC的界面形成应力缓冲层,变形曲线斜率在Tg点前后更平缓,中心上凸幅度较P-BGA降低约25%。
三、钢网开口设计优化
基于P-BGA和F-BGA的热变形曲线特征,可以制定以下钢网开口优化策略:
P-BGA钢网开口设计
区域差异化开口:根据四角上翘和中心上凸的区域特征,分别采用“内缩型”和“扩展型”开口设计,以补偿焊膏的过量或不足。
阶梯厚度设计:使用组合钢网,在四角区域形成焊膏体积梯度,平衡冷却收缩应力。
F-BGA钢网开口设计
Cu盖影响区处理:在Cu盖投影区采用“窗口型”开口,利用Cu盖的平面度优势;在非覆盖区采用“密间距微孔”设计,增强焊膏释放均匀性。
热应力缓冲设计:在封装四角对应钢网区域设置应力释放槽,减少焊接残余应力。
四、协同优化与验证方法
温度曲线协同优化
通过控制预热区的升温速率和峰值温度,影响BGA封装的热变形行为,与钢网开口设计形成协同优化效应。
变形量监测
使用激光干涉仪实时采集BGA表面形貌,确保变形量在可控范围内。
焊点可靠性验证
通过剪切强度测试和热循环试验,验证优化后焊点的可靠性和稳定性。
五、工程实践建议
材料匹配性验证:建立EMC-载板-钢网开口参数数据库,针对不同Tg值EMC配置对应开口方案。
智能钢网技术:采用可变厚度钢网(VPS),通过激光雕刻实现局部厚度调节。
DFM协同设计:在PCB布局阶段预留BGA四角应力释放区,与钢网开口优化形成双重补偿机制。
六、结论
通过深入了解P-BGA和F-BGA的热变形过程,并结合热变形曲线进行钢网开口设计的优化,可以有效提高BGA封装的焊接良率和可靠性。通过文章中的图可以为工程师提供了直观的视觉指导,有助于更好地理解和优化BGA封装的制造过程。在实际工程中,应综合考虑材料特性、温度曲线和钢网开口设计等多个因素,以实现最佳的封装效果。
审核编辑 黄宇
-
封装
+关注
关注
128文章
9152浏览量
147932 -
BGA
+关注
关注
5文章
581浏览量
50983
发布评论请先 登录
BGA芯片阵列封装植球技巧,助力电子完美连接

紫宸激光植球技术:为BGA/LGA封装注入精“芯”动力

解析LGA与BGA芯片封装技术的区别

GT-BGA-2000高速BGA测试插座
BGA封装焊球推力测试解析:评估焊点可靠性的原理与实操指南

倾斜仪是否支持二维或三维测量?可以绘制结构物变形曲线吗?

首款自发声动态变形OLED面板问世
BGA焊盘设计与布线

基于RC热阻SPICE模型的GaNPX®和PDFN封装的热特性建模

罗彻斯特电子针对BGA封装的重新植球解决方案

GaNPX®和PDFN封装器件的热设计
热变形微卡软化点测试仪:材料性能检测的关键仪器

科普知识丨热变形维卡软化点测试仪是什么?

BGA芯片封装:现代电子产业不可或缺的技术瑰宝
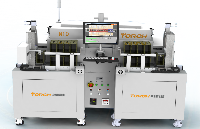





 常用BGA封装的动态热变形曲线
常用BGA封装的动态热变形曲线












评论