1:制造先进的启动晶片(SOI)的方法。
2:作为一种创建复杂三维结构和腔体的方法,以创造设备功能。(分庭,通道,喷嘴.)
3:作为一种创建封闭的包装方法环境(用于谐振器、反射镜和红外器件的真空封装)




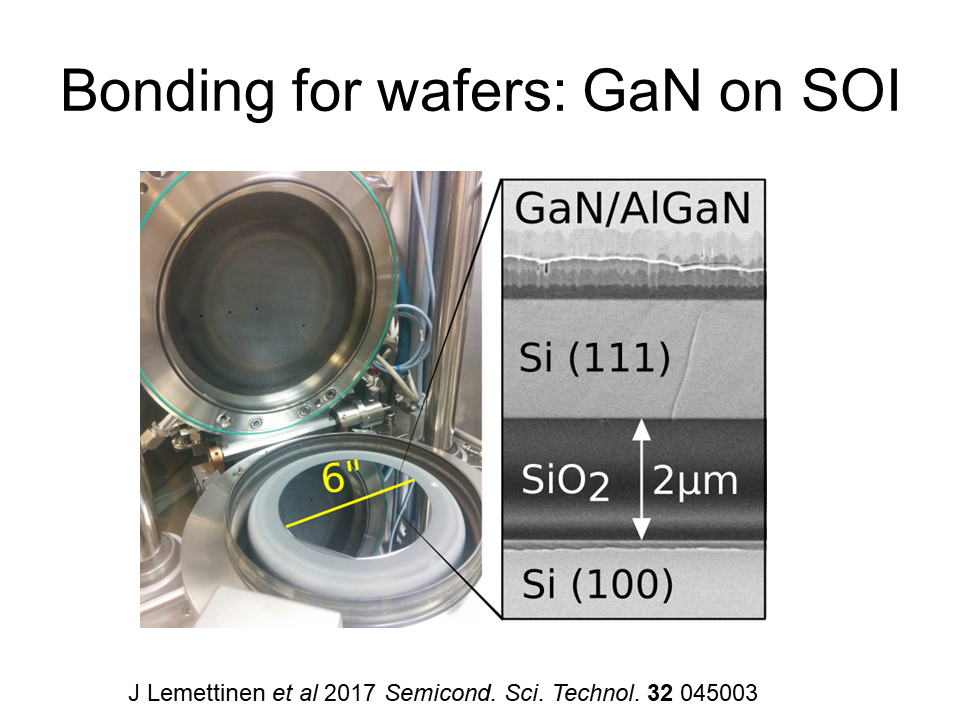
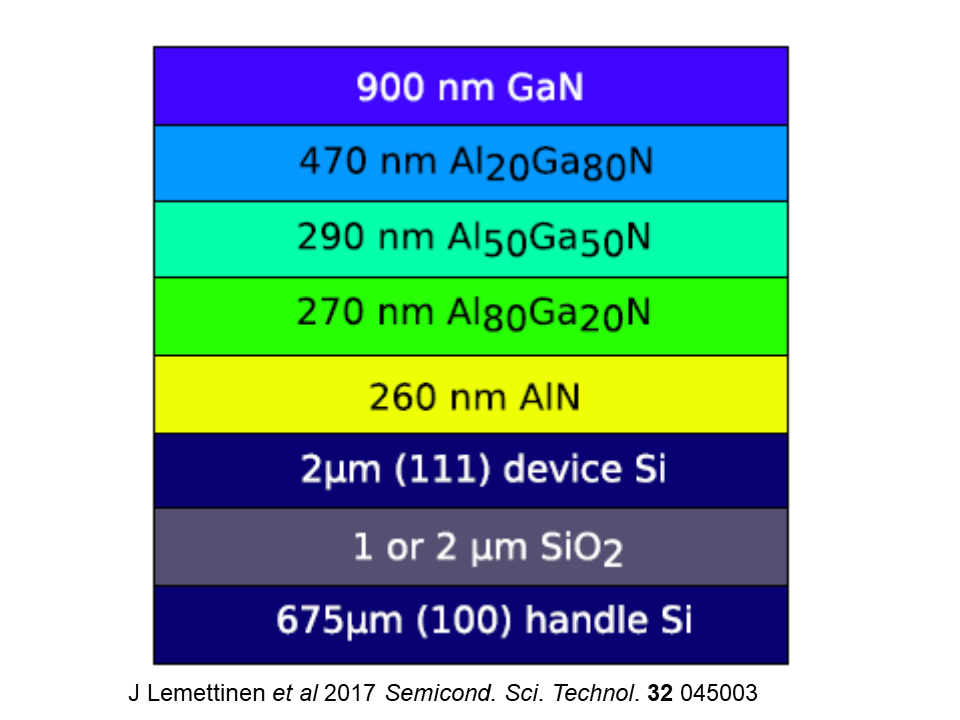
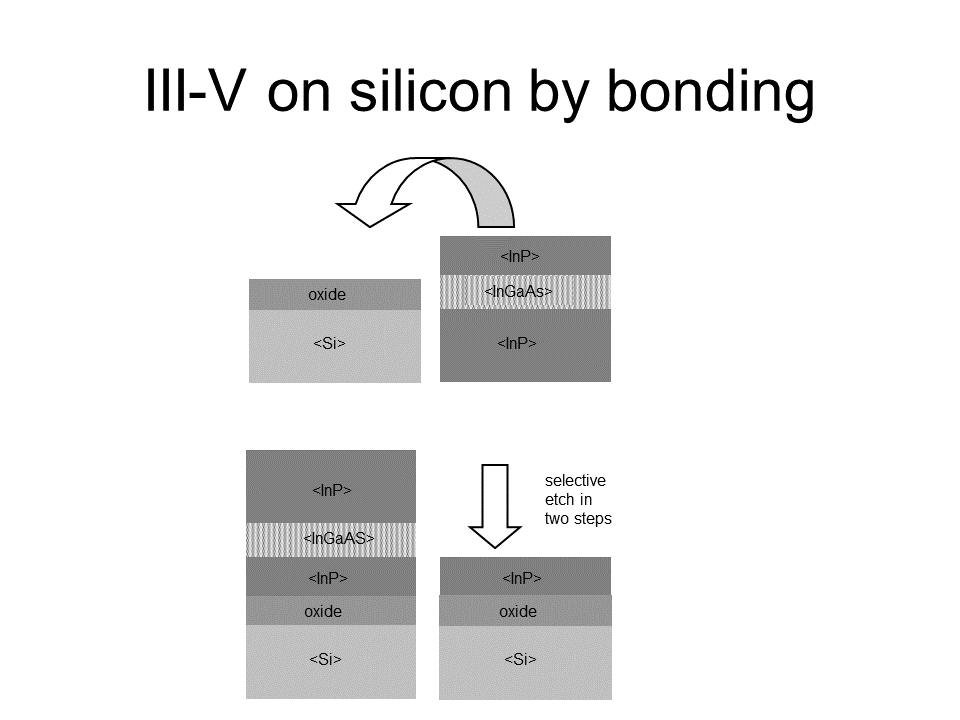

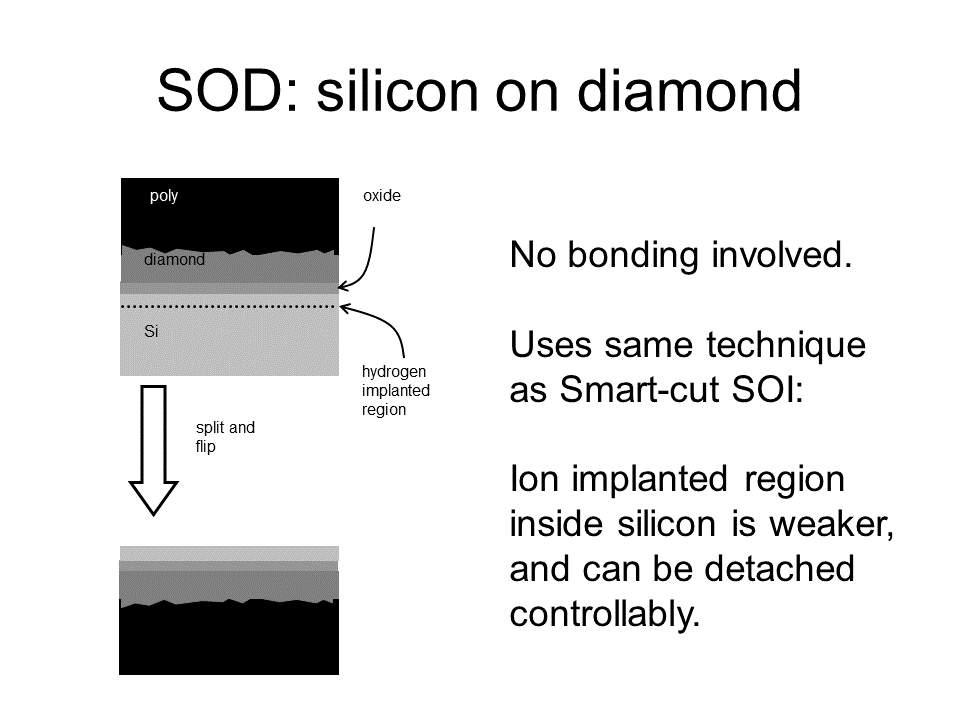
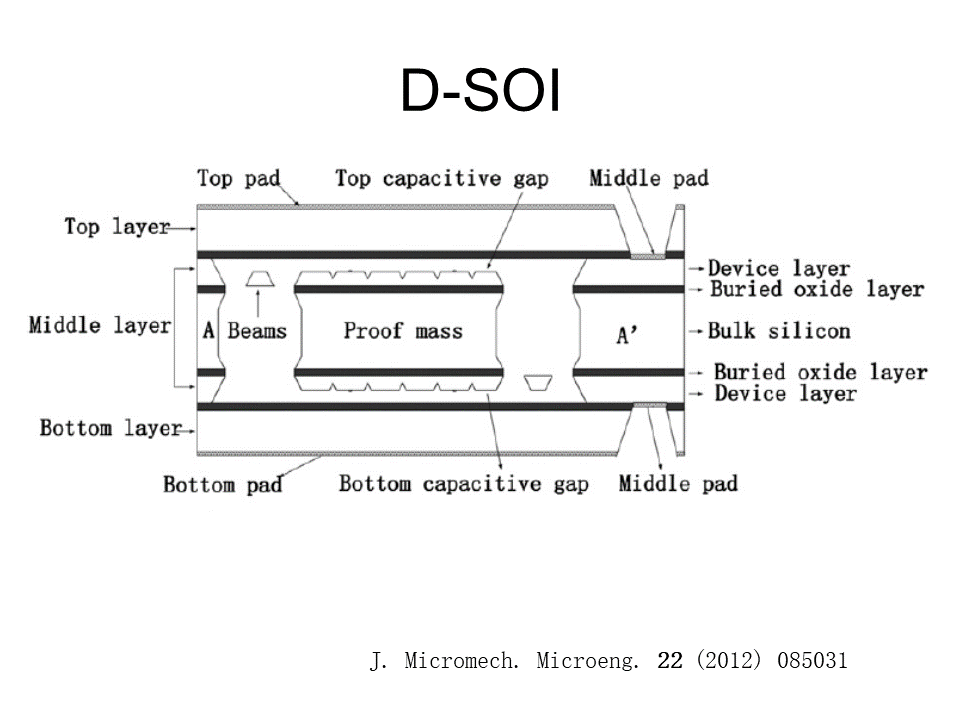
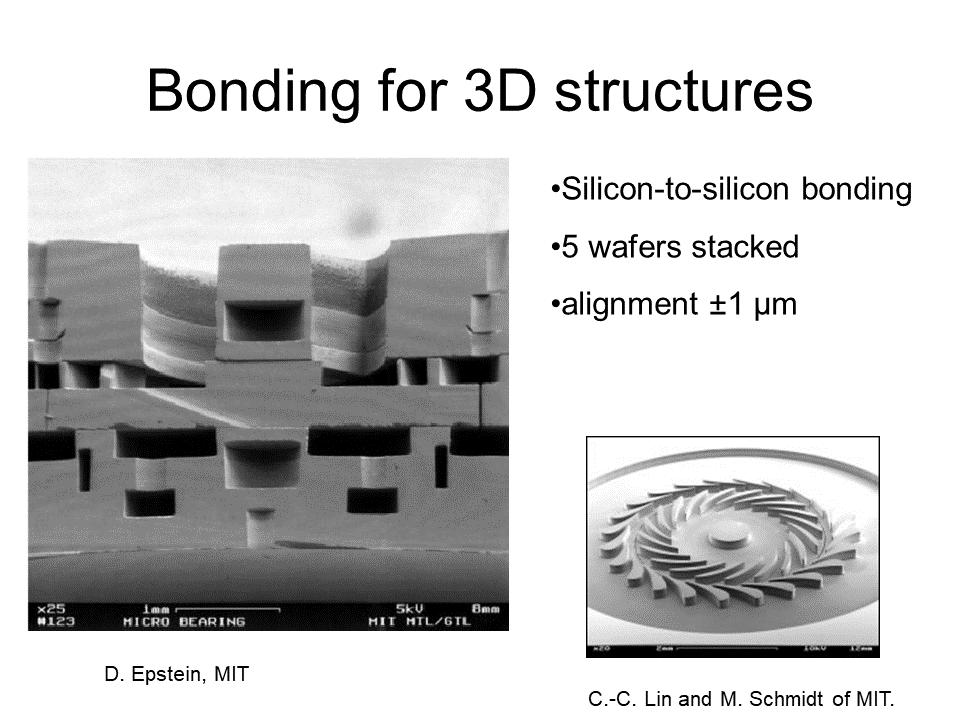
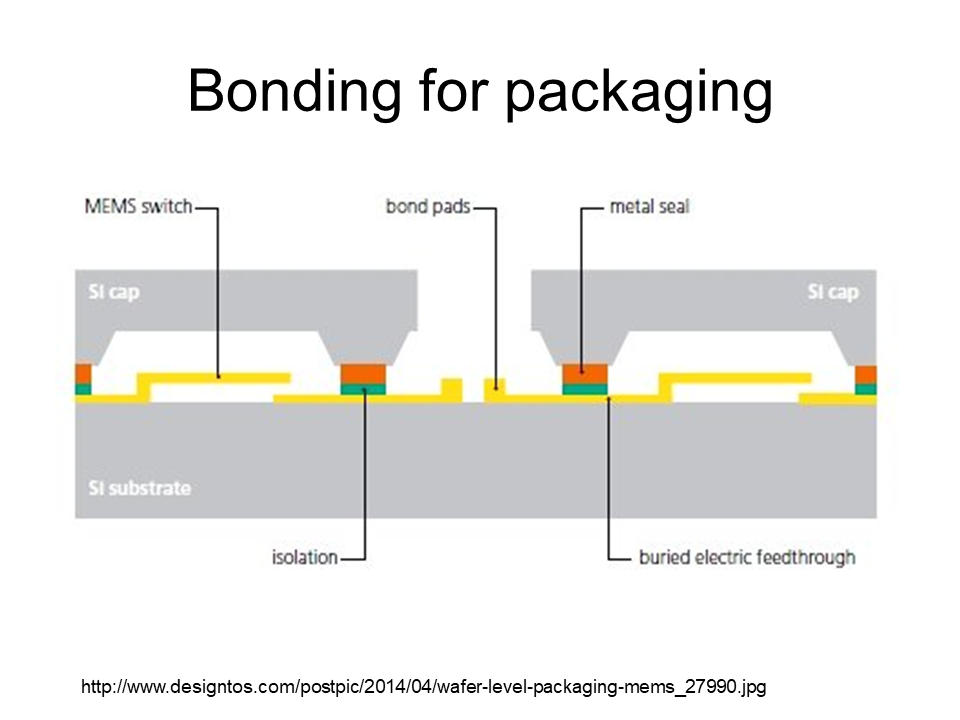
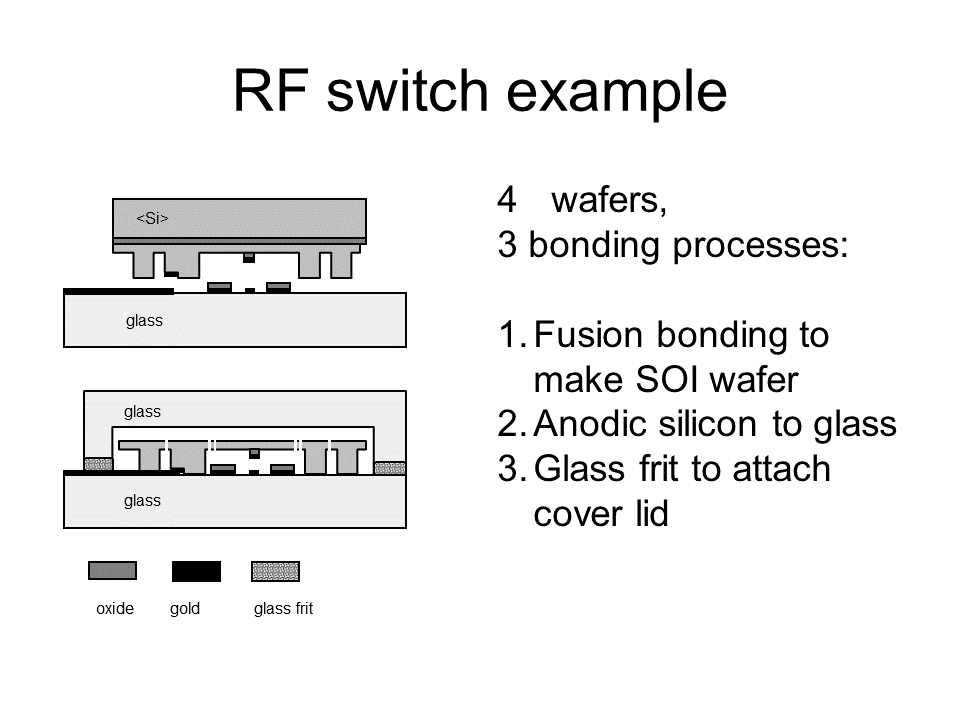
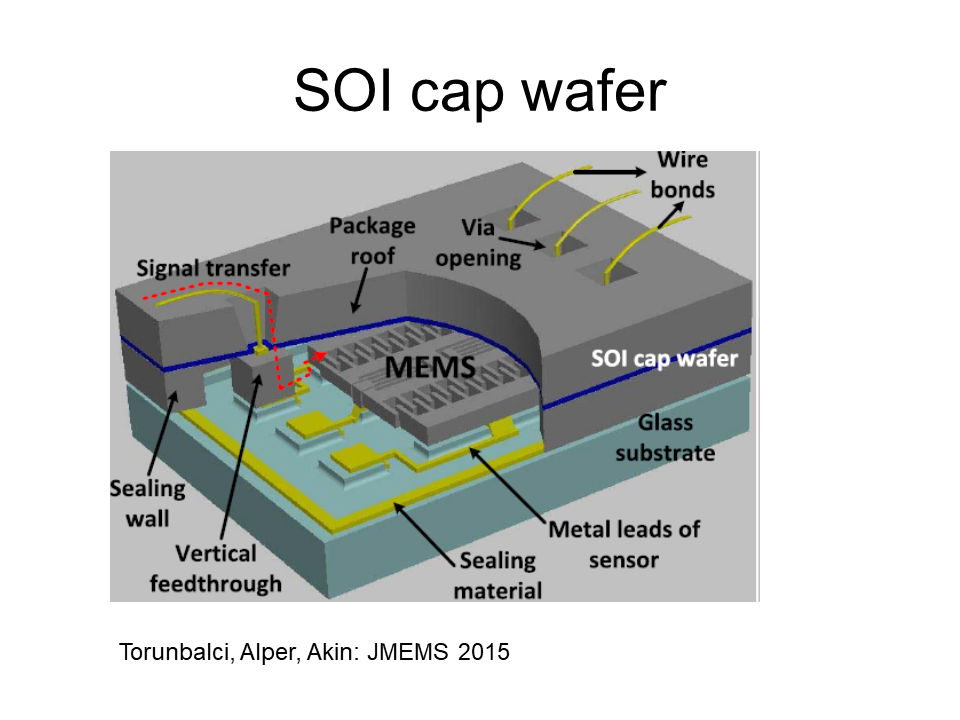
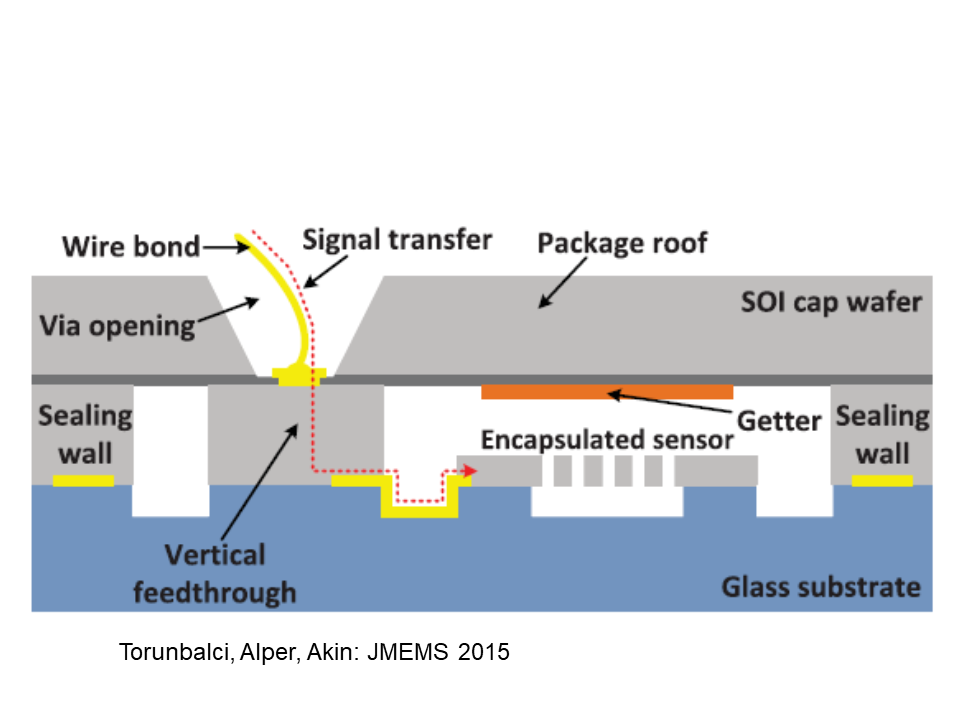
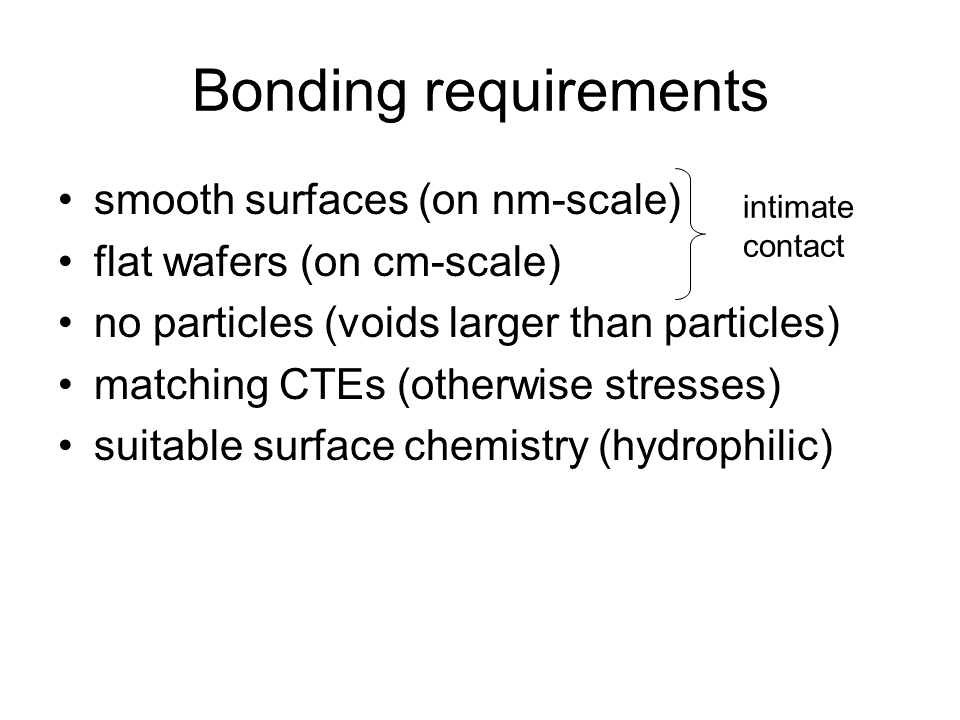

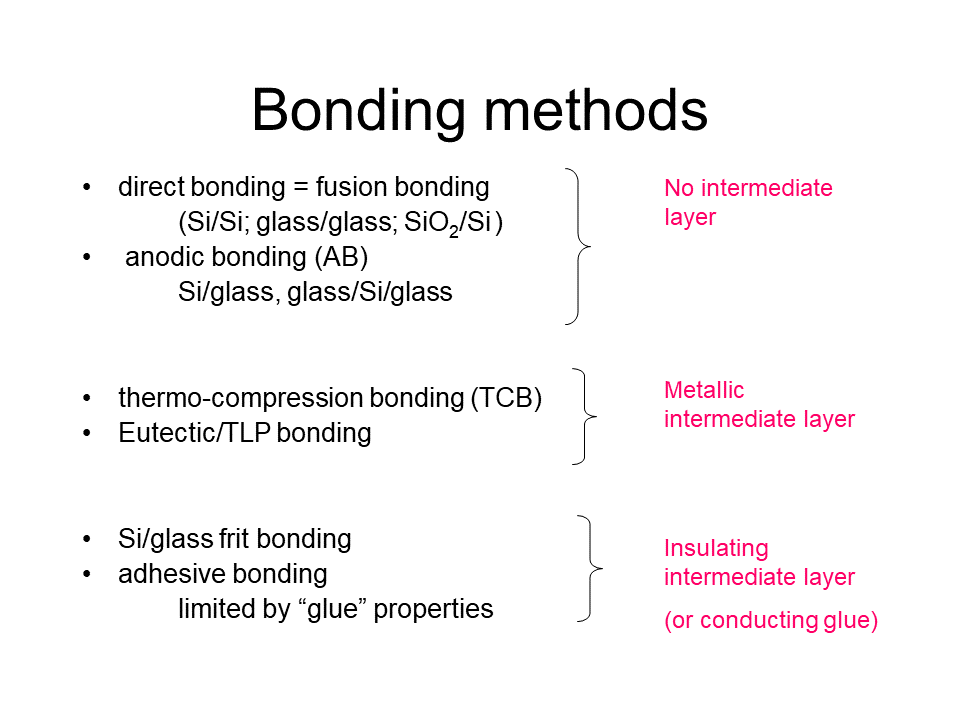





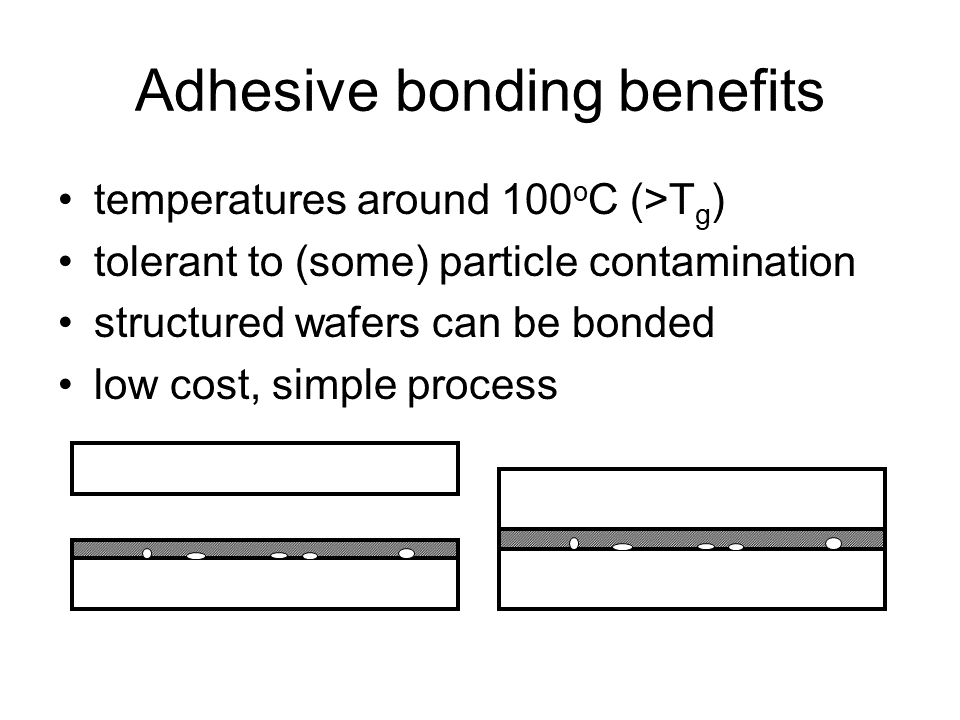



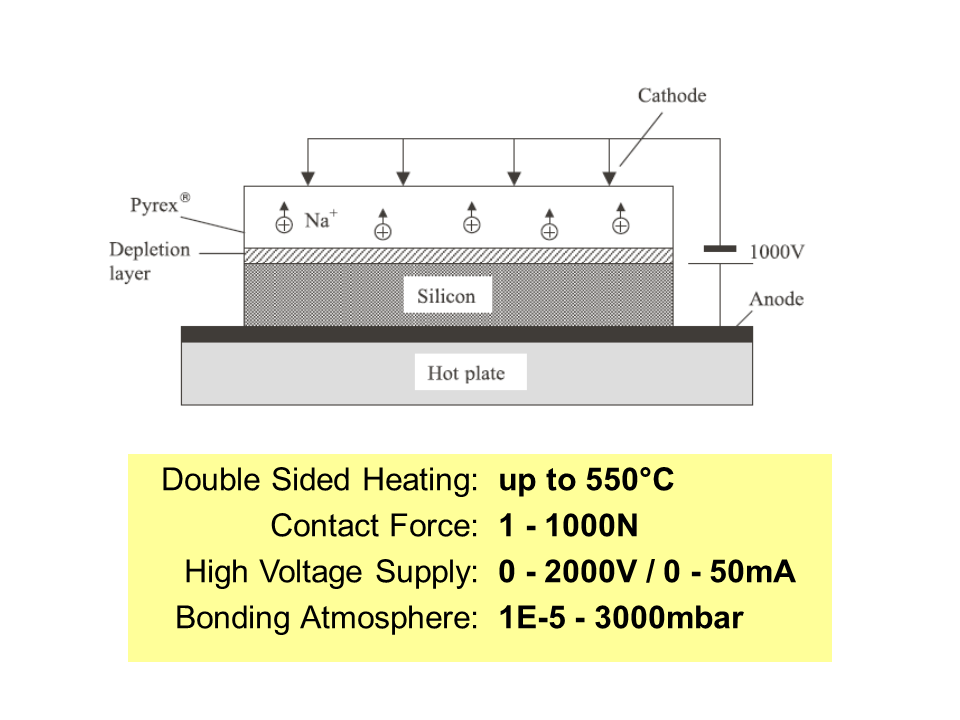








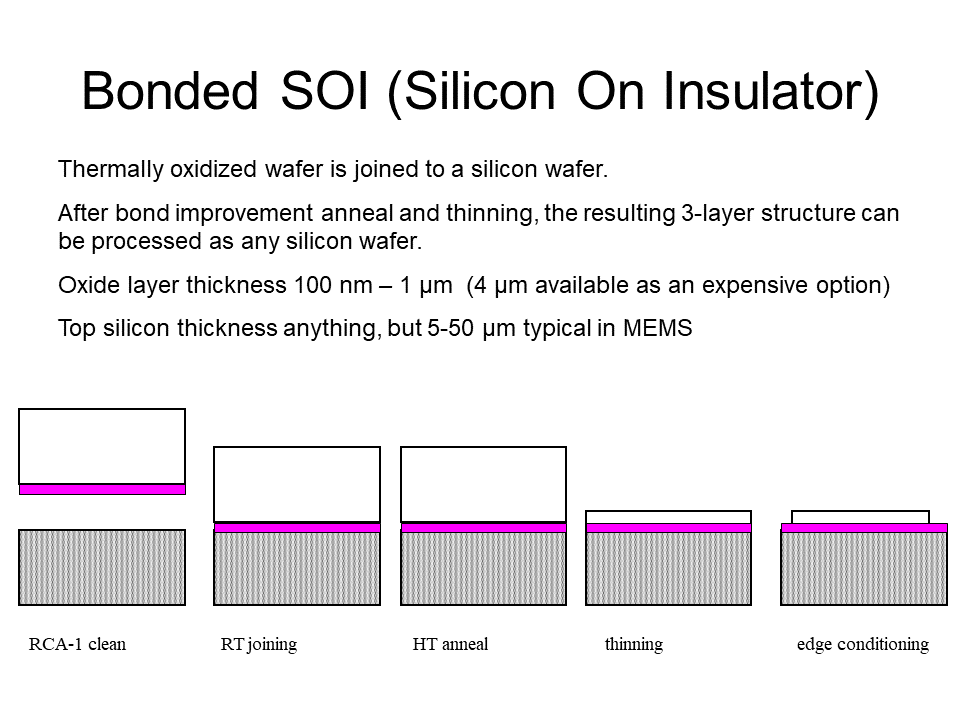
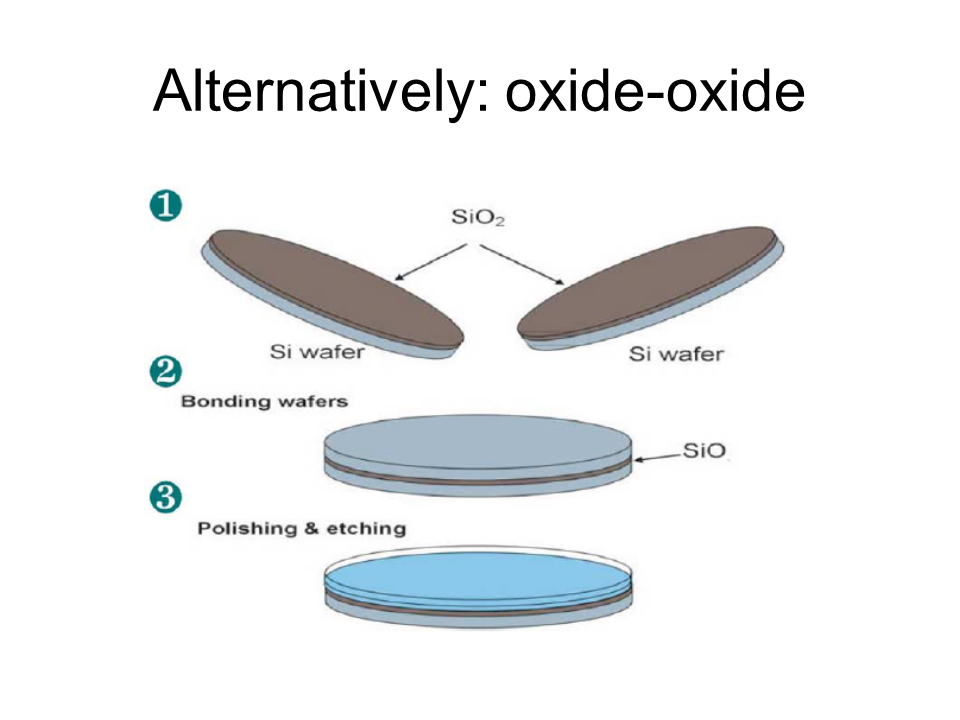



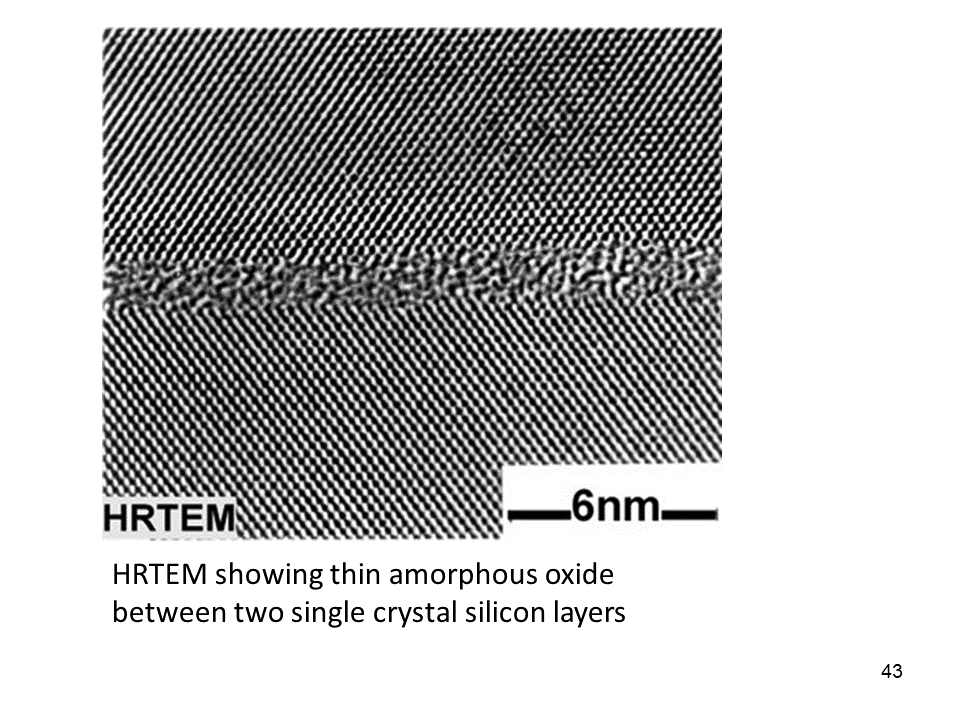



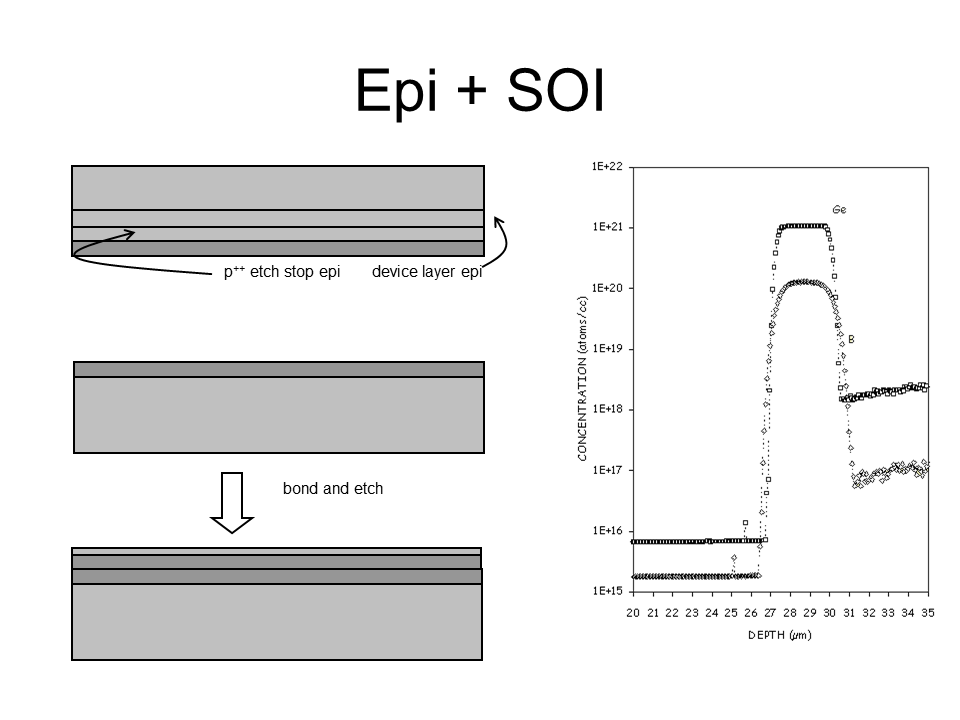
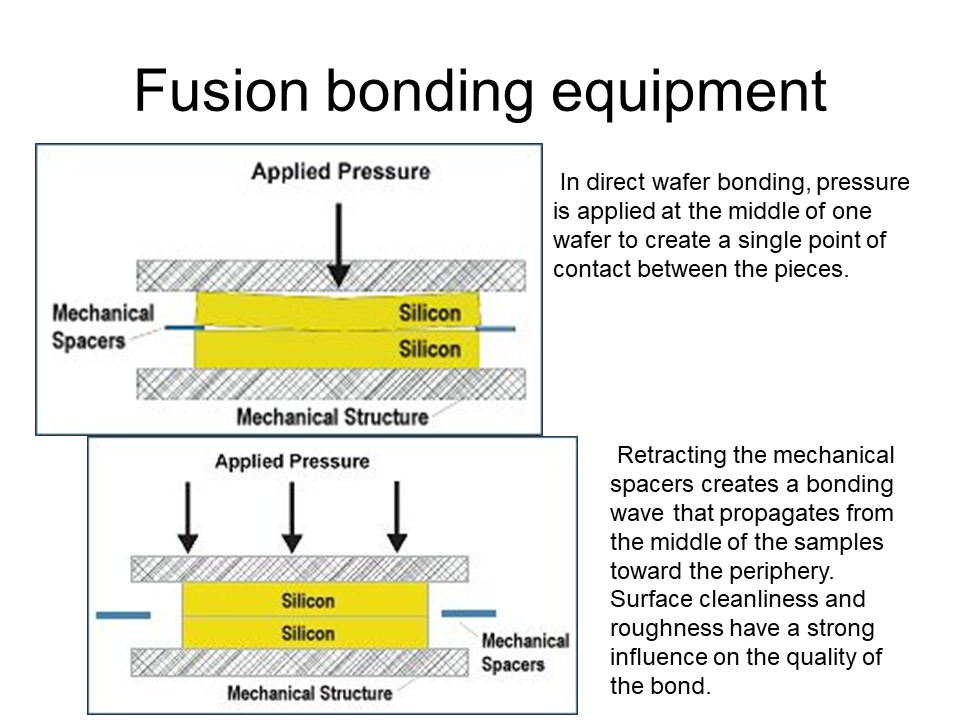







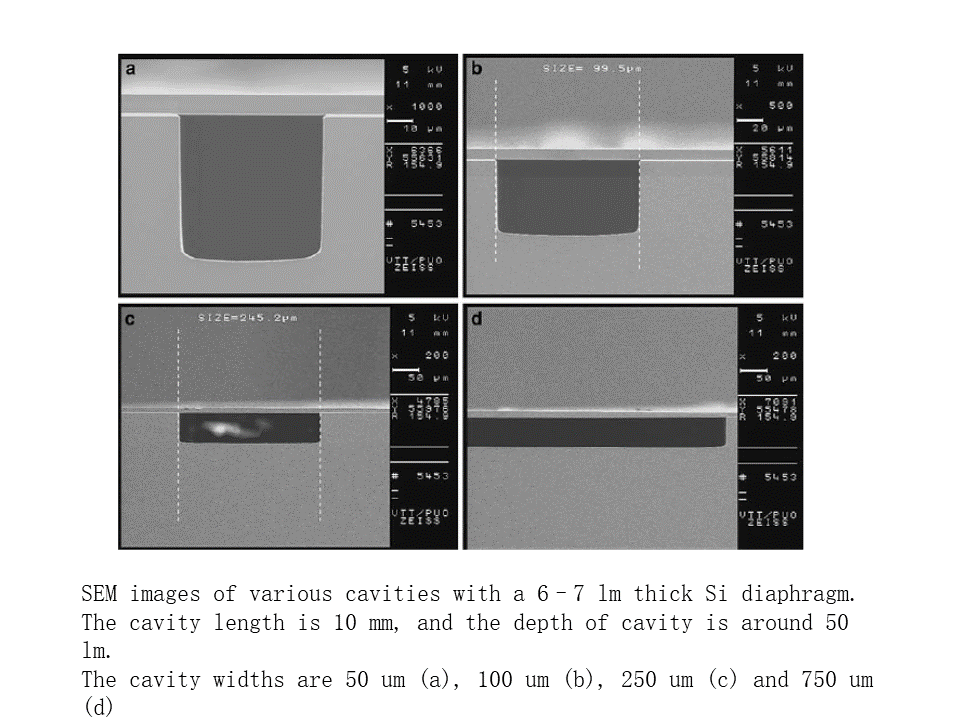
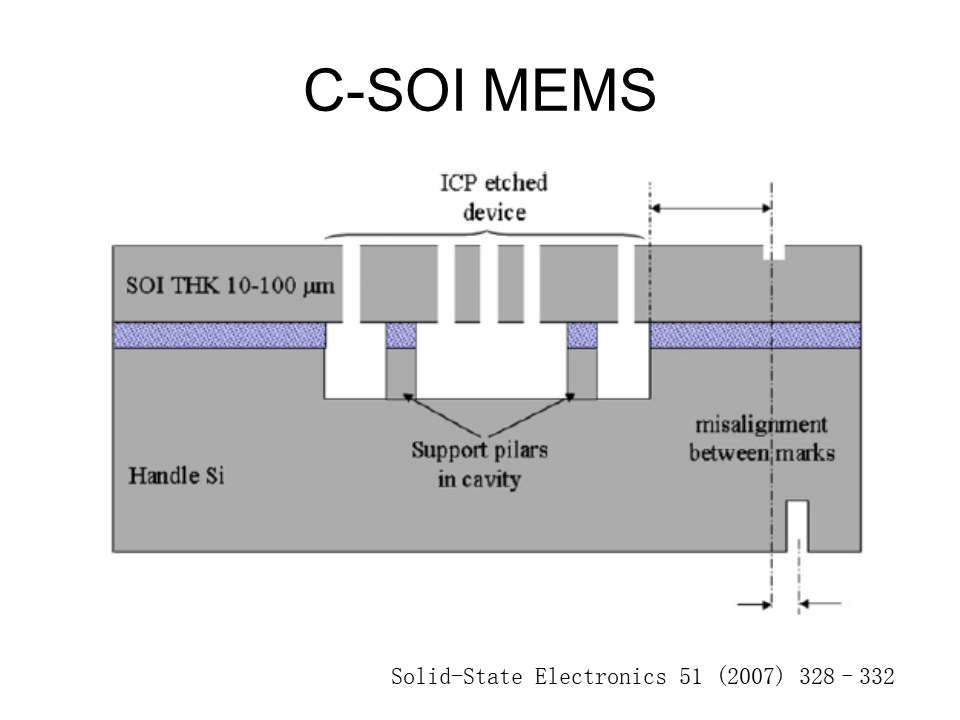

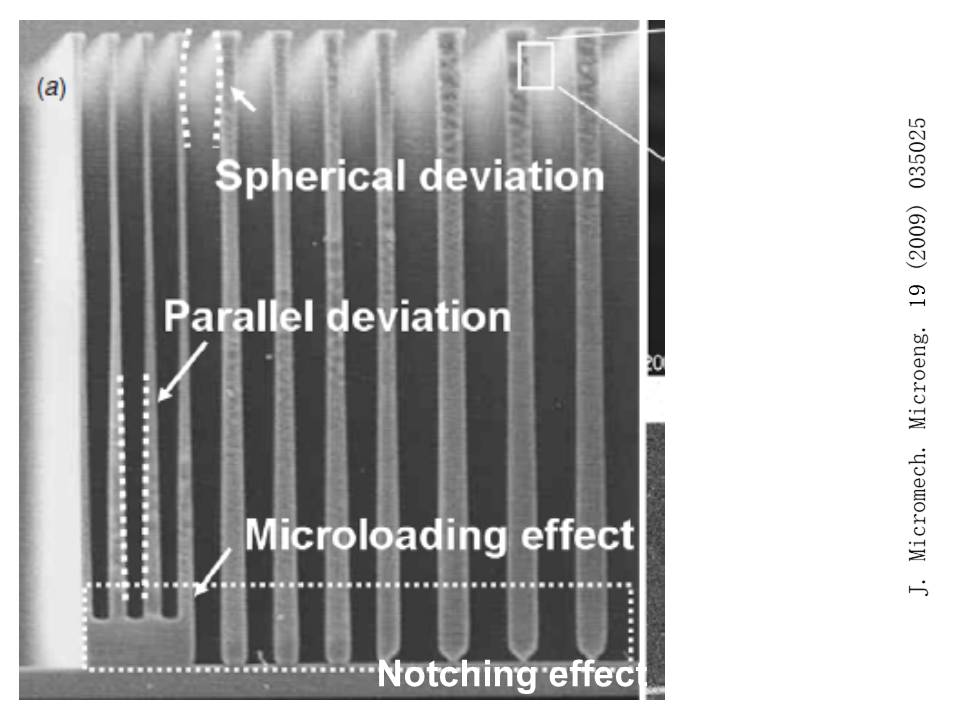

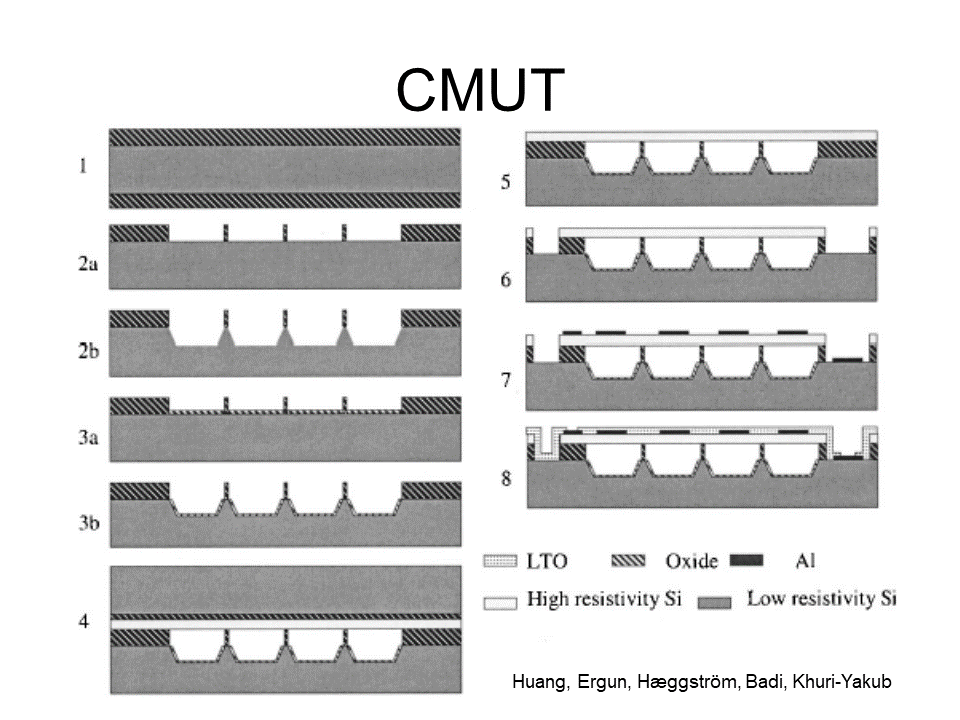
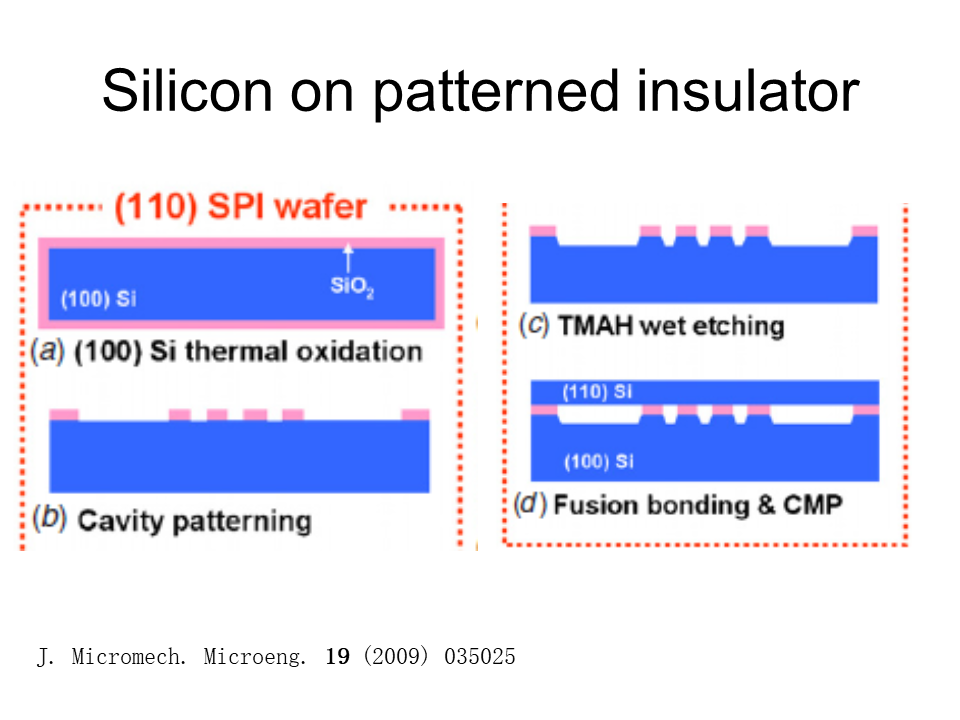
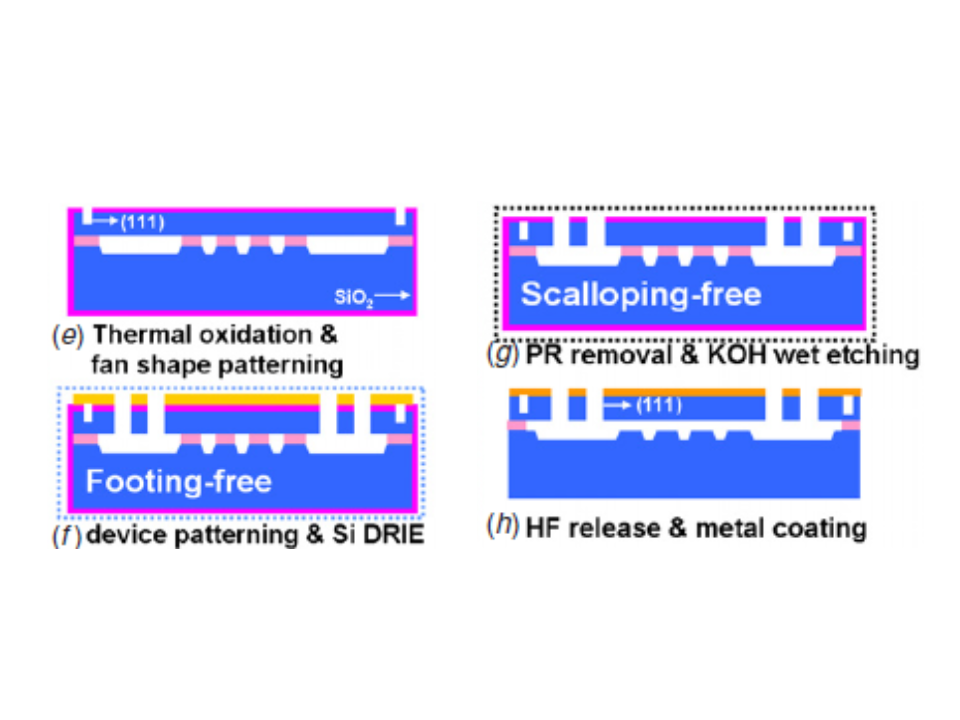
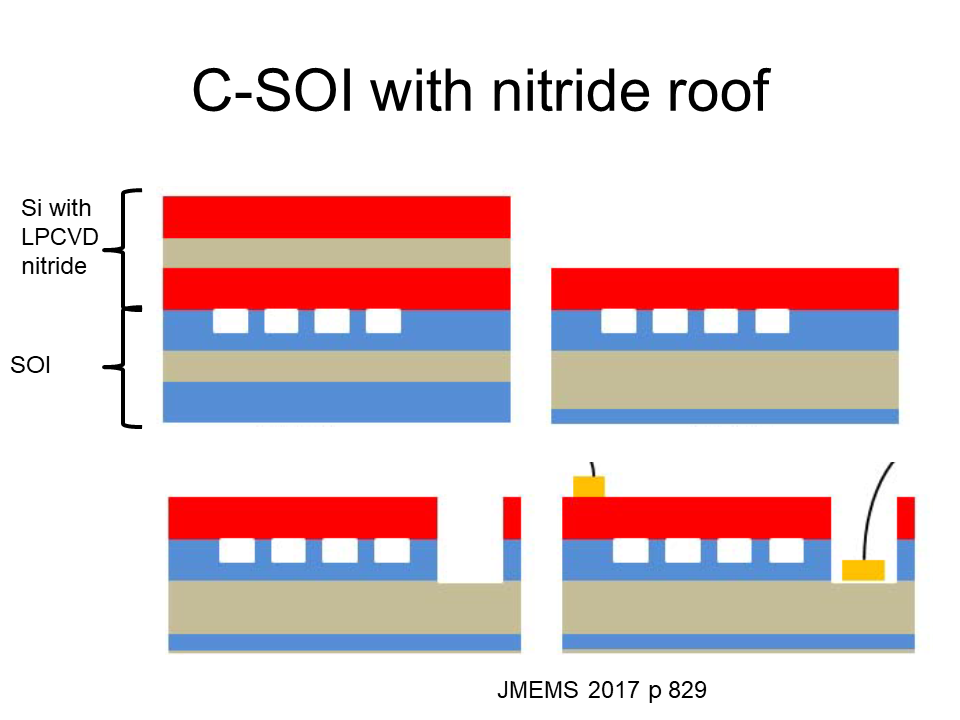




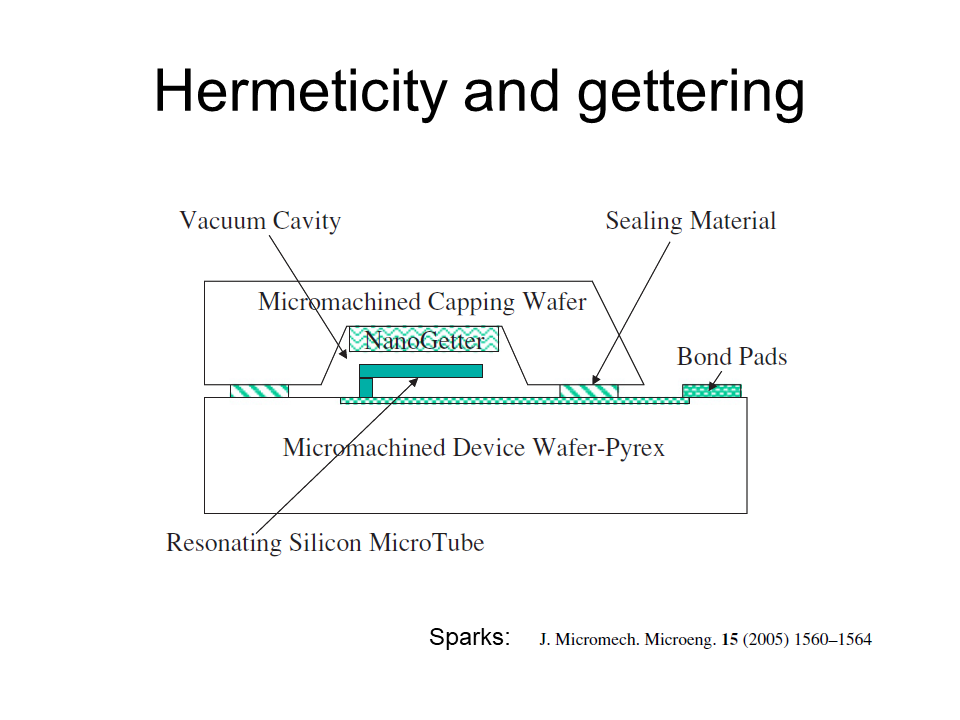
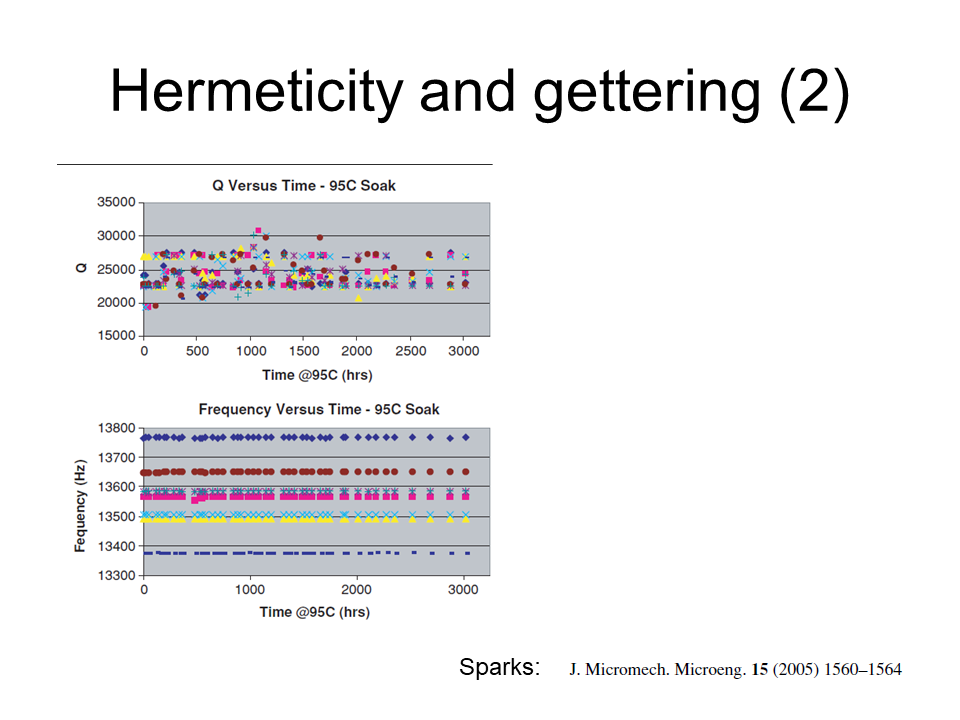






审核编辑:黄飞
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
晶圆
+关注
关注
53文章
5449浏览量
132749 -
谐振器
+关注
关注
4文章
1171浏览量
67569
原文标题:晶圆键合工艺技术详解
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
晶圆级CSP的装配工艺流程
晶圆级CSP的装配工艺流程
目前有两种典型的工艺流程,一种是考虑与其他元件的SMT配,首先是锡膏印刷,然后贴装CSP,回流焊接
发表于 11-20 15:44
•1664次阅读
晶圆级扇出型封装的三大核心工艺流程
塑封料(EMC) 扩展芯片面积,从而在芯片范围之外提供额外的I/O连接空间。根据工艺流程的差异,FOWLP主要分为三大类:芯片先装(Chip-First)面朝下、芯片先装面朝上以及RDL先制。本文将深入剖析这三种工艺的具体流程、




 晶圆键合工艺流程与关键技术探讨
晶圆键合工艺流程与关键技术探讨














评论