使用SEMulator3D®工艺步骤进行刻蚀终点探测
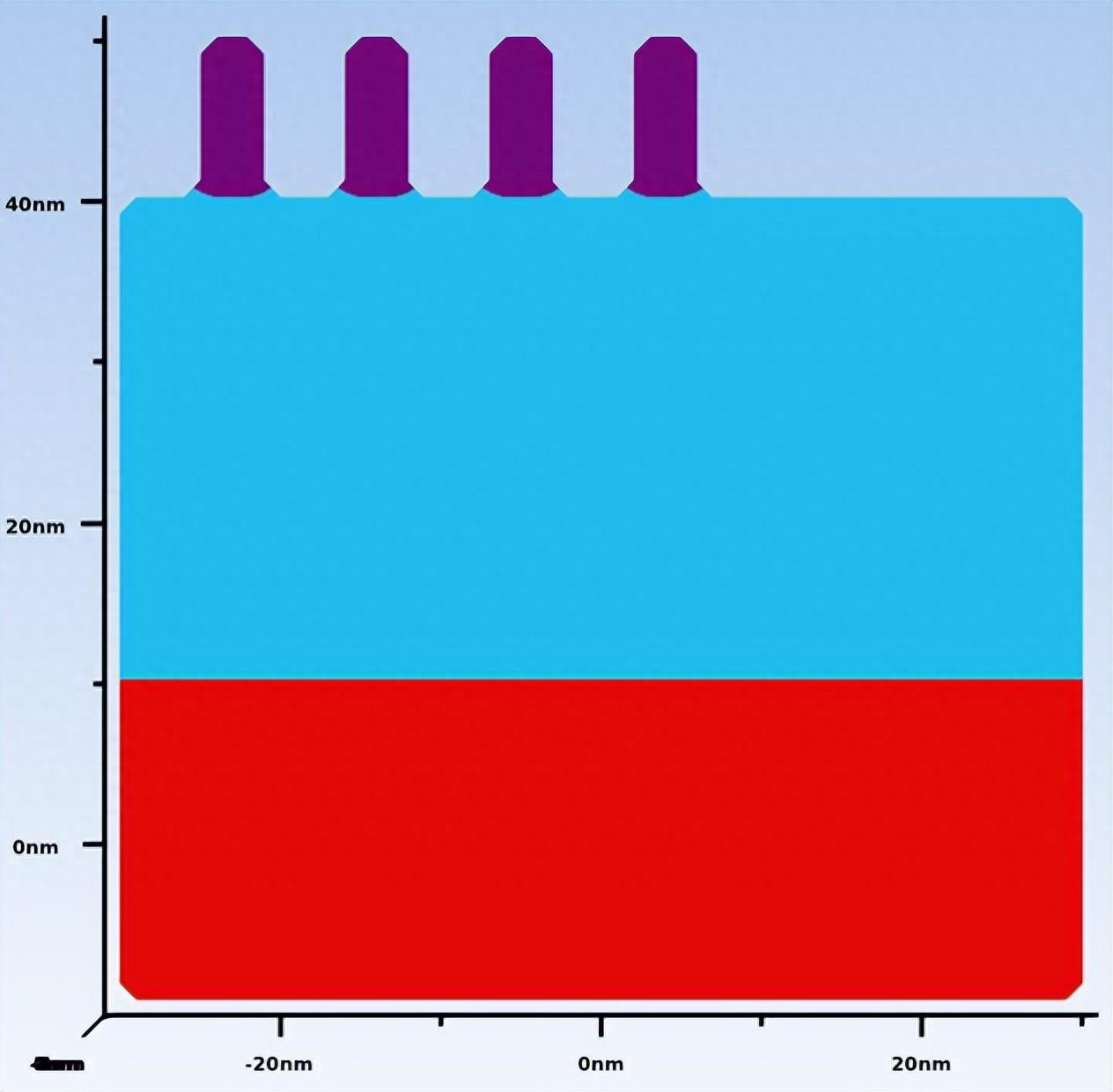
作者:泛林集团 Semiverse Solutions 部门软件应用工程师 Pradeep Nanja
介绍
半导体行业一直专注于使用先进的刻蚀设备和技术来实现图形的微缩与先进技术的开发。随着半导体器件尺寸缩减、工艺复杂程度提升,制造工艺中刻蚀工艺波动的影响将变得明显。刻蚀终点探测用于确定刻蚀工艺是否完成、且没有剩余材料可供刻蚀。这类终点探测有助于最大限度地减少刻蚀速率波动的影响。
刻蚀终点探测需要在刻蚀工艺中进行传感器和计量学测量。当出现特定的传感器测量结果或阈值时,可指示刻蚀设备停止刻蚀操作。如果已无材料可供刻蚀,底层材料(甚至整个器件或晶圆)就会遭受损坏,从而极大影响良率[1],因此可靠的终点探测在刻蚀工艺中十分重要。半导体行业需要可以在刻蚀工艺中为工艺监测和控制提供关键信息的测量设备。目前,为了提升良率,晶圆刻蚀工艺使用独立测量设备和原位(内置)传感器测量。相比独立测量,原位测量可对刻蚀相关工艺(如刻蚀终点探测)进行实时监测和控制。
使用 SEMulator3D®工艺步骤进行刻蚀终点探测
通过构建一系列包含虚拟刻蚀步骤、变量、流程和循环的“虚拟”工艺,可使用 SEMulator3D 模拟原位刻蚀终点探测。流程循环用于在固定时间内重复工艺步骤,加强工艺流程控制(如自动工艺控制)的灵活性[2]。为模拟控制流程,可使用 "For Loop" 或 "Until Loop"(就像计算机编程)设置一定数量的循环。在刻蚀终点探测中,可使用 "Until Loop",因为它满足“已无材料可供刻蚀”的条件。在循环中,用户可以在循环索引的帮助下确认完成的循环数量。此外,SEMulator3D 能进行“虚拟测量”,帮助追踪并实时更新刻蚀工艺循环中的材料厚度。通过结合虚拟测量薄膜厚度估测和流程循环索引,用户可以在每个循环后准确获取原位材料刻蚀深度的测量结果。
用 SEMulator3D 模拟刻蚀终点探测的示例
初始设定
在一个简单示例中,我们的布局图像显示处于密集区的四个鳍片和密集区右侧的隔离区(见图1)。我们想测量隔离区的材料完成刻蚀时密集区的刻蚀深度。我们将用于建模的区域用蓝框显示,其中有四个鳍片(红色显示)需要制造。此外,我们框出了黄色和绿色的测量区域,将在其中分别测量隔离区的薄膜厚度 (MEA_ISO_FT) 和沟槽区的刻蚀深度 (MEA_TRENCH_FT)。工艺流程的第一步是使用 20nm 厚的硅晶体层(红色)、30nm 的氧化物(浅蓝色)和 10nm 的光刻胶(紫色)进行晶圆设定(图2)。我们曝光鳍片图形,并对使用基本模型刻蚀对光刻胶进行刻蚀,使用特定等离子体角度分布的可视性刻蚀对氧化物材料进行刻蚀。氧化物对光刻胶的选择比是100比1。我们在 SEMulator3D 中使用可视性刻蚀模型来观察隔离区和有鳍片的密集区之间是否有厚度上的差异。
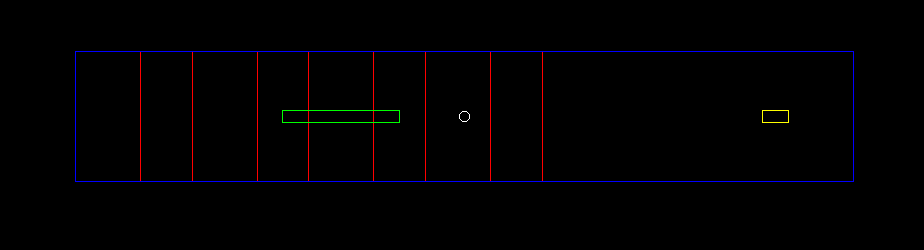
图1:模型边界区域(蓝色),其中包含四个鳍片(红色)和用于测量隔离区(黄色)和沟槽区(绿色)薄膜厚度的两个测量区域
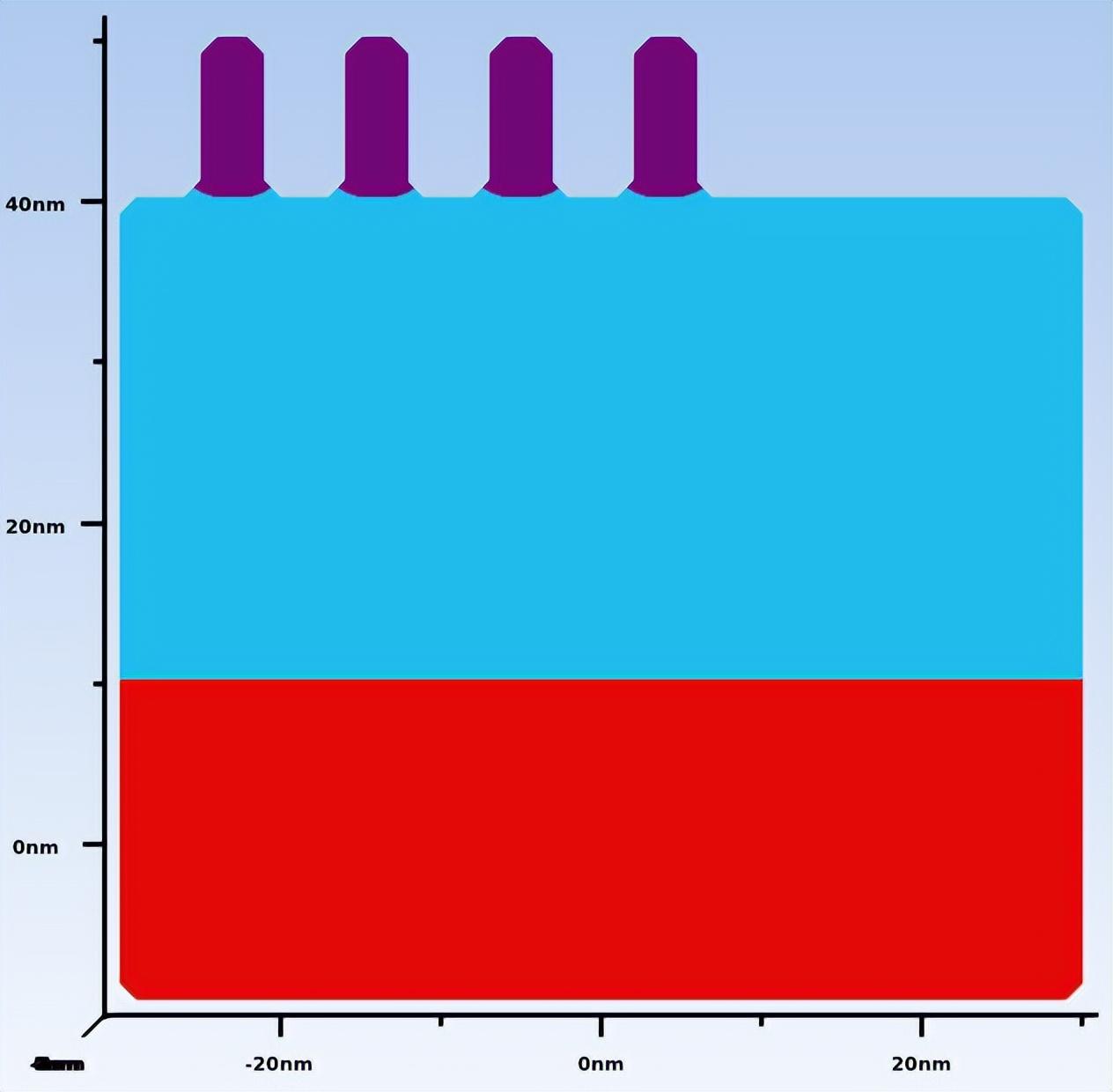
图2:SEMulator3D 模型,硅晶体(红色)、氧化物(浅蓝色)和在光刻胶中显影的四个鳍片(紫色)
SEMulator3D 刻蚀终点探测循环
SEMulator3D 的工艺流程使用 Until Loop 循环流程。我们将测量隔离区的材料厚度,并在隔离氧化物薄膜耗尽、即厚度为0时 (MEA_ISO_FT==0) 停止该工艺。在这个循环中,每个循环我们每隔 1nm 对氧化物材料进行1秒的刻蚀,并同时测量此时隔离区氧化物薄膜厚度。此外,我们将在每次循环后追踪两个鳍片间沟槽区的刻蚀深度。这个循环索引有助于追踪刻蚀循环的重复次数(图3)。

图3:SEMulator3D 刻蚀终点探测模拟中的循环流程
结果
对隔离薄膜进行刻蚀,直至其剩余 20nm、10nm 和 0nm 深度的模拟结果如图4所示。模型中计算出隔离薄膜厚度的测量结果,以及两个鳍片间沟槽区的刻蚀深度。

图4:隔离区薄膜厚度剩余 20nm、10nm 和 0nm 的工艺模拟流程,及相应从光刻胶底部开始的沟槽刻蚀深度
我们对循环模型进行近30次重复后,观察到隔离区的薄膜厚度已经达到0,并能追踪到沟槽区氧化物的刻蚀深度(当隔离区被完全刻蚀时,密集区 30nm 的氧化物已被刻蚀 28.4nm)。
结论
SEMulator3D 可用来创建刻蚀终点探测工艺的虚拟模型。这项技术可用来确定哪些材料在刻蚀工艺中被完全去除,也可测量刻蚀后剩下的材料(取决于刻蚀类型)。使用这一方法可成功模拟原位刻蚀深度控制。使用类似方法,也可以进行其他类型的自动工艺控制,例如深度反应离子刻蚀 (DRIE) 或高密度等离子体化学气相沉积 (HDP-CVD) 工艺控制。
参考资料:
[1] Derbyshire, Katherine. In Situ Metrology for Real-Time Process Control, Semiconductor Online, 10 July 1998, https://www.semiconductoronline.com/doc/in-situ-metrology-for-real-time-process-contr-0001.
[2] SEMulator3D V10 Documentation: Sequences, Loops, Variables, etc.
审核编辑 黄宇
-
探测
+关注
关注
0文章
222浏览量
21083 -
测量
+关注
关注
10文章
5724浏览量
116981 -
刻蚀
+关注
关注
2文章
223浏览量
13828
发布评论请先 登录
蓝牙信道探测(Bluetooth® Channel Sounding)
蓝宝石光纤珐珀腔压力传感测量系统在淄研制成功,可靠解决高温压力、温度动态原位测量

晶圆湿法刻蚀技术有哪些优点

白光干涉仪在晶圆湿法刻蚀工艺后的 3D 轮廓测量

湿法刻蚀的工艺指标有哪些
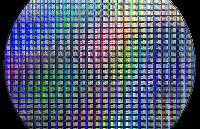
台阶仪测量膜厚的方法改进:通过提高膜厚测量准确性优化镀膜工艺

台阶仪表征MEMS压力传感器硅槽刻蚀:TMAH80℃下薄膜良率达到92.67%

湿法刻蚀的主要影响因素一览
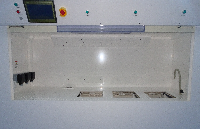
台阶仪在半导体制造中的应用 | 精准监测沟槽刻蚀工艺的台阶高度

MEMS制造中玻璃的刻蚀方法
金属低刻蚀的光刻胶剥离液及其应用及白光干涉仪在光刻图形的测量




 为刻蚀终点探测进行原位测量
为刻蚀终点探测进行原位测量






评论