3月15-16日,第19届中国半导体封装测试技术与市场年会于江苏成功召开。两天时间,各与会专家就芯片成品制造的创新与趋势、封装测试与设备、关键材料等当下热门问题,展开热烈讨论。
会上,中国半导体协会封装分会当值理事长郑力在《中国半导体测封产业现状与展望》演讲中提到:“半导体先进封装,或者说芯片产品制造,可能成为后摩尔时代的重要颠覆性技术之一,特别是后道成品制造在产业链中的地位愈发重要,有望成为集成电路产业新的制高点。” 而这也将深刻地改变集成电路产业链形态,并驱动芯片设计、晶圆制造、材料等产业链上下游共同发生革命性变化。材料作为半导体封装产业链中的关键一环,此次大会也特设《后尔摩时代的先进封装材料的创新与合作》专场研讨。会上,博威板带技术市场部高级经理——张敏带来了《高品质半导体引线框架铜合金》的主题演讲。
 博威合金主题演讲博威合金关注到“尽管引线框架作为一种经典的封装方式,但技术上保持着持续不断地进步”。而这也正如清华大学教授、中国半导体行业协会集成电路设计分会理事长魏少军所言“后摩尔时代的创新,将在封装技术的创新”。“小型化”发展趋势,对封装要求更小、更轻、更薄,反映到引线框架材料上,要求材料厚度减薄、精度提高。与此同时,蚀刻工艺也被越来越多的应用到引线框架的生产中,这对材料研发制造提出挑战。
博威合金主题演讲博威合金关注到“尽管引线框架作为一种经典的封装方式,但技术上保持着持续不断地进步”。而这也正如清华大学教授、中国半导体行业协会集成电路设计分会理事长魏少军所言“后摩尔时代的创新,将在封装技术的创新”。“小型化”发展趋势,对封装要求更小、更轻、更薄,反映到引线框架材料上,要求材料厚度减薄、精度提高。与此同时,蚀刻工艺也被越来越多的应用到引线框架的生产中,这对材料研发制造提出挑战。
基于以上背景,博威合金进一步阐述了引线框架材料的发展趋势。
1引线框架材料发展趋势
a.冲压材料引线框架的封装密度急剧增加,在同一个片上,集合了越来越多的引线框架单元,而这给材料带来的变化:
精细的pitch针加工
封装密封增加,键合区域面积增加,要求更高级的铜带表面质量
片宽增加,需要材料具有优异的侧弯,来保证高速冲压工艺
优异的电镀性能
引线框架在封装的时候,起到键合丝从芯片把信号引到框架上的作用。那键合丝的直径通常在20-50微米。如果铜带表面或框架表面有凹坑、凸起缺陷,将直接影响键合的牢固程度。
而在表面质量这块,博威合金也标准化了引线框架应用方面的表面质量等级,分为LFX、LFQ、PSQ这三种,对材料最大粗糙度、平均粗糙度、以及材料表面凹陷及凸起个数等,有一套严格的要求规范。b.蚀刻框架材料
片宽越来越宽,对铜带的宽度尺寸可达300-450毫米
随着封装宽度增大,密度增加,键合区域更多,就需要更高级的铜带表面质量(也就是LFX等级)
优异的电镀性能
蚀刻加工后有一个半蚀刻工艺,要求蚀刻加工后有优异的平面度

通常,铜带的制造会导致铜带表层跟内部的应力分布不均匀。所以,当我们做半蚀刻,内应力的不均匀会导致翘片。这一点,博威通过采用特殊工艺,使得材料有优异的平整度和分布均匀的内应力。
2引线框架材料性能
蚀刻工艺IC框架材料性能
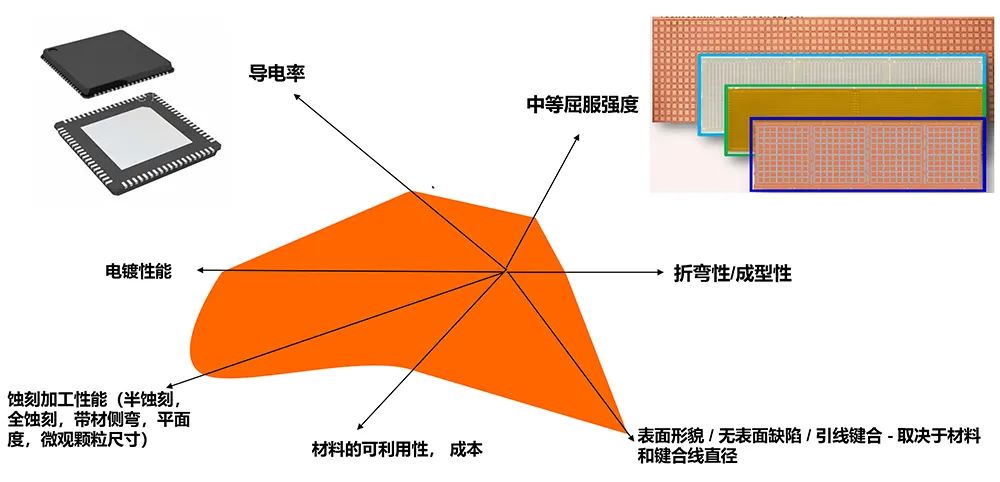
蚀刻加工性能,包括:半蚀刻、全蚀刻、带材侧弯、平面度、微观颗粒的尺寸等
电镀性能,易于电镀,电镀质量非常重要
表面形貌、表面缺陷
其他:导电率、中等屈服强度、折弯的成型性、材料的成本等
冲压工艺分立元器件框架材料性能

抗高温软化性能
合金热处理后,不可逆的伸长
电镀性能、塑料的粘附性
功率器件做异型材时,材料需满足易加工、高导电特性
表面形貌
3博威合金X引线框架材料选型
材料特征:高强度(片厚越来越薄)、抗高温软化、易于电镀、表面缺陷少、适用于蚀刻加工(内应力要小)
△冲压引线框架选材
boway 19400、boway 70250、boway 19210
△蚀刻引线框架选材boway 19400、boway 70250
△功率半导体、霍尔器件等分立元件选材boway 19210、boway 10100、boway 18070、boway 18090
-
半导体封装
+关注
关注
4文章
331浏览量
15280
发布评论请先 登录
AI时代算力瓶颈如何破?先进封装成半导体行业竞争新高地
韬定律:后摩尔时代走向“时间缩微”,光互联与SOA的新可能性
华为发表半导体“韬定律”
长电科技邀您相约SEMICON CHINA 2026
华宇电子亮相2026中国半导体先进封测大会

奥芯明:AI驱动半导体产业迎来“异构集成”新纪元,先进封装成破局关键

BW-4022A半导体分立器件综合测试平台---精准洞察,卓越测量
面向硅基产线:二维半导体接触电阻的性能优化

半导体欧姆接触工艺 | MoGe₂P₄实现超低接触电阻的TLM验证

先进封装转接板的典型结构和分类
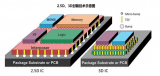
Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障




 后摩尔时代:半导体封装材料发展走向何方?
后摩尔时代:半导体封装材料发展走向何方?








评论