点击蓝字关注我们
SiC MOSFET 在功率半导体市场中正迅速普及,因为它最初的一些可靠性问题已得到解决,并且价位已达到非常有吸引力的水平。随着市场上的器件越来越多,必须了解 SiC MOSFET 与 IGBT 之间的共性和差异,以便用户充分利用每种器件。本系列文章将概述安森美 M 1 1200 V SiC MOSFET 的关键特性及驱动条件对它的影响,作为安森美提供的全方位宽禁带生态系统的一部分,还将提供NCP51705(用于 SiC MOSFET 的隔离栅极驱动器)的使用指南。本文为第一部分,将重点介绍安森美M 1 1200 V SiC MOSFET的静态特性。
原版文档获取点击文末的“赞”和“在看”,并发送截图和您的邮箱地址到后台,即可领取原版文档哦~
碳化硅 (SiC) 是用于制造分立功率半导体的宽禁带 (WBG) 半导体材料系列的一部分。如表 1 所示,传统硅 (Si) MOSFET 的带隙能量为 1.12 eV,而 SiC MOSFET 的带隙能量则为 3.26 eV。
SiC 和氮化镓 (GaN) 具有更宽的带隙能量,意味着将电子从价带移动到导带需要大约 3 倍的能量,从而使材料的表现更像绝缘体而不像导体。这使得 WBG 半导体能够承受更高的击穿电压,其击穿场稳健性是硅的 10 倍。对于给定的额定电压,较高的击穿场可以减小器件的厚度,从而转化为较低的导通电阻和较高的电流能力。SiC 和 GaN 都具有与硅相同数量级的迁移率参数,这使得两种材料都非常适合高频开关应用。SiC 的热导率是硅和 GaN 的三倍。对于给定的功耗,较高的热导率将转化为较低的温升。
特定所需击穿电压的 RDS(ON)是 MOSFET的一部分,它与迁移率乘以临界击穿场的立方成反比。即使 SiC 的迁移率低于硅,但其临界击穿场高 10 倍,导致给定击穿电压的 RDS(ON)要低得多。
商用 SiC MOSFET 的保证最高工作温度为 150℃< TJ< 200℃。相比之下,可以实现高达 600℃ 的 SiC 结温,但其主要受键合和封装技术的限制。这使得 SiC 成为适用于高压、高速、高电流、高温、开关电源应用的优质 WBG 半导体材料。
表 1:半导体材料属性
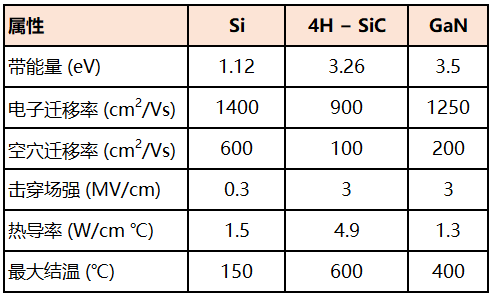
SiC MOSFET 通常在 650 V < BVDSS < 1.7 kV 范围内可用。尽管 SiC MOSFET 的动态开关行为与标准硅 MOSFET 非常相似,但必须考虑其器件特性决定的独特栅极驱动要求。
静态特性
 阻断电压能力
阻断电压能力安森美 M 1 1200 V SiC MOSFET 的额定电压为 1200 V,具有每个特定器件的数据表中规定的最大零栅极电压漏极电流 (IDSS)。然而,SiC MOSFET 的阻断电压能力会随着温度的升高而降低。以 1200 V 20 m SiC MOSFET 电源模块为例,与 25℃ 时的值相比,−40℃ 时阻断电压 (VDS) 的典型降额约为 11%。即使安森美的器件通常留有一些裕度,在设计期间,也应考虑 VDS 的降额,尤其是在器件将在极低温度下运行时。在图 1 中可以看到击穿电压与温度的典型分布。
重要提示:这些是典型的参考值,无法保证一定会实现,请参考数据表中的值或联系您当地的技术支持人员。


图 1:VDS 与温度的典型分布
 RDS(ON) 特性和驱动安森美 M 1 1200 V SiC MOSFET 的推荐 VGS
RDS(ON) 特性和驱动安森美 M 1 1200 V SiC MOSFET 的推荐 VGS与硅相关产品相比,SiC MOSFET 的主要区别之一是漏极-源极电压 (VDS) 与特定漏极电流 (ID) 的栅源电压 (VGS) 的相关性,并且在这个安森美 1200 V SiC MOSFET 中也不例外。图 2 显示传统的 Si MOSFET 在线性(欧姆)和有源区(饱和)之间显示出明显的过渡。另一方面,参见图 3,SiC MOSFET 并不会出现这种状况,实际上没有饱和区,这意味着 SiC MOSFET 的表现更像是可变电阻,而不是非理想型的电流源。

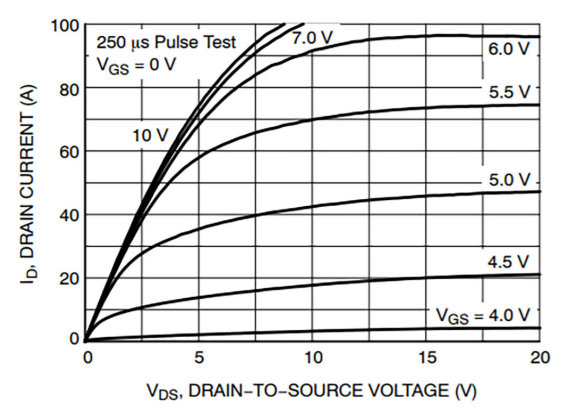
图 2:SJ MOSFET 的典型静态特性
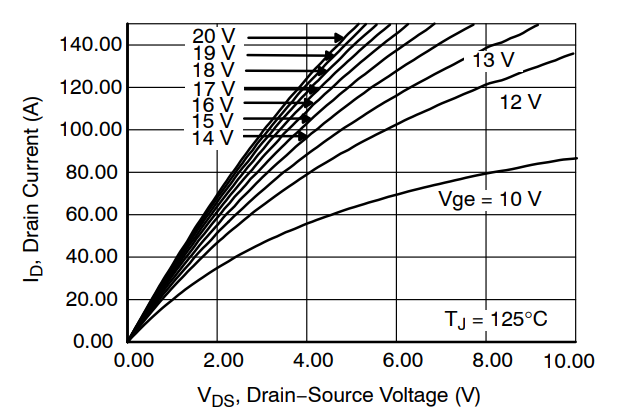
图 3:安森美 1200 V SiC MOSFET M 1 的典型静态特性
在选择适当的 VGS 时需要考虑的一个重要方面是,与硅基器件不同,当 VGS 增加时,即使在相对较高的电压下,SiC MOSFET 也仍会表现出 RDS(ON)的显著改善。这可以从图 3 中看出:当 VGS增加时,曲线向左移动。如果我们看一下图 2,当 VGS >> VTh 时,Si MOSFET 的 RDS(ON) 未表现出显著改善,因此,大多数 Si MOSFET 通常以 VGS≤ 10 V 驱动。因此,如果用 SiC 替换 Si MOSFET,建议修改驱动电压。尽管 10 V 高于 SiC MOSFET 的典型阈值电压,但在如此低的 VGS 下的传导损耗很可能会导致器件的热失控。这是建议使用 VGS ≥ 18 V 来驱动安森美 1200 V M 1 SiC MOSFET 的原因之一。
如果选择的电压过高,则会在栅极氧化物中引入更高的应力,这可能导致长期可靠性问题或关键特性变化,如 VTH 漂移。在资质认定阶段,安森美 M 1 1200 V SiC MOSFET 经过大量测试,以确定 + 25 V 的最大栅极电压。例如,在图 4 中,正栅极偏压应力测试的结果以绿色显示。与其他供应商相比,安森美 M 1 1200 V SiC MOSFET 在持续施加 + 25 V 电压时表现出良好的稳定性。


图 4:正栅极偏压应力测试。测试条件:VGS = 25 V,T = 175℃
即使采用最佳布局和最少电感封装,也无法避免管芯栅极处的瞬态电压尖峰。为了不超过 + 25 V 的势垒,建议最大向 MOSFET 施加 VGS ≤ 20 V 的恒定电压。
 RDS(ON),温度相关性
RDS(ON),温度相关性需要考虑的另一个因素是 SiC MOSFET 的温度系数。在低温下,SiC MOSFET 通常呈现负温度系数 (NTC),直到其达到某一温度并开始具有正温度系数 (PTC)。这个转折点受 VGS 影响。在较低的 VGS 下,NTC 会一直持续到较高的温度,而如果这个电压增加,则转折点将在较低的温度下发生。在图 5 中,可以看出安森美 M 1 SiC MOSFET 在不同 VGS 下 RDS(ON) 与温度的典型相关性。如果我们观察 VGS = 15 V 时的曲线,NTC 在负温度下非常陡峭,在大约 50℃ 时仍然明显,这导致高温下的 RDS(ON) 在所有情况下都低于负温度下的 RDS(ON)。如果两个组件并联切换,就像我们的许多电源模块一样,其中一个组件可能会过载,特别是当器件在负环境温度下启动时,可能会导致热失控。如果 VGS 增加,此现象将得到纠正。在 18 V 时,温度系数的转折点约为 25℃,在 100℃ 时,RDS(ON) 值已经高于 −40℃ 时的值,这使其成为并联切换器件的安全电压,即使在寒冷的环境中使用也是如此。

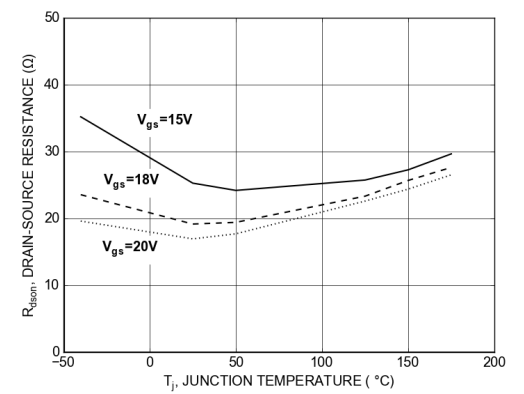
图 5:不同 VGS 下 RDS(ON) 的温度相关性
为了计算 SiC MOSFET 器件的静态损耗或为了比较不同的供应商,不仅要查看器件在 25℃ 时的 RDS(ON)(通常在出于营销目的而定义器件时使用),还要查看目标应用温度下的 RDS(ON)。如前一段所述,在某个转折点之后,SiC MOSFET 会具有 PTC。个中好处已经解释过了,但如果系数很高,25℃ 和应用中实际温度下的 RDS(ON)之间的差异会变得非常关键,导致在目标工作温度下的传导损耗显著增加。在选择 SiC MOSFET 时需要考虑这一点。
当温度升高时,安森美 M 1 1200 V SiC MOSFET 在 RDS(ON)方面表现出良好的稳定性。图 6 显示了在不同漏极电流 (ID) 下,20 m 器件在 25℃ 和 150℃ 时的差异。当 ID = 50 A 时,RDS(ON) 增加了 33%,这足以确保良好的并联工作,且不会导致静态损耗显著增加。

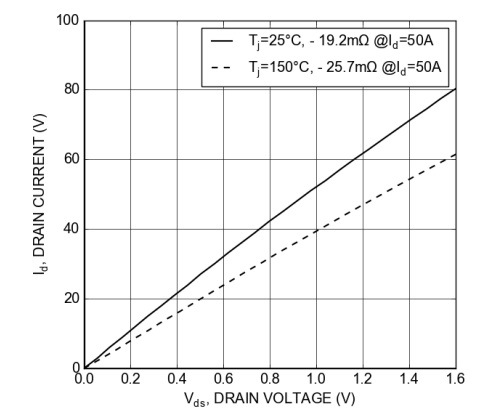
图 6:1200 V、20 mΩ SiC MOSFET 电源模块在不同温度下的 VDS 与 ID
 选择负栅极偏压
选择负栅极偏压到目前为止,已经讨论了用于定义正栅极偏压的不同参数。结论是,安森美 M 1 1200 V SiC MOSFET 的 VGS 在静态操作期间应设置为 + 18 V ≤ VGS ≤ 20 V,而在动态瞬态中不应超过 + 25 V。但如何定义负栅极偏压呢?当然,该值应足够低,以确保器件正确关闭,同时避免在那些容易产生直通电流的拓扑(如半桥)中出现寄生导通。
就 VTH 而言,目前市场上有两种类型的 SiC MOSFET,即典型值高于 3.5V 的高阈值电压 SiC MOSFET 和典型值低于 3V 至 3.5V 的低阈值电压 SiC MOSFET。安森美 M 1 1200 V SiC MOSFET 属于第二类,其典型 VTH 值在 2.75 V 的范围内(各个器件的具体值见数据表)。该值随温度变化,可能低至 1.8 V,也可能高达 4.3 V。
在可能产生直通电流的应用中,建议使用 − 5 V 的负栅极偏压,以留有足够的安全裕度,避免寄生导通,尤其是在较高的开关频率下。将负 VTH 设置为 − 5 V 还应给予足够的裕度,以避免瞬态栅极电压低于在 −15 V 设置的最小限值。
在直通电流风险不存在(即升压器拓扑)或借助现有技术而降低(即用寄生电感解耦半桥输出)的情况下,负栅极偏压可以增加到高达 0V 的任何安全值。这对器件的性能有其他影响,将在下一章进行讨论。
与正栅极偏压一样,具有非常低的负栅极偏压可能会触发 SiC 晶体的缺陷,导致可靠性问题或关键参数的修改,例如 VTH 或 RDS(ON) 漂移,这在谈论负栅极偏压和当前可用的 SiC 沟槽 MOSFET 时尤其关键。为了防止这些问题,安森美在设计中考虑了这一点,并对 M 1 1200 V SiC MOSFET 进行了大量的静态和动态测试,以确认没有漂移。图 7 显示了静态负栅极偏压的结果及其在 VTH 方面的影响。此外,我们的生产线还进行了老化测试,以限制过早发生故障的情况。


图 7:负栅极偏压应力测试。测试条件:VGS = -20 V,T = 175 ℃
 体二极管正向电压 (Vf) vs. VGS
体二极管正向电压 (Vf) vs. VGS众所周知,与其他类型的二极管相比,SiC MOSFET 的体二极管具有较高的正向电压。在使用 SiC MOSFET 时应考虑这一特性,通常,不建议在许多拓扑的死区时间之外使用,以避免高损耗。减少体二极管使用的一种有效方式是在需要反向导通时激活 MOSFET 的沟道。这样做可以显著减少损耗。
但是,对于在激活沟道之前需要死区时间的拓扑,即同步整流中的典型半桥,无法有效地停用体二极管,因为需要更多器件和/或修改电流路径。此外,即使采取许多预防措施,也可能无法完全避免在死区时间使用体二极管。安森美 M 1 1200 V SiC MOSFET 可以使用体二极管,且不会导致可靠性下降或 MOSFET 主要参数出现重大漂移。
考虑到这一点,必须要知道 VGS 将对体二极管的静态性能产生影响。图 8 显示了当应用不同的 VGS 时,安森美 M 1 1200 V SiC MOSFET 的体二极管与正向电流 (If) 的 Vf相关性。如图所示,当负栅极偏压减小时,Vf 略微增加。此图具有一些误导性,因为它可能会让用户得出将 VGS 设置为 0 V 是最佳解决方案的结论。然而,这个 Vf 较低的原因是 MOSFET 的沟道处于微导通状态,所以外部看起来 Vf较低的实际上是从体二极管接收部分电流的沟道。当二极管停止导通时,沟道仍将保持微导通。根据开关拓扑,这可能会对总损耗产生负面影响,并增加泄漏。此外,在 0 V 时,开关损耗将急剧增加,具体稍后会进行解释。这种现象在 SiC 技术中很常见,可以通过将 VGS 降低到 −5 V 来避免。

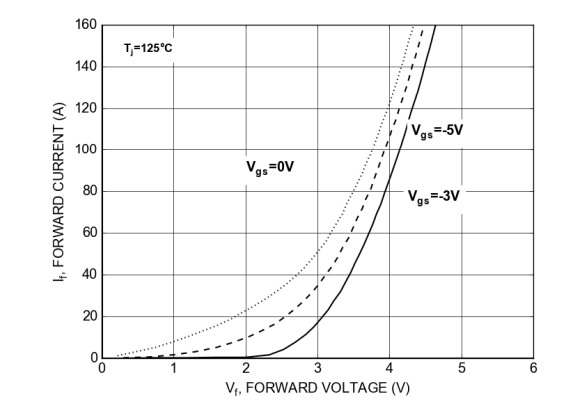
图 8:20 mΩ、1200 V SiC MOSFET 模块中不同 VGS 的 Vf 与 If
 VTH,温度相关性
VTH,温度相关性在前几章中,已经介绍了当施加正或负栅极偏压时的 VTH 漂移。影响 VTH 的另一个因素是温度。与所有 MOSFET 一样,安森美 M 1 1200 V SiC MOSFET 具有负温度系数。结果是,VTH 可以从 25℃ 时的约 2.6 V 典型值降低到 175℃ 时的 1.8 V。图 9 显示了 40 mΩ 器件在不同温度下的典型 VTH 值。在设计栅极驱动器电路时必须考虑这一点,以避免不必要的寄生导通。再次重申,应在实际应用温度下考虑此数据。例如,与 125℃ 时相比,室温下栅极处的 2 V 电压尖峰触发寄生导通的可能性更低。

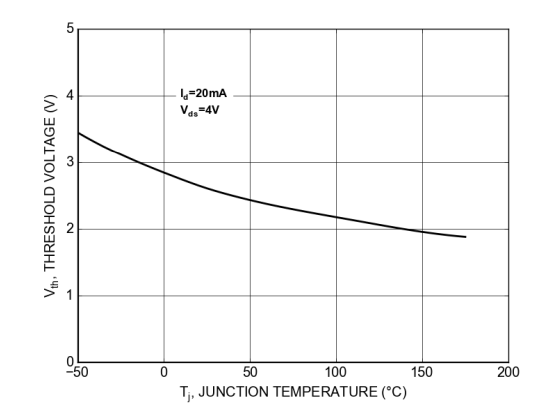
图 9:40 mΩ、1200 V SiC MOSFET 中的典型 VTH 值与温度
为了在对寄生导通敏感的拓扑(如半桥)中保持安全裕度。建议在器件关闭时设置负 VGS。
原版文档获取点击文末的“赞”和“在看”,并发送截图和您的邮箱地址到后台,即可领取原版文档哦~


原文标题:安森美 M 1 1200 V SiC MOSFET 静态特性分析
文章出处:【微信公众号:安森美】欢迎添加关注!文章转载请注明出处。
-
安森美
+关注
关注
33文章
2172浏览量
95845
原文标题:安森美 M 1 1200 V SiC MOSFET 静态特性分析
文章出处:【微信号:onsemi-china,微信公众号:安森美】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
安森美 NXH003P120M3F2PTHG SiC 模块深度解析
安森美SiC模块NXH030F120M3F1PTG:技术特性与应用解析
安森美EliteSiC功率MOSFET模块NXVF6532M3TG01:技术剖析与应用洞察
安森美FQP17P06 P沟道MOSFET:特性、参数与应用分析
安森美NTMFS5C677NL N沟道MOSFET的特性与应用分析
安森美NTMFS6H864NL单通道N沟道功率MOSFET的特性与应用分析
安森美NVMFD6H840NL双N沟道MOSFET的特性与应用分析
安森美100V N沟道MOSFET:NVMFS016N10MCL的特性与应用解析
安森美NVTFS5124PL P沟道MOSFET的特性与应用分析
安森美1200V碳化硅MOSFET:NTH4L013N120M3S的特性与应用分析

安森美NTH4L028N170M1碳化硅MOSFET深度解析

安森美SiC MOSFET NVBG025N065SC1:汽车电子应用的理想之选

安森美SiC MOSFET:NVBG070N120M3S解析与应用

安森美SiC Combo JFET的静态特性和动态特性




 安森美 M 1 1200 V SiC MOSFET 静态特性分析
安森美 M 1 1200 V SiC MOSFET 静态特性分析




评论