蓝宝石材料经过长晶、掏棒、切割、研磨、抛光等加工工艺后达到所需的表面效果,抛光是蓝宝石加工的最后一道工序,决定着抛光后的表面效果。目前化学机械抛光Chemical Mechanical Polishing (CMP)是主要的抛光方式之一。

蓝宝石在化学机械抛光过程中所用的抛光垫表面非常粗糙,抛光垫粗糙度的数量级远远大于抛光液颗粒的粒径,致使一部分抛光液颗粒随着抛光液的流动而无法参加抛光。
当蓝宝石基片与抛光垫表面接触时,只有抛光垫表面凸出部分才能与蓝宝石基片接触,而较凹的部分无法与蓝宝石基片接触,所以实际接触面并不像我们看到的接触面那样大。附着在抛光垫表面的凸峰上且抛光液粒径大于平均值的颗粒才能参加抛光,称之为有效磨粒。假设,磨粒在抛光垫与蓝宝石基片接触区域的分布与在抛光液中的分布相同,且为均匀分布。抛光垫表面粗糙峰高度的分布服从正态分布,那么实际接触面积与有效颗粒数均与抛光压力、转速成正比,所以蓝宝石去除速率与压力、转速成正比。

蓝宝石抛光液的PH值呈碱性,一般为10~13,在此碱性环境中会发生如下化学反应:
Al2O3+2OH-=2AlO2-+H2O
Al(OH)3+OH-=AlO2-+2H2O
CMP过程主要是抛光液化学腐蚀à抛光液磨粒磨削去除à去除物被抛光液带走,这三步在抛光过程中是同时发生的,缺一不可。即抛光液与蓝宝石基片发生化学反应生成一层反应层,抛光液中的磨粒与反应层发生磨削去除作用,同时新的抛光液流入,旧的抛光液以及磨削废屑被带走。由此可见化学腐蚀对蓝宝石材料的去除率影响很大,只有被腐蚀的蓝宝石表面才能被去除,磨粒在未腐蚀的表面很难产生去除作用。
在化学腐蚀点处的浓度越高,腐蚀速率越快。在抛光过程中抛光液持续流动,我们假设在腐蚀点处的浓度可以保持初始时的浓度,腐蚀率以最快的速度发生,则抛光液不同的PH值对应一个腐蚀率,由此可见,去除速率与PH值有关,PH越高,速率越快。
当腐蚀率>机械去除率时,蓝宝石表面材料被抛光液腐蚀,质地变软,较易去除;但当腐蚀率<机械去除率时,部分磨粒会在未被腐蚀或不完全腐蚀的蓝宝石表面上磨擦,其去除量将明显降低。当腐蚀率=机械去除率时,以这一点对应的去除参数进行加工可以得到良好的蓝宝石表面效果。
审核编辑 :李倩
-
机械
+关注
关注
8文章
1768浏览量
43950 -
抛光
+关注
关注
0文章
63浏览量
12180
发布评论请先 登录
新型铜互连方法—电化学机械抛光技术研究进展
化学机械抛光CMP技术的发展应用及存在问题
化学机械抛光(CMP)技术的发展、应用及存在问题
刷洗清洗过程中的颗粒去除机理—江苏华林科纳半导体
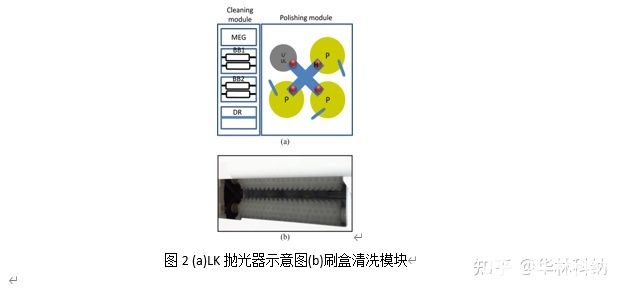
多晶硅薄膜后化学机械抛光的新型清洗解决方案

CMP后化学机械抛光清洗中的纳米颗粒去除报告
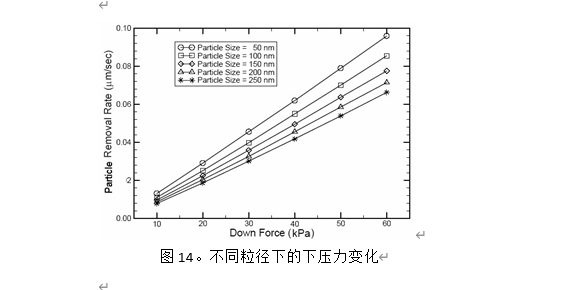
采用化学机械抛光(CMP)工艺去除机理
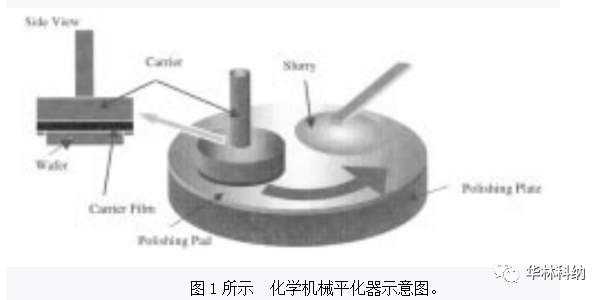
芯秦微获A+轮融资,用于化学机械抛光液产线建设
半导体国产替代材料 | CMP化学机械抛光(Chemical Mechanical Planarization)




 蓝宝石在化学机械抛光过程中的材料去除机理
蓝宝石在化学机械抛光过程中的材料去除机理

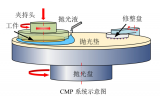


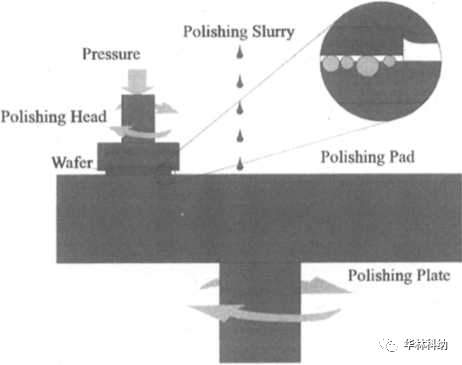
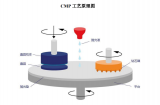



评论