以系统应用为出发点,各种技术进行异质整合的先进封装技术持续演进。先进封装也称为高密度先进封装HDAP(High Density Advanced Package)。 采用了先进的设计思路和先进的集成工艺、缩短引线互连长度,对芯片进行系统级封装的重构,并且能有效提高系统功能密度的封装。现阶段的先进封装是指:倒装焊(FlipChip)、晶圆级封装(WLP)、2.5D封装(Interposer、RDL)、3D封装(TSV) 与传统封装相比,先进封装的应用范围不断扩大,根据Yole数据,预计到 2026 年将占到整个封装市场的 50% 以上。半导体先进封装市场简析(2022)”报告从半导体先进封装发展背景、半导体先进封装定义、半导体先进封装市场结构及规模、半导体先进封装产业链图谱、半导体先进封装产业竞争格局进行分析。







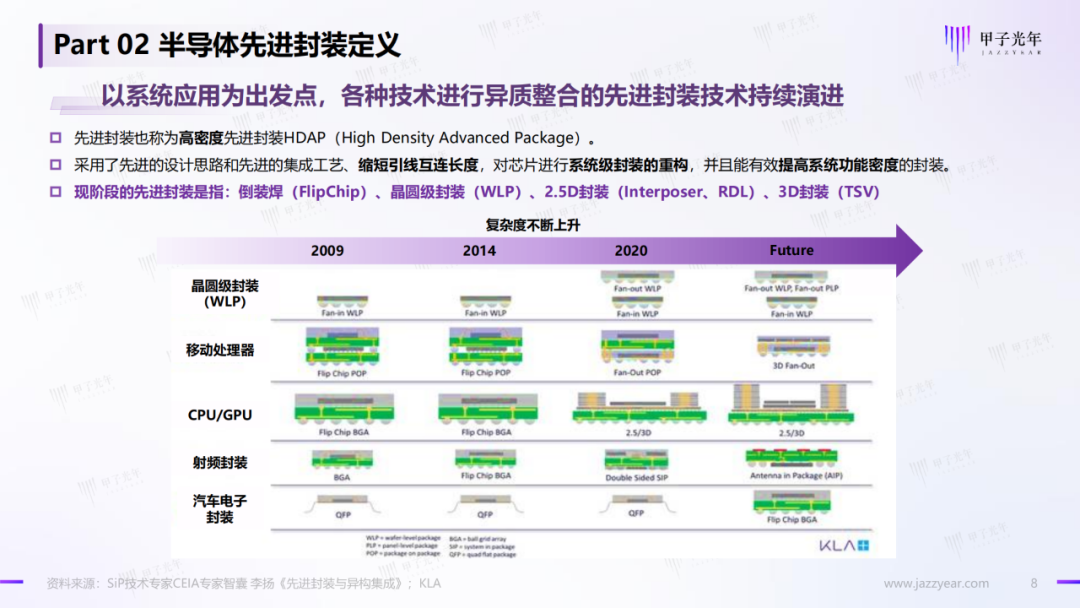





审核编辑 :李倩
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31480浏览量
267640 -
封装
+关注
关注
128文章
9380浏览量
149214 -
先进封装
+关注
关注
2文章
571浏览量
1075
原文标题:半导体先进封装市场简析(2022)
文章出处:【微信号:AI_Architect,微信公众号:智能计算芯世界】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
AI时代算力瓶颈如何破?先进封装成半导体行业竞争新高地
电子发烧友网报道(文/李弯弯)在半导体行业,先进封装(Advanced Packaging)已然占据至关重要的地位。它不再局限于芯片制造的“后道工序”范畴,而是成为提升芯片性能、在后摩尔定律时代突破


半导体先进封装之“2.5D/3D封装技术”的详解;
如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习! 讲到半导体封装,相信大家现阶段听到最多的就是“先进封装”了。 其实

携手伏达半导体:RedPKG解决方案助力封装自主,加速产品创新
伴随摩尔定律逐步放缓,后摩尔时代正式来临,半导体产业的技术创新重心向封装领域持续倾斜。因此,在追求高效与自主的半导体产业浪潮中,封装已成为连接芯片设计与终端

3D-Micromac CEO展望2026半导体:AI 为核,激光微加工赋能先进封装
2025 年半导体市场在 AI 需求爆发与全产业链复苏的双重推动下,呈现出强劲的增长态势。以 EDA/IP 先进方法学、先进工艺、算力芯片、端侧 AI、精准控制、高端模拟、高速互联、新
发表于 12-24 10:00
•5161次阅读


奥芯明:AI驱动半导体产业迎来“异构集成”新纪元,先进封装成破局关键
在10月29日至30日于深圳举办的第四届SEMI大湾区产业峰会上ASMPT集团半导体事业部副总裁,奥芯明半导体设备技术有限公司首席商务官、先进封装研发中心负责人薛晗宸先生在开幕式上发表

BW-4022A半导体分立器件综合测试平台---精准洞察,卓越测量
可靠性保驾护航!
一、严谨细微,铸就精准测试之魂
BW-4022A半导体分立器件综合测试平台采用先进的高精度传感器和精密的测量算法,如同拥有一双“火眼金睛”,能够对 Si/SiC/GaN 等各类材料
发表于 10-10 10:35
自主创新赋能半导体封装产业——江苏拓能半导体科技有限公司与 “半导体封装结构设计软件” 的突破之路
当前,全球半导体产业正处于深度调整与技术革新的关键时期,我国半导体产业在政策支持与市场需求的双重驱动下,加速向自主可控方向迈进。作为半导体产业链后道核心环节的


半导体先进封测年度大会:长电科技解读AI时代封装趋势,江苏拓能半导体科技有限公司技术成果受关注
2025年7月,半导体先进封测年度大会如期举行,汇聚了行业内众多企业与专家,共同聚焦先进封装技术在AI时代的发展方向。其中,长电科技总监萧永宽的主题演讲,分别从



 半导体先进封装市场简析(2022)
半导体先进封装市场简析(2022)







评论