双镶嵌 (Dual-Damascene)和多层金属互连接 (Multi-Interconnection)通孔-1(V1)和金属-2 (M2)互连的形成是通过双镶嵌 (Dual -Damascene)工艺实现的,如图所示。
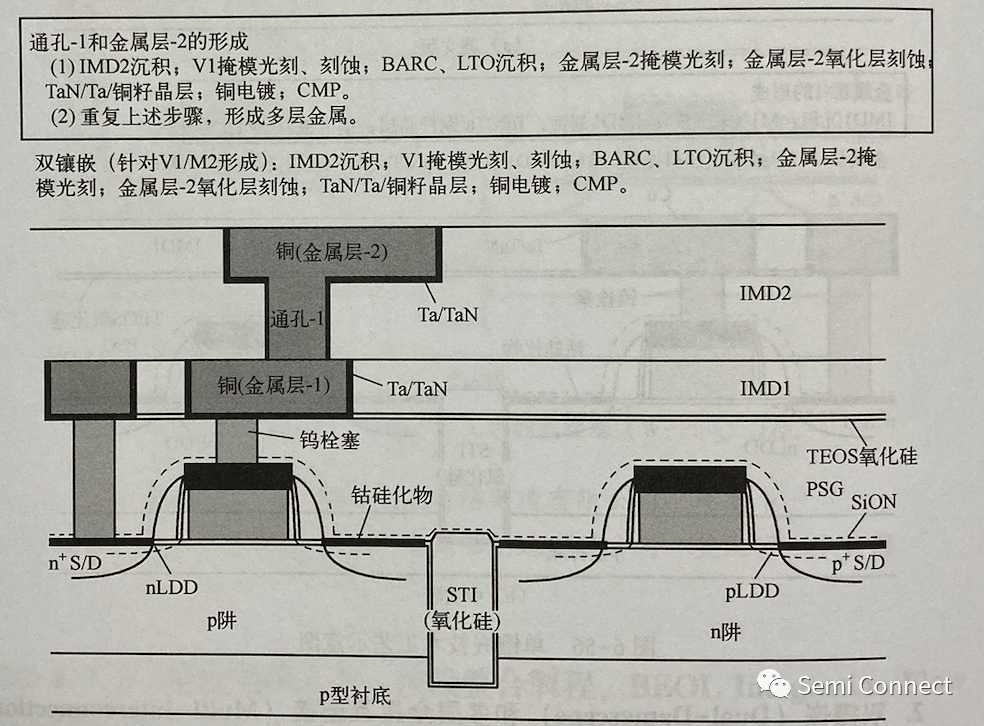
双镶嵌工艺分为先通孔 (Via-First) 和先沟槽(Trench-First)两种技术。以先通孔技术为例,首先沉积IMD2层(如 SiCN层,厚度约为 50nm,含碳低kPECVD 氧化硅黑金刚石层厚度约为 600nm),然后形成V1的图形并进行刻蚀。多层IMD1 的主要作用是提供良好的密封和覆盖更加多孔的低k介质。 为了平坦化,需要在通孔中填充底部抗反射涂层 (Bottom-Ani-Rellective Coatings, BARC),并沉积一层 LTO (Low Temperature Oxide)。随后形成M2 的图形并刻蚀氧化物,去除 BARC 并清洗后,沉积 Ta / TaN 阻挡层和 Cu 籽晶层,随后进行 Cu 填充(使用 ECP 法),并进行 CMP 平坦化,这样 M2 互连就形成了。 通过重复上述步骤,可以实现多层铜互连。相应的,先沟槽技术的双镶嵌工艺就是先实施 M2 沟槽制备再形成 V1 的图形并刻蚀氧化物,然后沉积阻挡层和籽晶层,最后进行 Cu 填充和 CMP 平坦化。
审核编辑 :李倩
-
工艺
+关注
关注
4文章
720浏览量
30395 -
金属
+关注
关注
1文章
621浏览量
25220
原文标题:后段集成工艺(BEOL Integration Flow)- 2
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
长电科技成功完成晶圆级射频集成无源器件工艺验证
使用 Neutron 运行eiq_genai_flow时输出错误怎么解决?
使用 ASR 运行eiq_genai_flow时出现 ALSA 错误怎么解决?
在 advantech aom-5521(iMX95) 上执行 eIQ GenAI Flow Demonstrator 时出错,怎么解决?
集成电路制造中的前道、中道和后道工艺介绍

集成电路制造中常用湿法清洗和腐蚀工艺介绍

芯片引脚成型与整形:电子制造中不可或缺的两种精密工艺
集成电路制造中薄膜刻蚀的概念和工艺流程

锂电池制造:电芯后段处理中的除气工艺

FLOW Digital Infrastructure宣布在东京市中心新建数据中心
半导体分层工艺的简单介绍
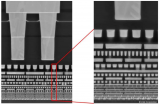
半导体封装工艺流程的主要步骤




 后段集成工艺(BEOL Integration Flow)- 2
后段集成工艺(BEOL Integration Flow)- 2


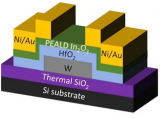




评论