摘要 本文使用导模法(EFG)制备了4英寸氧化镓(β-Ga2O3)单晶,并对晶体物相、结晶质量、缺陷、光学及电学 特性进行了研究。晶体不同方向劳厄(Laue)衍射斑点清晰一致,符合β-Ga2O3衍射特征。晶体(400)面摇摆曲线半峰 全宽(FWHM)为57.57″,通过化学腐蚀获得其腐蚀坑位错密度为1.06×104 cm-2。晶体在紫外截止边为262.1 nm, 对应光学带隙为4.67 eV。通过C-V测试分析获得非故意掺杂晶体中的电子浓度为7.77×1016 cm-3。
关键词: 氧化镓;宽禁带半导体;缺陷;晶体生长;导模法;单晶
引言
作为超宽禁带半导体材料,氧化镓禁带宽度约4.8 eV、击穿场强8 MV/cm、紫外截止边约260 nm,同 时可采用熔体法低成本制备,成为宽禁带半导体领域的研究热点[1-3]。氧化镓可用于制备功率器件、紫外探 测器、高能射线探测器,同时也可作为GaN、ZnO等半导体的衬底材料使用[4]。由于超高的击穿场强和巴 利加优值,氧化镓功率器件具有耐压高、导通损耗低、开关速度快的优点。目前,氧化镓二极管及场效应 晶体管器件耐压均可达几千伏,器件击穿场强已超过SiC和GaN的理论极限[1]。 β-Ga2O3 结构是热力学最稳定的结构,属于单斜晶系,空间群为C2/m,其晶格常数:a=1.221 nm,b=0.303 nm,c=0.579 nm,a与c的夹角约为103.8°[5]。由于β-Ga2O3 是热力学稳定相,通过熔体只能生长β-Ga2O3晶体。β-Ga2O3 晶体常用生长方法为光学浮区法、导模法、提拉法、布里奇曼法等[6-8]。不同晶体生长方法 各有特点,目前导模法和提拉法较为成熟,并且可以制备出2英寸(1英寸=2.54 cm)及以上单晶。由于 导电晶体具有较强自吸收的特性,提拉法晶体生长过程中界面控制难度较大,导致一般提拉法只能生长高阻β-Ga2O3 晶体[9]。导模法则既可生长高阻晶体也可生长导电晶体,是目前产品化衬底的主要制备方法。在单晶制备方面,日本Novel Crystal Technology目前已通过导模法实现了2~6英寸片状晶体的生长[10]。德 国莱布尼兹晶体生长研究所、美国空军实验室及Northrop Grumman公司也通过提拉法生长获得了高阻2 英寸晶体[1,11]。
本文通过导模法制备了4英寸β-Ga2O3单晶,晶体外形完整,通过劳厄衍射、高分辨X射线摇摆曲线 分析确认晶体结晶质量较高。采用湿法刻蚀的方法,研究了晶体腐蚀特性及位错密度。通过C-V测试,确 认了晶体电子浓度。
1 实验
1.1 晶体生长
晶体生长使用的原料为氧化镓粉末,纯度99.999%,采用中频感应加热,铱金发热体、铱金模具,铱 金坩埚周围放置氧化锆作为保温材料。采用《010》方向籽晶,晶体最大主面为(001)面,模具宽度为105 mm。氧化镓粉末加热熔化后,熔体会通过毛细作用上升到模具表面,通过籽晶诱导作用不断提拉长大。图1为 导模法生长4英寸β-Ga2O3 晶体。
1.2 性能测试与表征
湿法化学腐蚀使用质量分数为30%的KOH溶液,温度为110 ℃,腐蚀时间90 min。
扫描电子显微镜(SEM)图像使用FEI公司的Nova NanoSEM450扫描电子显微镜进行测试,电子束流强 度为0.6 pA~200 nA,着陆电压为50 V~20 kV。
原子力显微镜(AFM)图像使用Bruker公司的Bioscope Resolve型原子力显微镜,可实现快速扫描,扫描 速度不低于70 Hz。
高分辨X射线衍射设备来自Bruker AXS公司,型号为D8 Discover,靶材为Cu Kα1,波长λ为0.154056 nm。
劳厄衍射斑点图使用Multiwire Laboratories公司的MWL 120型X射线劳厄衍射仪,X射线靶为钨靶,光源焦斑尺寸小于0.5 mm×0.5 mm。
紫外光谱使用PerkinElmer Lambda950型紫外-可见-近红外分析光度计进行测试,测试的波长范围为 200~400 nm。
使用HHV auto 500电子束蒸发镀膜系统在β-Ga2O3 (100)制备肖特基接触Pt/Au(50 nm/50 nm)和欧姆接 触Ti/Au(50 nm/50 nm)的垂直结构电极,其中圆点肖特基电极的直径为360 μm。
C-V测试使用Keysight B1500 fA级半导体参数测试系统进行测试,测试频率为1 MHz。
结果与讨论
2.1 物相与晶体质量分析
为评估晶体质量,采用X射线劳厄衍射仪对晶体进行劳厄测试。图2为晶体(010)和(001)面不同位置 的劳厄衍射斑点图。衍射斑点与β-Ga2O3 理论衍射斑点一致,衍射斑点清晰对称,无重叠现象,并且同一 晶面不同位置的衍射斑点图具有高度一致性,说明晶体具有良好的单晶性,无孪晶存在。

图2 β-Ga2O3单晶劳厄衍射图 Fig. 2 Laue diffraction pattern of the β-Ga2O3 single crystal
采用湿法化学腐蚀技术对晶体质量进行表征,并采用SEM和AFM研究蚀坑形状。图3(a)和(b)分别为 在光学显微镜和SEM中观察到化学腐蚀后(100)面晶片表面的形貌图。从图中可以看到晶体表面有三角形 蚀坑出现,顶点朝向c向。从SEM照片中可以看到清晰的蚀坑形状,核心位于蚀坑的中上部,蚀坑左右 两侧的形状呈对称,采用AFM测量蚀坑深度约为1.27 μm。通过计算蚀坑数量得出位错密度为1.06×104 cm- 2。另外,没有发现(100)晶片表面密集且定向排列的蚀坑,说明晶体内无小角晶界缺陷。
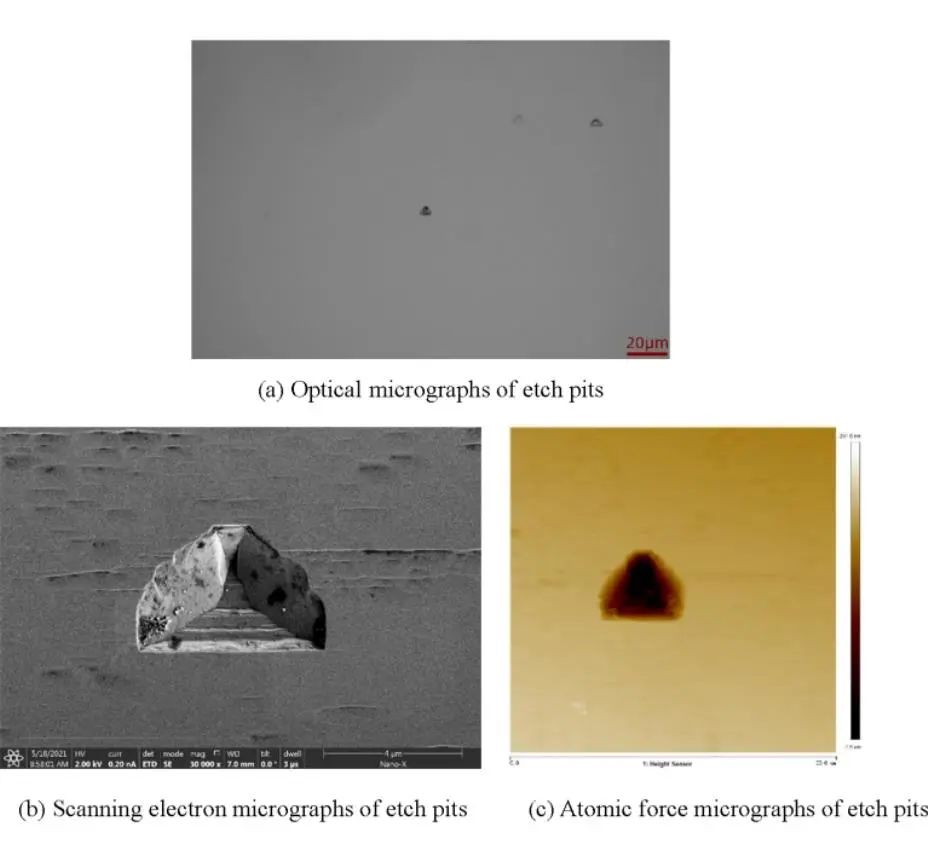
图3 晶体表面腐蚀形貌 Fig. 3 Morphology of crystal surface after chemical etching
除此之外,为进一步确定晶体的单晶质量,采用高分辨X射线衍射仪对晶体进行测试。图4为β-Ga2O3单晶(400)面的摇摆曲线测试结果。摇摆曲线为对称的单峰,半高宽仅为57.57″,无峰劈裂和肩峰的情况, 说明晶体中不含小角度晶界,结晶质量高。

图4 β-Ga2O3 (400)面摇摆曲线 Fig. 4 X-ray rocking curve of β-Ga2O3 (400) plane
2.2 光电性能
图5为β-Ga2O3晶体C-V曲线图,由公式可得β-Ga2O3 的载流子浓度为7.77×1016 cm- 3,其中S为电极接触面积、εr为相对介电常数、ε 0 为真空介电常数、N为载流子浓度。可以看出非故意 掺杂晶体具有一定的载流子浓度,目前已有研究表明Si元素在β-Ga2O3 晶体中是很好的浅施主杂质[12],并 且有研究人员利用杂化泛函计算出氧空位在晶体中以深能级的形式存在,其激活能高达1 eV,不能作为n 型背景电子的根本来源[13]。所以如今研究者普遍认为杂质是造成非故意掺杂衬底n型导电的原因。因此猜 测晶体中的施主可能来源于原料中的Si等n型杂质离子。

图5 β-Ga2O3晶体C-V曲线图 Fig. 5 C-V curve of β-Ga2O3 crystal
晶体的紫外透过光谱如图6(a)所示,当波长为λ的光入射到半导体表面时,光激发产生电子-空穴对的 条件是,Eg为禁带宽度、h为普朗克常量、c为光速,即半导体的禁带宽度决定了材料的紫外截 止边。β-Ga2O3 紫外截止边为到262.1 nm,通过外推法得到晶体的禁带宽度为4.67 eV,如图6(b)所示。

图6 β-Ga2O3晶体的紫外波段透过光谱及禁带宽度推算 Fig.6 Transmission spectra in ultraviolet band of the β-Ga2O3 crystal and its calculated bandgap
3 结 论
本文使用导模法生长了4英寸β-Ga2O3 单晶,晶体具有较高的结晶质量,劳厄斑点清晰、对称,晶体(400) 面摇摆曲线半高宽仅为57.57″。采用湿法化学腐蚀技术对晶体质量进行表征,晶体表面有三角形蚀坑出现, 顶点朝向c向位错密度为1.06×104 cm-2。通过C-V测试确认β-Ga2O3 晶体中载流子浓度为7.77×1016 cm-3,晶 体中的施主可能来源于原料中的Si等n型杂质离子。本研究通过导模法获得了高质量4英寸β-Ga2O3 单晶, 为下一步国内β-Ga2O3 材料与器件发展奠定了良好基础。
论文信息作者:穆文祥,贾志泰,陶绪堂
来源:https://doi.org/10.16553/j.cnki.issn1000-985x.20220831.001.人工晶体学报
编辑:黄飞
-
二极管
+关注
关注
149文章
10498浏览量
180056 -
晶体
+关注
关注
2文章
1450浏览量
37750 -
氧化镓
+关注
关注
5文章
92浏览量
10914 -
宽禁带半导体
+关注
关注
0文章
111浏览量
8715
原文标题:4英寸氧化镓单晶生长与性能
文章出处:【微信号:DT-Semiconductor,微信公众号:DT半导体】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
氧化镓射频器件研究进展

第四代半导体新进展:4英寸氧化镓单晶导电型掺杂
8英寸!第四代半导体再突破,我国氧化镓研究取得系列进展,产业化再进一步
陶绪堂:氧化镓单晶生长技术

氧化镓(Ga2O3)沟槽二极管的相关研究进展
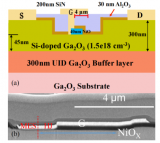
氧化镓异质集成和异质结功率晶体管研究

一种用于调控Ga2O3薄膜的表面电子结构的的热重组工程
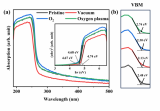
上海光机所在n型β-Ga2O3单晶光电性能调控方面取得进展




 使用导模法生长4英寸β-Ga2O3 氧化镓单晶性能分析
使用导模法生长4英寸β-Ga2O3 氧化镓单晶性能分析









评论