半导体制造的工艺过程由晶圆制造(Wafer Fabr ication)、晶圆测试(wafer Probe/Sorting)、芯片封装(Assemble)、测试(Test)以及后期的成品(Finish Goods)入库所组成。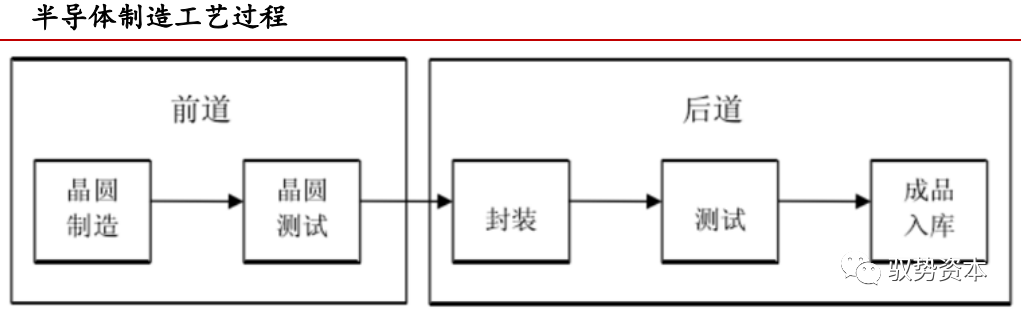
半导体器件制作工艺分为前道和后道工序,晶圆制造和测试被称为前道(Front End)工序,而芯片的封装、测试及成品入库则被称为后道(Back End)工序,前道和后道一般在不同的工厂分开处理。
前道工序是从整块硅圆片入手经多次重复的制膜、氧化、扩散,包括照相制版和光刻等工序,制成三极管、集成电路等半导体元件及电极等,开发材料的电子功能,以实现所要求的元器件特性。
后道工序是从由硅圆片分切好的一个一个的芯片入手,进行装片、固定、键合联接、塑料灌封、引出接线端子、按印检查等工序,完成作为器件、部件的封装体,以确保元器件的可靠性,并便于与外电路联接。
封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
随着汽车电气化和智能化的发展,中国汽车电子市场也正面临着新的机遇和挑战。汽车性能的不断提升不仅意味着更加先进的芯片设计,也意味着更先进的制造,封装工艺,其中也对芯片粘接技术提出了更高的要求。
面对新趋势、新变化,全球粘合剂技术领导品牌汉高依托广泛的技术和产品组合,结合本地生产工厂和全球技术中心的优势,成功开发了新型半烧结、超高导热的导电粘接胶水,为更精密的芯片粘接需求提供解决方案。
汉高半烧结粘接材料主要为银烧结材料。烧结是一种固态扩散过程,它通过质量传输使颗粒间和颗粒与基板结合在一起。银粉颗粒烧结发生在低于500℃的温度,远低于962℃的本体熔化温度。
汉高的半烧结芯片粘接胶水实现了技术的跃升,无需高温高压烧结,175℃即可进行低温烧结,具有优越的可靠性和作业性,且溶剂含量超低。同时,汉高的半烧结芯片粘接胶水具有更出色的可靠性,更高的热稳定性和电气稳定性。为了实现优越的性能,汉高提高了银粉含量,以获得强度更高、结合更致密的胶层。良好的韧性也提升了该产品的热循环性能,断裂伸长率达到5%。
自2016年以来,汉高就一直致力于半烧结材料的开发,并成功研制出了LOCTITE ABLESTICK ABP 8068系列半烧结芯片粘接胶水,该系列第三代产品LOCTITE ABLESTICK ABP 8068TI现在也已经进入了成熟的放大生产阶段。该产品要求芯片背面镀金属,适用于银、PPF、金和铜引线框架的粘接,本体导热能达到165W。
在经历0级的热循环测试之后,汉高半烧结芯片粘接胶水也不会出现胶层断裂现象。这一进步满足了汽车应用等级性能的要求,也彻底解决了客户的后顾之忧。
与此同时,汉高还推出了第一代无需芯片背面镀金属的产品LOCTITE ABLESTICK ABP 8068TD。该产品和多种铜引线框架相容性好,芯片背面镀金属可选,可同时用于无背金属和背金属的芯片粘接,具有优异的可靠性和作业性。在PPF框架上,5*5mm2尺寸的芯片可达MSL1。
此外,汉高半烧结芯片粘接胶水由于超低的溶剂含量,具有类似或者优于传统胶水的操作性能,便利生产操作。
在半烧结芯片粘接材料之外,汉高也提供汉高全烧结芯片粘接材料SSP 2020,同时适用于无压和有压烧结,具有超高导热性能和超强可靠性。
审核编辑:刘清
-
半导体封装
+关注
关注
4文章
327浏览量
15267 -
ABP
+关注
关注
0文章
3浏览量
2522
原文标题:半导体封装关键材料——芯片粘接材料
文章出处:【微信号:wc_ysj,微信公众号:旺材芯片】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录

85页PPT,看懂芯片半导体的封装工艺!

半导体先进封装之“2.5D/3D封装技术”的详解;



半导体“封装过程”工艺技术的详解;

半导体封装介绍

BW-4022A半导体分立器件综合测试平台---精准洞察,卓越测量
自主创新赋能半导体封装产业——江苏拓能半导体科技有限公司与 “半导体封装结构设计软件” 的突破之路


TGV技术:推动半导体封装创新的关键技术

汉思胶水在半导体封装中的应用概览




 半导体封装是指什么?封装过程是如何完成的
半导体封装是指什么?封装过程是如何完成的







评论