BGA封装形式解读
BGA(ball grid array)球形触点阵列是表面贴装型封装之一;BGA封装最早是美国Motorola 公司开发的。
BGA是在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI 用的一种封装。
封装本体也可做得比QFP(四侧引脚扁平封装)小。而且BGA 不用担心QFP 那样的引脚变形问题。
从封装形式的发展来看,大致可以理解为经历过TO- DIP- PLCC- QFP- BGA-CSP-----; BGA封装是大家可以经常见到的。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54409浏览量
469120 -
封装
+关注
关注
128文章
9325浏览量
149032 -
BGA
+关注
关注
5文章
586浏览量
51945 -
BGA封装
+关注
关注
4文章
125浏览量
19128
发布评论请先 登录
相关推荐
热点推荐
无压纳米烧结银:AI时代FC-BGA的关键材料
兼容性等方面的瓶颈,支撑了AI芯片如GPU、CPU、ASIC向高密度、高速度、低功耗方向的升级。 一 FC-BGA封装的技术需求:高I/O密度与大功率散热的双重挑战 FC-BGA是AI芯片的主流
一文掌握BGA封装技术:从基础到可靠性测试,推拉力测试机如何保障品质?
技术,其核心结构是在封装基板背面,以矩阵形式排列的微小锡球作为与外部电路连接的媒介。 二、 BGA封装的优势 相比传统的QFP(四边引脚扁平封装

GT-BGA-2003高性能BGA插座
1.00mm节距、1369引脚的大型BGA封装,具备低信号损耗、高机械耐久性和极端环境适应性,适用于5G、航空航天等领域的芯片测试与验证。主要技术参数参数规格
引脚间距 (Pitch)1.00 mm
发表于 02-10 08:41
罗彻斯特电子为客户提供厂内BGA封装元器件重新植球服务
当BGA封装的元器件从含铅工艺升级为符合RoHS标准的产品,或者长期存储的BGA元器件在生产过程中出现焊球损坏或焊接不良时,该如何应对?
激光锡焊技术在BGA封装的应用场景
随着消费电子产品、5G通信设备和汽车电子不断追求小型化、高性能和高密度集成,球栅阵列(BGA) 封装已成为连接芯片与电路板的主流技术。然而,其底部数以百计的微型焊点,也给制造和返修带来了前所未有的精度与可靠性挑战。




GT-BGA-2002高性能BGA测试插座
中等规模 BGA 封装,依托弹性体互连技术实现94GHz+超高频低损耗传输,具备高精度定位、极端环境耐久性及快速定制能力,可显著缩短研发验证到量产周期,是5G、航空航天等领域理想的测试解决方案。关键规格
发表于 12-18 10:00
BGA芯片阵列封装植球技巧,助力电子完美连接
紫宸激光焊锡应用ApplicationofVilaserSoldering高效节能绿色环保行业领先BGA(BallGridArray,球栅阵列封装)芯片植球是电子元器件焊接领域中的一项重要技术。其

紫宸激光植球技术:为BGA/LGA封装注入精“芯”动力
LGA和BGA作为两种主流的芯片封装技术,各有其适用的场景和优势。无论是BGA高密度植球还是LGA精密焊接,紫宸激光的植球设备均表现卓越,速度高达5点/秒,良率超99.98%,助力您大幅提升生产效率与产品可靠性。

解析LGA与BGA芯片封装技术的区别
在当今电子设备追求轻薄短小的趋势下,芯片封装技术的重要性日益凸显。作为两种主流的封装方式,LGA和BGA各有特点,而新兴的激光锡球焊接技术正在为封装工艺带来革命性的变化。本文将深入解析

GT-BGA-2000高速BGA测试插座
、全面功能测试以及长时间老旧化实验等核心应用领域。主要特征- 封装/尺寸:直接焊接到目标 PCB(需预开连接孔),无铅无焊料安装使用,适用 BGA 封装。- 高频性能:选用GT Elastomer弹性体
发表于 08-01 09:10
BGA失效分析原因-PCB机械应力是罪魁祸首
一、关于BGA简介 首先,我们需要明白什么是BGA。BGA是一种表面贴装封装技术,它的主要特点是在芯片底部形成一个球形矩阵。通过这个矩阵,芯片可以与电路板进行电气连接。这种

芯片传统封装形式介绍
个,间距2.54mm。1980年,表面贴装技术取代通孔插装技术,小外形封装、四边引脚扁平封装等形式涌现,引脚数扩展到3 - 300个,间距1.27 - 0.4mm 。1995年后,BGA
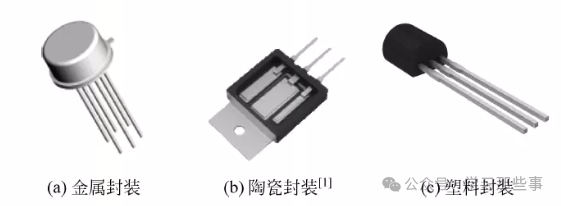



 bga封装是什么意思 BGA封装形式解读
bga封装是什么意思 BGA封装形式解读




评论